سلول خورشیدی سیلیکون آمورف (a-Si:H) (1D) — لایهنازک p/i/n (محدودشده توسط عیب)
1. مقدمه

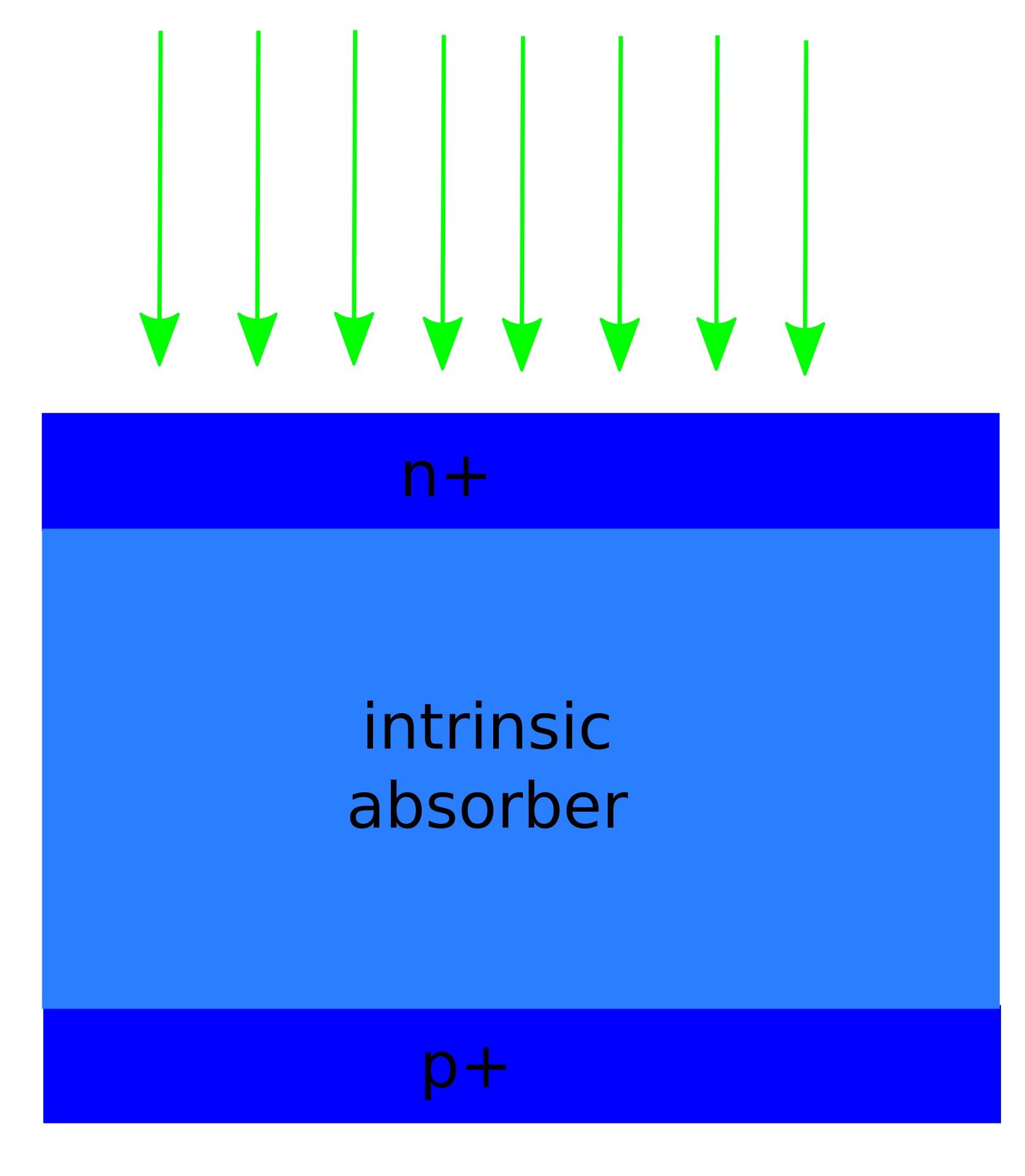
سلولهای خورشیدی سیلیکون آمورف هیدروژنه (a-Si:H) یک فناوری متعارف فتوولتائیک لایهنازک هستند. برخلاف سیلیکون بلوری، a-Si:H از نظر ساختاری بینظم است و چگالی بالایی از حالتهای عیب و دنباله دارد. در نتیجه، رفتار دستگاه معمولاً بهواسطه عیوب از نظر بازترکیب محدود میشود (فرایندهای از نوع Shockley–Read–Hall) و بهواسطه تحرکهای کمتر از نظر انتقال محدود میشود. این موضوع a-Si:H را به سامانهای عالی برای یادگیری این نکته تبدیل میکند که چگونه بازترکیب و چگالی حامل Voc را تعیین میکنند، و چگونه اپتیک لایهنازک Jsc را شکل میدهد.
این آموزش یک روند کاری عملی و مبتنی بر فیزیک برای شبیهسازی یک سلول خورشیدی a-Si:H در 1D با استفاده از OghmaNano ارائه میدهد. مدل، انتقال حامل رانش–پخش را که به الکترواستاتیک پواسون کوپل شده است، همراه با تولید نوری وابسته به عمق و بازترکیب با انگیزه فیزیکی که تحت سلطه بازترکیب عیبی از نوع SRH است، حل میکند. هدف این است که خروجیهای استاندارد—منحنیهای JV، Voc و رفتار Suns–Voc—به متغیرهای داخلی (نوارها، سطوح شبهفرمی، بار، و زمان بازترکیب مؤثر) متصل شوند.
شما یک سلول خورشیدی a-Si:H لایهنازک یکبعدی با یک ساختار استاندارد p/i/n خواهید ساخت و شبیهسازی خواهید کرد (نگاه کنید به ??). دستگاه بهصورت زیر تعریف میشود: ساختار (جلو → پشت): a-Si:H نوع p / a-Si:H ذاتی / a-Si:H نوع n / تماس فلزی. با استفاده از این دستگاه پایه، شما یک منحنی JV تحت روشنایی تولید میکنید، شاخصهای کلیدی عملکرد را استخراج میکنید و پویشهای Voc و Suns–Voc را اجرا میکنید تا افت ولتاژ محدودشده توسط بازترکیب و وابستگی آن به چگالی حامل را شناسایی کنید.
2. ساخت یک شبیهسازی جدید
برای شروع، از پنجره اصلی OghmaNano یک شبیهسازی جدید ایجاد کنید. روی دکمه شبیهسازی جدید در نوار ابزار کلیک کنید. این کار پنجره انتخاب نوع شبیهسازی را باز میکند (نگاه کنید به ??).


در پنجره نوع شبیهسازی، روی دموهای Si دوبار کلیک کنید، سپس روی سیلیکون آمورف (a-Si:H) دوبار کلیک کنید (نگاه کنید به ??). OghmaNano یک شبیهسازی از پیش تعریفشده سلول خورشیدی لایهنازک a-Si:H را بارگذاری خواهد کرد.


پنجره اصلی (نگاه کنید به ??) یک نمای سهبعدی از ساختار دستگاه فراهم میکند. میتوانید از ماوس برای چرخش، جابهجایی و بزرگنمایی صحنه جهت بررسی هندسه استفاده کنید. اگرچه آموزش حاضر از یک مدل الکتریکی یکبعدی استفاده میکند، نمای سهبعدی راهی مناسب برای بصریسازی پشته لایهنازک و تماسها فراهم میآورد.
روی زبانه ویرایشگر لایه کلیک کنید تا جدول لایهها باز شود (نگاه کنید به ??). در اینجا میتوانید ساختار عمودی دستگاه را بررسی کنید، از جمله لایه نوع p، جاذب ذاتی (لایه i)، لایه نوع n و تماس پشتی، همراه با ضخامتها و مواد تخصیصیافته آنها.
3. بررسی پروفایل دوپینگ

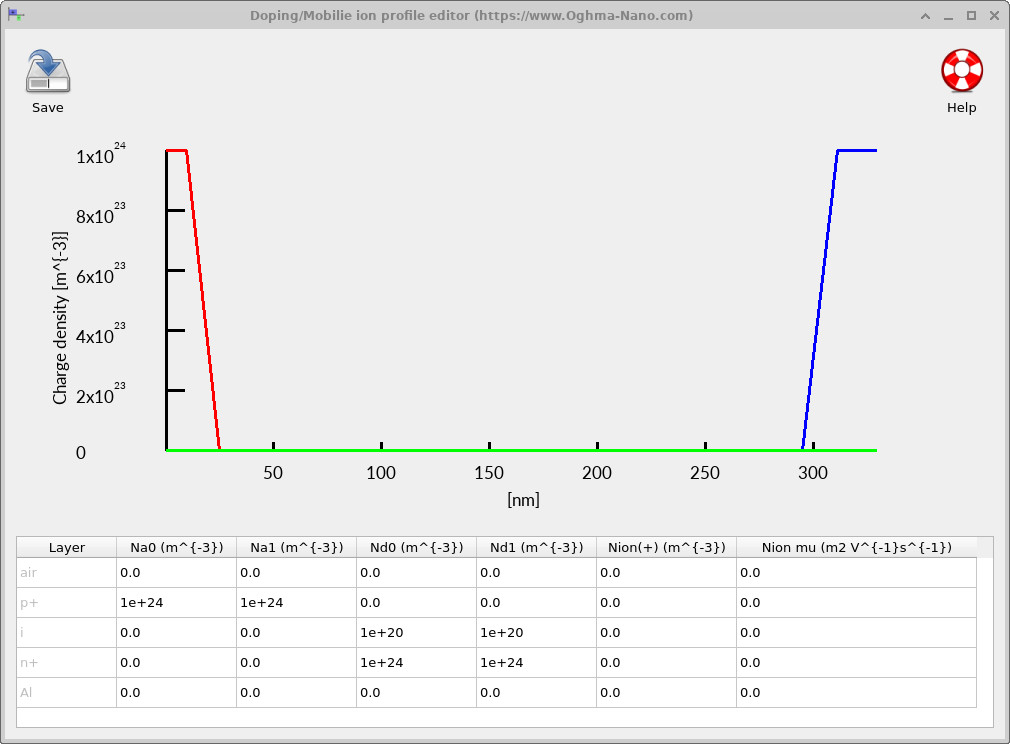
پروفایل دوپینگ ساختار الکترواستاتیکی دستگاه را پیش از اعمال روشنایی و بایاس تعیین میکند. در یک سلول خورشیدی سیلیکون آمورف (a-Si:H) لایهنازک، دوپینگ عمدتاً برای تشکیل تماسهای انتخابی حامل بهکار میرود، نه برای ایجاد یک ناحیه تهی پهن درون یک جاذب دوپشده. اصل عملکرد مرکزی، میدان الکتریکی داخلی در سراسر یک لایه ذاتی است که حاملهای نوریتولیدشده را جدا کرده و منتقل میکند.
برای مشاهده دوپینگ در OghmaNano، نوار Electrical را در پنجره اصلی باز کنید و روی Doping / Ions کلیک کنید (نگاه کنید به ??). این کار ویرایشگر پروفایل را باز میکند (نگاه کنید به ??), که چگالی بار دهنده و پذیرنده را بر حسب عمق رسم میکند و مقادیر عددی تخصیصیافته به هر لایه را فهرست میکند.
دستگاه از یک ساختار استاندارد p+/i/n+ از نوع a-Si:H استفاده میکند. یک لایه نازک و بهشدت دوپشده p+ در سطح جلوییِ روشنشونده قرار داده میشود (چگالی پذیرنده در مرتبه \(10^{24}\,\mathrm{m^{-3}}\)) که یک تماس انتخابی حفره فراهم میکند و خمیدگی نوار در سمت جلویی را تعیین میکند. سپس یک لایه جاذب ذاتی از a-Si:H با ضخامت بسیار بیشتر قرار میگیرد، که فقط بسیار سبک دوپ شده است (در اینجا \(\sim 10^{20}\,\mathrm{m^{-3}}\)) و بخش عمده تولید نوری را در خود دارد. در عقب دستگاه، یک لایه نازک و بهشدت دوپشده n+ (با چگالی دهنده دوباره \(\sim 10^{24}\,\mathrm{m^{-3}}\)) یک تماس پشتی انتخابی الکترون در مجاورت فلز تشکیل میدهد.
ویژگی کلیدی که باید در ویرایشگر پروفایل تشخیص دهید این است که میدان الکتریکی داخلی قوی در سراسر لایه ذاتی گسترده میشود، نه نواحی دوپشده. حاملهای نوریتولیدشده عمدتاً در a-Si:H ذاتی ایجاد میشوند و توسط این میدان داخلی از هم جدا میشوند: الکترونها به سمت تماس پشتی n+ رانده میشوند، در حالی که حفرهها به سمت تماس جلویی p+ رانده میشوند. لایههای دوپشده نازک نگه داشته میشوند تا بازترکیب کمکگرفته از عیب کمینه شود، در حالی که هنوز گزینشپذیری الکتریکی و رسانایی تماس مناسبی فراهم میشود.
4. پارامترهای الکتریکی: انتقال، الکترواستاتیک و بازترکیب در a-Si:H
ویرایشگر پارامترهای الکتریکی را از پنجره اصلی باز کنید: Device structure → Electrical parameters. پارامترها برای هر ناحیه با استفاده از زبانههای p+، i و n+ تعریف میشوند، که بهترتیب متناظر با لایه تماس جلویی، جاذب ذاتی و لایه تماس پشتی در پشته a-Si:H هستند. تنظیمات این ویرایشگر ضرایب انتقال رانش–پخش، همترازی انرژی، و سازوکارهای بازترکیب مورد استفاده در طی پویشهای JV و Suns–Voc را تعیین میکنند.



انتقال در سیلیکون آمورف به دلیل بینظمی و پراکندگی شدید با تحرکهای پایین مشخص میشود. بنابراین دمو از تحرکهایی بسیار کمتر از سیلیکون بلوری استفاده میکند. در لایه ذاتی (نگاه کنید به ??), تحرک الکترون روی μn = 7×10−4 m2V−1s−1 و تحرک حفره روی μp = 7×10−6 m2V−1s−1 تنظیم شده است. لایههای مجاور تماس از تحرکهای متفاوتی (معمولاً کمتر) استفاده میکنند (نگاه کنید به ?? و ??), که بازتاب این واقعیت است که لایههای دوپشده/انتخابی عمدتاً بهعنوان نواحی نازک استخراج عمل میکنند نه جاذبهای با تحرک بالا. در رانش–پخش، تحرک کمتر زمان ماند حامل را افزایش میدهد و بازترکیب را در نزدیکی مدار باز مهمتر میسازد.
خط مبنای الکترواستاتیکی بهکاررفته در سراسر پشته در هر زبانه قابل مشاهده است: الکترونخواهی χ = 4.05 eV، گاف انرژی Eg = 1.75 eV، و گذردهی نسبی εr = 11. گاف انرژی بزرگتر بازتاب گاف نوری a-Si:H است و کران بالای فوتوولتاژ قابل دستیابی را تعیین میکند، در حالی که الکترونخواهی و گذردهی همترازی نوار و نفوذ میدان را تعریف میکنند. این پارامترها همراه با پروفایل دوپینگ p+/i/n+ در بخش ??, یک میدان داخلی قوی را در سراسر لایه ذاتی برقرار میکنند، که سازوکار اصلی جداسازی حامل در دستگاههای لایهنازک p–i–n است.
بازترکیب در a-Si:H تحت سلطه فرایندهای میانجیشده توسط عیب است، بنابراین مدل اتلاف مرکزی بازترکیب Shockley–Read–Hall (SRH) از طریق حالتهای تله موضعی است. این مورد در همه نواحی از طریق بلوک Equilibrium SRH traps فعال شده است (به فیلدهای پارامتر SRH در ??, ??، و ?? نگاه کنید). در این صورتبندی، چگالی تله Nt، سطح مقطعهای گیراندازی σn و σp، و تراز انرژی تله Et نرخهای گیراندازی حامل و در نتیجه طولعمر مؤثر را تعیین میکنند: \[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \] که در آن \(v_{\mathrm{th}}\) سرعت گرمایی است. نرخ متناظر بازترکیب SRH به شکل استاندارد \[ R_{\mathrm{SRH}} = \frac{np - n_i^2}{\tau_p (n+n_1) + \tau_n (p+p_1)}, \] است، که در آن \(n_1\) و \(p_1\) توسط تراز انرژی تله \(E_t\) تعیین میشوند. از آنجا که بیشتر تولید نوری در جاذب ذاتی رخ میدهد، بازترکیب SRH در لایه i سازوکار اصلی محدودکننده شکافت سطح شبهفرمی و در نتیجه Voc در این آموزش است.
پارامترهای بازترکیب اوژه نیز در زبانههای p+ و n+ حضور دارند (نگاه کنید به ?? و ??), با ضرایب Cn = Cp = 1×10−43 m6s−1. بازترکیب اوژه بیانگر فرایندهای اتلاف سهذرهای در چگالی بالا به شکل \[ R_{\mathrm{Auger}} = C_n\,n^2 p + C_p\,p^2 n, \] است که هنگامی مرتبط میشوند که چگالی حاملها زیاد باشد، مانند نواحی تماس بهشدت دوپشده یا تحت روشنایی بسیار شدید در شبیهسازیهای Suns–Voc. در عملکرد استاندارد 1-sun در سیلیکون آمورف، بازترکیب اوژه معمولاً یک اثر ثانویه است؛ افت ولتاژ تحت سلطه بازترکیب Shockley–Read–Hall (SRH) میانجیشده توسط عیب است. با این حال، دربرگرفتن ترمهای اوژه یک کانال تزریق بالای سازگار با فیزیک فراهم میکند و از انباشتگی غیرفیزیکی حامل هنگامی که دستگاه به چگالیهای حامل بسیار بالا رانده میشود جلوگیری میکند (برای مثال در صدها تا هزاران suns). بحثی مفصل درباره بازترکیب اوژه و پیادهسازی آن در نظریه بازترکیب اوژه ارائه شده است.
در مجموع، تحرکهای پایین حامل، گاف مؤثر نسبتاً بزرگ، و چگالی بالای حالتهای عیب موضعی a-Si:H را بهطور کامل در یک رژیم عملکرد محدودشده توسط بازترکیب قرار میدهند. در نتیجه، هم منحنی JV و هم پاسخ Suns–Voc عمدتاً توسط اینکه چگونه طولعمر مؤثر SRH با افزایش چگالی حامل فرو میریزد کنترل میشوند. بنابراین این آموزش رفتار ولتاژ را مستقیماً برحسب شکافت سطح شبهفرمی و بازترکیب کنترلشده توسط عیب تفسیر میکند، نه بر مبنای فرضهای سیلیکون بلوری از تحرک بالا و عملکرد محدودشده توسط انتقال. بحثی مفصل درباره فیزیک بازترکیب SRH و نقش آن در مدلسازی دستگاههای نیمهرسانا در بخش نظری نظریه بازترکیب Shockley–Read–Hall ارائه شده است.
برای شفافیت و شفافیت عددی، این آموزش بازترکیب عیبی را با استفاده از یک تراز تله مؤثر SRH منفرد با سطح مقطعهای گیراندازی ثابت مدل میکند. این یک انتخاب مدلسازی عمدی برای آموزش حاضر است: این کار فیزیک غالب بازترکیب مرتبط با سلولهای خورشیدی a-Si:H را ثبت میکند و در عین حال فضای پارامتر را فشرده نگه میدارد. OghmaNano همچنین از روشهای پیشرفتهتری پشتیبانی میکند که در آنها یک توزیع از تلهها بهطور فعال بار را ذخیره میکند و تحت بایاس و روشنایی بهصورت دینامیکی تکامل مییابد. چنین روشهای غیرتعادلی زمانی ضروری میشوند که رفتار حوزه زمان در نظر گرفته شود، هنگامی که باردارشدن دستگاه مهم باشد، یا زمانی که تطابق کمی با دادههای آزمایشی گذرا یا دارای هیسترزیس مورد نیاز باشد. این بسطها و انگیزه فیزیکی آنها در چرا تلهها در نیمهرساناهای بینظم لازم هستند و بازترکیب غیرتعادلی Shockley–Read–Hall توصیف شدهاند.
5. پروفایل تولید نوری
این دمو از یک محاسبه نوری یکبعدی برای تولید یک ترم منبع وابسته به عمق برای حلگر رانش–پخش استفاده میکند. در عمل، مدل نوری محاسبه میکند که طیف ورودی AM1.5 چگونه به درون پشته لایهنازک منتشر میشود، چه مقدار بهعنوان تابعی از طول موج و عمق جذب میشود، و آن توان جذبشده را به نرخ تولید زوج الکترون–حفره تبدیل میکند. در a-Si:H لایهنازک، جاذب معمولاً فقط چند صد نانومتر ضخامت دارد، بنابراین پروفایل نوری بهشدت به طراحی پشته کوپل است: بخش زیادی از جذب مفید در نزدیکی سمت روشنشونده رخ میدهد، و راهبردهای بازتاب پشتی/بهداماندازی نور بهشدت بر Jsc اثر میگذارند.
برای مشاهده (و بازتولید) حل نوری، به نوار Optical در پنجره اصلی بروید و روی Transfer matrix کلیک کنید. این کار ویرایشگر شبیهسازی نوری را باز میکند. دکمه آبی Run optical simulation (آیکون پخش) را فشار دهید تا میدان نوری محاسبه شود و نمودارها بهروزرسانی شوند (نگاه کنید به ??).
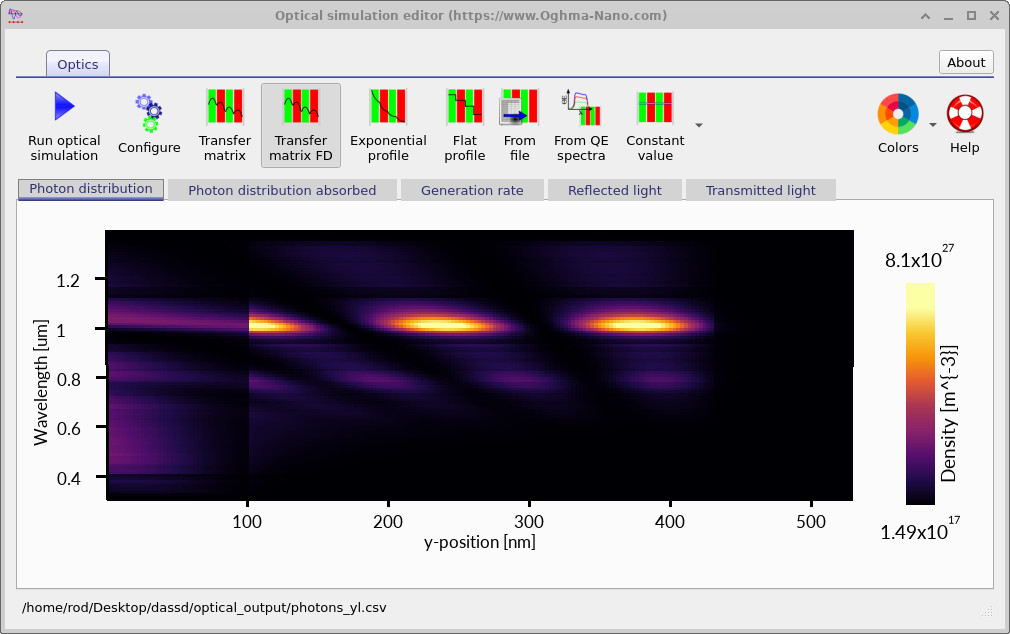
نمودار در ?? یک نقشه طول موج–عمق است. محور افقی عمق درون دستگاه است (با برچسب y-position)، و محور عمودی طول موج است. رنگهای روشن در نزدیکی سطح روشنشونده نشاندهنده جمعیت بالای فوتون هستند؛ کمرنگ شدن با عمق نشاندهنده جذب درون پشته است.
برای a-Si:H، جذب در ناحیه مرئی قوی است، بنابراین بخش بزرگی از فوتونهای مفید در فاصلهای نسبتاً کوتاه از سمت جلو جذب میشوند. حد طول موج بلندتر توسط گاف مؤثر a-Si:H کنترل میشود: فوتونهای زیر گاف انرژی حاملها را بهطور مؤثر تولید نمیکنند، بنابراین نقشه فوتون یک مرز طیفی را نشان خواهد داد که فراتر از آن جذب و تولید بهشدت افت میکند. این یکی از دلایلی است که دستگاههای a-Si:H لایهنازک معمولاً Jsc مطلق را با گاف انرژی بالاتر و گزینشپذیری طیفی بهبودیافته نسبت به سیلیکون بلوری مبادله میکنند.
ویرایشگر نوری چندین زبانه فراهم میکند زیرا «چگالی فوتون» با «نرخ تولید» یکسان نیست. نمای Photon distribution به شما میگوید میدان نوری کجا وجود دارد. زبانههای Photon distribution absorbed و Generation rate همانهایی هستند که برای مدل الکتریکی اهمیت دارند: نقشه فوتون جذبشده به یک نرخ تولید زوج الکترون–حفره وابسته به عمق تبدیل میشود که همان ترم منبع تزریقشده به معادلات رانش–پخش است. برای این سلول a-Si:H، پروفایل تولید حاصل بهشدت در جلو متمرکز است و به جاذب نازک محدود میشود، که دقیقاً همان رژیمی است که در آن بازترکیب و انتقال در نزدیکی مدار باز برای Voc تعیینکننده میشوند.
6. اجرای شبیهسازی، منحنیهای JV و استخراج پارامترها
هنگامی که ساختار دستگاه، پارامترهای الکتریکی و تولید نوری تعریف شدند، شبیهسازی را میتوان مستقیماً از پنجره اصلی اجرا کرد. برای شروع حلگر روی دکمه Run simulation در نوار ابزار کلیک کنید. هنگام اجرا، اطلاعات پیشرفت و همگرایی حلگر در پنجره ترمینال نوشته میشوند (نگاه کنید به ??).
برای هر نقطه بایاس، ولتاژ اعمالشده در تماس بالایی ابتدا فهرست میشود و پس از آن چگالی جریان حاصل میآید. تحت روشنایی، جریان در ابتدا منفی است (تولید توان). با افزایش ولتاژ اعمالی، بزرگی جریان کاهش مییابد تا در ولتاژ مدار باز از صفر عبور کند. فراتر از این نقطه، جریان مثبت میشود که متناظر با عملکرد دیودی در بایاس مستقیم است. خروجی ترمینال همچنین باقیمانده حلگر و زمان همگرایی برای هر گام بایاس را گزارش میکند. باقیماندههای کوچک نشان میدهند که معادلات کوپلشده رانش–پخش و پواسون با دقت حل میشوند.


jv.csv و siminfo.dat هستند.
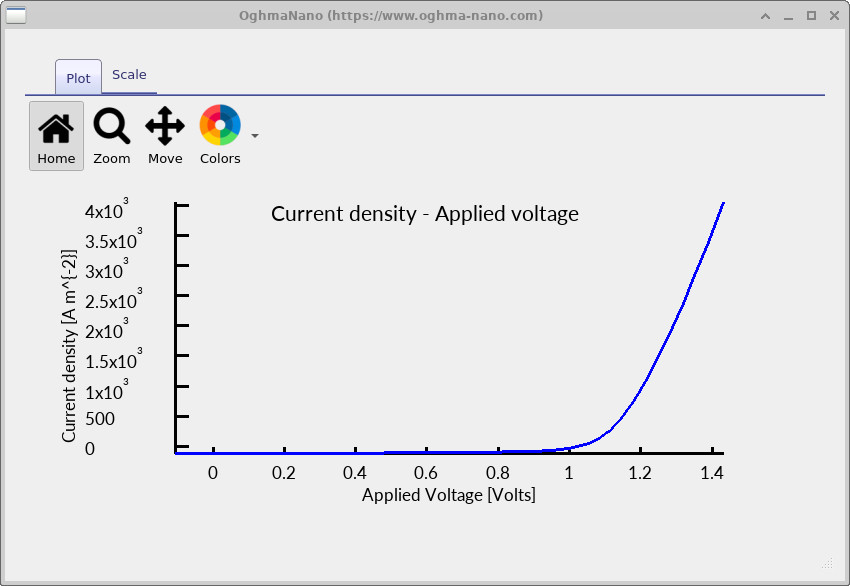
jv.csv بهدست میآید. منحنی، جریان منفی را در ولتاژ پایین،
عبور از جریان صفر در Voc، و رسانش مستقیم را در بایاس بالاتر نشان میدهد.

siminfo.dat باز میشود و شاخصهای استخراجشده دستگاه
مانند Voc، Jsc، فاکتور پرشدگی و بازده را فهرست میکند.
برای بررسی مشخصههای الکتریکی، زبانه Output را باز کنید و روی
jv.csv دوبار کلیک کنید. این کار منحنی چگالی جریان–ولتاژ (JV) را نمایش میدهد
(نگاه کنید به ??).
منحنی JV ابزار تشخیصی اصلی رفتار دستگاه است: باید از جریان اتصال کوتاه
در بایاس صفر عبور کند و در ولتاژ مدار باز از جریان صفر عبور کند.
دوبار کلیک روی siminfo.dat پنجره اطلاعات شبیهسازی را باز میکند
(نگاه کنید به ??),
که شاخصهای عملکرد استخراجشده، از جمله فاکتور پرشدگی، بازده تبدیل توان،
نقطه بیشینه توان، Voc و Jsc را گزارش میکند.
کمیتهای تشخیصی اضافی، مانند چگالیهای حامل آزاد در مدار باز، نیز برای تفسیر
رفتار محدودشده توسط عیب در a-Si:H مفید هستند.
یک قاعده عملی این است که همیشه پیش از تفسیر شاخصهای عددی، منحنی JV را بررسی کنید.
اگر منحنی JV بهطور تمیز از اتصال کوتاه و مدار باز عبور نکند، یا اگر جریان علامت یا شکل
غیرمنتظرهای داشته باشد، کمیتهای مشتقشده در siminfo.dat نیز غیرقابلاعتماد خواهند بود.
بررسی بصری منحنی JV سریعترین راه برای تشخیص مسائل پیکربندی یا مدلسازی است.
7. تحلیل Suns–Voc: ولتاژ محدودشده توسط بازترکیب در a-Si:H
یک اندازهگیری Suns–Voc بررسی میکند که چگونه ولتاژ مدار باز بهعنوان تابعی از شدت روشنایی تحت شرایط کاملاً بدون جریان تکامل مییابد. چون جریان ترمینال مجبور است صفر باشد، Suns–Voc فیزیک بازترکیب را از اثرات انتقال و مقاومت تماس جدا میکند. بنابراین منحنی حاصل یکی از مستقیمترین ابزارهای تشخیص سازوکارهای افت ولتاژ در یک سلول خورشیدی است.
در OghmaNano، Suns–Voc بهصورت یک حالت شبیهسازی اختصاصی پیادهسازی شده است. بهجای پویش ولتاژ اعمالی، حلگر شدت روشنایی را پویش میکند و در هر شدت، ولتاژ ترمینال را تا زمانی تنظیم میکند که جریان خالص صفر شود. این کار مستقیماً نقطه عملکرد مدار باز را در هر سطح روشنایی محاسبه میکند.
برای فعالکردن Suns–Voc، نوار Simulation type را در پنجره اصلی باز کنید
(نگاه کنید به ??)
و Suns–Voc را انتخاب کنید. سپس روی Run simulation کلیک کنید.
حلگر بهطور خودکار نتایج را روی دیسک مینویسد؛ فایل
suns_voc.csv شامل Voc بهعنوان تابعی از شدت روشنایی است.
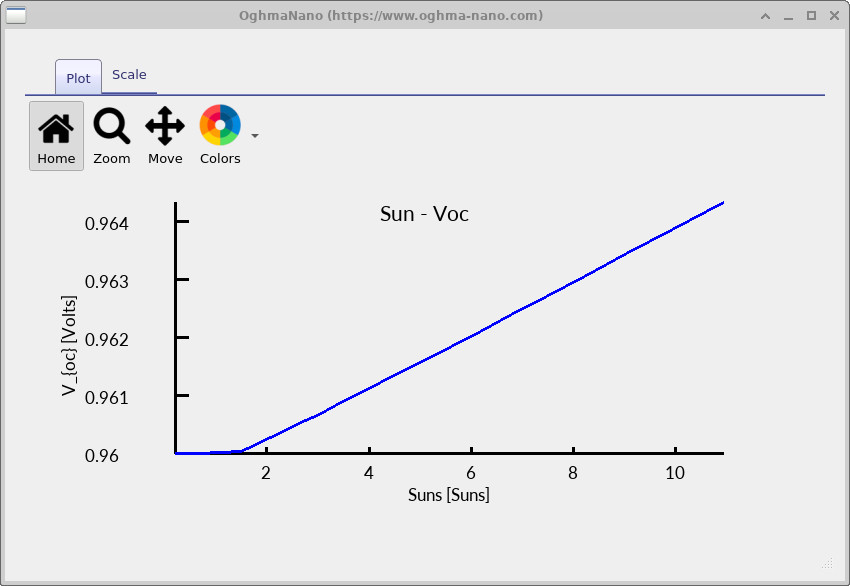

suns_voc.csv، charge_suns.csv و tau_suns.csv را نشان میدهد.
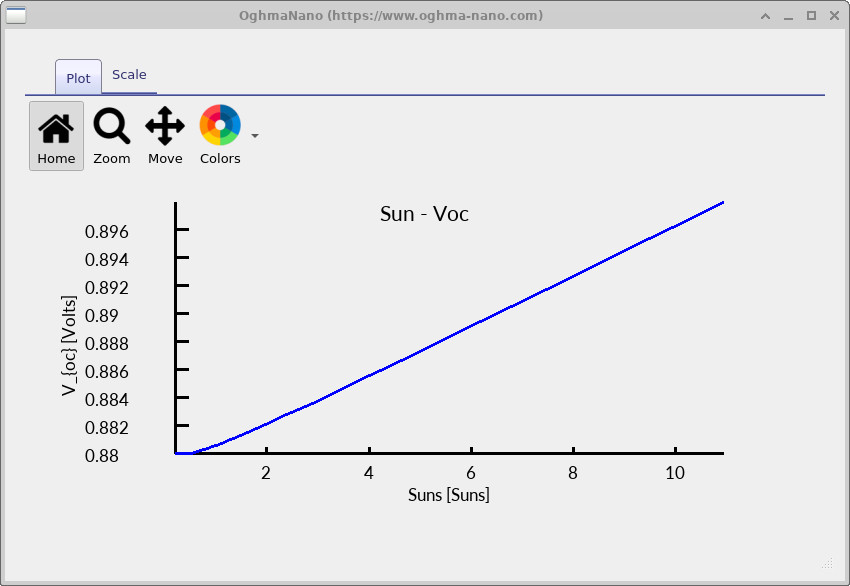
در روشنایی پایین، افزایش Voc توسط انباشت چگالی حامل اضافی در جاذب ذاتی کنترل میشود. در حد غیرتباهگنی، شکافت سطح شبهفرمی برابر است با \[ qV_{\mathrm{oc}} = E_{Fn} - E_{Fp} = kT \ln\!\left(\frac{np}{n_i^2}\right), \] بنابراین Voc فقط بهصورت لگاریتمی با چگالی حامل افزایش مییابد.
در سیلیکون آمورف، این رژیم شدت پایین اغلب توسط اثرات اشغال عیب تغییر میکند. در نرخهای تولید بسیار پایین، بخش قابلتوجهی از حاملهای نوریتولیدشده پیش از آنکه به جمعیت حامل آزاد کمک کنند توسط حالتهای عمیق و دنباله گیر افتاده میشوند. این میتواند یک پاسخ اولیه ضعیف یا اندکی تختشده در منحنی Suns–Voc ایجاد کند، همانطور که در ?? مشاهده میشود. این رفتار یک پیامد فیزیکی پرشدن تله است، نه یک آرتیفکت عددی.
برای بررسی رژیم تزریق بالا، بازه روشنایی را گسترش دهید. Suns–Voc editor را از نوار Editors باز کنید و stop intensity را به 1000 suns افزایش دهید. شبیهسازی را دوباره اجرا کنید.


باز کردن suns_voc.csv پس از اجرای دوباره شبیهسازی، رفتار کل
بازه روشنایی را آشکار میکند (نگاه کنید به ??).
در روشنایی زیاد، Voc به افزایش ادامه میدهد اما با شیبی که پیوسته
کاهش مییابد، و در نهایت به اشباع نزدیک میشود.
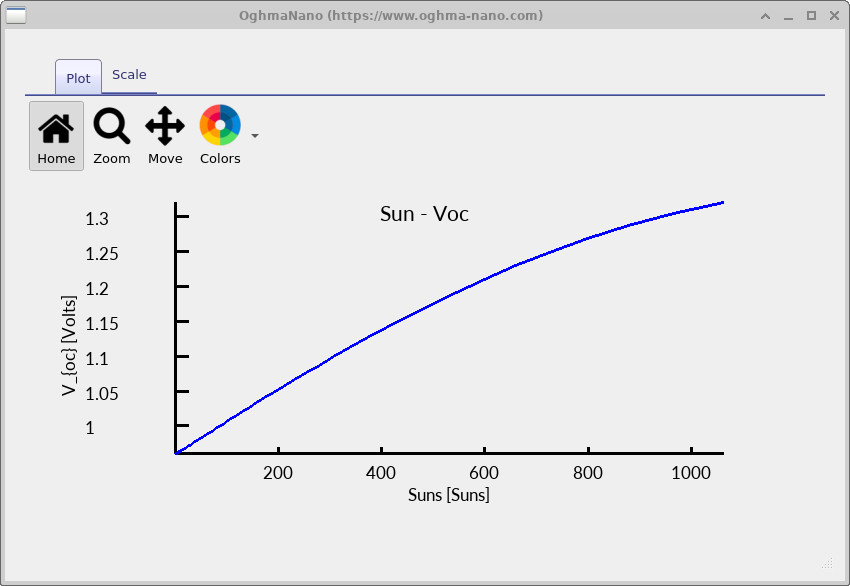
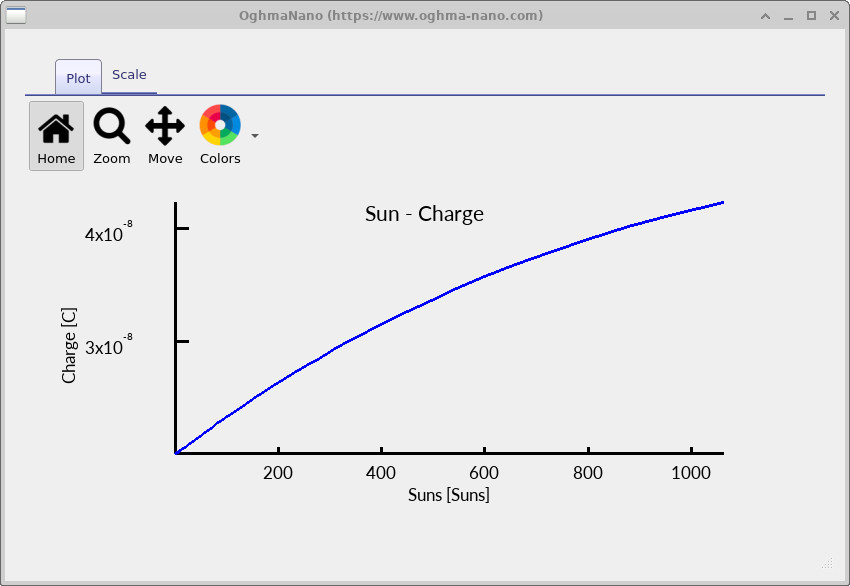
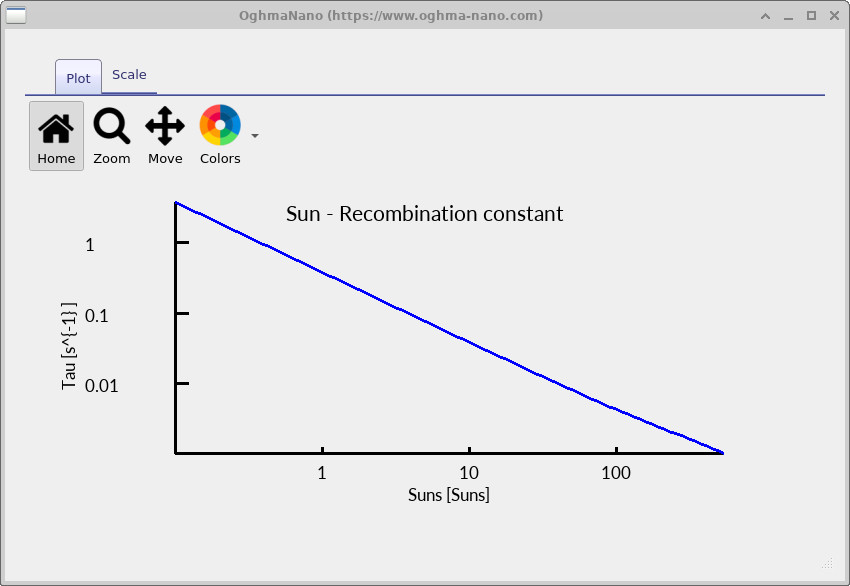
منشأ اشباع ولتاژ هنگامی روشن میشود که منحنی Suns–Voc همراه با بار ذخیرهشده و طولعمر مؤثر دیده شود. با افزایش روشنایی، چگالی کل حامل اضافی افزایش مییابد (نگاه کنید به ??), اما زمان بازترکیب مؤثر بهطور همزمان کاهش مییابد (نگاه کنید به ??).
در a-Si:H، بازترکیب تحت سلطه فرایندهای از نوع SRH میانجیشده توسط عیب است. با افزایش چگالی حامل، بازترکیب کمکگرفته از تله شتاب میگیرد و طولعمر مؤثر \[ \tau_{\mathrm{eff}} = \frac{\Delta n}{R} \] کاهش مییابد. فراتر از این نقطه، فتوتولید اضافی عمدتاً بازترکیب را افزایش میدهد نه جدایش سطوح شبهفرمی را.
این موازنه بین تولید و بازترکیب یک حد بالای ذاتی را بر Voc تحمیل میکند. بیشینه ولتاژ پایینتر از گاف مؤثر a-Si:H باقی میماند زیرا بازترکیب مانع از آن میشود که سطوح شبهفرمی الکترون و حفره همزمان به لبههای نوار متناظر خود نزدیک شوند. بنابراین اختلاف Eg/q − Voc نمایانگر افت بنیادی ولتاژ ناشی از بازترکیب در این دستگاه است.