非晶硅 (a-Si:H) 太阳能电池 (1D) — 薄膜 p/i/n(缺陷受限)
1. 简介

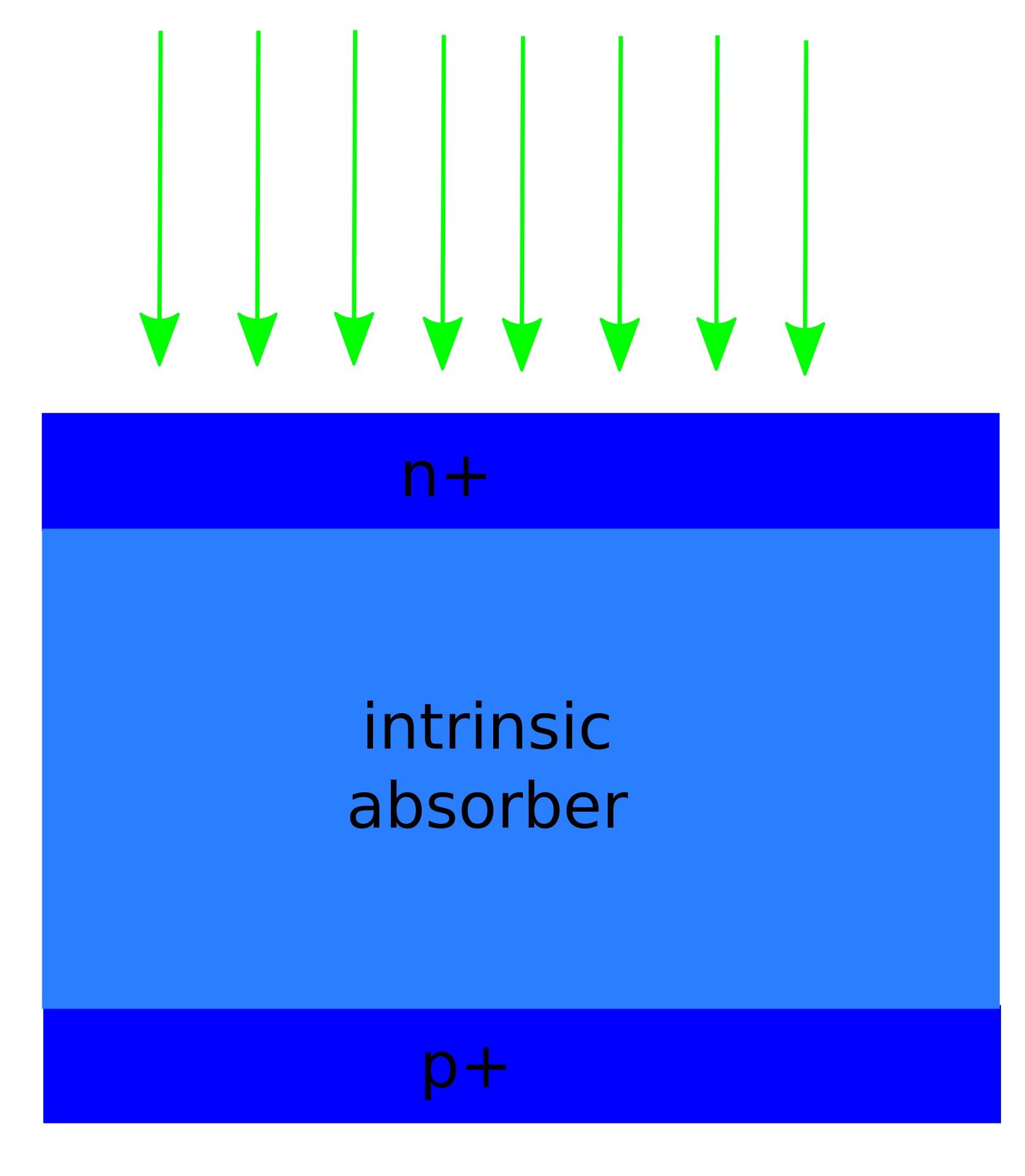
氢化非晶硅 (a-Si:H) 太阳能电池是一种典型的薄膜光伏技术。 与晶体硅不同,a-Si:H 在结构上是无序的,并含有高密度的缺陷态和带尾态。 因此,器件行为通常受缺陷限制的复合(Shockley–Read–Hall 型过程) 和较低迁移率限制的输运所支配。 这使得 a-Si:H 成为学习复合与载流子密度如何决定 Voc, 以及薄膜光学如何塑造 Jsc 的极佳体系。
本教程提供了一个基于物理的实用流程,用于使用 OghmaNano 在 1D 中仿真 a-Si:H 太阳能电池。 该模型解析了与 Poisson 静电耦合的漂移–扩散载流子输运,并包含随深度变化的光学生成以及 以SRH 型缺陷复合为主导的物理复合机制。 目标是将标准输出——JV 曲线、Voc 和 Suns–Voc 行为——与内部变量(能带、准费米能级、空间电荷 和有效复合时间)联系起来。
你将构建并仿真一个一维薄膜 a-Si:H 太阳能电池, 采用标准的 p/i/n 架构 (见 ??)。 器件定义为: 结构(前 → 后):p a-Si:H / i a-Si:H / n a-Si:H / 金属接触。 以此基线器件为基础,你将生成受光照条件下的JV 曲线,提取关键性能指标,并执行 Voc 和 Suns–Voc 扫描,以识别复合限制的电压损失及其对载流子密度的依赖。
2. 创建新仿真
首先,从 OghmaNano 主窗口创建一个新仿真。 点击工具栏中的 New simulation 按钮。 这将打开仿真类型选择对话框 (见 ??)。


在仿真类型对话框中,双击 Si demos, 然后双击 Amorphous silicon (a-Si:H) (见 ??)。 OghmaNano 将加载一个预定义的 a-Si:H 薄膜太阳能电池仿真。


主窗口 (见 ??) 提供了器件结构的三维视图。 你可以使用鼠标旋转、平移和缩放场景来检查几何结构。 尽管本教程使用的是一维电学模型, 3D 视图仍然为可视化薄膜堆叠和接触提供了便利方式。
点击 Layer editor 选项卡打开层表 (见 ??)。 在这里你可以检查垂直器件结构,包括 p 型层、本征吸收层(i 层)、n 型层以及背接触, 以及它们的厚度和指定材料。
3. 检查掺杂分布

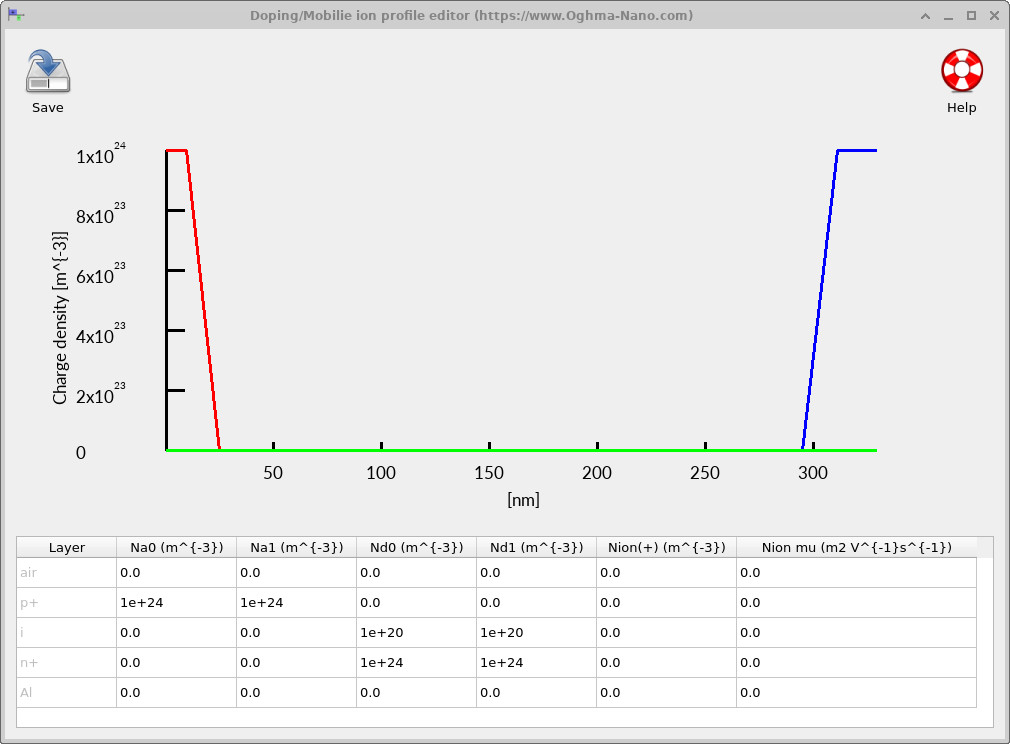
掺杂分布决定了器件在施加光照和偏压之前的静电结构。 在薄膜非晶硅 (a-Si:H) 太阳能电池中,掺杂的主要作用是形成 载流子选择性接触,而不是在掺杂吸收层内部形成宽耗尽区。 其核心工作原理是本征层上的内建电场, 该电场负责分离和输运光生载流子。
要在 OghmaNano 中查看掺杂,请在主窗口中打开 Electrical ribbon 并点击 Doping / Ions (见 ??)。 这将打开分布编辑器 (见 ??), 其中绘制了施主和受主电荷密度随深度的变化,并列出了分配给每一层的数值。
该器件采用标准的 p+/i/n+ a-Si:H 结构。 在受光照的前表面放置一层薄而重掺杂的 p+ 层 (受主密度数量级约为 \(10^{24}\,\mathrm{m^{-3}}\)), 以提供空穴选择性接触并设定前表面的能带弯曲。 其后是厚得多的本征 a-Si:H 吸收层, 该层仅被很轻地掺杂(此处约为 \(\sim 10^{20}\,\mathrm{m^{-3}}\)),并包含大部分光学生成。 在器件后部,一层薄而重掺杂的 n+ 层 (施主密度同样约为 \(\sim 10^{24}\,\mathrm{m^{-3}}\))形成与金属相邻的电子选择性背接触。
在分布编辑器中需要识别的关键特征是: 强内建电场跨越的是本征层,而不是掺杂区。 光生载流子主要在本征 a-Si:H 中产生,并由这一内建场分离: 电子被驱动至 n+ 背接触, 而空穴被驱动至 p+ 前接触。 掺杂层被保持得很薄,以尽量减小缺陷辅助复合,同时仍提供良好的电学选择性和接触电导率。
4. 电学参数:a-Si:H 中的输运、静电与复合
从主窗口打开电学参数编辑器: Device structure → Electrical parameters。 参数按区域在 p+、i 和 n+ 选项卡中定义, 分别对应于 a-Si:H 堆叠中的前接触层、本征吸收层和背接触层。 此编辑器中的设置决定了漂移–扩散输运系数、能级排列, 以及在 JV 和 Suns–Voc 扫描中使用的复合机制。



非晶硅中的输运以低迁移率为特征,这是由无序和强散射造成的。 因此该示例使用远低于晶体硅的迁移率。 在本征层中 (见 ??), 电子迁移率设置为 μn = 7×10−4 m2V−1s−1, 空穴迁移率设置为 μp = 7×10−6 m2V−1s−1。 与接触相邻的层使用不同(通常更低)的迁移率 (见 ?? 和 ??), 这反映了掺杂/选择性层主要充当薄提取区,而不是高迁移率吸收层。 在漂移–扩散模型中,较低迁移率会增加载流子的停留时间, 并使复合在接近开路时变得更为重要。
整个堆叠中使用的静电基准在每个选项卡中都可见: 电子亲和势 χ = 4.05 eV,带隙 Eg = 1.75 eV,相对介电常数 εr = 11。较宽带隙反映了 a-Si:H 的光学带隙,并设定了可达到光电压的上限, 而电子亲和势和介电常数则定义了能带排列和电场穿透。 结合第 ?? 节中的 p+/i/n+ 掺杂分布, 这些参数在本征层上建立了强内建电场, 这是薄膜 p–i–n 器件中主要的载流子分离机制。
a-Si:H 中的复合由缺陷介导过程主导,因此中心损耗模型是 通过局域陷阱态发生的Shockley–Read–Hall (SRH) 复合。 这在所有区域中都通过 Equilibrium SRH traps 模块启用 (见 ??、 ?? 和 ?? 中的 SRH 参数字段)。 在这种表述中,陷阱密度 Nt、俘获截面 σn 和 σp,以及陷阱能级 Et 设定了载流子俘获速率,从而决定有效寿命: \[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \] 其中 \(v_{\mathrm{th}}\) 为热速度。相应的 SRH 复合速率采用标准形式 \[ R_{\mathrm{SRH}} = \frac{np - n_i^2}{\tau_p (n+n_1) + \tau_n (p+p_1)}, \] 其中 \(n_1\) 和 \(p_1\) 由陷阱能级 \(E_t\) 决定。由于大部分光生载流子产生在本征吸收层中, 因此 i 层中的 SRH 复合是本教程中限制准费米能级分裂、 进而限制Voc 的主要机制。
在 p+ 和 n+ 选项卡中也存在 Auger 复合参数 (见 ?? 和 ??), 其系数为 Cn = Cp = 1×10−43 m6s−1。 Auger 复合表示高载流子密度下的三粒子损耗过程,其形式为 \[ R_{\mathrm{Auger}} = C_n\,n^2 p + C_p\,p^2 n, \] 当载流子密度很高时,这一过程会变得相关, 例如在重掺杂接触区或在 Suns–Voc 仿真中的极高光照条件下。 在标准 1-sun 非晶硅运行条件下,Auger 复合通常是次要效应; 电压损失主要由缺陷介导的 Shockley–Read–Hall (SRH) 复合主导。 尽管如此,加入 Auger 项仍提供了一个物理上一致的高注入损耗通道, 并防止在极高载流子密度条件下 (例如数百到数千 suns) 出现不合理的载流子积累。 关于 Auger 复合及其实现的详细讨论见 Auger recombination theory。
综合来看,较低的载流子迁移率、相对较宽的有效带隙以及高密度局域缺陷态 使 a-Si:H 明确处于 复合限制运行区。 因此,JV 曲线和 Suns–Voc 响应主要由 有效 SRH 寿命如何随载流子密度增加而塌缩所决定。 因而本教程将直接用 准费米能级分裂和缺陷控制复合来解释电压行为, 而不是采用晶体硅式的高迁移率和输运限制运行假设。 关于 SRH 复合物理及其在半导体器件建模中的作用的详细讨论 见理论部分 Shockley–Read–Hall recombination theory。
为了保持清晰性和数值透明性,本教程使用 具有固定俘获截面的单一有效 SRH 陷阱能级 来建模缺陷复合。 这是本教程中有意采用的建模选择: 它能捕捉与 a-Si:H 太阳能电池相关的主要复合物理,同时保持参数空间紧凑。 OghmaNano 也支持更高级的处理方式,其中陷阱分布 可以主动存储电荷,并在偏压和光照下动态演化。 一旦考虑时域行为、 器件充电效应重要, 或需要与瞬态或滞后实验数据进行定量符合时, 这些非平衡处理就变得必不可少。 这些扩展及其物理动机可参见 Why traps are required in disordered semiconductors 和 Non-equilibrium Shockley–Read–Hall recombination。
5. 光学生成分布
该示例使用一维光学计算来生成漂移–扩散求解器所需的随深度变化的源项。 实际上,光学模型计算入射 AM1.5 光谱如何传播到薄膜堆叠中、 在不同波长和深度上有多少光被吸收, 并将这些吸收功率转换为电子–空穴对生成率。 在薄膜 a-Si:H 中,吸收层厚度通常只有几百纳米, 因此光学分布与堆叠设计紧密耦合: 大量有效吸收发生在受光表面附近,而背反射/陷光策略会强烈影响 Jsc。
要查看(并重新生成)光学解, 在主窗口中进入 Optical ribbon 并点击 Transfer matrix。 这将打开光学仿真编辑器。 按下蓝色的 Run optical simulation 按钮(播放图标)以计算光场并更新图形 (见 ??)。
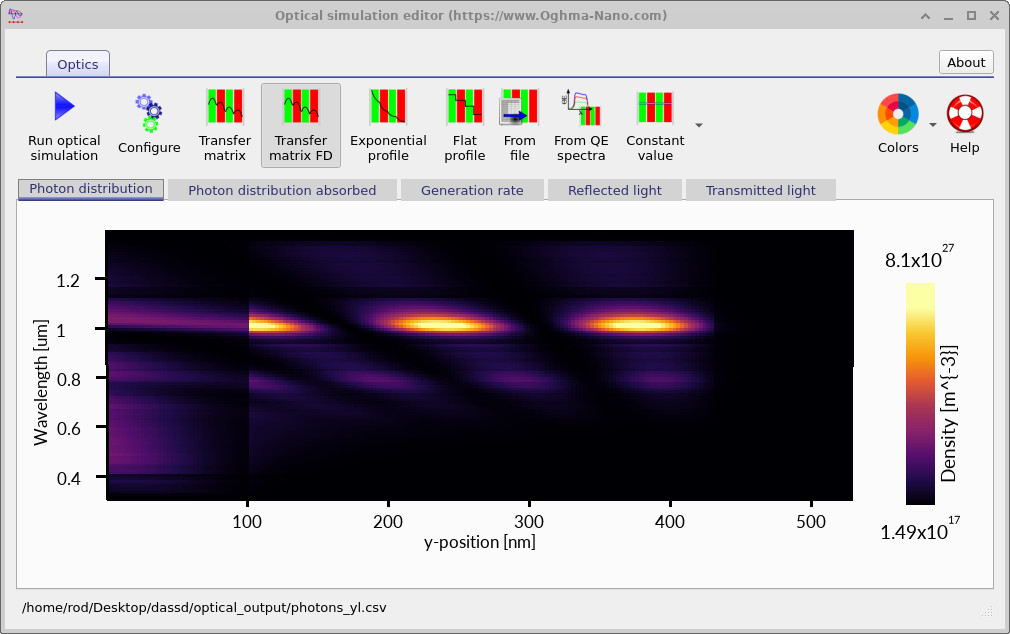
图 ?? 是一幅波长–深度图。 横轴是器件深度(标记为 y-position),纵轴是波长。 靠近受光表面的亮色表示较高的光子分布;随深度逐渐减弱则表示堆叠中的吸收。
对于 a-Si:H,可见光区吸收很强,因此大量有效光子会在靠近前表面的相对较短距离内被吸收。 长波长极限由 a-Si:H 的有效带隙控制:低于带隙的光子不能高效地产生载流子,因此光子图会显示出一个谱边界, 超过该边界后吸收和生成会明显下降。 这也是为什么薄膜 a-Si:H 器件相比晶体硅通常以较低的绝对 Jsc 为代价, 换取更高带隙和更强光谱选择性的原因之一。
光学编辑器提供多个选项卡,因为“光子密度”与“生成率”并不相同。 Photon distribution 视图告诉你光场存在于哪里。 对电学模型真正重要的是 Photon distribution absorbed 和 Generation rate 选项卡: 吸收光子图会被转换为随深度变化的电子–空穴对生成率, 即注入漂移–扩散方程中的源项。 对于该 a-Si:H 电池, 所得到的生成分布在前侧高度集中并局限于薄吸收层中, 这正是接近开路条件下复合和输运对 Voc 起决定作用的典型情形。
6. 运行仿真、JV 曲线与参数提取
一旦定义了器件结构、电学参数和光学生成, 就可以直接从主窗口运行仿真。 点击工具栏中的 Run simulation 按钮启动求解器。 在执行期间,求解器进度和收敛信息会写入终端窗口 (见 ??)。
对于每个偏压点,首先列出顶部接触处施加的电压,然后给出所得电流密度。 在光照条件下,初始电流为负(发电)。 随着施加电压增加,电流幅值减小, 直到在开路电压处穿过零值。 在此之后,电流变为正值,对应二极管正向偏置运行。 终端输出还会给出每个偏压步的求解器残差和收敛时间。 较小的残差表明耦合的漂移–扩散和 Poisson 方程被精确求解。


jv.csv 和 siminfo.dat。
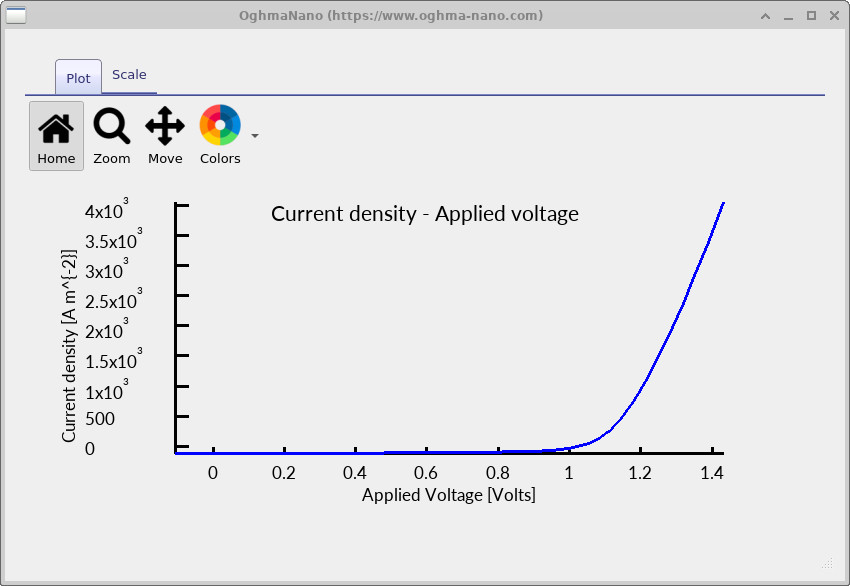
jv.csv 得到的 JV 曲线。该曲线在低电压下显示负电流,
在 Voc 处零电流交叉,并在更高偏压下显示正向导通。

siminfo.dat 打开的仿真信息窗口,列出提取的器件指标,
例如 Voc、Jsc、填充因子和效率。
要检查电学特性,请打开 Output 选项卡并双击
jv.csv。
这将显示电流密度–电压 (JV) 曲线
(见 ??)。
JV 曲线是器件行为的主要诊断图:
在零偏压处应通过短路电流点,
在开路电压处应穿过零电流点。
双击 siminfo.dat 会打开仿真信息窗口
(见 ??),
其中报告提取的性能指标,包括填充因子、功率转换效率、
最大功率点、Voc 和 Jsc。
额外的诊断量,例如开路条件下的自由载流子密度,
也有助于解释 a-Si:H 中的缺陷限制行为。
一个实用原则是:在解释数值指标之前,总是先检查 JV 曲线。
如果 JV 曲线没有清晰地通过短路点和开路点,
或者电流的符号或形状异常,
那么 siminfo.dat 中导出的量也将不可靠。
对 JV 曲线进行可视化检查,是诊断配置或建模问题的最快方式。
7. Suns–Voc 分析:a-Si:H 中的复合限制电压
Suns–Voc 测量探测的是 开路电压 在严格零电流条件下如何随光照强度变化。 由于端电流被约束为零,Suns–Voc 能够将 复合物理与输运和接触电阻效应分离开来。 因此,所得曲线是诊断太阳能电池中 电压损失机制的最直接方法之一。
在 OghmaNano 中,Suns–Voc 被实现为一种专用仿真模式。 它不是扫描施加电压,而是扫描光照强度, 并在每个光强下调整端电压,直到净电流为零。 这就直接计算出了每个光照水平下的开路工作点。
要启用 Suns–Voc,请在主窗口中打开 Simulation type ribbon
(见 ??)
并选择 Suns–Voc。然后点击 Run simulation。
求解器会自动将结果写入磁盘;
文件
suns_voc.csv 包含了 Voc 随光照强度变化的数据。
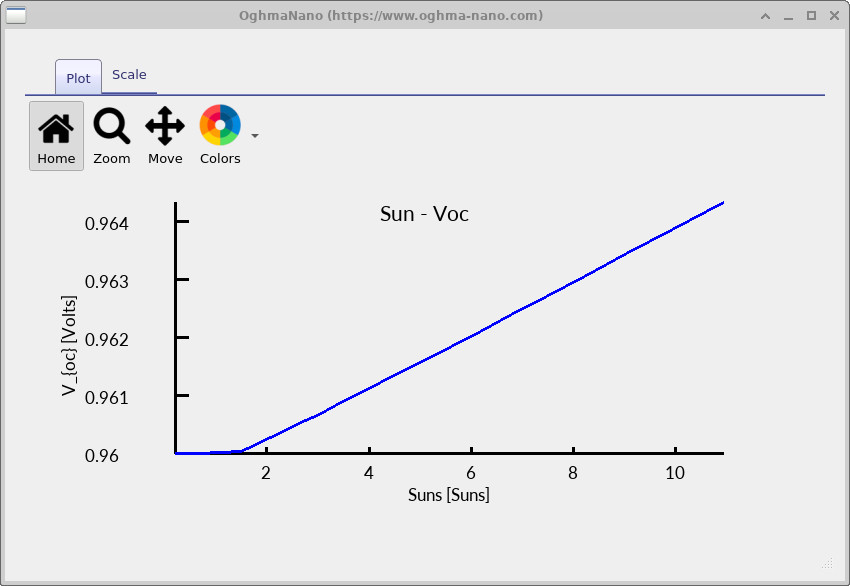

suns_voc.csv、charge_suns.csv 和 tau_suns.csv 文件。
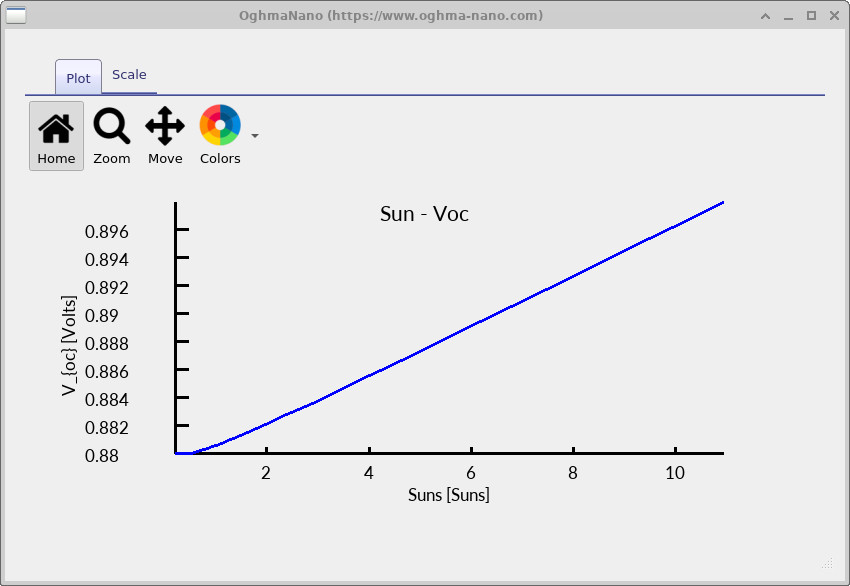
在低光照条件下, Voc 的增加由本征吸收层中过剩载流子密度的建立所控制。 在非简并极限下,准费米能级分裂为 \[ qV_{\mathrm{oc}} = E_{Fn} - E_{Fp} = kT \ln\!\left(\frac{np}{n_i^2}\right), \] 因此 Voc 仅随载流子密度按对数增长。
在非晶硅中,这一低光强区域通常会受到 缺陷占据效应的影响。 在极低生成速率下, 大量光生载流子在进入自由载流子群体之前, 就会被深能级和带尾态俘获。 这可能会在 Suns–Voc 曲线中产生较弱或略微变平的初始响应, 如 ?? 所示。 这种行为是陷阱填充的物理结果,而不是数值伪影。
为了探索高注入区间,请扩大光照范围。 从 Editors ribbon 打开 Suns–Voc editor, 并将 stop intensity 增加到 1000 suns。 然后重新运行仿真。


重新运行仿真后打开 suns_voc.csv,
可以看到完整光照范围下的行为
(见 ??)。
在高光照条件下,Voc 继续增加,
但其斜率持续减小,并最终趋于饱和。
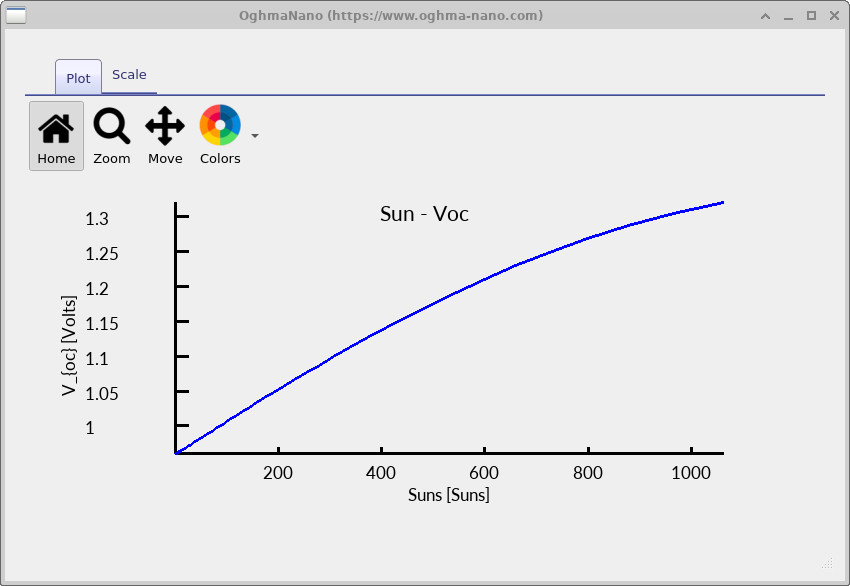
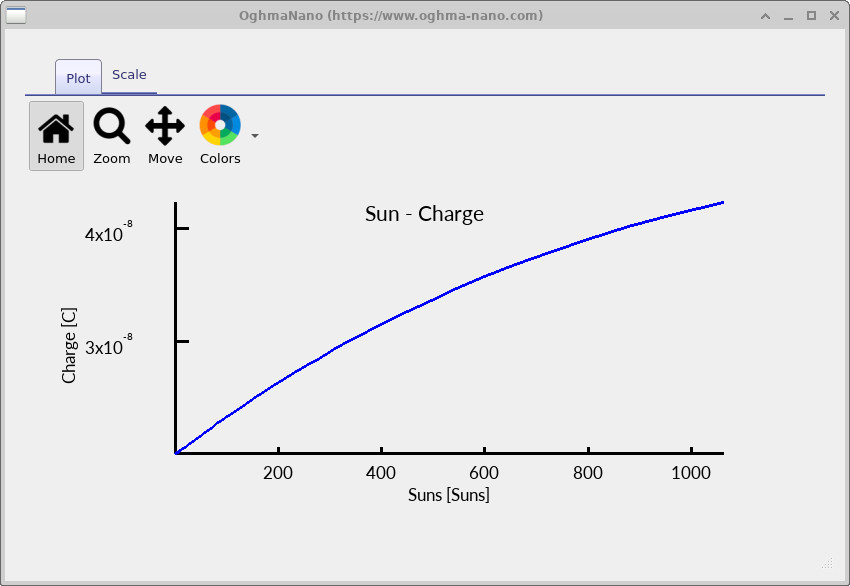
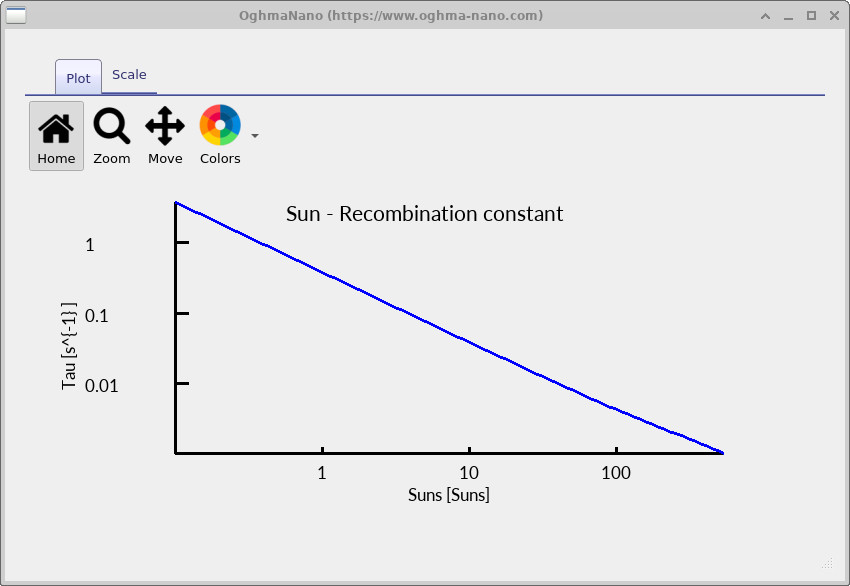
当将 Suns–Voc 曲线 与存储电荷和有效寿命一起查看时, 电压饱和的起因就变得清晰了。 随着光照增强,器件中的总过剩载流子密度上升 (见 ??), 但与此同时有效复合时间也在下降 (见 ??)。
在 a-Si:H 中,复合以缺陷介导的 SRH 型过程为主。 随着载流子密度增加,陷阱辅助复合加速,有效寿命 \[ \tau_{\mathrm{eff}} = \frac{\Delta n}{R} \] 会下降。 超过这一点后,额外的光生载流子主要增强复合, 而不是增加准费米能级分裂。
这种生成与复合之间的平衡对 Voc 施加了内在上限。 最大电压低于 a-Si:H 的有效带隙, 因为复合阻止电子和空穴准费米能级同时逼近各自的能带边。 因此差值 Eg/q − Voc 就表示该器件中由复合引起的基本电压损失。