Célula solar de silicio amorfo (a-Si:H) (1D) — p/i/n de película delgada (limitada por defectos)
1. Introducción

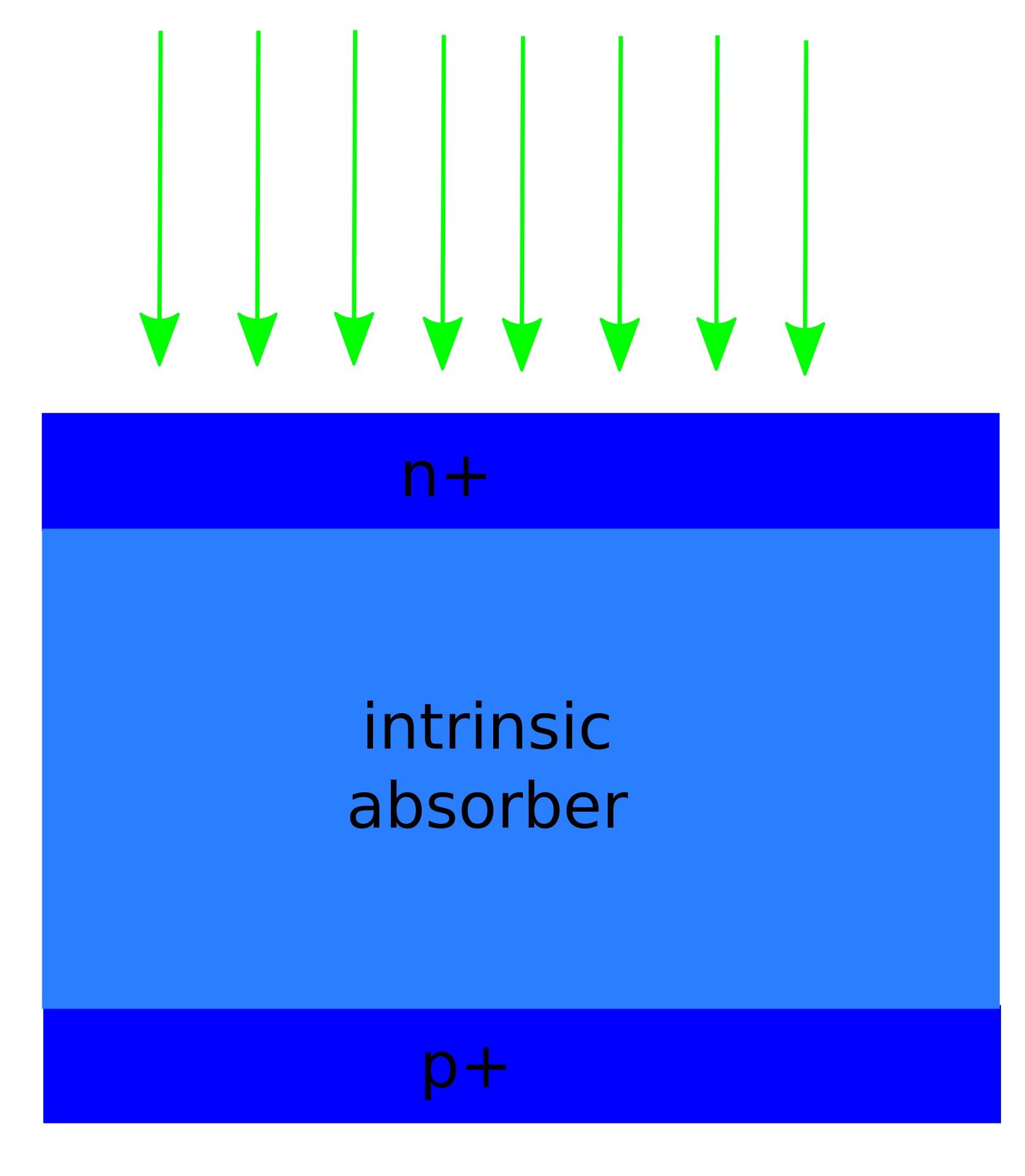
Las células solares de silicio amorfo hidrogenado (a-Si:H) son una tecnología fotovoltaica canónica de película delgada. A diferencia del silicio cristalino, el a-Si:H es estructuralmente desordenado y contiene una alta densidad de estados de defecto y de cola. Como resultado, el comportamiento del dispositivo suele estar limitado por recombinación debida a defectos (procesos tipo Shockley–Read–Hall) y limitado por transporte debido a movilidades más bajas. Esto convierte al a-Si:H en un sistema excelente para aprender cómo la recombinación y la densidad de portadores determinan el Voc, y cómo la óptica de película delgada moldea el Jsc.
Este tutorial proporciona un flujo de trabajo práctico y basado en la física para simular una célula solar de a-Si:H en 1D usando OghmaNano. El modelo resuelve el transporte de portadores por drift–diffusion acoplado a la electrostática de Poisson, con generación óptica dependiente de la profundidad y recombinación físicamente motivada dominada por recombinación por defectos tipo SRH. El objetivo es conectar las salidas estándar—curvas JV, Voc y comportamiento Suns–Voc—con variables internas (bandas, niveles cuasi-Fermi, carga, y tiempo efectivo de recombinación).
Construirá y simulará una célula solar unidimensional de a-Si:H de película delgada con una arquitectura estándar p/i/n (véase ??). El dispositivo se define como: Estructura (frente → dorso): a-Si:H p / a-Si:H i / a-Si:H n / contacto metálico. Usando este dispositivo base, generará una curva JV iluminada, extraerá métricas clave de rendimiento y ejecutará barridos de Voc y Suns–Voc para identificar la pérdida de voltaje limitada por recombinación y su dependencia con la densidad de portadores.
2. Creación de una nueva simulación
Para comenzar, cree una nueva simulación desde la ventana principal de OghmaNano. Haga clic en el botón New simulation de la barra de herramientas. Esto abre el cuadro de diálogo de selección del tipo de simulación (véase ??).


En el cuadro de diálogo de tipo de simulación, haga doble clic en Si demos, luego haga doble clic en Silicio amorfo (a-Si:H) (véase ??). OghmaNano cargará una simulación predefinida de célula solar de película delgada de a-Si:H.


La ventana principal (véase ??) proporciona una vista tridimensional de la estructura del dispositivo. Puede usar el ratón para rotar, desplazar y ampliar la escena para inspeccionar la geometría. Aunque el presente tutorial utiliza un modelo eléctrico unidimensional, la vista 3D proporciona una forma cómoda de visualizar la pila de película delgada y los contactos.
Haga clic en la pestaña Layer editor para abrir la tabla de capas (véase ??). Aquí puede inspeccionar la estructura vertical del dispositivo, incluyendo la capa tipo p, el absorbedor intrínseco (capa i), la capa tipo n y el contacto posterior, junto con sus espesores y materiales asignados.
3. Examen del perfil de dopado

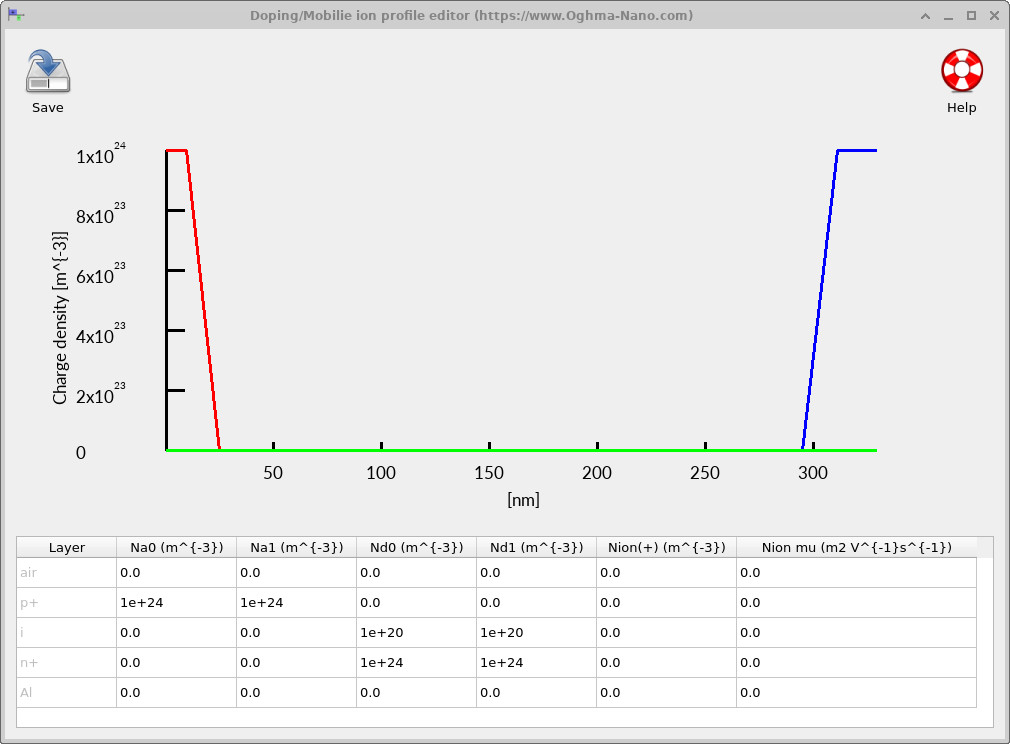
El perfil de dopado establece la estructura electrostática del dispositivo antes de aplicar iluminación y polarización. En una célula solar de silicio amorfo (a-Si:H) de película delgada, el dopado se utiliza principalmente para formar contactos selectivos de portadores en lugar de crear una amplia región de agotamiento dentro de un absorbedor dopado. El principio central de funcionamiento es el campo eléctrico incorporado a través de una capa intrínseca, que separa y transporta los portadores fotogenerados.
Para ver el dopado en OghmaNano, abra la cinta Electrical en la ventana principal y haga clic en Doping / Ions (véase ??). Esto abre el editor de perfiles (véase ??), que representa la densidad de carga de donadores y aceptores frente a la profundidad y enumera los valores numéricos asignados a cada capa.
El dispositivo utiliza una arquitectura estándar de a-Si:H p+/i/n+. Una capa delgada y fuertemente dopada p+ se coloca en la superficie frontal iluminada (densidad de aceptores del orden de \(10^{24}\,\mathrm{m^{-3}}\)), proporcionando un contacto selectivo para huecos y estableciendo la curvatura de bandas del lado frontal. A continuación sigue una capa absorbedora de a-Si:H intrínseca mucho más gruesa, que solo está muy débilmente dopada (aquí \(\sim 10^{20}\,\mathrm{m^{-3}}\)) y contiene la mayor parte de la generación óptica. En la parte posterior del dispositivo, una capa delgada y fuertemente dopada n+ (densidad de donadores también \(\sim 10^{24}\,\mathrm{m^{-3}}\)) forma un contacto posterior selectivo para electrones adyacente al metal.
La característica clave que debe reconocerse en el editor de perfiles es que el fuerte campo incorporado abarca la capa intrínseca, no las regiones dopadas. Los portadores fotogenerados se crean principalmente en el a-Si:H intrínseco y son separados por este campo interno: los electrones son impulsados hacia el contacto posterior n+, mientras que los huecos son impulsados hacia el contacto frontal p+. Las capas dopadas se mantienen delgadas para minimizar la recombinación asistida por defectos, a la vez que proporcionan buena selectividad eléctrica y conductividad de contacto.
4. Parámetros eléctricos: transporte, electrostática y recombinación en a-Si:H
Abra el editor de parámetros eléctricos desde la ventana principal: Device structure → Electrical parameters. Los parámetros se definen por región usando las pestañas p+, i y n+, correspondientes a la capa de contacto frontal, el absorbedor intrínseco y la capa de contacto posterior de la pila de a-Si:H. Los ajustes en este editor determinan los coeficientes de transporte drift–diffusion, la alineación energética y los mecanismos de recombinación utilizados durante los barridos JV y Suns–Voc.



El transporte en silicio amorfo se caracteriza por movilidades bajas debido al desorden y a la fuerte dispersión. Por tanto, la demostración utiliza movilidades muy inferiores a las del silicio cristalino. En la capa intrínseca (véase ??), la movilidad electrónica se fija en μn = 7×10−4 m2V−1s−1 y la movilidad de huecos en μp = 7×10−6 m2V−1s−1. Las capas adyacentes a los contactos usan movilidades diferentes (normalmente menores) (véanse ?? y ??), reflejando el hecho de que las capas dopadas/selectivas actúan principalmente como regiones delgadas de extracción y no como absorbedores de alta movilidad. En drift–diffusion, una movilidad reducida aumenta el tiempo de residencia de los portadores y hace que la recombinación sea más importante cerca de circuito abierto.
La base electrostática utilizada en toda la pila es visible en cada pestaña: afinidad electrónica χ = 4.05 eV, bandgap Eg = 1.75 eV, y permitividad relativa εr = 11. El bandgap más ancho refleja la brecha óptica del a-Si:H y establece el límite superior del fotovoltaje alcanzable, mientras que la afinidad electrónica y la permitividad definen la alineación de bandas y la penetración del campo. Junto con el perfil de dopado p+/i/n+ de la Sección ??, estos parámetros establecen un fuerte campo incorporado a través de la capa intrínseca, que es el principal mecanismo de separación de portadores en dispositivos de película delgada p–i–n.
La recombinación en a-Si:H está dominada por procesos mediados por defectos, por lo que el modelo central de pérdidas es la recombinación Shockley–Read–Hall (SRH) a través de estados trampa localizados. Esto está habilitado en todas las regiones mediante el bloque Equilibrium SRH traps (véanse los campos de parámetros SRH en ??, ??, y ??). En esta formulación, la densidad de trampas Nt, las secciones eficaces de captura σn y σp, y el nivel energético de la trampa Et fijan las tasas de captura de portadores y, por tanto, la vida media efectiva: \[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \] donde \(v_{\mathrm{th}}\) es la velocidad térmica. La tasa de recombinación SRH correspondiente toma la forma estándar \[ R_{\mathrm{SRH}} = \frac{np - n_i^2}{\tau_p (n+n_1) + \tau_n (p+p_1)}, \] con \(n_1\) y \(p_1\) determinados por el nivel energético de la trampa \(E_t\). Dado que la mayor parte de la fotogeneración ocurre en el absorbedor intrínseco, la recombinación SRH en la capa i es el mecanismo primario que limita la separación de niveles cuasi-Fermi y, por tanto, Voc en este tutorial.
Los parámetros de recombinación Auger también están presentes en las pestañas p+ y n+ (véanse ?? y ??), con coeficientes Cn = Cp = 1×10−43 m6s−1. La recombinación Auger representa procesos de pérdida de tres partículas a alta densidad de la forma \[ R_{\mathrm{Auger}} = C_n\,n^2 p + C_p\,p^2 n, \] que se vuelven relevantes cuando las densidades de portadores son elevadas, como en regiones de contacto fuertemente dopadas o bajo iluminación extrema en simulaciones Suns–Voc. Bajo funcionamiento estándar a 1 sol en silicio amorfo, la recombinación Auger suele ser un efecto secundario; la pérdida de voltaje está dominada por la recombinación Shockley–Read–Hall (SRH) mediada por defectos. Incluir términos Auger proporciona, no obstante, un canal físicamente coherente de alta inyección y evita acumulaciones no físicas de portadores cuando el dispositivo es llevado a densidades de portadores muy altas (por ejemplo a cientos o miles de soles). Una discusión detallada de la recombinación Auger y su implementación se ofrece en Teoría de la recombinación Auger.
En conjunto, las bajas movilidades de portadores, el bandgap efectivo relativamente amplio y la alta densidad de estados localizados de defecto sitúan al a-Si:H claramente en un régimen de funcionamiento limitado por recombinación. Como resultado, tanto la curva JV como la respuesta Suns–Voc están gobernadas principalmente por cómo la vida media efectiva SRH colapsa con el aumento de la densidad de portadores. Este tutorial interpreta por tanto el comportamiento del voltaje directamente en términos de separación de niveles cuasi-Fermi y recombinación controlada por defectos, en lugar de las suposiciones del silicio cristalino de alta movilidad y operación limitada por transporte. Una discusión detallada de la física de la recombinación SRH y su papel en el modelado de dispositivos semiconductores se ofrece en la sección teórica Teoría de la recombinación Shockley–Read–Hall.
Para claridad y transparencia numérica, este tutorial modela la recombinación por defectos usando un único nivel efectivo de trampa SRH con secciones eficaces de captura fijas. Esta es una elección de modelado deliberada para el presente tutorial: capta la física dominante de recombinación relevante para células solares de a-Si:H mientras mantiene compacto el espacio de parámetros. OghmaNano también soporta tratamientos más avanzados en los que una distribución de trampas almacena carga activamente y evoluciona dinámicamente bajo polarización e iluminación. Tales tratamientos no en equilibrio se vuelven esenciales una vez que se considera comportamiento en el dominio temporal, cuando la carga del dispositivo es importante o cuando se requiere acuerdo cuantitativo con datos experimentales transitorios o con histéresis. Estas extensiones y su motivación física se describen en Por qué se requieren trampas en semiconductores desordenados y Recombinación Shockley–Read–Hall no en equilibrio.
5. Perfil de generación óptica
Esta demostración utiliza un cálculo óptico unidimensional para generar un término fuente dependiente de la profundidad para el solver drift–diffusion. En la práctica, el modelo óptico calcula cómo el espectro AM1.5 incidente se propaga en la pila de película delgada, cuánto se absorbe en función de la longitud de onda y de la profundidad, y convierte esa potencia absorbida en una tasa de generación de pares electrón–hueco. En película delgada de a-Si:H, el absorbedor suele tener solo cientos de nanómetros de espesor, por lo que el perfil óptico está fuertemente acoplado al diseño de la pila: gran parte de la absorción útil ocurre cerca del lado iluminado, y las estrategias de reflexión posterior/atrapamiento de luz afectan fuertemente a Jsc.
Para ver (y regenerar) la solución óptica, vaya a la cinta Optical en la ventana principal y haga clic en Transfer matrix. Esto abre el editor de simulación óptica. Pulse el botón azul Run optical simulation (el icono de reproducción) para calcular el campo óptico y actualizar los gráficos (véase ??).
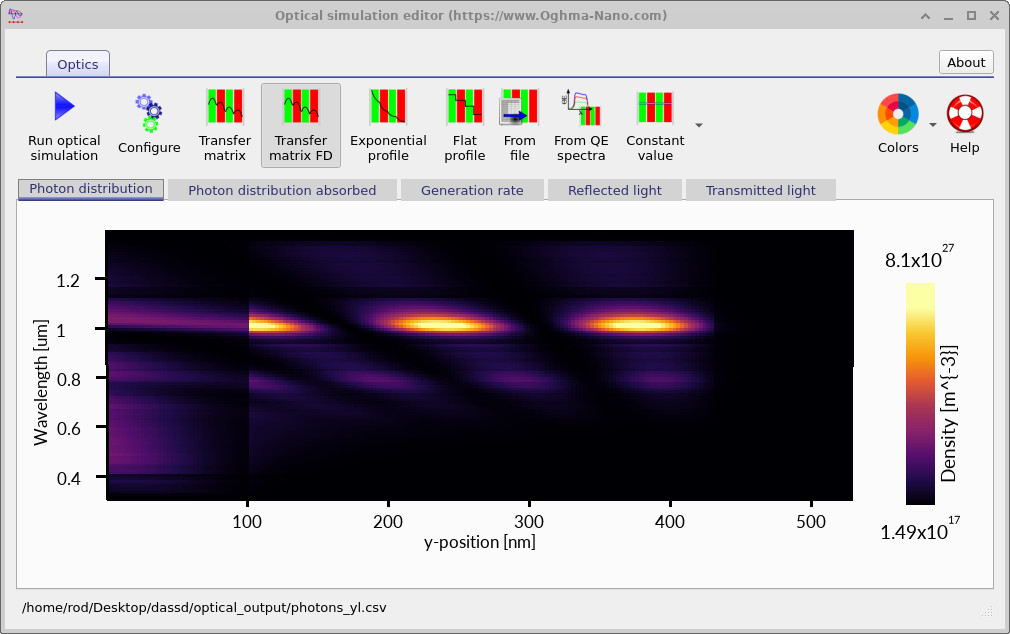
El gráfico de ?? es un mapa longitud de onda–profundidad. El eje horizontal es la profundidad en el dispositivo (etiquetada como posición y), y el eje vertical es la longitud de onda. Los colores brillantes cerca de la superficie iluminada indican una alta población de fotones; el desvanecimiento con la profundidad indica absorción dentro de la pila.
Para a-Si:H, la absorción en el visible es fuerte, por lo que una gran fracción de los fotones útiles se absorben a una distancia relativamente corta desde el frente. El límite de longitudes de onda largas está controlado por el bandgap efectivo del a-Si:H: los fotones por debajo del bandgap no generan portadores eficientemente, por lo que el mapa de fotones mostrará un límite espectral más allá del cual la absorción y la generación disminuyen fuertemente. Esta es una razón por la que los dispositivos de a-Si:H de película delgada suelen intercambiar Jsc absoluto por un bandgap más alto y una selectividad espectral mejorada en comparación con el silicio cristalino.
El editor óptico proporciona varias pestañas porque la “densidad de fotones” no es lo mismo que la “tasa de generación”. La vista Photon distribution le indica dónde existe el campo óptico. Las pestañas Photon distribution absorbed y Generation rate son las que importan para el modelo eléctrico: el mapa de fotones absorbidos se convierte en una tasa de generación de pares electrón–hueco dependiente de la profundidad, que es el término fuente inyectado en las ecuaciones drift–diffusion. Para esta célula de a-Si:H, el perfil de generación resultante está fuertemente cargado hacia el frente y confinado al absorbedor delgado, que es precisamente el régimen en el que la recombinación y el transporte cerca de circuito abierto se vuelven decisivos para Voc.
6. Ejecución de la simulación, curvas JV y extracción de parámetros
Una vez definidos la estructura del dispositivo, los parámetros eléctricos y la generación óptica, la simulación puede ejecutarse directamente desde la ventana principal. Haga clic en el botón Run simulation de la barra de herramientas para iniciar el solver. Durante la ejecución, el progreso del solver y la información de convergencia se escriben en la ventana de terminal (véase ??).
Para cada punto de polarización, primero se lista el voltaje aplicado en el contacto superior, seguido de la densidad de corriente resultante. Bajo iluminación, la corriente es inicialmente negativa (generación de potencia). A medida que se incrementa el voltaje aplicado, la magnitud de la corriente disminuye hasta cruzar cero en el voltaje de circuito abierto. Más allá de este punto, la corriente se vuelve positiva, correspondiente a operación de diodo polarizado en directa. La salida del terminal también informa del residuo del solver y del tiempo de convergencia para cada paso de polarización. Residuos pequeños indican que las ecuaciones acopladas drift–diffusion y de Poisson se están resolviendo con precisión.


jv.csv y siminfo.dat.
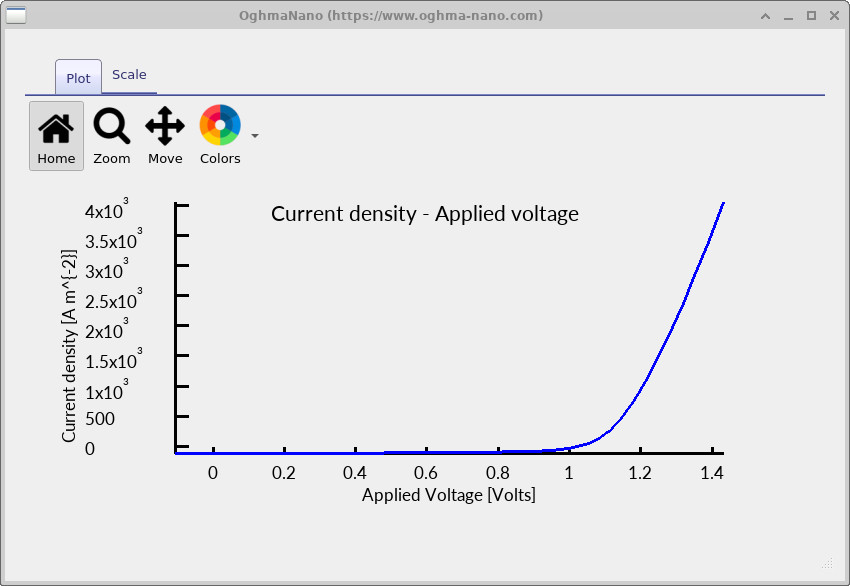
jv.csv. La curva muestra corriente negativa a bajo voltaje,
un cruce de corriente cero en Voc y conducción en directa a voltajes mayores.

siminfo.dat, que enumera métricas extraídas del dispositivo
como Voc, Jsc, factor de forma y eficiencia.
Para inspeccionar las características eléctricas, abra la pestaña Output y haga doble clic en
jv.csv. Esto muestra la curva densidad de corriente–voltaje (JV)
(véase ??).
La curva JV es el diagnóstico principal del comportamiento del dispositivo: debe pasar por la corriente de cortocircuito
a polarización cero y cruzar corriente cero en el voltaje de circuito abierto.
Hacer doble clic en siminfo.dat abre la ventana de información de simulación
(véase ??),
que informa de métricas de rendimiento extraídas, incluyendo factor de forma, eficiencia de conversión de potencia,
punto de máxima potencia, Voc, y Jsc.
Cantidades diagnósticas adicionales, como densidades de portadores libres en circuito abierto, también son útiles para interpretar
el comportamiento limitado por defectos en a-Si:H.
Una regla práctica es inspeccionar siempre la curva JV antes de interpretar las métricas numéricas.
Si la curva JV no pasa limpiamente por cortocircuito y circuito abierto, o si la corriente tiene un
signo o forma inesperados, las cantidades derivadas en siminfo.dat también serán poco fiables.
La inspección visual de la curva JV es la forma más rápida de diagnosticar problemas de configuración o modelado.
7. Análisis Suns–Voc: voltaje limitado por recombinación en a-Si:H
Una medida Suns–Voc estudia cómo evoluciona el voltaje de circuito abierto en función de la intensidad de iluminación bajo condiciones estrictas de corriente cero. Como la corriente terminal se fuerza a anularse, Suns–Voc aísla la física de recombinación de los efectos de transporte y resistencia de contacto. La curva resultante es, por tanto, uno de los diagnósticos más directos de los mecanismos de pérdida de voltaje en una célula solar.
En OghmaNano, Suns–Voc está implementado como un modo de simulación dedicado. En lugar de barrer el voltaje aplicado, el solver barre la intensidad de iluminación y, para cada intensidad, ajusta el voltaje terminal hasta que la corriente neta es cero. Esto calcula directamente el punto de funcionamiento en circuito abierto para cada nivel de iluminación.
Para habilitar Suns–Voc, abra la cinta Simulation type en la ventana principal
(véase ??)
y seleccione Suns–Voc. Luego haga clic en Run simulation.
El solver escribe automáticamente los resultados en disco; el archivo
suns_voc.csv contiene Voc en función de la intensidad de iluminación.
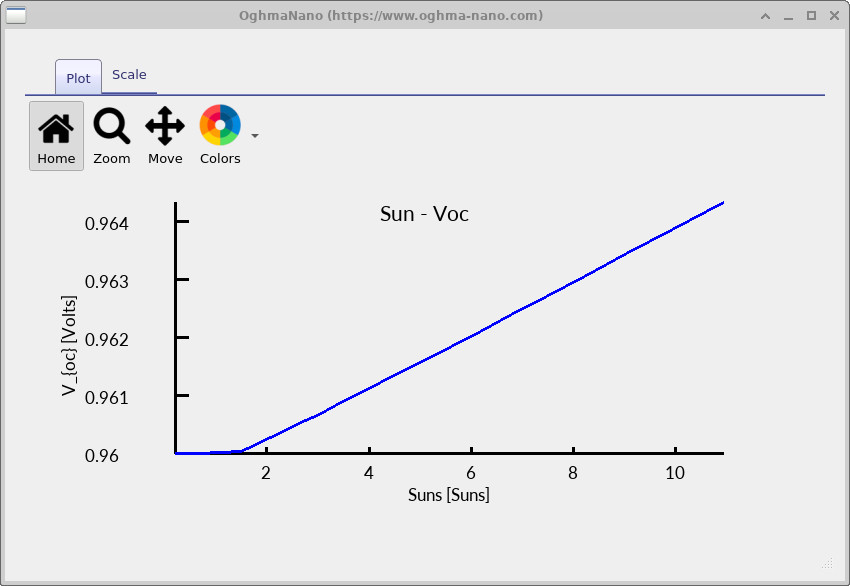

suns_voc.csv, charge_suns.csv, y tau_suns.csv.
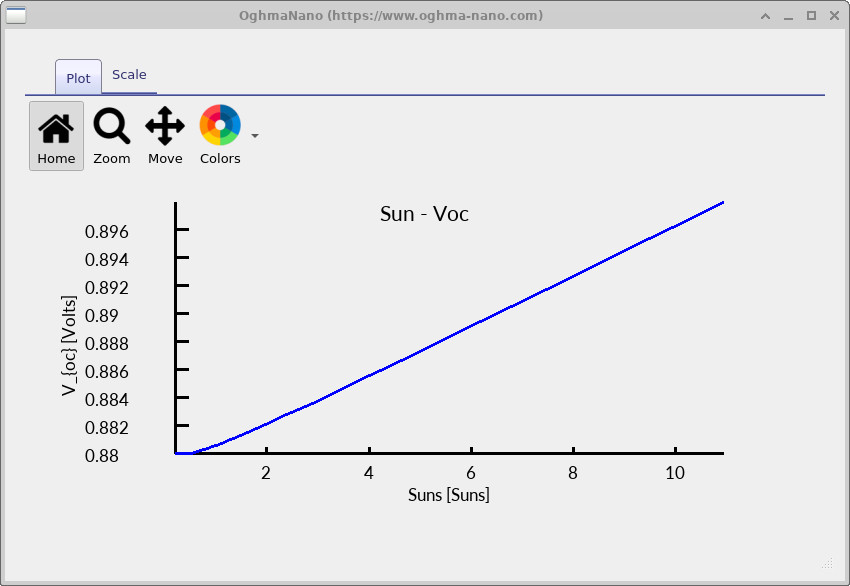
A baja iluminación, el aumento de Voc está gobernado por la acumulación de densidad de portadores en exceso en el absorbedor intrínseco. En el límite no degenerado, la separación de niveles cuasi-Fermi es \[ qV_{\mathrm{oc}} = E_{Fn} - E_{Fp} = kT \ln\!\left(\frac{np}{n_i^2}\right), \] por lo que Voc aumenta solo logarítmicamente con la densidad de portadores.
En silicio amorfo, este régimen de baja intensidad suele estar modificado por efectos de ocupación de defectos. A tasas de generación muy bajas, una fracción sustancial de los portadores fotogenerados es capturada por estados profundos y de cola antes de contribuir a las poblaciones de portadores libres. Esto puede producir una respuesta inicial débil o ligeramente aplanada en la curva Suns–Voc, como se observa en ??. Este comportamiento es una consecuencia física del llenado de trampas y no un artefacto numérico.
Para explorar el régimen de alta inyección, amplíe el rango de iluminación. Abra el Suns–Voc editor desde la cinta Editors y aumente la stop intensity a 1000 suns. Vuelva a ejecutar la simulación.


Abrir suns_voc.csv tras volver a ejecutar la simulación revela el comportamiento en todo
el rango de iluminación (véase ??).
A alta iluminación, Voc continúa aumentando pero con una pendiente
cada vez menor, aproximándose finalmente a la saturación.
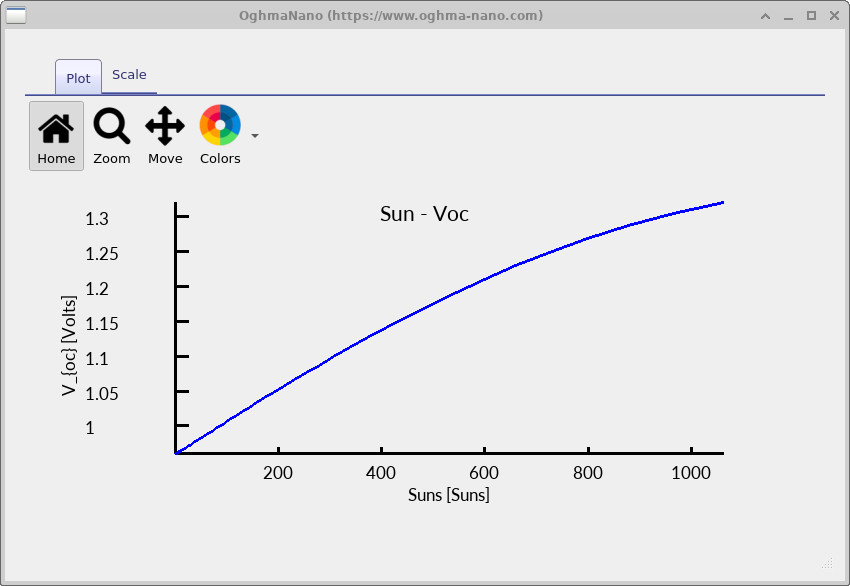
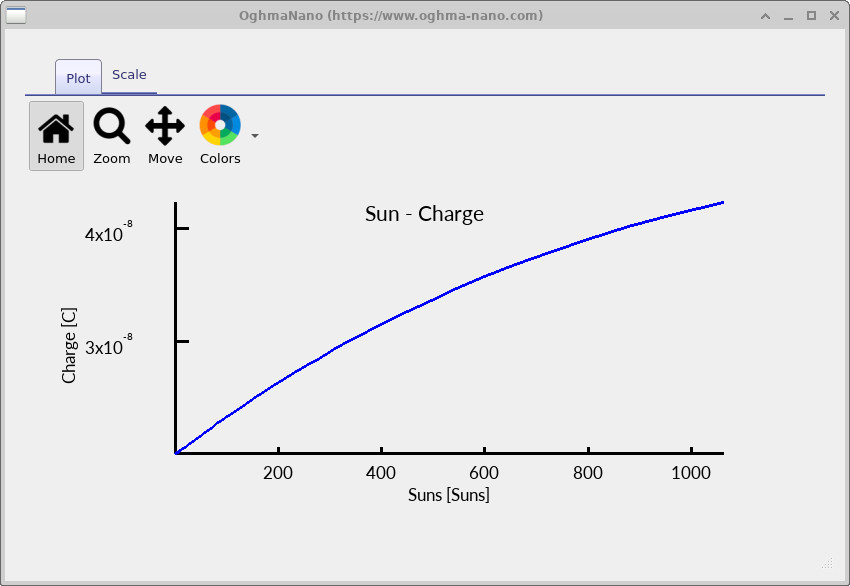
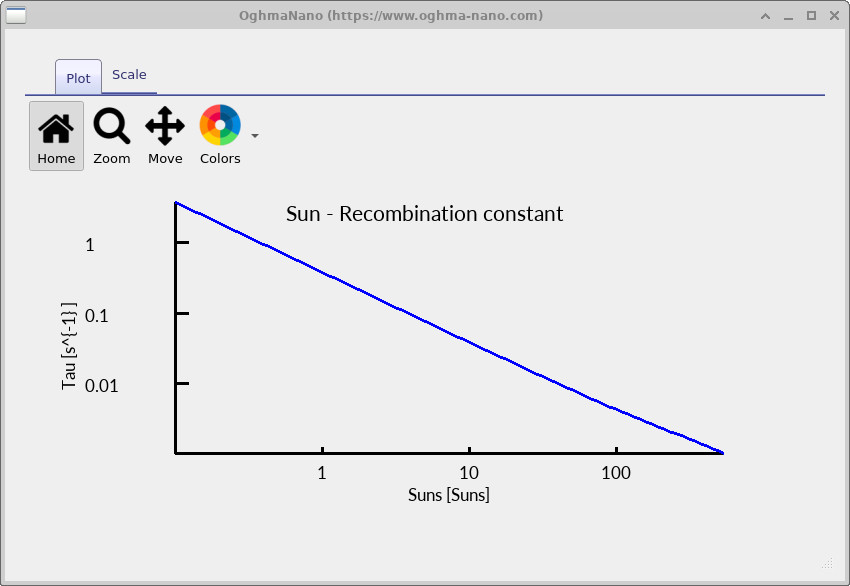
El origen de la saturación del voltaje se hace claro cuando la curva Suns–Voc se observa junto con la carga almacenada y la vida media efectiva. A medida que aumenta la iluminación, se eleva la densidad total de portadores en exceso (véase ??), pero el tiempo efectivo de recombinación disminuye simultáneamente (véase ??).
En a-Si:H, la recombinación está dominada por procesos tipo SRH mediados por defectos. A medida que aumenta la densidad de portadores, la recombinación asistida por trampas se acelera y la vida media efectiva \[ \tau_{\mathrm{eff}} = \frac{\Delta n}{R} \] cae. Más allá de este punto, la fotogeneración adicional incrementa principalmente la recombinación en lugar de aumentar la separación de niveles cuasi-Fermi.
Este equilibrio entre generación y recombinación impone un límite intrínseco superior a Voc. El voltaje máximo permanece por debajo del bandgap efectivo del a-Si:H porque la recombinación impide que los niveles cuasi-Fermi de electrones y huecos se aproximen simultáneamente a sus respectivos bordes de banda. La diferencia Eg/q − Voc representa, por tanto, la pérdida fundamental de voltaje inducida por recombinación en este dispositivo.