アモルファスシリコン (a-Si:H) 太陽電池 (1D) — 薄膜 p/i/n (欠陥律速)
1. イントロダクション

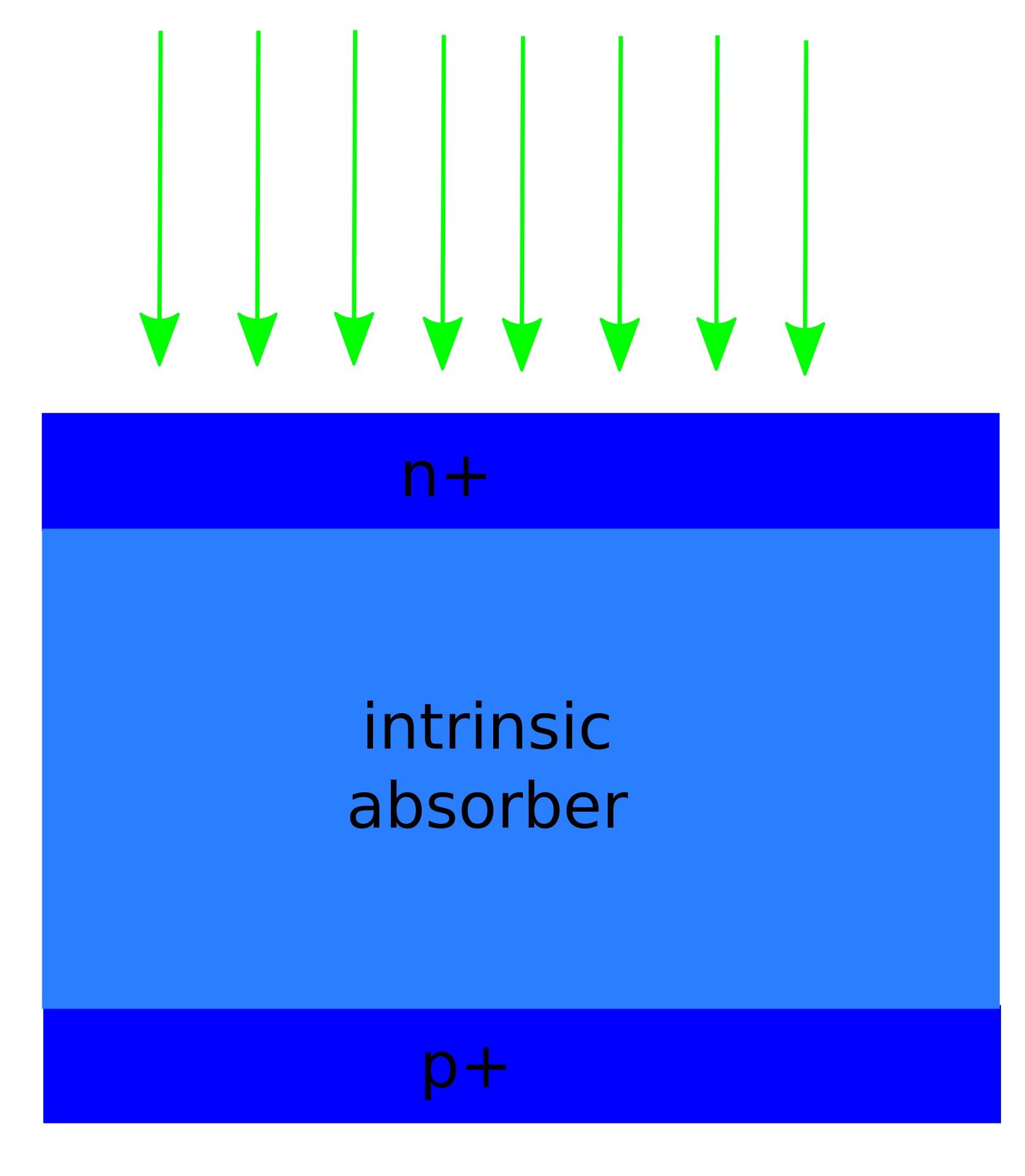
水素化アモルファスシリコン (a-Si:H) 太陽電池は、代表的な薄膜太陽光発電技術です。 結晶シリコンとは異なり、a-Si:H は構造的に無秩序であり、高密度の欠陥状態およびテール状態を含みます。 その結果、デバイス挙動は典型的に 欠陥によって再結合律速され(Shockley–Read–Hall 型過程)、 より低い移動度によって輸送律速されます。 このため、a-Si:H は再結合とキャリア密度が Voc をどのように決定するか、 および薄膜光学が Jsc をどのように形成するかを学ぶための優れた系です。
このチュートリアルでは、OghmaNano を用いて 1D で a-Si:H 太陽電池をシミュレーションするための、 実践的で物理に基づいたワークフローを提供します。 このモデルは、深さ依存の光学生成と、 SRH 型欠陥再結合が支配する物理的に妥当な再結合を伴う、 ポアソン静電気学と結合した drift–diffusion キャリア輸送を解きます。 目的は、標準出力—JV 曲線、Voc、および Suns–Voc 挙動—を、内部変数(バンド、準フェルミ準位、電荷、 および有効再結合時間)へ結び付けることです。
あなたは標準的な p/i/n アーキテクチャを持つ 一次元薄膜 a-Si:H 太陽電池を構築・シミュレーションします (?? を参照)。 デバイスは次のように定義されます: 構造(前面 → 背面): p a-Si:H / i a-Si:H / n a-Si:H / 金属接触。 このベースラインデバイスを用いて、照明下の JV 曲線 を生成し、主要性能指標を抽出し、 Voc および Suns–Voc 掃引を実行して、再結合律速電圧損失とそのキャリア密度依存性を特定します。
2. 新しいシミュレーションの作成
まず、OghmaNano のメインウィンドウから新しいシミュレーションを作成します。 ツールバーの New simulation ボタンをクリックしてください。 これによりシミュレーション種別選択ダイアログが開きます (?? を参照)。


シミュレーション種別ダイアログで、Si demos をダブルクリックし、 次に Amorphous silicon (a-Si:H) をダブルクリックします (?? を参照)。 OghmaNano は、あらかじめ定義された a-Si:H 薄膜太陽電池シミュレーションを読み込みます。


メインウィンドウ (?? を参照) にはデバイス構造の三次元表示が提供されます。 マウスを使ってシーンを回転、パン、およびズームし、形状を確認できます。 このチュートリアルでは一次元電気モデルを使用しますが、 3D 表示は薄膜スタックと接触を可視化する便利な手段です。
Layer editor タブをクリックして層テーブルを開きます (?? を参照)。 ここでは、 p 型層、真性吸収層(i 層)、n 型層、および背面接触を含む 垂直デバイス構造と、それらの厚さおよび割り当てられた材料を確認できます。
3. ドーピングプロファイルの確認

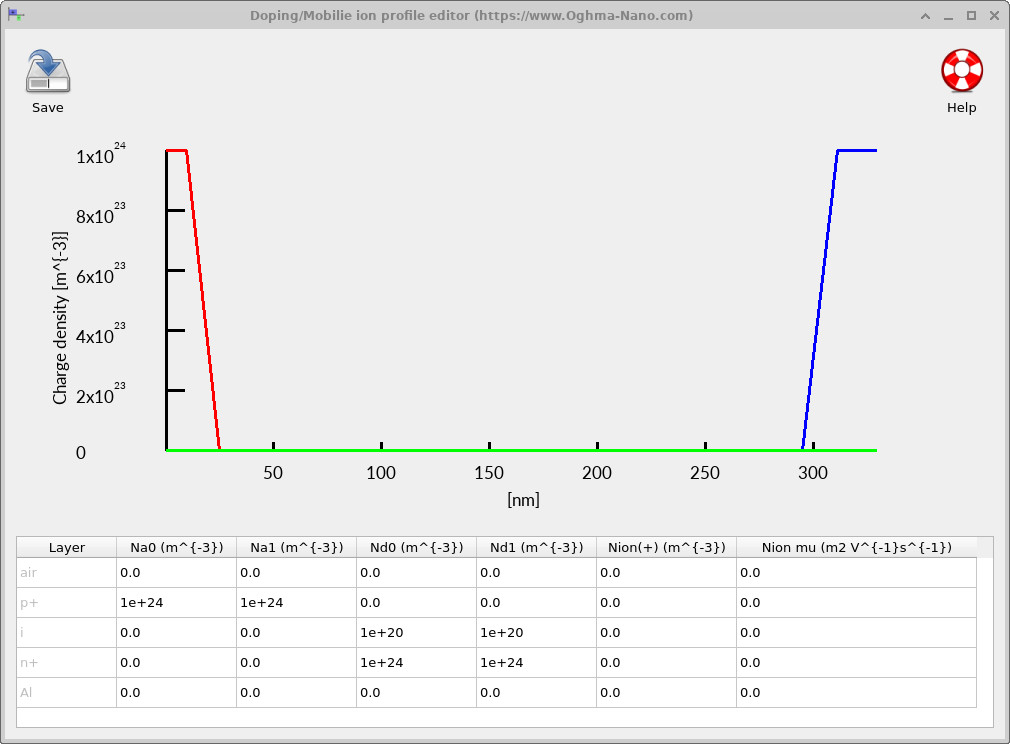
ドーピングプロファイルは、照明やバイアスが印加される前のデバイスの静電構造を決定します。 薄膜 アモルファスシリコン (a-Si:H) 太陽電池では、ドーピングは主に 広い空乏領域をドープ吸収体内に形成するためではなく、 キャリア選択接触を形成するために使用されます。 中心的な動作原理は、真性層にわたる内蔵電場であり、これが光生成キャリアを分離・輸送します。
OghmaNano でドーピングを表示するには、メインウィンドウの Electrical リボンを開き、 Doping / Ions をクリックします (?? を参照)。 これによりプロファイル editor が開きます (?? を参照)。 ここには、深さに対するドナーおよびアクセプタ電荷密度がプロットされ、 各層に割り当てられた数値も一覧表示されます。
デバイスは標準的な p+/i/n+ a-Si:H アーキテクチャを使用しています。 薄く高濃度にドープされた p+ 層が照明側前面に配置されており (アクセプタ密度は \(10^{24}\,\mathrm{m^{-3}}\) 程度)、 正孔選択接触を提供し、前面側のバンドベンディングを定めます。これに続いて、 より厚い 真性 a-Si:H 吸収層があり、 これはごく軽くドープされているだけで(ここでは \(\sim 10^{20}\,\mathrm{m^{-3}}\))、 光学生成の大部分がここで生じます。デバイス背面には、薄く高濃度にドープされた n+ 層があり (ドナー密度も再び \(\sim 10^{24}\,\mathrm{m^{-3}}\))、 金属に隣接した電子選択背面接触を形成します。
プロファイル editor で認識すべき重要な点は、強い内蔵電場が 真性層にわたって広がっており、ドープ領域にはないということです。光生成キャリアは主に 真性 a-Si:H 内で生成され、この内部電場によって分離されます。電子は n+ 背面接触へ向かって駆動され、正孔は p+ 前面接触へ向かって駆動されます。ドープ層は、 欠陥補助再結合を最小限に抑えつつ、良好な電気選択性および接触導電性を与えるために薄く保たれています。
4. 電気パラメータ: a-Si:H における輸送、静電気学、および再結合
メインウィンドウから電気パラメータ editor を開きます: Device structure → Electrical parameters。 パラメータは p+、i、n+ タブを用いて領域ごとに定義され、 それぞれ前面接触層、真性吸収層、および a-Si:H スタックの背面接触層に対応します。 この editor の設定は、JV および Suns–Voc 掃引時に使用される drift–diffusion 輸送係数、 エネルギー整合、および再結合機構を決定します。



アモルファスシリコンにおける輸送は、無秩序と強い散乱により低い移動度によって特徴付けられます。 そのため、このデモでは結晶シリコンよりはるかに低い移動度を使用しています。真性層では (?? を参照)、 電子移動度は μn = 7×10−4 m2V−1s−1 に設定され、正孔移動度は μp = 7×10−6 m2V−1s−1 に設定されています。接触隣接層では異なる(通常はより低い)移動度が使われています (?? および ?? を参照)。 これは、ドープ/選択層が主に高移動度吸収体ではなく、薄い抽出領域として機能することを反映しています。 drift–diffusion では、移動度の低下はキャリア滞在時間を増大させ、開放電圧近傍で再結合の影響を大きくします。
スタック全体で用いられる静電気学的基準はすべてのタブに表示されています。電子親和力 χ = 4.05 eV、バンドギャップ Eg = 1.75 eV、および比誘電率 εr = 11 です。より広いバンドギャップは a-Si:H の光学ギャップを反映し、 到達可能な光起電圧の上限を設定します。一方、電子親和力と誘電率はバンド整合と電場侵入を定義します。 セクション ?? の p+/i/n+ ドーピングプロファイルと合わせて、 これらのパラメータは真性層にわたる強い内蔵電場を確立し、これが薄膜 p–i–n デバイスにおける主要なキャリア分離機構となります。
a-Si:H における再結合は欠陥媒介過程によって支配されるため、中心的な損失モデルは 局在化トラップ状態を介した Shockley–Read–Hall (SRH) 再結合です。これはすべての領域で Equilibrium SRH traps ブロックを介して有効化されています (??、 ??、および ?? にある SRH パラメータ欄を参照)。 この定式化では、トラップ密度 Nt、捕獲断面積 σn および σp、およびトラップエネルギー準位 Et がキャリア捕獲率を定め、したがって有効寿命を決定します: \[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \] ここで \(v_{\mathrm{th}}\) は熱速度です。対応する SRH 再結合率は標準的な形 \[ R_{\mathrm{SRH}} = \frac{np - n_i^2}{\tau_p (n+n_1) + \tau_n (p+p_1)}, \] をとり、\(n_1\) と \(p_1\) はトラップエネルギー準位 \(E_t\) によって決定されます。光生成の大部分は真性吸収層で起こるため、 i 層における SRH 再結合が、このチュートリアルで準フェルミ準位分離、ひいては Voc を制限する主要機構です。
Auger 再結合パラメータも p+ および n+ タブに存在し (?? および ?? を参照)、 係数は Cn = Cp = 1×10−43 m6s−1 です。 Auger 再結合は \[ R_{\mathrm{Auger}} = C_n\,n^2 p + C_p\,p^2 n, \] の形をとる高密度三体損失過程を表し、重ドープ接触領域や Suns–Voc シミュレーションにおける極端な照明条件のようにキャリア密度が大きい場合に重要になります。 アモルファスシリコンの標準 1-sun 動作では、Auger 再結合は通常二次的な効果であり、 電圧損失は欠陥媒介 Shockley–Read–Hall (SRH) 再結合に支配されます。 それでも Auger 項を含めることで、物理的に整合した高注入チャネルが与えられ、 デバイスが非常に高いキャリア密度へ駆動されたとき (たとえば数百から数千 suns)に非物理的なキャリア蓄積を防ぐことができます。 Auger 再結合とその実装についての詳細な議論は Auger recombination theory にあります。
これらを総合すると、低いキャリア移動度、比較的広い有効バンドギャップ、および高密度の局在欠陥状態により、 a-Si:H は明確に 再結合律速動作領域 に位置します。 その結果、JV 曲線と Suns–Voc 応答の両方は主として、 有効 SRH 寿命がキャリア密度の増加とともにどのように低下するかによって支配されます。 したがって、このチュートリアルでは電圧挙動を、 結晶シリコン型の高移動度・輸送律速動作の仮定ではなく、 準フェルミ準位分離と欠陥制御再結合の観点から直接解釈します。 SRH 再結合物理とそれが半導体デバイスモデリングで果たす役割についての詳細は、 理論セクション Shockley–Read–Hall recombination theory にあります。
明確さと数値的透明性のために、このチュートリアルでは欠陥再結合を、 固定捕獲断面積を持つ 単一有効 SRH トラップ準位 を用いてモデル化します。 これは本チュートリアルにおける意図的なモデリング選択であり、 a-Si:H 太陽電池に関連する支配的な再結合物理を捉えつつ、パラメータ空間をコンパクトに保ちます。 OghmaNano は、トラップ分布が実際に電荷を蓄積し、 バイアスおよび照明下で動的に進化する、より高度な取り扱いにも対応しています。 このような非平衡取り扱いは、時間領域挙動を考える場合、 デバイス帯電が重要な場合、または過渡的・ヒステリシス的な実験データとの定量的一致が必要な場合に本質的になります。 これらの拡張とその物理的動機は Why traps are required in disordered semiconductors および Non-equilibrium Shockley–Read–Hall recombination に記載されています。
5. 光学生成プロファイル
このデモでは、drift–diffusion ソルバに深さ依存のソース項を与えるために、 一次元光学計算を使用します。 実際には、光学モデルは入射 AM1.5 スペクトルが 薄膜スタック内をどのように伝搬するか、波長と深さの関数としてどれだけ吸収されるかを計算し、 その吸収パワーを電子–正孔対生成率へ変換します。 薄膜 a-Si:H では吸収体は通常数百 nm 程度しかないため、光学プロファイルはスタック設計と強く結びついています。 有効な吸収の多くは照明側近傍で生じ、背面反射/光閉じ込め戦略が Jsc に強く影響します。
光学解を表示(および再計算)するには、メインウィンドウの Optical リボンに移動し、 Transfer matrix をクリックします。 これにより光学シミュレーション editor が開きます。 青い Run optical simulation ボタン(再生アイコン)を押すと、光学場が計算され、プロットが更新されます (?? を参照)。
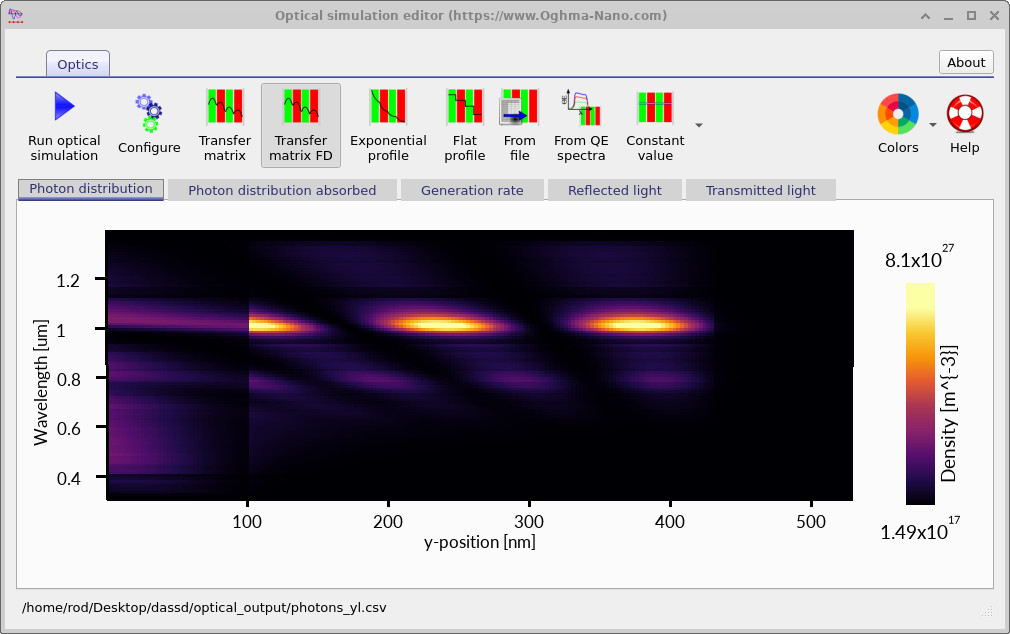
?? のプロットは波長–深さマップです。 横軸はデバイス内部の深さ(y-position と表示)、縦軸は波長です。 照明側近傍の明るい色は高い光子数を示し、深さとともに減衰していく様子はスタック内での吸収を示します。
a-Si:H では可視光の吸収が強いため、有効な光子の大部分は前面から比較的短い距離で吸収されます。 長波長側の限界は a-Si:H の有効バンドギャップによって支配されます。バンドギャップ以下の光子はキャリアを効率的に生成しないため、 光子マップには吸収と生成が強く低下するスペクトル境界が現れます。これが、薄膜 a-Si:H デバイスが通常 結晶シリコンに比べて絶対的な Jsc を犠牲にしつつ、より高いバンドギャップと改善されたスペクトル選択性を持つ理由の一つです。
光学 editor には複数のタブがありますが、それは「光子密度」が「生成率」と同じではないためです。 Photon distribution 表示は、光学場がどこに存在するかを示します。 Photon distribution absorbed と Generation rate タブこそが電気モデルにとって重要です。 吸収光子マップは、drift–diffusion 方程式へ注入されるソース項である、 深さ依存の電子–正孔対生成率へ変換されます。 この a-Si:H セルでは、結果として得られる生成プロファイルは前面側に強く偏っており、薄い吸収体内に制限されています。 まさにこの領域で、開放電圧近傍における再結合と輸送が Voc にとって決定的となります。
6. シミュレーションの実行、JV 曲線、およびパラメータ抽出
デバイス構造、電気パラメータ、および光学生成が定義されたら、 シミュレーションはメインウィンドウから直接実行できます。 ツールバーの Run simulation ボタンをクリックして ソルバを開始してください。 実行中、ソルバの進行状況と収束情報はターミナルウィンドウに書き出されます (?? を参照)。
各バイアスポイントについて、最初に上部接触に印加された電圧が表示され、続いてその結果として得られる電流密度が表示されます。 照明下では電流は最初は負(発電)です。印加電圧が増加すると、電流の大きさは減少し、 開放電圧でゼロを横切ります。この点を超えると電流は正になり、順方向バイアスのダイオード動作に対応します。 ターミナル出力には各バイアスステップに対するソルバ残差と収束時間も表示されます。残差が小さいことは、結合した drift–diffusion およびポアソン方程式が正確に解かれていることを示します。


jv.csv と siminfo.dat があります。
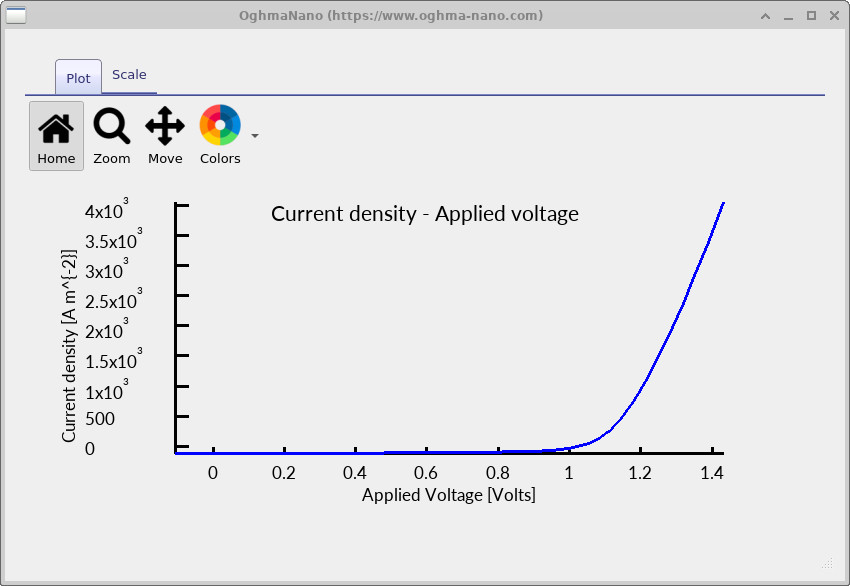
jv.csv を開いて得られた JV 曲線。低電圧での負電流、
Voc におけるゼロ電流交点、および高バイアスでの順方向伝導を示しています。

siminfo.dat から開いたシミュレーション情報ウィンドウ。Voc、Jsc、フィルファクタ、および効率などの抽出されたデバイス指標を一覧表示します。
電気特性を確認するには、Output タブを開き、
jv.csv をダブルクリックします。 これにより電流密度–電圧 (JV) 曲線が表示されます
(?? を参照)。
JV 曲線はデバイス挙動の主要診断量であり、ゼロバイアスで短絡電流を通り、
開放電圧でゼロ電流を横切るはずです。
siminfo.dat をダブルクリックするとシミュレーション情報ウィンドウが開きます
(?? を参照)。
ここにはフィルファクタ、変換効率、
最大出力点、Voc、および Jsc を含む抽出された性能指標が表示されます。
追加の診断量、たとえば開放電圧における自由キャリア密度も、
a-Si:H における欠陥律速挙動を解釈するうえで有用です。
実用上のルールとして、数値指標を解釈する前に常に JV 曲線を確認してください。
JV 曲線が短絡および開放回路をきれいに通過しない場合、あるいは電流の符号や形状が予想外である場合、
siminfo.dat にある派生量も信頼できません。
JV 曲線の視覚確認は、設定またはモデル化の問題を診断する最も速い方法です。
7. Suns–Voc 解析: a-Si:H における再結合律速電圧
Suns–Voc 測定は、厳密なゼロ電流条件下で、 開放電圧 が照明強度の関数としてどのように変化するかを調べるものです。 端子電流はゼロに制約されているため、Suns–Voc は 輸送や接触抵抗の影響から 再結合物理 を切り離します。 したがって、得られる曲線は太陽電池における電圧損失機構の 最も直接的な診断の一つです。
OghmaNano では、Suns–Voc は専用のシミュレーションモードとして実装されています。 印加電圧を掃引する代わりに、ソルバは照明強度を掃引し、 各強度において端子電圧を調整して正味電流がゼロになるようにします。 これにより、各照明レベルでの開放電圧動作点が直接計算されます。
Suns–Voc を有効にするには、メインウィンドウで Simulation type リボンを開き
(?? を参照)、
Suns–Voc を選択します。その後 Run simulation をクリックしてください。
ソルバは結果を自動的にディスクへ書き出します。ファイル
suns_voc.csv には照明強度の関数としての Voc が含まれています。
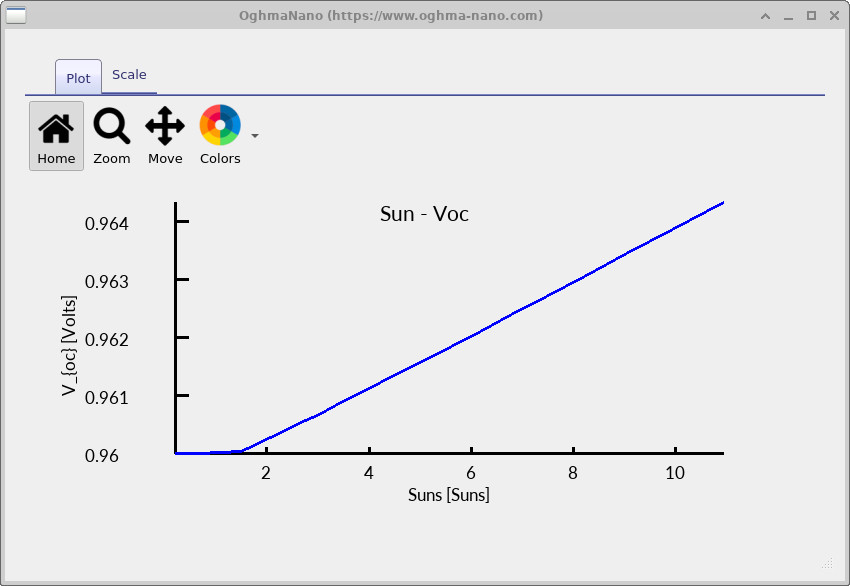

suns_voc.csv、charge_suns.csv、および tau_suns.csv ファイルを示しています。
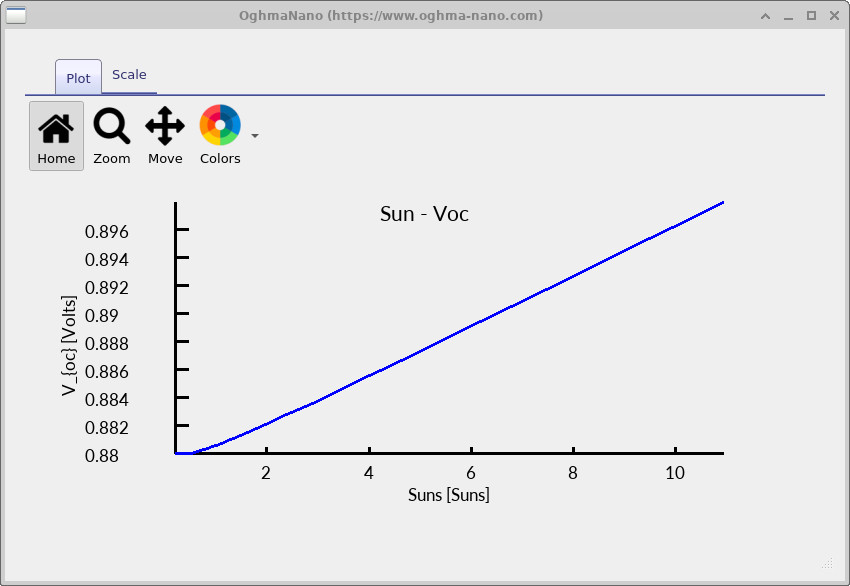
低照明では、Voc の増加は 真性吸収体における過剰キャリア密度の蓄積によって支配されます。 非縮退極限では、準フェルミ準位分離は \[ qV_{\mathrm{oc}} = E_{Fn} - E_{Fp} = kT \ln\!\left(\frac{np}{n_i^2}\right), \] となるため、Voc はキャリア密度に対して対数的にしか増加しません。
アモルファスシリコンでは、この低照明領域はしばしば 欠陥占有効果によって修飾されます。 非常に低い生成率では、光生成キャリアのかなりの割合が、 自由キャリア集団へ寄与する前に深い状態やテール状態に捕獲されます。 これにより、?? に見られるように、 Suns–Voc 曲線に弱い、あるいはわずかに平坦化した初期応答が生じることがあります。 この挙動は数値アーティファクトではなく、トラップ充填の物理的帰結です。
高注入領域を調べるには、照明範囲を拡張します。 Editors リボンから Suns–Voc editor を開き、 stop intensity を 1000 suns に増やします。 その後シミュレーションを再実行してください。


シミュレーション再実行後に suns_voc.csv を開くと、
照明範囲全体にわたる挙動が現れます
(?? を参照)。
高照明では、Voc は引き続き増加しますが、
勾配は着実に低下し、最終的には飽和に近づきます。
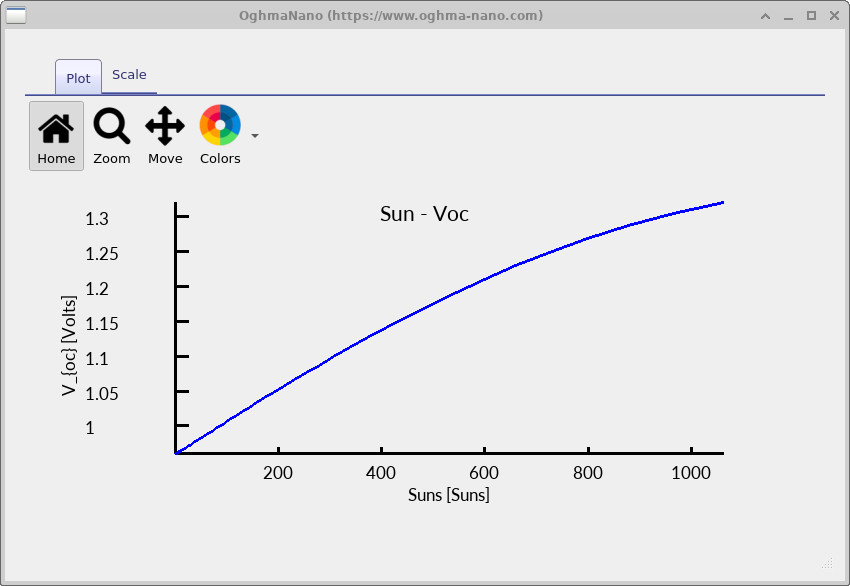
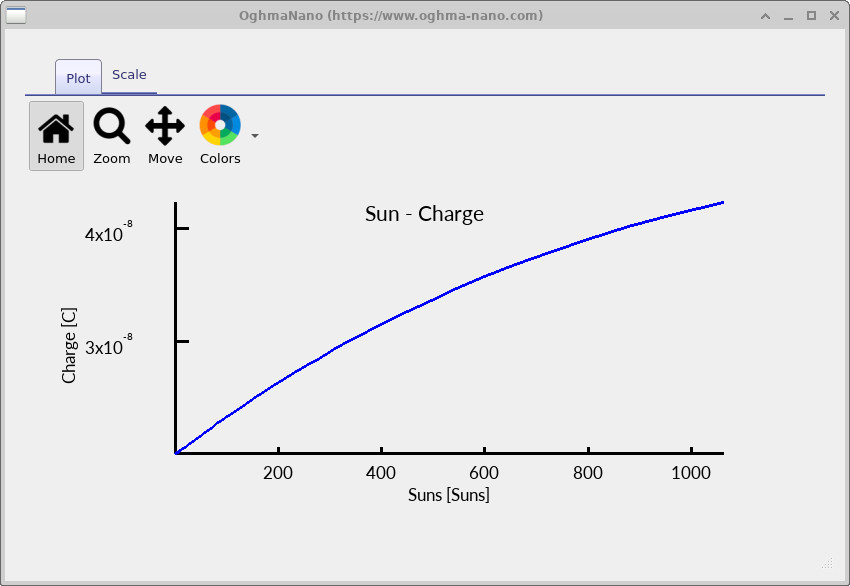
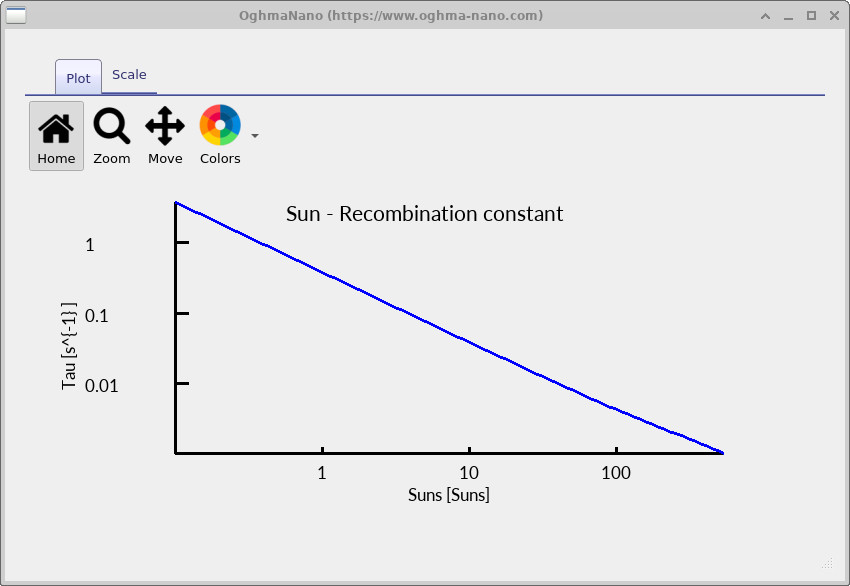
電圧飽和の起源は、Suns–Voc 曲線を 蓄積電荷および有効寿命と合わせて見ると明らかになります。 照明が増加すると、総過剰キャリア密度は増加します (?? を参照)。 しかし同時に、有効再結合時間は減少します (?? を参照)。
a-Si:H では、再結合は欠陥媒介の SRH 型過程に支配されます。 キャリア密度が増加すると、トラップ補助再結合が加速し、有効寿命 \[ \tau_{\mathrm{eff}} = \frac{\Delta n}{R} \] は低下します。この点を超えると、追加の光生成は 準フェルミ準位分離を増加させるのではなく、主として再結合を増加させます。
この生成と再結合のバランスが、 Voc に本質的な上限を課します。 再結合により電子および正孔の準フェルミ準位がそれぞれのバンド端へ同時に近づくことが妨げられるため、 最大電圧は有効 a-Si:H バンドギャップより低くとどまります。 差 Eg/q − Voc は、したがってこのデバイスにおける根本的な再結合起因電圧損失を表します。