دیود پیوند PN آرسنید گالیم (GaAs) (1D) — Drift–Diffusion (I–V تاریک، بازترکیب SRH)
۱. مقدمه

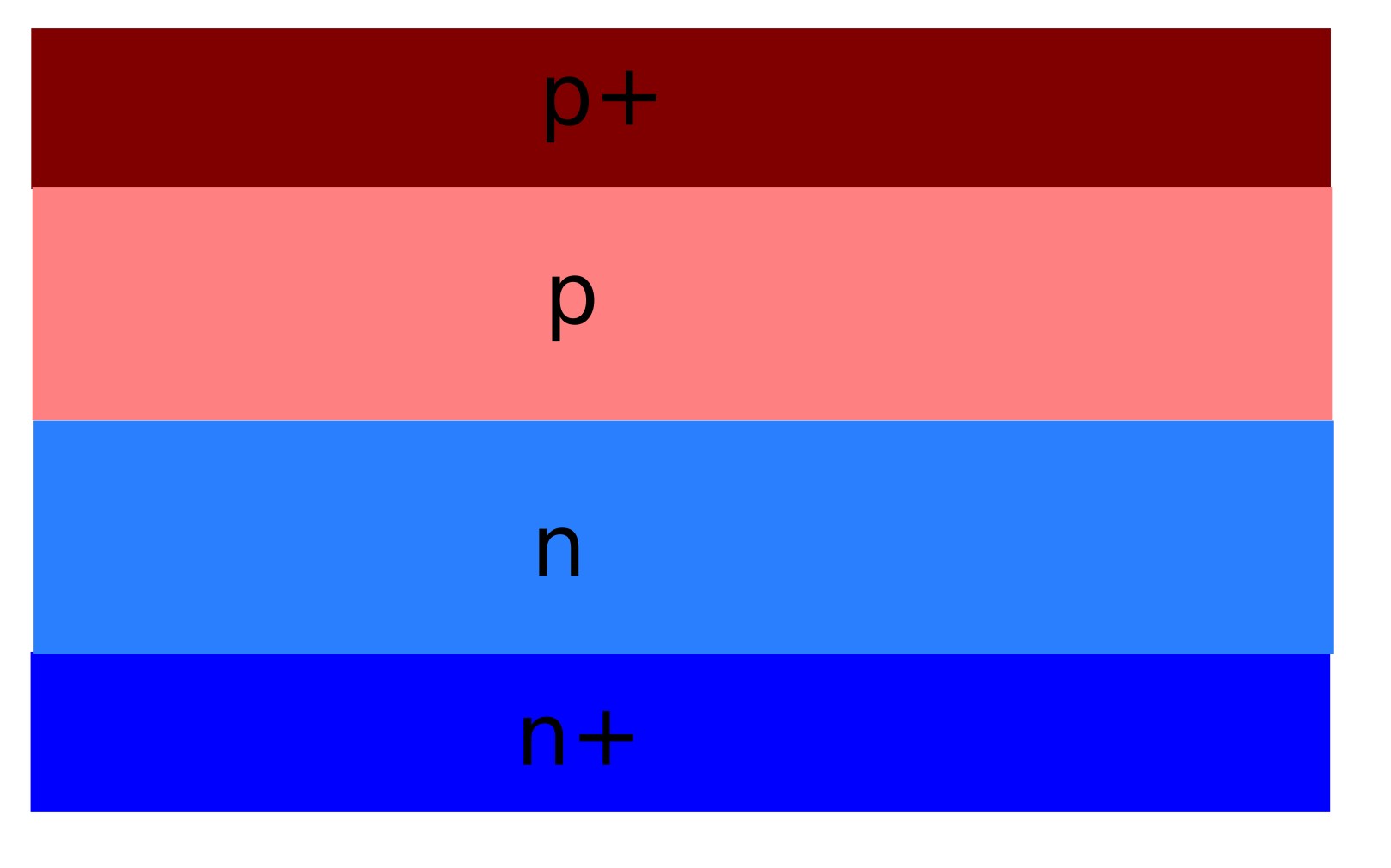
دیود پیوند PN آرسنید گالیم (GaAs) یک دستگاه نیمهرسانای بنیادی III–V است. این دیود بهطور گسترده در مدارهای مجتمع RF و مایکروویو مبتنی بر GaAs ادغام میشود، جایی که پیوندهای PN فشرده از یکسوسازی، بایاسدهی، حفاظت، و عملکردهای کلیدزنی در front-end سامانه RF پشتیبانی میکنند. یک زمینه کاربردی نماینده در ?? نشان داده شده است، که نوع سکوی GaAs در مقیاس تراشه را که در الکترونیک فرکانسبالای مدرن استفاده میشود، نشان میدهد.
آرسنید گالیم برای این کاربردها مناسب است زیرا تحرکپذیری بالای الکترون آن امکان انتقال سریع حامل و افت مقاومتی کم را فراهم میکند، و از عملکرد کارآمد در فرکانسهای GHz و موج میلیمتری مورد استفاده در سامانههای 5G پشتیبانی میکند. در عمل، پیوندهای PN کوتاه مانند آنچه در اینجا مدل شده، در سراسر طراحیهای RF بهعنوان عناصر بایاس، clampها، دیودهای ESD و حفاظتی، و ساختارهای کلیدزنی ظاهر میشوند. پشته لایهای در ?? هندسه عمودی فشرده مورد استفاده روی تراشه را بازتاب میدهد: نواحی تماس نازک و بهشدت دوپشده که با یک پیوند فعال کوتاه جفت شدهاند.
اگرچه دستگاه شبیهسازیشده در این آموزش ساده است، باید بهعنوان یک بلوک سازنده اولیه در نظر گرفته شود. همان الکترواستاتیک پیوند، ساختارهای diode-connected، نواحی ایزولاسیون، و لایههای تزریق درون فناوریهای GaAs مورد استفاده در الکترونیک پرسرعت و اپتوالکترونیک را کنترل میکند. ساختار لایهای دوپینگ مورد استفاده در اینجا بهصورت شماتیک در ?? نشان داده شده است.
در این آموزش شما یک دیود پیوند PN از جنس GaAs را در یک بعد با استفاده از حلگر کوپلشده drift–diffusion + Poisson در OghmaNano شبیهسازی خواهید کرد. بهجای اتکا صرف به معادله ایدهآل Shockley، این رویکرد میدان الکتریکی داخلی، ناحیه تهی، و توزیعهای مکانی چگالیها و جریانهای حامل را حل میکند.
۲. ایجاد یک شبیهسازی جدید
برای شروع، از پنجره اصلی OghmaNano یک شبیهسازی جدید ایجاد کنید. روی دکمه شبیهسازی جدید در نوار ابزار کلیک کنید. این کار کادر انتخاب نوع شبیهسازی را باز میکند (نگاه کنید به ??).
در کادر نوع شبیهسازی، روی دموهای GaAs دوبار کلیک کنید، سپس مثال پیوند/دیود GaAs را انتخاب کنید (نگاه کنید به ??). OghmaNano یک ساختار پیوند از پیشتعریفشده GaAs را بارگذاری میکند که ما آن را بهعنوان یک دیود PN در نظر خواهیم گرفت.
ساختار دستگاه بارگذاریشده در پنجره اصلی شبیهسازی نشان داده شده است (نگاه کنید به ??). اگرچه مسئله الکتریکی حلشده در این آموزش یکبعدی است، نمای سهبعدی یک نمایش بصری روشن از پشته عمودی لایهها و نواحی شرکتکننده در انتقال حامل و بازترکیب فراهم میکند.
دیود بهصورت دنبالهای از لایههای عمودی GaAs پیادهسازی شده است، که از یک ناحیه بهشدت دوپشده p+، یک ناحیه با دوپینگ سبکتر p، یک ناحیه با دوپینگ سبک n، و یک ناحیه بهشدت دوپشده n+ تشکیل شده است. این ساختار بهصورت صریح در ویرایشگر لایه فهرست شده است (نگاه کنید به ??), که در آن به هر لایه یک ضخامت، ماده، و نقش الکتریکی اختصاص داده شده است.
لایههای مرکزی p و n پیوند PN فعال را تشکیل میدهند. در تعادل، یک ناحیه تهی در سراسر این مرز ایجاد میشود و میدان الکتریکی داخلی را بهوجود میآورد که جداسازی و انتقال حامل را کنترل میکند. لایههای نازک و بهشدت دوپشده p+ و n+ بهعنوان نواحی تماس با مقاومت پایین عمل میکنند، تا اطمینان حاصل شود که افت بایاس اعمالشده عمدتاً در سراسر پیوند رخ میدهد نه در محل تماسها.
در بخشهای بعد، این ساختار بهصورت یک دستگاه یکبعدی در نظر گرفته خواهد شد: تمام تغییرات در راستای رشد حل میشوند، در حالی که تغییرات جانبی نادیده گرفته میشوند. با وجود این سادهسازی، مدل الکترواستاتیک اساسی، انتقال حامل، و فیزیک بازترکیبی را که رفتار I–V تاریک دیودهای پیوند PN مبتنی بر GaAs مورد استفاده در پشتههای عملی دستگاههای اپتوالکترونیکی و الکترونیکی پرسرعت را کنترل میکنند، ثبت میکند.


۳. بررسی پروفایل دوپینگ
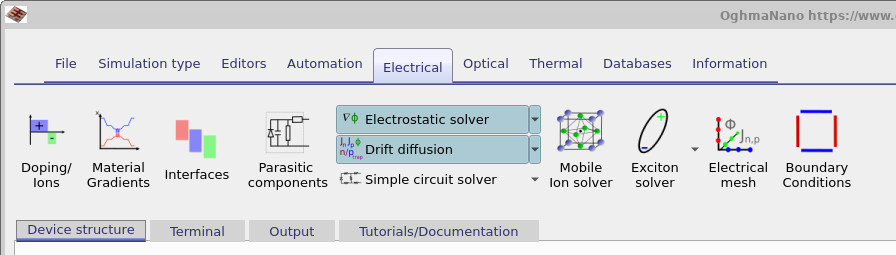
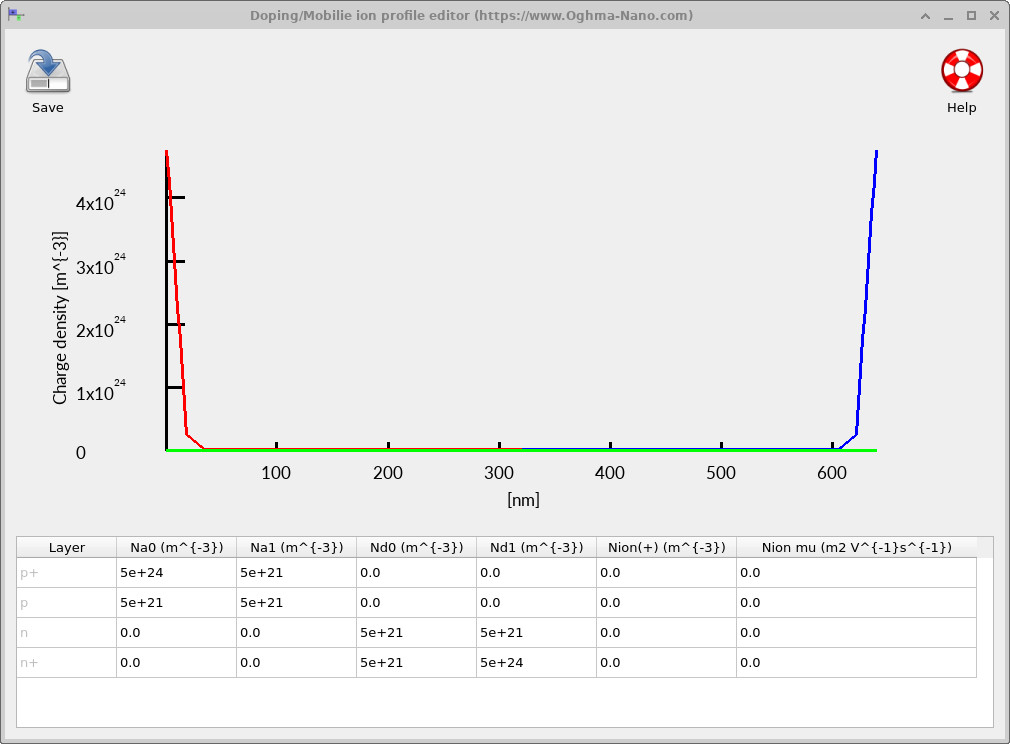
پروفایل دوپینگ، پیوند PN در GaAs را تعریف میکند و بنابراین الکترواستاتیک بنیادی دیود را تعیین میکند. این پروفایل محل پیوند، پتانسیل داخلی، پهنای ناحیه تهی، و میدان الکتریکی داخلیای را که در تعادل و تحت بایاس ایجاد میشود مشخص میکند.
برای مشاهده پیکربندی دوپینگ، ویرایشگر Doping / Ions را از نوار Electrical باز کنید (نگاه کنید به ??). ویرایشگر، توزیع مکانی دهندهها و پذیرندههای یونیدهشده را برحسب عمق نمایش میدهد (نگاه کنید به ??).
در این آموزش، دیود با استفاده از یک پروفایل دوپینگ متداول p+/p/n/n+ در GaAs ساخته شده است. نواحی مرکزی p و n بهطور متوسط دوپ شدهاند و پیوند PN فعال را تشکیل میدهند، جایی که ناحیه تهی و میدان الکتریکی داخلی ایجاد میشوند.
لایههای نازک و بهشدت دوپشده p+ و n+ بهعنوان نواحی تماس با مقاومت پایین عمل میکنند. نقش آنها فراهم کردن تزریق و استخراج الکتریکی مناسب حاملها است، در حالی که تضمین میکنند بیشتر ولتاژ اعمالشده در سراسر خود پیوند افت میکند نه در تماسها.
برای اهداف این آموزش، بررسی کلیدی صرفاً این است که دستگاه شامل یک ناحیه عمدتاً دوپشده با پذیرنده و یک ناحیه عمدتاً دوپشده با دهنده باشد، با یک گذار روشن بین آنها. مقادیر عددی دقیق چگالیهای دوپینگ عمدتاً بر پهنای ناحیه تهی و شدت میدان داخلی اثر میگذارند، که در بخشهای بعدی بهطور غیرمستقیم از طریق مشخصههای I–V تاریک دیود بررسی خواهند شد.
۴. بررسی پارامترهای الکتریکی و سازوکارهای بازترکیب
پارامترهای الکتریکی ماده بهصورت ناحیهبهناحیه تعریف میشوند و انتقال حامل، بازترکیب، و الکترواستاتیک را در سراسر دیود کنترل میکنند. ویرایشگر پارامترهای الکتریکی را از پنجره اصلی از مسیر ساختار دستگاه ← پارامترهای الکتریکی باز کنید. هر لایه در پشته دستگاه زبانه پارامتری مخصوص خود را دارد. در این آموزش از همان مدل ماده GaAs در هر چهار ناحیه استفاده میکنیم، اما آنها را بهصورت متفاوت تفسیر میکنیم: p+ و n+ بهعنوان نواحی تماس با مقاومت پایین عمل میکنند، در حالی که p و n پیوند PN فعال را تشکیل میدهند.
شکلهای ??– ?? ویرایشگر پارامترهای الکتریکی را برای هر ناحیه نشان میدهند (p+، p، n، n+). برای GaAs، چشمگیرترین پارامترها در وهله اول تحرکپذیریهای حامل هستند: تحرکپذیری الکترون در مقایسه با سیلیکون زیاد است، در حالی که تحرکپذیری حفره متعادلتر است. این عدم تقارن یک ویژگی تعیینکننده GaAs است و زیربنای استفاده گسترده آن در الکترونیک فرکانسبالا محسوب میشود.
از آنجا که انتقال حامل در GaAs، بهویژه برای الکترونها، معمولاً سریع است، رفتار I–V تاریک یک پیوند PN در GaAs اغلب بهوسیله انتقال حجمی محدود نمیشود. در عوض، تعادل میان تزریق، الکترواستاتیک، و بازترکیب پاسخ دستگاه را تعیین میکند. بنابراین پارامترهای نشاندادهشده در ویرایشگر در درجه اول کنترل میکنند که حاملهای تزریقشده پس از کاهش سد پیوند، تا چه اندازه کارآمد توسط فرایندهای بازترکیبی حذف میشوند.
چگالیهای مؤثر حالات که در ویرایشگر نشان داده شدهاند (برای مثال ??) آمار حامل و غلظتهای تعادلی حامل را برای GaAs تعیین میکنند. این مقادیر بهعلت ساختار نواری و جرمهای مؤثر متفاوت GaAs با سیلیکون فرق دارند، و بهطور مستقیم هم بر سطوح تزریق حامل و هم بر نرخهای بازترکیب از طریق چگالیهای الکترون و حفره \(n\) و \(p\) اثر میگذارند.




بازترکیب آزاد-به-آزاد (تابشی)
از آنجا که GaAs یک نیمهرسانای با گاف نواری مستقیم است، بازترکیب بین الکترونهای آزاد و حفرههای آزاد میتواند بهطور کارآمد از طریق گذارهای تابشی رخ دهد. در GaAs با کیفیت بالا، این کانال بازترکیب آزاد-به-آزاد اغلب سازوکار اتلاف غالب در پیوند فعال تحت بایاس مستقیم است. در OghmaNano، این فرایند توسط ثابت نرخ بازترکیب الکترون آزاد–به–حفره آزاد که در ویرایشگر پارامترهای الکتریکی قابل مشاهده است کنترل میشود (نگاه کنید، برای مثال، ??).
نرخ بازترکیب متناظر دارای فرم زیر است
\[ R_{\mathrm{rad}} = B \left( np - n_i^2 \right), \]که در آن \(B\) ضریب بازترکیب آزاد-به-آزاد (تابشی) است. در GaAs، این جمله میتواند پس از تزریق حاملها به پیوند، بر موازنه بازترکیب غالب شود، بهویژه زمانی که چگالی عیوب کم باشد. در نتیجه، مشخصه I–V تاریک یک دیود GaAs با کیفیت بالا اغلب فیزیک بازترکیب تابشی را بازتاب میدهد نه رفتار محدودشده توسط عیب.
بازترکیب Shockley–Read–Hall (SRH)
بازترکیب Shockley–Read–Hall (SRH) بازترکیب میانجیشده توسط عیب را از طریق حالتهای الکترونیکی در گاف نواری ثبت میکند. در OghmaNano این فرایند با استفاده از پارامترهای تله SRH تعادلی که در ویرایشگر نشان داده شدهاند کنترل میشود (نگاه کنید به ??): یک انرژی تله \(E_t\) (نسبت به midgap)، یک چگالی تله \(N_t\)، و سطحمقطعهای بهداماندازی الکترون و حفره \(\sigma_n\) و \(\sigma_p\).
در GaAs، بازترکیب SRH معمولاً حد ذاتی بازترکیب ماده را نشان نمیدهد. در عوض، معیاری از کیفیت ماده و چگالی عیب فراهم میکند. در GaAs اپیتاکسیال با کیفیت بالا، بازترکیب SRH ضعیف است و بازترکیب تابشی غالب میشود؛ در مواد با کیفیت پایینتر یا نزدیک فصل مشترکها و آسیبهای فرایندی، بازترکیب SRH میتواند قابلتوجه شود.
طولعمرهای SRH بهصورت زیر تعریف میشوند
\[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \]و نرخ بازترکیب حاصل برابر است با
\[ R_{\mathrm{SRH}} = \frac{np - n_i^2} {\tau_p (n + n_1) + \tau_n (p + p_1)} . \]در این آموزش، بازترکیب SRH عمداً حفظ شده است. این به شما امکان میدهد بررسی کنید که چگونه افزایش چگالی عیب یا کاهش طولعمر حامل دیود را از رفتار غالباً تابشی بهسوی عملکرد محدودشده توسط بازترکیب جابهجا میکند، که برای درک دستگاههای واقعی، جایی که فرایند ساخت و فصل مشترکها نقش مهمی ایفا میکنند، بهویژه مرتبط است.
الکترواستاتیک و پارامترهای نواری
در نهایت، پارامترهای ساختار نواری و الکترواستاتیکی مورد استفاده برای تعریف GaAs در زبانه هر ناحیه قابل مشاهده هستند (برای مثال ??): الکترونخواهی، گاف نواری (\(E_g \approx 1.42\,\mathrm{eV}\) در دمای اتاق)، و گذردهی نسبی (\(\varepsilon_r \approx 12.9\)). این پارامترها پتانسیل داخلی پیوند PN را تعیین میکنند و مقیاس ولتاژی را مشخص میکنند که در آن تزریق قابلتوجه حامل رخ میدهد.
برای GaAs، ترکیب گاف نواری مستقیم و تحرکپذیری بالای حامل به این معناست که با کاهش سد پیوند، حاملها بهطور کارآمد تزریق میشوند و فیزیک بازترکیب به عامل غالب شکلدهنده منحنی I–V تاریک تبدیل میشود. بنابراین، درک این که این پارامترهای الکتریکی چگونه با هم کار میکنند برای تفسیر هم نتایج شبیهسازی و هم رفتار واقعی دستگاههای GaAs ضروری است.
۵. اجرای شبیهسازی، منحنیهای I–V تاریک، و استخراج پارامترها
پس از تعریف ساختار دستگاه، پروفایل دوپینگ، و پارامترهای الکتریکی، شبیهسازی دیود را میتوان مستقیماً از پنجره اصلی اجرا کرد. برای شروع حلگر روی اجرای شبیهسازی کلیک کنید. در طول اجرا، اطلاعات همگرایی برای هر نقطه بایاس در ترمینال نوشته میشود، و به شما امکان میدهد پایداری حلگر و پیشرفت آن را پایش کنید (نگاه کنید به ??).


jv.csv نتیجه اصلی مورد توجه است.
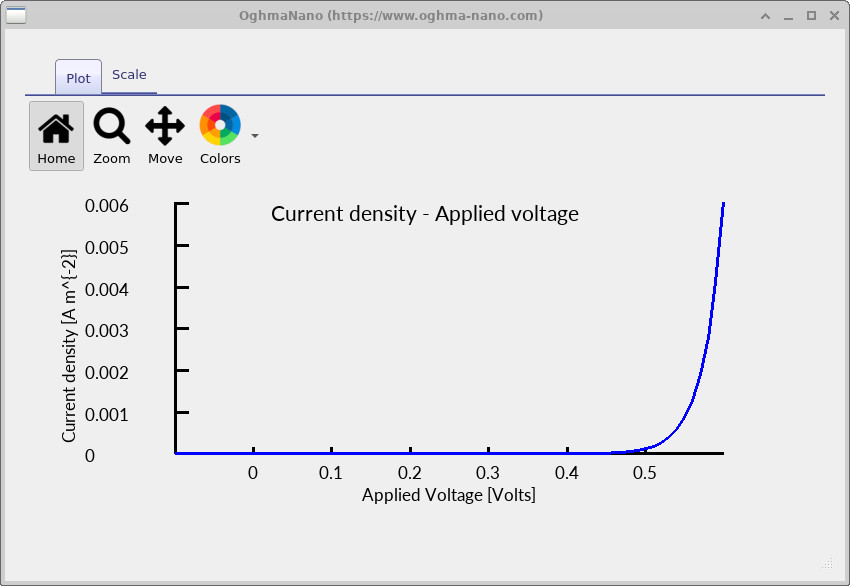
برای بررسی مشخصه دیود، زبانه Output را باز کرده و روی
jv.csv
دوبار کلیک کنید
(نگاه کنید به ??).
برای یک دیود GaAs که بهدرستی پیکربندی شده باشد، منحنی I–V باید هموار و یکنواخت باشد.
در بایاس معکوس، جریان کوچک و با وابستگی ضعیف به ولتاژ باقی میماند،
که بازتاب اشباع محدودشده توسط بازترکیب است.
در بایاس مستقیم، جریان با ولتاژ اعمالی بهسرعت افزایش مییابد،
که متناظر با تزریق حامل در سراسر پیوند PN است.
شکل ناحیه بایاس مستقیم حاوی اطلاعات فیزیکی مفیدی است. در نمودار نیمهلگاریتمی، شیب ناحیه نمایی را میتوان برای استخراج یک فاکتور ایدهآلی بهکار برد، که نشان میدهد آیا جریان تحت سلطه انتقال محدودشده توسط نفوذ (\(n \approx 1\)) یا فرایندهای محدودشده توسط بازترکیب (\(n \approx 2\)) است. عرض از مبدأ برونیابیشده این ناحیه برآوردی از جریان اشباع معکوس فراهم میکند، که مستقیماً به پارامترهای بازترکیب SRH و Auger مطرحشده در بخش ۴ مرتبط است. در GaAs، گاف نواری مستقیم و تحرکپذیریهای معمولاً بالا به این معناست که تزریق میتواند بسیار کارآمد باشد، بنابراین تنظیمات بازترکیب اغلب اثر مشخصی بر شیب و عرض از مبدأ در بایاس مستقیم میگذارند.
بهعنوان یک قاعده عملی، همیشه پیش از تفسیر هر کمیت مشتقشده، منحنی I–V را بررسی کنید. ناپیوستگیها، قراردادهای علامت غیرمنتظره، یا جهشهای غیرفیزیکی در جریان معمولاً نشاندهنده مشکلاتی در شرایط مرزی، گامبندی بایاس، تنظیمات بازترکیب، یا همگرایی حلگر هستند. برای یک دیود PN ساده از جنس GaAs مانند این مورد، منحنی I–V تاریک باید از نظر فیزیکی شهودی و بهراحتی قابل تفسیر باشد.
۶. بررسی snapshotهای شبیهسازی: نوارها، بازترکیب، و جریان حامل
در طول یک جاروب I–V، OghmaNano حل داخلی معادلات drift–diffusion را در هر نقطه بایاس در پوشه snapshots ذخیره میکند. این فایلها آنچه حلگر در داخل دیود پیشبینی میکند را آشکار میسازند: خمشدن نوارها، شکافت ترازهای شبهفرمی، فعالیت بازترکیب، و انتقال جریان. بررسی این کمیتها برای درک اینکه چرا یک مشخصه I–V معین پدید میآید ضروری است.
در این بخش سه نقطه بایاس نماینده را بررسی میکنیم: یک بایاس معکوس نزدیک به تعادل (−0.1 V)، یک بایاس مستقیم متوسط نزدیک روشنشدن (≈0.45 V)، و یک بایاس مستقیم زیاد (0.8 V). این snapshotها در کنار هم گذار از تعادل، از طریق انتقال محدودشده توسط تزریق، به کارکرد با تزریق زیاد را نشان میدهند. برای GaAs، همین گذار کیفی برقرار است، در حالی که کانال بازترکیب غالب در ناحیه فعال معمولاً آزاد-به-آزاد (تابشی) است نه SRH محدودشده توسط عیب.
۶.۱ لبههای نوار و ترازهای شبهفرمی
برای بازتولید نمودارهای نواری، نمایشگر snapshot را باز کنید و فایلهای
Ec.csv، Ev.csv, Fn.csv, و Fp.csv
را اضافه کنید.
اینها بهترتیب متناظر با لبه نوار رسانش، لبه نوار ظرفیت،
تراز شبهفرمی الکترون، و تراز شبهفرمی حفره هستند.
در −0.1 V (شکل ??)، دیود نزدیک تعادل است. خمشدن نوارها پتانسیل داخلی تحمیلشده توسط پروفایل دوپینگ را بازتاب میدهد، و ترازهای شبهفرمی تقریباً تخت و منطبق هستند، که نشاندهنده جریان خالص ناچیز است. ناحیه تهی بهوضوح بهصورت ناحیهای با خمیدگی زیاد نوارها در پیوند دیده میشود. در ≈0.45 V (شکل ??)، بایاس مستقیم سد پیوند را کاهش میدهد. ترازهای شبهفرمی الکترون و حفره در سراسر ناحیه تهی از هم جدا میشوند، که امضای داخلی تزریق حامل است. این جدایی ترازهای شبهفرمی مستقیماً مسئول افزایش نمایی جریان مشاهدهشده در منحنی I–V است. در 0.8 V (شکل ??)، پیوند عمیقاً در بایاس مستقیم قرار دارد. سد بهشدت تضعیف شده است، ترازهای شبهفرمی بهطور گسترده از هم جدا هستند، و دستگاه در یک ناحیه تزریق زیاد کار میکند که در آن چگالی حامل در بخش بزرگی از ساختار زیاد است. در GaAs، این شکافت شبهفرمی بهویژه آموزنده است زیرا مستقیماً با تزریق قوی حامل و بازترکیب کارآمد آزاد-به-آزاد در ناحیه فعال مرتبط است.
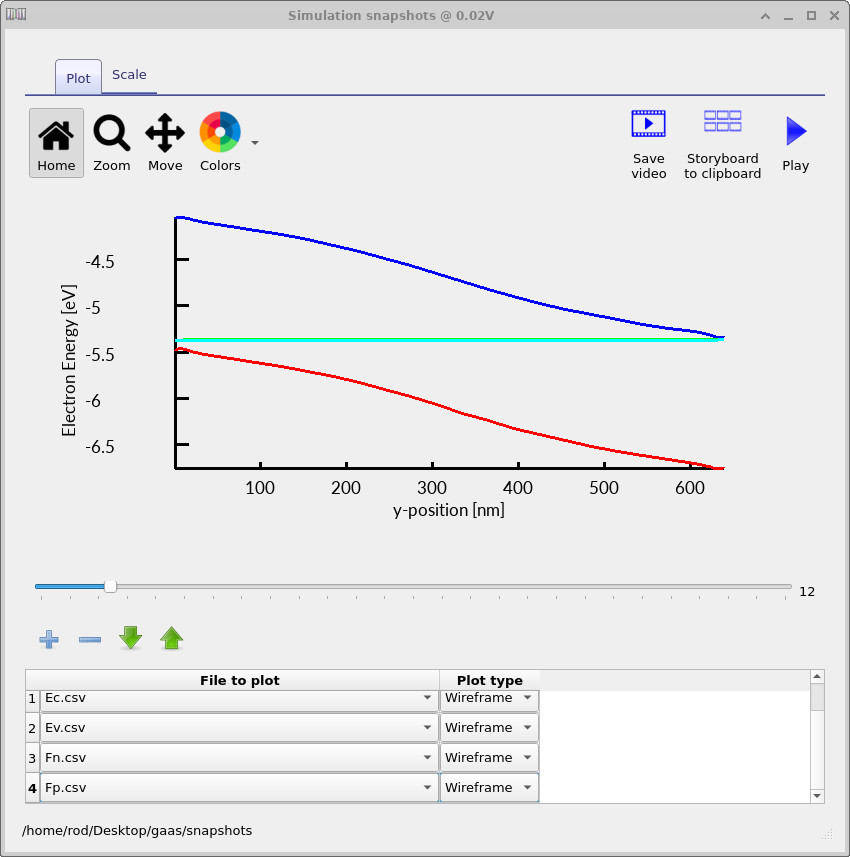
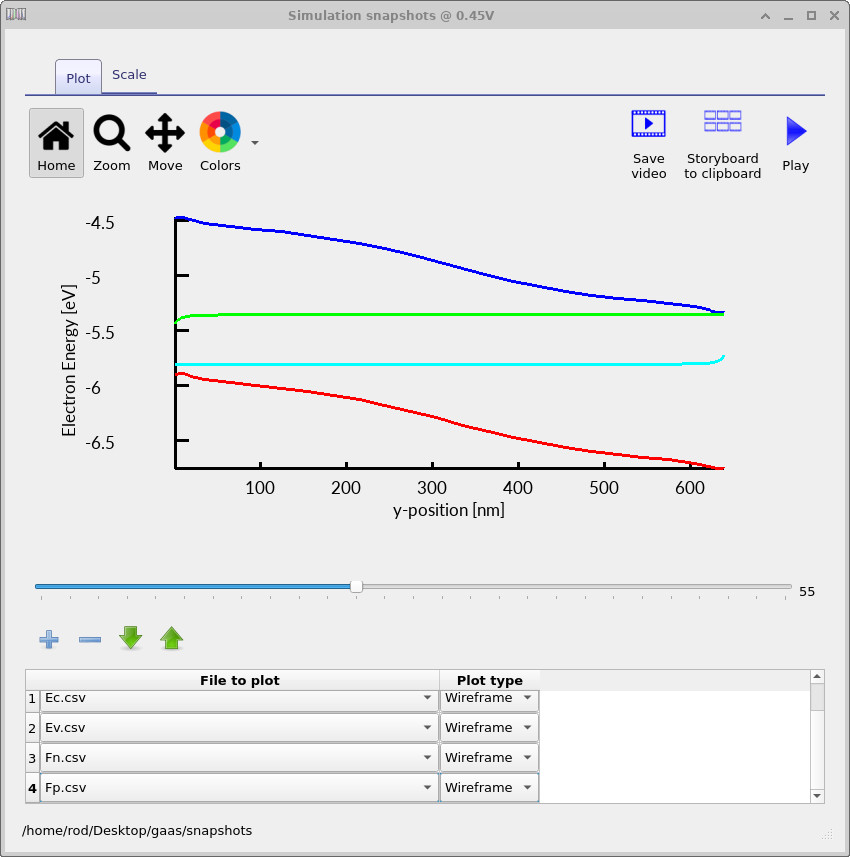

۶.۴ بازترکیب آزاد-به-آزاد (تابشی) در ناحیه فعال
بازترکیب آزاد-به-آزاد را میتوان با رسم R_nfree_to_pfree.csv بررسی کرد،
که نرخ بازترکیب تابشی موضعی را برحسب مکان گزارش میکند.
در GaAs، این کانال معمولاً سازوکار بازترکیب غالب در پیوند فعال تحت بایاس مستقیم است،
زیرا GaAs یک نیمهرسانای با گاف نواری مستقیم است و گذارهای تابشی در آن کارآمد هستند.
هنگام تفسیر این نمودارها، مهمترین ویژگی ساختار مکانی ریز نیست،
بلکه شکل کلی پروفایل بازترکیب و چگونگی تحول اندازه آن با بایاس است.
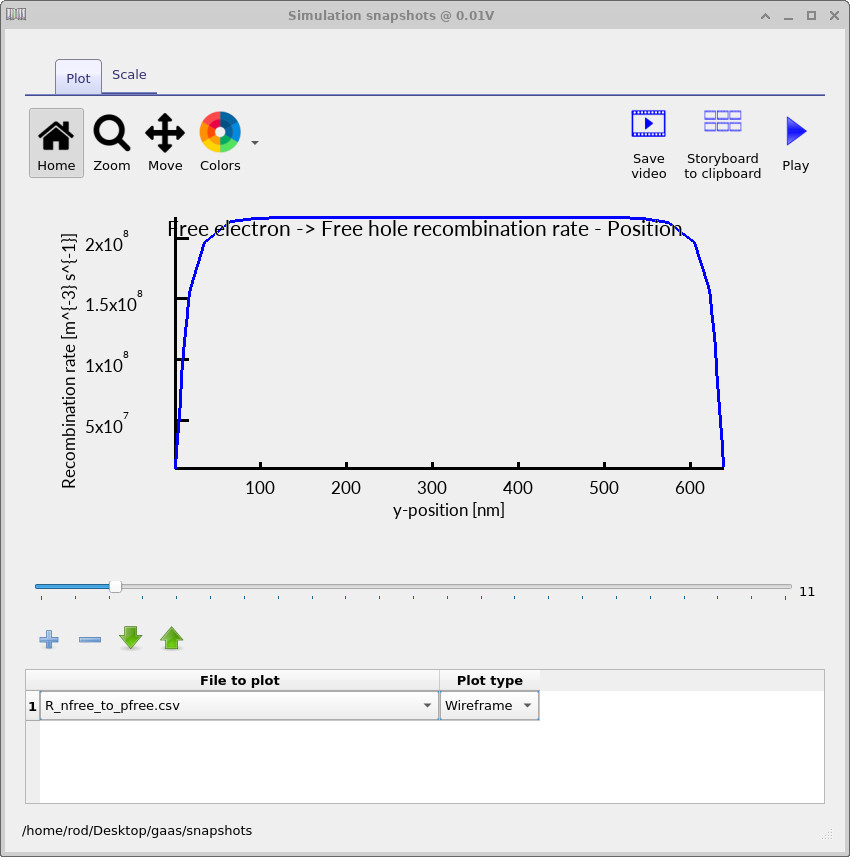
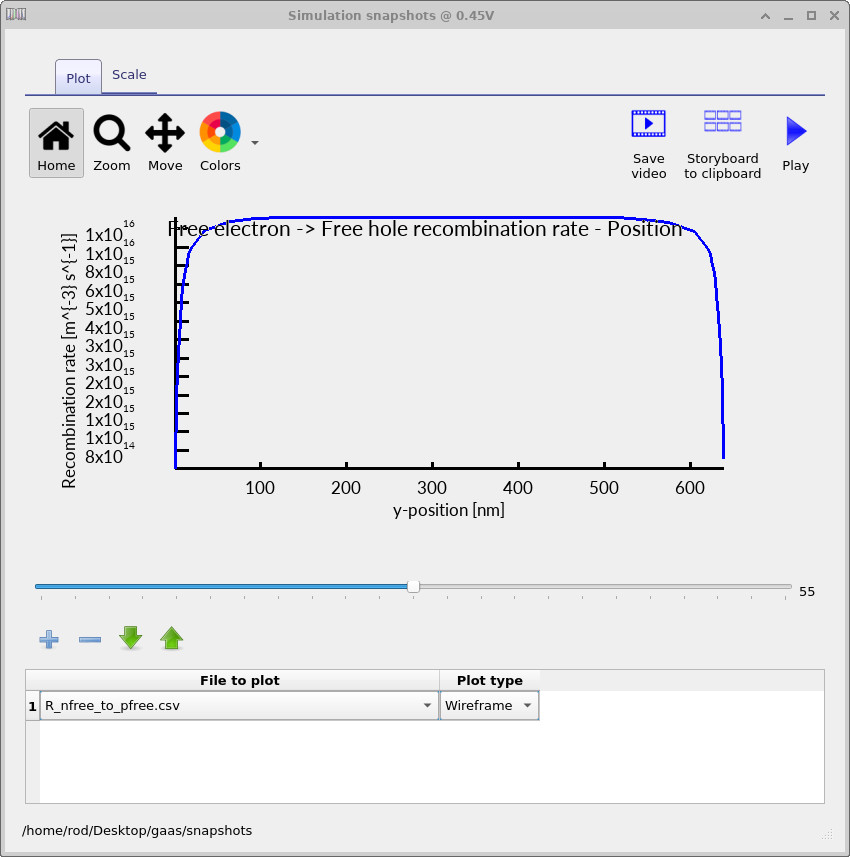
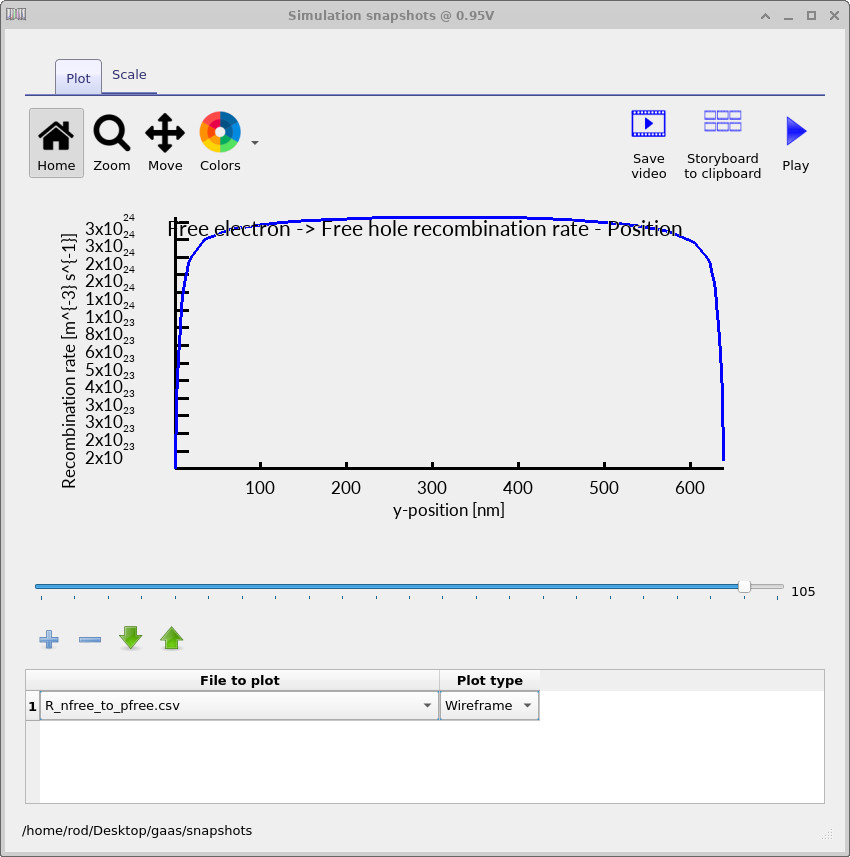
در بایاس بسیار کم (شکل ??)، بازترکیب آزاد-به-آزاد ضعیف است زیرا دستگاه نزدیک تعادل است و حاصلضرب حامل \(np\) نزدیک \(n_i^2\) باقی میماند. اگرچه GaAs از گذارهای تابشی کارآمد پشتیبانی میکند، چگالیهای حامل لازم برای ایجاد یک نرخ تابشی زیاد هنوز وجود ندارند.
وقتی دیود به بایاس مستقیم رانده میشود (شکل ??)، الکترونها و حفرههای تزریقشده در بیشتر بخشهای ساختار با هم همزیست میشوند. پروفایل بازترکیب آزاد-به-آزاد حاصل، شکل کلاهکی پهن و با خمیدگی ملایم به خود میگیرد که تقریباً کل دستگاه را در بر میگیرد. این شکل بازتاب این واقعیت است که بازترکیب تابشی عمدتاً به حاصلضرب موضعی حامل \(np\) وابسته است، که پس از برقراری تزریق در نواحی شبهخنثی نسبتاً یکنواخت است. برخلاف بازترکیب SRH، تمرکز شدیدی روی ناحیه تهی وجود ندارد.
در بایاس مستقیم زیاد (شکل ??)، شکل پروفایل بازترکیب آزاد-به-آزاد در کل مشابه باقی میماند، در حالی که اندازه آن چندین مرتبه بزرگی افزایش مییابد. این یک ویژگی تشخیصی کلیدی بازترکیب غالباً تابشی در GaAs است: افزایش بایاس در درجه اول چگالی حامل را در همهجا بالا میبرد، نه اینکه محل وقوع بازترکیب را تغییر دهد. این پروفایل هموار و گسترده در کل دستگاه نشان میدهد که بازترکیب تابشی بهعنوان یک فرایند حجمی در سراسر نواحی تزریقشده عمل میکند.
این رفتار تضاد شدیدی با بازترکیب میانجیشده توسط عیب دارد. بازترکیب SRH معمولاً قلههای باریک و متمرکز بر پیوند ایجاد میکند که فقط در تزریق زیاد پهن میشوند، در حالی که بازترکیب آزاد-به-آزاد در GaAs یک «گنبد» بازترکیبی منفرد و گسترده ایجاد میکند که ارتفاع آن — نه گستره مکانی آن — سطح تزریق را رمزگذاری میکند. بنابراین در دستگاههای با گاف نواری مستقیم، این پروفایل تابشی پهن نشانهای از کیفیت بالای ماده و تزریق کارآمد حامل است، و اغلب سهم غالب را در موازنه بازترکیبی شکلدهنده مشخصه I–V فراهم میکند.
۶.۲ بازترکیب Shockley–Read–Hall
برای بررسی بازترکیب میانجیشده توسط عیب، R_ss_srh.csv را رسم کنید که نرخ بازترکیب
Shockley–Read–Hall را بهصورت تفکیکشده در مکان درون دیود نشان میدهد.
سه نمودار زیر متناظر با همان نقاط بایاس بهکاررفته در تحلیل نمودار نواری هستند:
−0.1 V، ≈0.45 V، و 0.8 V.
برای GaAs، این نمودارها بهتر است بهعنوان یک ابزار تشخیصی برای اتلاف کمکگرفته از تله تفسیر شوند نه کانال بازترکیب غالب در یک پیوند با کیفیت بالا.
نکته اصلی که باید روی آن تمرکز کرد این است که مکانیابی مکانی بازترکیب SRH چگونه با پروفایل آزاد-به-آزادِ گستردهتر در بالا مقایسه میشود.
در −0.1 V (شکل ??)، دیود نزدیک تعادل است. الکترونها در سمت نوع n و حفرهها در سمت نوع p غالب هستند، بنابراین بازترکیب SRH قابلتوجه تنها میتواند در ناحیه باریک اطراف پیوند رخ دهد که هر دو نوع حامل بهطور همزمان حضور دارند. در نتیجه، نرخ بازترکیب SRH بهشدت در مرکز دستگاه موضعی میشود، که با ناحیه تهی منطبق است. در ≈0.45 V (شکل ??)، بایاس مستقیم حاملها را در سراسر پیوند تزریق میکند و حاصلضرب موضعی چگالیهای الکترون و حفره را افزایش میدهد. قله SRH از نظر اندازه بهطور قابلتوجهی رشد میکند، اما از نظر مکانی همچنان به ناحیه مرکزی دستگاه محدود میماند. این نشان میدهد که SRH همچنان یک کانال اتلاف متمرکز بر پیوند باقی میماند، که توسط همپوشانی حامل و فعالیت تله درون و نزدیک ناحیه تهی کنترل میشود. در 0.8 V (شکل ??)، این رفتار با افزایش تزریق حامل در سراسر ساختار گستردهتر میشود. با این حال، حتی زمانی که SRH گسترش مییابد، معمولاً همچنان با وزن بیشتری به ناحیه پیوند وابسته میماند تا بازترکیب آزاد-به-آزاد، که در GaAs تمایل دارد در سراسر نواحی شبهخنثی تزریقشده توزیع شود.
مقایسه این دو کانال بازترکیب، تصویری داخلی و مفید از عملکرد دیود GaAs میدهد. بازترکیب آزاد-به-آزاد پس از برقراری تزریق یک مخزن حجمی فراهم میکند و بهطور معمول بر موازنه کلی بازترکیب در حجم فعال دستگاه غالب است. در مقابل، بازترکیب SRH نشان میدهد که اتلاف کمکگرفته از تله کجا متمرکز شده است—اغلب درون و نزدیک ناحیه تهی—و آن را به شاخصی حساس از کیفیت ماده و آسیبهای فصل مشترکی تبدیل میکند. این تمایز به توضیح این موضوع کمک میکند که چرا دیودهای GaAs میتوانند تزریق قوی و جریانهای بزرگ نشان دهند و در عین حال نسبت به عیوب موجود در پیوند بسیار حساس باقی بمانند.



۶.۳ چگالی جریان الکترون و حفره
در نهایت، جریانهای حامل را با رسم Jn.csv و Jp.csv بررسی کنید،
که بهترتیب چگالی جریان الکترون و حفره را بهصورت تفکیکشده در مکان نشان میدهند.
این نمودارها نمایی مستقیم از نحوه انتقال بار در دیود
تحت شرایط مختلف بایاس ارائه میکنند و نشان میدهند که دستگاه چگونه از تعادل
به رسانش پایای بایاس مستقیم گذار میکند.
در −0.1 V (شکل
??)،
دیود نزدیک تعادل است و جریان فیزیکی واقعی بسیار کوچک است.
شارهای الکترون و حفره تقریباً در همهجای دستگاه متعادل هستند،
بنابراین جریان خالص از تفاضل دو کمیت تقریباً مساوی بهدست میآید.
در این ناحیه، مسئله عددی ذاتاً بدشرط است،
و نوسانهای کوچک یا نویز ظاهری در پروفایلهای جریان قابل انتظار است.
در این دمو GaAs، این اثر میتواند آشکارتر به نظر برسد: ترکیب انتقال بسیار سریع حامل
(بهویژه برای الکترونها) و جریان خالص بسیار کوچک، مسئله خنثیشدن را شدیدتر میکند،
بنابراین ردپاهای خام Jn/Jp ممکن است بهوضوح نویزی به نظر برسند، حتی اگر فیزیک زیربنایی صرفاً «جریان تقریباً صفر» باشد. در ≈0.45 V (شکل
??)،
بایاس مستقیم تزریق حامل را در سراسر پیوند پیش میبرد.
جریان الکترون در سمت n و جریان حفره در سمت p غالب است،
اما هر دو جریان در سراسر دستگاه پیوستهاند،
که بازتاب پایستگی بار در حالت پایاست.
چگالی جریان نسبت به حالت نزدیک تعادل بهسرعت افزایش مییابد،
با این حال پروفایلها همچنان میتوانند نزدیک پیوند، جایی که گرادیانها تند هستند، ساختار عددی کوچکی نشان دهند.
در GaAs، جایی که تزریق میتواند پس از کاهش سد بهسرعت برقرار شود، مشاهده اینکه جریانها فقط
پس از خروج روشن دستگاه از ناحیه کمجریانِ تحت سلطه خنثیشدن «پایدار» میشوند، رایج است. در 0.8 V (شکل
??)،
دیود در بایاس مستقیم زیاد کار میکند.
چگالی حامل در سراسر ساختار زیاد است،
و هر دو جریان الکترون و حفره بزرگتر، هموارتر، و تقریباً یکنواختتر
در سراسر نواحی شبهخنثی میشوند.
حتی در این حالت نیز، شبیهسازیهای GaAs ممکن است اندکی ریپل باقیمانده در پروفایلهای خام جریان حفظ کنند،
بهویژه اگر حلگر در حال گزارش جریانهای نقطهایِ بدون فیلتر باشد؛ شاخص تشخیصی کلیدی این است که روند در مقیاس بزرگ از نظر فیزیکی سازگار باشد،
با جریان پیوسته و بدون وارونگی علامت کاذب در سراسر دستگاه فعال.
در مجموع، این نمودارهای چگالی جریان تصویری داخلی و سازگار از عملکرد دیود فراهم میکنند: از خنثیشدن تقریباً کامل شارهای الکترون و حفره در تعادل، از طریق رسانش مستقیم محدودشده توسط تزریق، تا انتقال پایای پرجریان در بایاس مستقیم زیاد.




