ガリウムヒ素 (GaAs) PN接合ダイオード (1D) — Drift–Diffusion (暗時 I–V、SRH 再結合)
1. はじめに

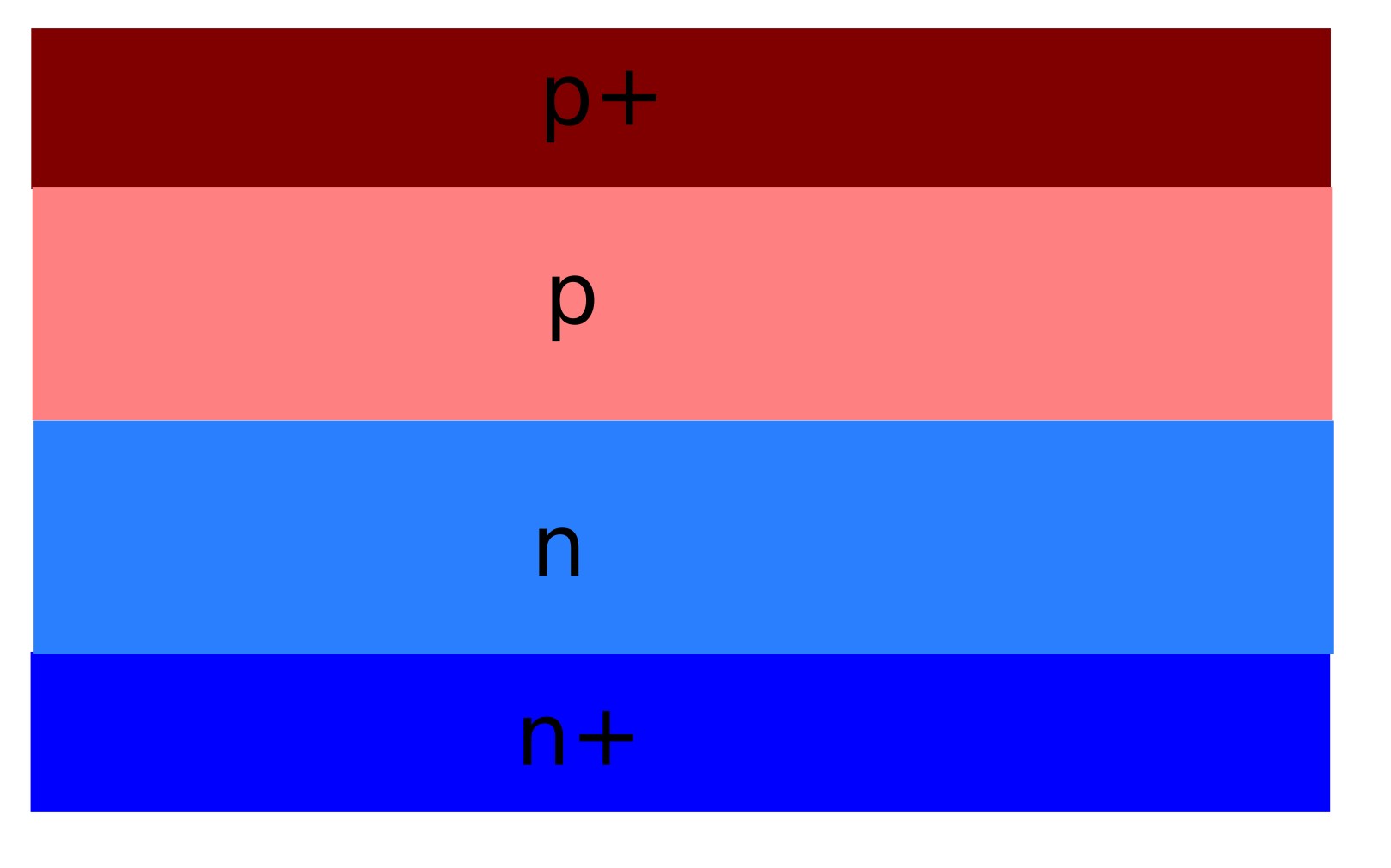
ガリウムヒ素 (GaAs) PN接合ダイオード は基本的な III–V 半導体デバイスです。 これは GaAs RF およびマイクロ波集積回路へ広く組み込まれており、コンパクトな PN 接合が RF フロントエンド内で整流、バイアス、保護、およびスイッチング機能を担っています。 代表的な応用文脈を ?? に示します。ここでは、現代の高周波電子回路で用いられる GaAs チップスケールプラットフォームの種類を示しています。
ガリウムヒ素がこれらの用途に適しているのは、 高い電子移動度 により高速なキャリア輸送と低い抵抗損失が可能であり、 5G システムで用いられる GHz およびミリ波周波数帯での高効率動作を支えるからです。 実際には、ここでモデル化するような短い PN 接合は、 RF 設計全体にわたってバイアス要素、クランプ、ESD/保護ダイオード、スイッチング構造として現れます。 ?? に示した層構造は、そのようなオンチップ用途で用いられるコンパクトな縦型幾何を反映しており、 薄い高濃度ドープ接触領域と短い活性接合が組み合わされています。
このチュートリアルでシミュレーションするデバイスは単純ですが、原始的な構成要素 として理解すべきです。 同じ接合静電場は、高速電子回路および光電子回路に使われる GaAs 技術におけるダイオード接続構造、絶縁領域、および注入層を支配しています。 ここで用いる層状ドーピング構造は ?? に模式的に示されています。
このチュートリアルでは、OghmaNano の連成 drift–diffusion + Poisson ソルバーを用いて、 一次元 の GaAs PN接合ダイオードをシミュレーションします。 理想 Shockley 方程式だけに頼るのではなく、この手法では 内蔵電場、空乏領域、 およびキャリア密度と電流の空間分布を解像します。
2. 新しいシミュレーションの作成
はじめに、OghmaNano のメインウィンドウから新しいシミュレーションを作成します。 ツールバーの New simulation ボタンをクリックしてください。 これによりシミュレーションタイプ選択ダイアログが開きます (?? 参照)。
シミュレーションタイプダイアログで、GaAs demos をダブルクリックし、その後 GaAs 接合/ダイオードの例を選択します (?? 参照)。 OghmaNano は、ここでは PN ダイオードとして扱う定義済みの GaAs 接合構造を読み込みます。
読み込まれたデバイス構造はメインシミュレーションウィンドウに表示されます (?? 参照)。 このチュートリアルで解く電気的問題は一次元ですが、 3D 表示は縦方向の層構造とキャリア輸送および再結合に関与する領域を 明確に可視化するのに便利です。
ダイオードは、縦方向に積層された一連の GaAs 層として実装されており、 高濃度ドープされた p+ 領域、 やや低濃度ドープの p 領域、 低濃度ドープの n 領域、 そして高濃度ドープの n+ 領域から構成されます。 この構造は Layer editor に明示的に一覧表示されており (?? 参照)、 そこでは各層に厚さ、材料、および電気的役割が割り当てられています。
中央の p 層と n 層が活性 PN 接合を形成します。 平衡状態では、この界面に空乏領域が発達し、 キャリア分離と輸送を制御する内蔵電場が生じます。 薄い高濃度ドープの p+ 層および n+ 層は 低抵抗接触領域として機能し、 印加電圧の主な電位降下が接触ではなく接合にかかるようにします。
以下の各節では、この構造を一次元デバイスとして扱います。 すなわち、すべての変化は成長方向に沿って解像され、横方向変化は無視されます。 この単純化にもかかわらず、このモデルは、 実際の光電子デバイスおよび高速電子デバイススタック内で用いられる GaAs PN接合ダイオードの暗時 I–V 挙動を支配する本質的な静電場、キャリア輸送、 および再結合物理を捉えています。


3. ドーピングプロファイルの確認
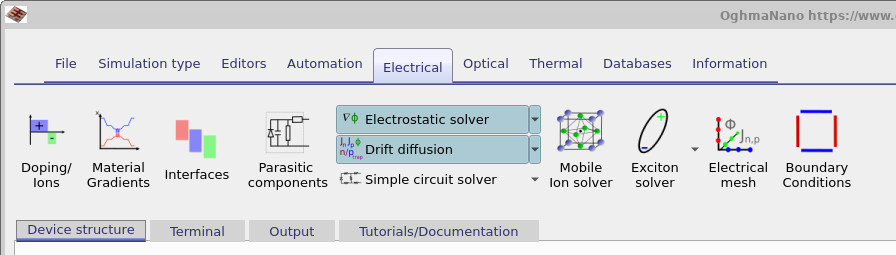
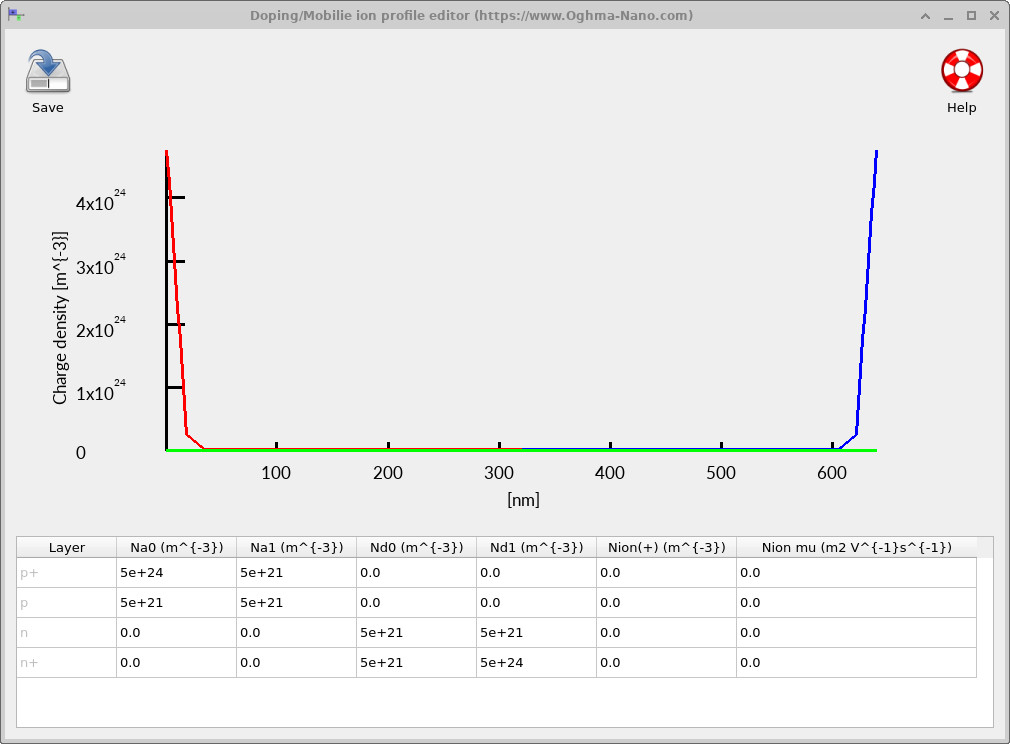
ドーピングプロファイルは GaAs PN 接合を定義し、したがってダイオードの基本静電場を決定します。 これは接合位置、内蔵電位、空乏幅、 および平衡時とバイアス印加時に発生する内部電場を決定します。
ドーピング構成を確認するには、 Electrical リボンの Doping / Ions エディタを開いてください (?? 参照)。 このエディタには、深さの関数としてのイオン化ドナーおよびアクセプタの空間分布が表示されます (?? 参照)。
このチュートリアルでは、ダイオードは従来型の p+/p/n/n+ GaAs ドーピングプロファイルを用いて構築されています。 中央の p および n 領域は中程度のドープ濃度を持ち、 空乏領域と内蔵電場が発達する活性 PN 接合を形成します。
薄い高濃度ドープの p+ および n+ 層は 低抵抗接触領域として機能します。 その役割は、キャリアの良好な電気的注入と抽出を与えつつ、 印加電圧の大部分が接触ではなく接合そのものに かかるようにすることです。
このチュートリアルの目的において重要な確認点は、 デバイスが主としてアクセプタドープされた領域を 1 つ、 そして主としてドナードープされた領域を 1 つ含み、 その間に明確な遷移があることです。 正確な数値としてのドーピング密度は主に空乏幅 と内蔵電場強度に影響し、これらは後の節で ダイオードの暗時 I–V 特性を通して間接的に調べます。
4. 電気パラメータと再結合機構の確認
電気材料パラメータは 領域ごと に定義され、 ダイオード全体にわたるキャリア輸送、再結合、および静電場を制御します。メインウィンドウから Device structure → Electrical parameters を通して電気パラメータエディタを開いてください。 デバイススタック内の各層には、それぞれ独自のパラメータタブがあります。 このチュートリアルでは、4 つの領域すべてで同じ GaAs 材料モデルを用いますが、それらを異なる役割として 解釈 します。 すなわち、p+ および n+ は低抵抗接触領域、 p および n は活性 PN 接合を形成します。
図 ??– ?? は、各領域 (p+、p、n、n+) の電気パラメータエディタを示しています。 GaAs で最も目を引くパラメータはキャリア移動度であり、 電子移動度はシリコンに比べて高く、一方で正孔移動度はより控えめです。 この非対称性は GaAs の特徴であり、高周波電子デバイスで広く用いられる基盤となっています。
特に電子について、GaAs におけるキャリア輸送は通常高速であるため、 GaAs PN 接合の暗時 I–V 挙動はしばしば バルク輸送 によって律速されません。 その代わりに、注入、静電場、および再結合のバランスがデバイス応答を決定します。 したがって、エディタに示されるパラメータは主として、 接合障壁が低下した後に注入キャリアが 再結合過程によってどれだけ効率よく除去されるかを制御します。
エディタに示される有効状態密度 (例えば ??) は、GaAs におけるキャリア統計と平衡キャリア濃度を設定します。 これらの値は GaAs の異なるバンド構造と有効質量のためシリコンとは異なり、 電子密度 \(n\) と正孔密度 \(p\) を通して、キャリア注入準位と再結合速度の両方に直接影響します。




自由電子–自由正孔(放射)再結合
GaAs は 直接遷移型バンドギャップ半導体 であるため、 自由電子と自由正孔の間の再結合は放射遷移を介して効率よく起こり得ます。 高品質な GaAs では、この 自由電子–自由正孔 再結合チャネルが、 順方向バイアス下の活性接合においてしばしば支配的な損失機構です。 OghmaNano では、この過程は電気パラメータエディタに表示される 自由電子–自由正孔再結合速度定数によって制御されます (例えば ?? 参照)。
対応する再結合速度は次式で与えられます
\[ R_{\mathrm{rad}} = B \left( np - n_i^2 \right), \]ここで \(B\) は自由電子–自由正孔(放射)再結合係数です。 GaAs では、特に欠陥密度が低い場合、 この項が接合へキャリアが注入されると再結合バランスを支配し得ます。 その結果、高品質 GaAs ダイオードの暗時 I–V 特性は、 欠陥律速挙動ではなく放射再結合物理を反映することがよくあります。
Shockley–Read–Hall (SRH) 再結合
Shockley–Read–Hall (SRH) 再結合は、バンドギャップ内の電子状態を介した欠陥媒介再結合を記述します。 OghmaNano では、これはエディタに表示される equilibrium SRH trap パラメータ (?? 参照)、 すなわちトラップエネルギー \(E_t\)(ミッドギャップ基準)、 トラップ密度 \(N_t\)、および電子・正孔捕獲断面積 \(\sigma_n\) と \(\sigma_p\) によって制御されます。
GaAs では、SRH 再結合は通常、その材料固有の再結合限界を表すものではありません。 むしろ、それは 材料品質 と欠陥密度の指標を与えます。 高品質エピタキシャル GaAs では SRH 再結合は弱く、放射再結合が支配的です。 一方で、低品質材料や界面近傍、加工損傷部では、SRH 再結合が顕著になることがあります。
SRH 寿命は次式で定義されます
\[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \]そして対応する再結合速度は
\[ R_{\mathrm{SRH}} = \frac{np - n_i^2} {\tau_p (n + n_1) + \tau_n (p + p_1)} . \]このチュートリアルでは、SRH 再結合を意図的に残しています。 これにより、欠陥密度を増加させる、あるいはキャリア寿命を短くすることで、 ダイオードが放射支配挙動から再結合律速動作へどのように移るかを探ることができます。 これは、加工や界面が重要な役割を果たす実デバイスを理解する上で特に重要です。
静電場とバンドパラメータ
最後に、GaAs を定義するために用いられるバンド構造および静電場パラメータは、 各領域タブに表示されています (例: ??)。 これには電子親和力、バンドギャップ(室温で \(E_g \approx 1.42\,\mathrm{eV}\))、 および比誘電率(\(\varepsilon_r \approx 12.9\))が含まれます。 これらのパラメータは PN 接合の内蔵電位を設定し、 顕著なキャリア注入が起こる電圧スケールを決定します。
GaAs では、直接遷移型バンドギャップと高いキャリア移動度の組み合わせにより、 一旦接合障壁が低下するとキャリアが効率よく注入され、 再結合物理が暗時 I–V 曲線を形成する支配要因となります。 したがって、これらの電気パラメータがどのように相互作用するかを理解することは、 シミュレーション結果と実際の GaAs デバイス挙動の両方を解釈するために不可欠です。
5. シミュレーション実行、暗時 I–V 曲線、およびパラメータ抽出
デバイス構造、ドーピングプロファイル、および電気パラメータが定義されたら、 ダイオードシミュレーションはメインウィンドウから直接実行できます。 Run simulation をクリックしてソルバーを開始してください。 実行中、各バイアスポイントの収束情報がターミナルへ書き込まれ、 ソルバー安定性と進行状況を監視できます (?? 参照)。


jv.csv が主要な結果ファイルです。
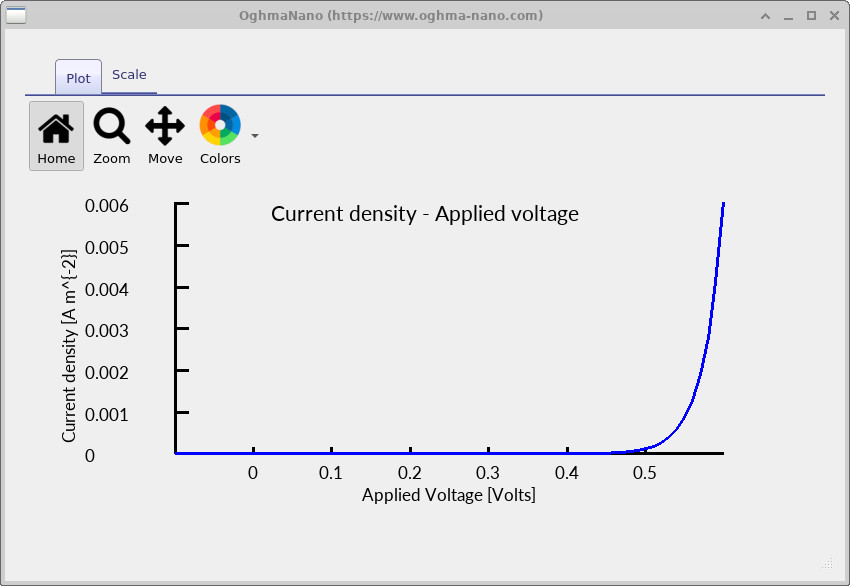
ダイオード特性を確認するには、Output タブを開き、
jv.csv をダブルクリックしてください
(?? 参照)。
正しく設定された GaAs ダイオードでは、I–V 曲線は滑らかで単調であるはずです。
逆バイアスでは、電流は小さく電圧依存性も弱く、
再結合律速飽和を反映します。
順バイアスでは、電流は印加電圧とともに急激に増加し、
PN 接合を越えたキャリア注入に対応します。
順バイアス領域の形状には有用な物理情報が含まれています。 片対数プロットでは、指数領域の傾きから 理想性因子 を抽出でき、 電流が拡散律速輸送(\(n \approx 1\))なのか、 再結合律速過程(\(n \approx 2\))なのかを示します。 この領域の外挿切片は 逆飽和電流 の推定を与え、 これはセクション 4 で議論した SRH および Auger 再結合パラメータと直接結びついています。 GaAs では直接遷移型バンドギャップと通常高い移動度のため、注入が非常に効率的になり得るため、 再結合設定は順バイアスの傾きと切片に特に明瞭な痕跡を残すことが多いです。
実用的な規則として、派生量を解釈する前に常に I–V 曲線を確認してください。 不連続、予期しない符号規約、あるいは非物理的な電流ジャンプは通常、 境界条件、バイアス刻み、再結合設定、あるいはソルバー収束に問題があることを示します。 このような単純な GaAs PN ダイオードでは、暗時 I–V 曲線は物理的に直感的で 解釈しやすいはずです。
6. シミュレーション snapshots の確認: バンド、再結合、および電流フロー
I–V 掃引中、OghmaNano は drift–diffusion 方程式の内部解を 各バイアスポイントで snapshots ディレクトリへ保存します。 これらのファイルは、ソルバーがダイオード 内部 で何を予測しているかを示します。 すなわち、バンド湾曲、準フェルミ準位分裂、再結合活性、および電流輸送です。 これらの量を確認することは、特定の I–V 特性がなぜ現れるかを理解するために不可欠です。
この節では 3 つの代表的バイアスポイントを調べます: 平衡に近い逆バイアス (−0.1 V)、 ターンオン近傍の中程度順バイアス (≈0.45 V)、 および高順バイアス (0.8 V) です。 これらの snapshots は合わせて、平衡状態から、 注入律速輸送、 そして高注入動作への遷移を示します。 GaAs では、同じ定性的遷移が成り立ちますが、活性領域における支配的再結合チャネルは通常、 欠陥律速 SRH ではなく自由電子–自由正孔(放射)再結合です。
6.1 バンド端と準フェルミ準位
バンド図を再現するには、snapshot viewer を開き、
Ec.csv、Ev.csv、Fn.csv、および Fp.csv
を追加してください。
これらはそれぞれ、伝導帯端、価電子帯端、
電子準フェルミ準位、および正孔準フェルミ準位に対応します。
−0.1 V では(図 ??)、 ダイオードは平衡に近い状態です。 バンド湾曲はドーピングプロファイルによって課される内蔵電位を反映しており、 準フェルミ準位はほぼ平坦かつ一致していて、 正味電流がほとんど流れていないことを示しています。 空乏領域は、接合での強いバンド曲率領域として明瞭に見えます。≈0.45 V では(図 ??)、 順バイアスにより接合障壁が低下します。 電子と正孔の準フェルミ準位は空乏領域を跨いで分離し、 これはキャリア注入の内部的指標です。 この準フェルミ準位分離が、I–V 曲線で観測される 電流の指数関数的増大を直接生みます。 0.8 V では(図 ??)、 接合は深い順バイアスに入っています。 障壁は大きく抑制され、準フェルミ準位は大きく分離し、 デバイスは構造のかなりの部分でキャリア密度が大きい 高注入領域で動作します。 GaAs では、この準フェルミ準位分離は特に有益です。なぜなら、それは活性領域での強いキャリア注入と効率的な自由電子–自由正孔再結合に直接結びつくからです。
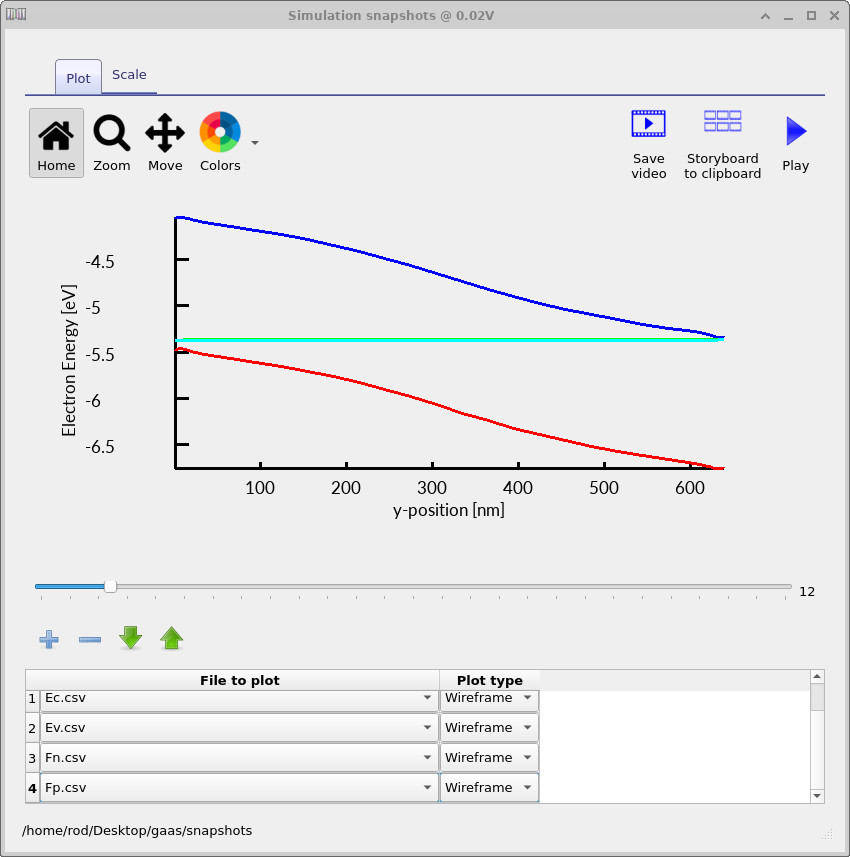
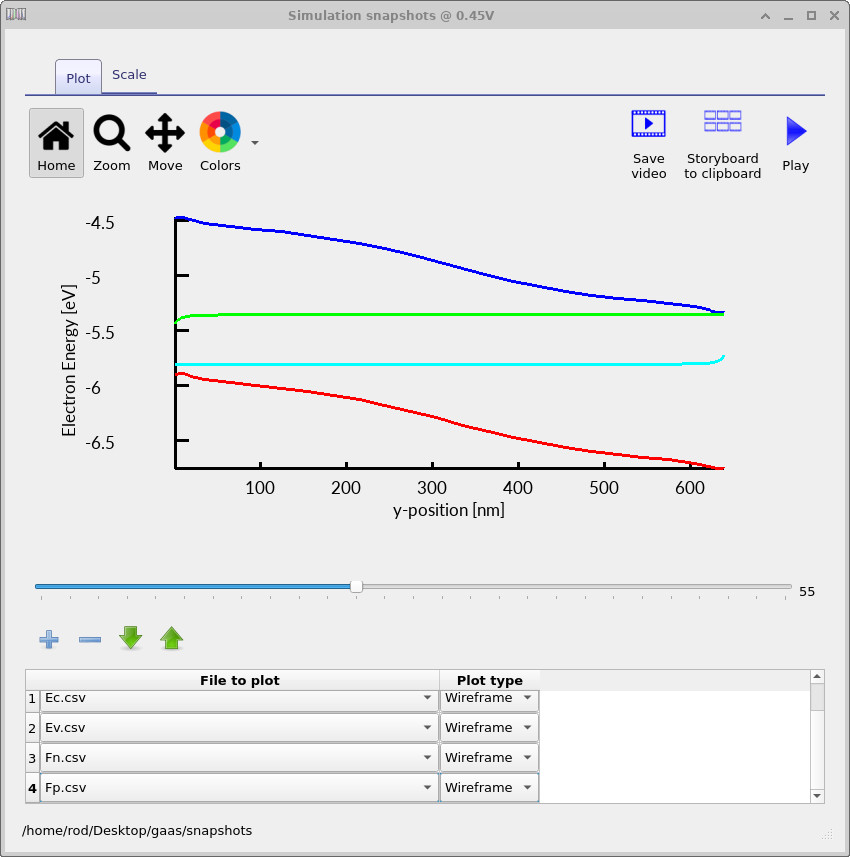

6.4 活性領域における自由電子–自由正孔(放射)再結合
自由電子–自由正孔再結合は、位置の関数として局所的な放射再結合速度を報告する
R_nfree_to_pfree.csv をプロットすることで確認できます。
GaAs では、このチャネルは通常、順方向バイアス下の活性接合で支配的な再結合機構です。
なぜなら GaAs は 直接遷移型バンドギャップ 半導体であり、放射遷移が効率的だからです。
これらのプロットを解釈するとき、最も重要なのは細かな空間構造ではなく、
再結合プロファイルの 全体形状 と、その大きさがバイアスとともにどのように変化するかです。
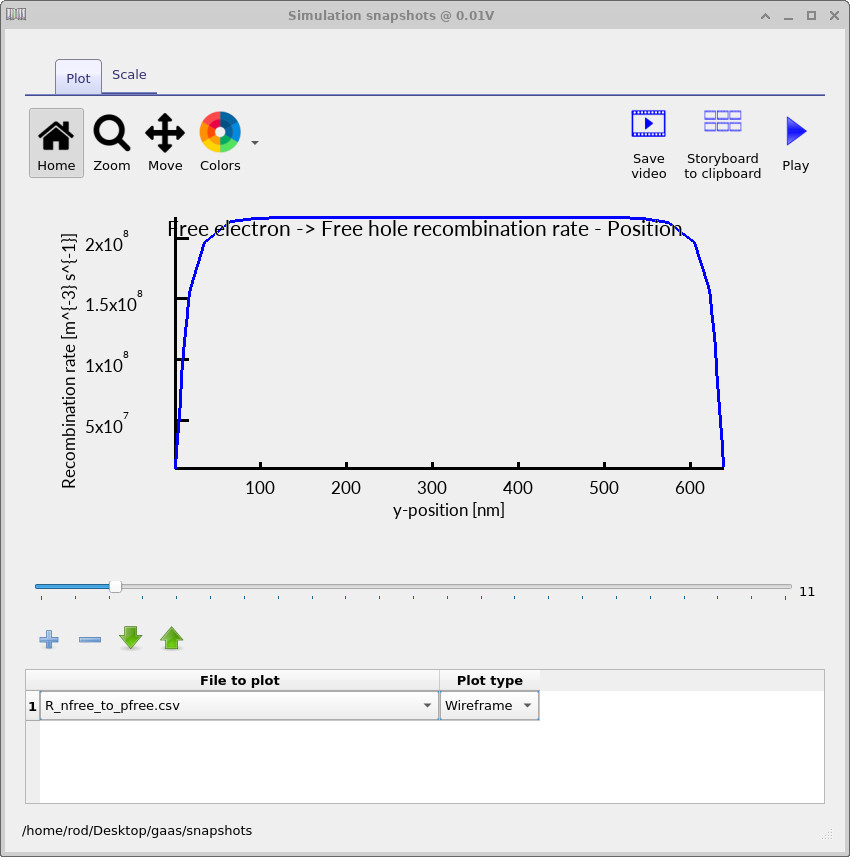
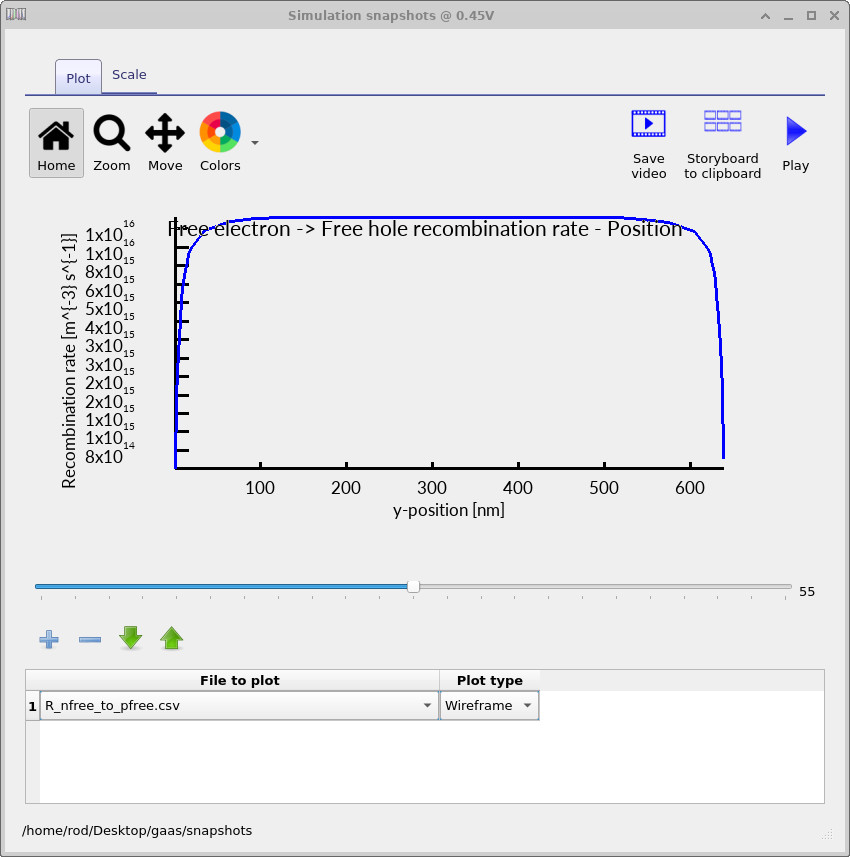
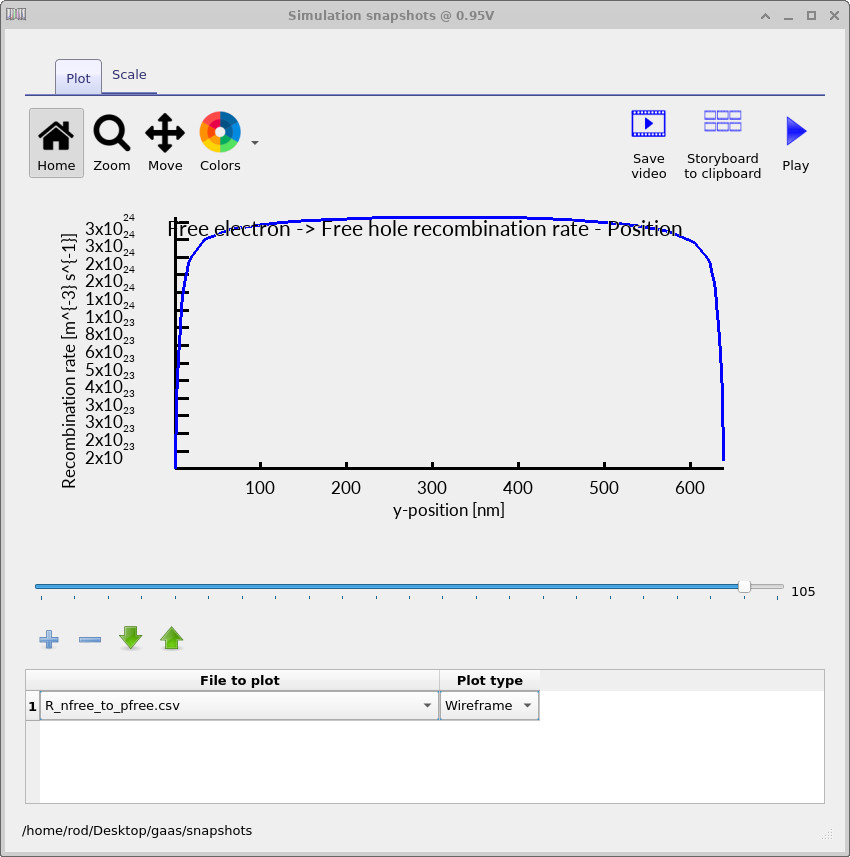
低バイアスでは(図 ??)、 デバイスは平衡に近く、キャリア積 \(np\) は \(n_i^2\) に近いままであるため、自由電子–自由正孔再結合は弱いです。 GaAs は効率的な放射遷移をサポートしますが、 大きな放射速度を駆動するのに必要なキャリア密度はまだ存在していません。
ダイオードが順方向バイアスへ駆動されると(図 ??)、 注入された電子と正孔が構造の大部分で共存するようになります。 その結果、自由電子–自由正孔再結合プロファイルは、 デバイス全体にまたがる 広く、緩やかに曲がった「帽子状」形状 を取ります。 この形状は、放射再結合が主として局所キャリア積 \(np\) に依存することを反映しており、 一旦注入が確立すると \(np\) は準中性領域全体で比較的一様になるためです。 SRH 再結合とは異なり、空乏領域への強い局在はありません。
高順バイアスでは(図 ??)、 自由電子–自由正孔再結合プロファイルの 形状 は概ね類似したままですが、 その 大きさは何桁も増加 します。 これは GaAs における放射支配再結合の重要な診断的特徴です。 すなわち、バイアスを上げることは主としてデバイス全体のキャリア密度を増加させるのであり、 再結合が起こる場所そのものを変えるのではありません。 滑らかでデバイス全体に広がるプロファイルは、 放射再結合が注入領域全体での体積過程として作用していることを示しています。
この挙動は欠陥媒介再結合とは大きく異なります。 SRH 再結合は通常、接合中心に鋭いピークを形成し、高注入時にのみ広がりますが、 GaAs における自由電子–自由正孔再結合は、 高さが — 空間的広がりではなく — 注入準位を符号化する単一の広がった再結合「ドーム」を形成します。 したがって、直接遷移型デバイスでは、この広い放射プロファイルは 高材料品質と効率的キャリア注入の指標であり、 I–V 特性を形成する再結合バランスの支配的寄与となることがよくあります。
6.2 Shockley–Read–Hall (SRH) 再結合
欠陥媒介再結合を調べるには、ダイオード内部の空間分解された
Shockley–Read–Hall 再結合速度を示す R_ss_srh.csv をプロットしてください。
以下の 3 つのプロットは、バンド図解析で用いたのと同じバイアスポイント、
すなわち −0.1 V、≈0.45 V、および 0.8 V に対応しています。
GaAs では、これらのプロットは高品質接合における支配的再結合チャネルとしてではなく、
トラップ支援損失の診断として解釈するのが最適です。
重要なのは、SRH 再結合の 空間局在 が上で見たより広い自由電子–自由正孔プロファイルとどう比較されるかです。
−0.1 V では(図 ??)、 ダイオードは平衡に近い状態です。 電子は n 型側で支配的であり、正孔は p 型側で支配的であるため、 有意な SRH 再結合は、両キャリアが同時に存在する接合近傍の狭い領域でしか起こりません。 その結果、SRH 再結合速度はデバイス中央に強く局在し、 空乏領域と一致します。≈0.45 V では(図 ??)、 順バイアスにより接合を越えてキャリアが注入され、 電子密度と正孔密度の局所積が増加します。 SRH ピークは大きく増加しますが、 依然としてデバイス中央領域に空間的に閉じ込められています。 これは、SRH が依然として 接合中心型 の損失チャネルであり、 空乏領域およびその近傍におけるキャリア重なりとトラップ活性によって制御されていることを示します。0.8 V では(図 ??)、 構造全体でキャリア注入が増加するにつれて、挙動はより広がります。 しかし、SRH が広がった場合でも、 GaAs における自由電子–自由正孔再結合が注入された準中性領域全体に分布するのに対し、 SRH は通常それよりも接合領域に強く重みづけられたままです。
2 つの再結合チャネルを比較すると、GaAs ダイオード動作の有用な内部像が得られます。 自由電子–自由正孔再結合は、一旦注入が確立すると体積的な消滅チャネルを与え、 活性デバイス体積における全再結合バランスをしばしば支配します。 一方、SRH 再結合は、トラップ支援損失がどこに集中しているか—しばしば空乏領域とその近傍—を強調し、 材料品質と界面損傷に対する高感度指標となります。 この違いは、GaAs ダイオードが強い注入と大きな電流を示しながらも、 接合部の欠陥に対して非常に敏感であり得る理由を説明する助けになります。



6.3 電子および正孔電流密度
最後に、空間分解された電子電流密度および正孔電流密度を示す
Jn.csv および Jp.csv
をプロットしてキャリア電流を確認してください。
これらのプロットは、異なるバイアス条件下で電荷がダイオードを通して
どのように輸送されるか、
そしてデバイスが平衡から
定常順方向伝導へどのように移行するかを直接示します。
−0.1 V では(図
??)、
ダイオードは平衡に近く、真の物理電流は極めて小さいです。
電子流束と正孔流束はデバイス内のどこでもほぼ釣り合っているため、
正味電流はほぼ等しい 2 つの量の差として生じます。
この領域では数値問題は本質的に悪条件であり、
電流プロファイルに小さな振動や見かけ上のノイズが現れることは予想されます。
この GaAs デモでは、その効果がより顕著に見えることがあります。すなわち、高速なキャリア輸送
(特に電子)と極めて小さい正味電流の組み合わせにより相殺問題が鋭くなり、
生の Jn/Jp トレースが、基礎物理が単に「ほぼゼロ電流」であるにもかかわらず、目に見えてノイジーに見える場合があります。≈0.45 V では(図
??)、
順バイアスが接合を越えたキャリア注入を駆動します。
電子電流は n 側で支配的、正孔電流は p 側で支配的ですが、
両電流はデバイス全体を通して連続であり、
これは定常状態の電荷保存を反映しています。
電流密度は平衡近傍の場合と比べて急速に増大しますが、
勾配が急な接合近傍では、プロファイルに小さな数値構造がまだ見られることがあります。
GaAs では、障壁が低下すると注入がすぐに確立し得るため、低電流で相殺支配の領域を
明確に抜けるまでは、電流が「落ち着いた」ように見えないことは珍しくありません。0.8 V では(図
??)、
ダイオードは深い順バイアスで動作しています。
キャリア密度は構造全体で高く、
電子電流と正孔電流の両方が大きく、より滑らかで、より一様に
準中性領域全体へ広がります。
それでも、特にソルバーが未平滑化の点ごとの電流を報告している場合、
生の電流プロファイルにいくらか残留リップルが残ることがあります。重要な診断点は、
大域的傾向が物理的に整合しており、
連続した電流フローが存在し、活性デバイス内に不自然な符号反転がないことです。
これらの電流密度プロットを総合すると、 ダイオード動作の一貫した内部像が得られます。 すなわち、平衡時の電子流束と正孔流束のほぼ完全な相殺から、 注入律速順方向伝導を経て、 大きな順方向バイアスでの高電流定常輸送への移行です。




