Diodo de Unión PN de Arseniuro de Galio (GaAs) (1D) — Drift–Diffusion (I–V en oscuridad, recombinación SRH)
1. Introducción

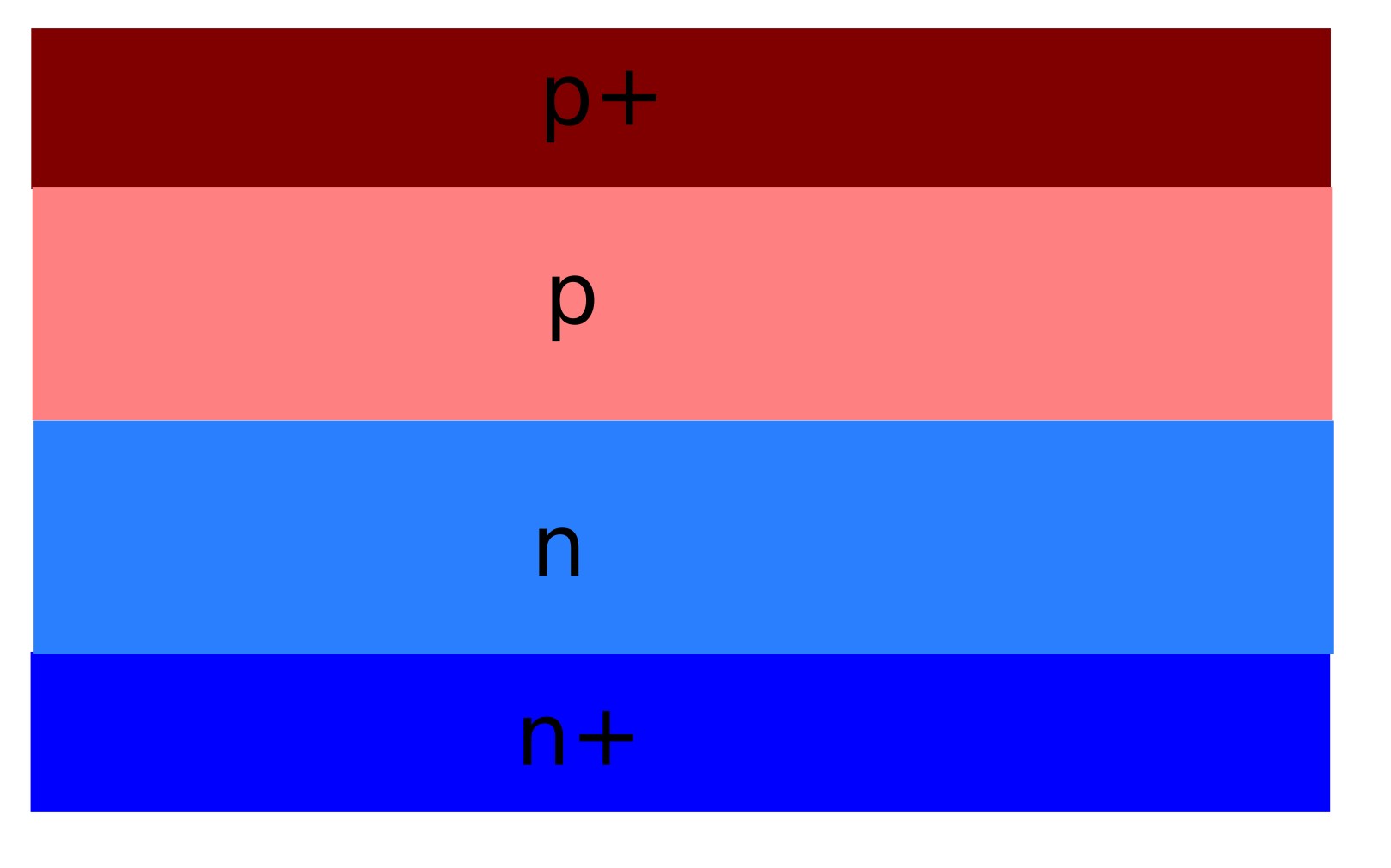
El diodo de unión PN de arseniuro de galio (GaAs) es un dispositivo semiconductor III–V fundamental. Está ampliamente integrado en circuitos integrados RF y de microondas basados en GaAs, donde uniones PN compactas soportan rectificación, polarización, protección y funciones de conmutación dentro del front-end RF. Un contexto de aplicación representativo se muestra en ??, ilustrando el tipo de plataforma GaAs a escala de chip utilizada en la electrónica moderna de alta frecuencia.
El arseniuro de galio es muy adecuado para estas aplicaciones porque su alta movilidad electrónica permite un transporte rápido de portadores y bajas pérdidas resistivas, soportando una operación eficiente a frecuencias de GHz y milimétricas utilizadas en sistemas 5G. En la práctica, uniones PN cortas como la modelada aquí aparecen a lo largo de diseños RF como elementos de polarización, clamps, diodos ESD y de protección, y estructuras de conmutación. La pila de capas de ?? refleja la geometría vertical compacta usada en chip: regiones de contacto delgadas y fuertemente dopadas emparejadas con una unión activa corta.
Aunque el dispositivo simulado en este tutorial es simple, debe entenderse como un bloque de construcción primitivo. La misma electrostática de unión gobierna estructuras conectadas como diodos, regiones de aislamiento y capas de inyección dentro de tecnologías GaAs utilizadas para electrónica de alta velocidad y optoelectrónica. La estructura de dopado en capas usada aquí se ilustra esquemáticamente en ??.
En este tutorial simulará un diodo de unión PN de GaAs en una dimensión usando el solucionador acoplado de drift–diffusion + Poisson de OghmaNano. En lugar de basarse únicamente en la ecuación ideal de Shockley, este enfoque resuelve el campo eléctrico incorporado, la región de agotamiento, y las distribuciones espaciales de densidades y corrientes de portadores.
2. Creación de una nueva simulación
Para comenzar, cree una nueva simulación desde la ventana principal de OghmaNano. Haga clic en el botón New simulation en la barra de herramientas. Esto abre el cuadro de diálogo de selección del tipo de simulación (véase ??).
En el cuadro de diálogo de tipo de simulación, haga doble clic en GaAs demos, y luego seleccione el ejemplo de unión/diodo GaAs (véase ??). OghmaNano cargará una estructura de unión GaAs predefinida que trataremos como un diodo PN.
La estructura del dispositivo cargado se muestra en la ventana principal de simulación (véase ??). Aunque el problema eléctrico resuelto en este tutorial es unidimensional, la vista 3D proporciona una visualización clara de la pila vertical de capas y de las regiones que participan en el transporte de portadores y la recombinación.
El diodo se implementa como una secuencia de capas de GaAs apiladas verticalmente, formada por una región p+ fuertemente dopada, una región p dopada más débilmente, una región n dopada débilmente, y una región n+ fuertemente dopada. Esta estructura se lista explícitamente en el Layer editor (véase ??), donde a cada capa se le asigna un espesor, material y función eléctrica.
Las capas centrales p y n forman la unión PN activa. En equilibrio, se desarrolla una región de agotamiento a través de esta interfaz, dando lugar al campo eléctrico incorporado que controla la separación y el transporte de portadores. Las capas delgadas y fuertemente dopadas p+ y n+ actúan como regiones de contacto de baja resistencia, asegurando que la polarización aplicada caiga principalmente a través de la unión y no en los contactos.
En las secciones que siguen, esta estructura será tratada como un dispositivo unidimensional: todas las variaciones se resuelven a lo largo de la dirección de crecimiento, mientras que las variaciones laterales se descuidan. A pesar de esta simplificación, el modelo captura la electrostática esencial, el transporte de portadores, y la física de recombinación que gobiernan el comportamiento I–V en oscuridad de diodos de unión PN de GaAs usados dentro de pilas prácticas de dispositivos optoelectrónicos y electrónicos de alta velocidad.


3. Examen del perfil de dopado
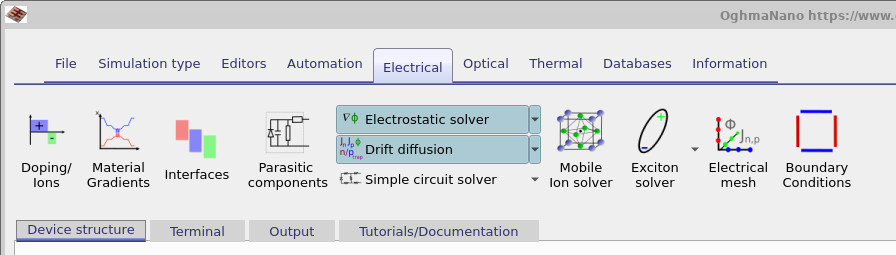
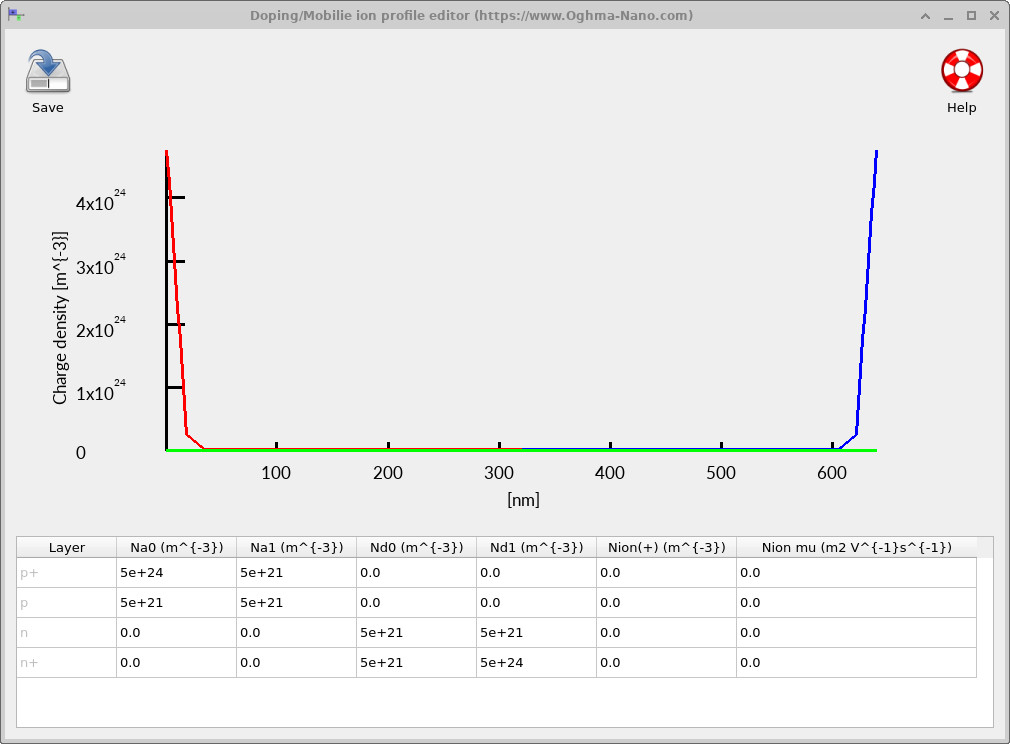
El perfil de dopado define la unión PN de GaAs y, por tanto, establece la electrostática fundamental del diodo. Determina la posición de la unión, el potencial incorporado, el ancho de agotamiento, y el campo eléctrico interno que se desarrolla en equilibrio y bajo polarización.
Para ver la configuración de dopado, abra el editor Doping / Ions desde la cinta Electrical (véase ??). El editor muestra la distribución espacial de donadores y aceptores ionizados en función de la profundidad (véase ??).
En este tutorial, el diodo se construye usando un perfil convencional de dopado GaAs p+/p/n/n+. Las regiones centrales p y n están moderadamente dopadas y forman la unión PN activa, donde se desarrollan la región de agotamiento y el campo eléctrico incorporado.
Las capas delgadas y fuertemente dopadas p+ y n+ actúan como regiones de contacto de baja resistencia. Su función es proporcionar buena inyección y extracción eléctrica de portadores, al tiempo que garantizan que la mayor parte del voltaje aplicado caiga sobre la propia unión y no en los contactos.
A los efectos de este tutorial, la comprobación clave es simplemente que el dispositivo contenga una región predominantemente dopada con aceptores y otra predominantemente dopada con donadores, con una transición clara entre ambas. Los valores numéricos exactos de las densidades de dopado afectan principalmente al ancho de agotamiento y a la intensidad del campo incorporado, que se explorarán indirectamente a través de las características I–V en oscuridad del diodo en secciones posteriores.
4. Examen de los parámetros eléctricos y de los mecanismos de recombinación
Los parámetros eléctricos del material se definen por región y controlan el transporte de portadores, la recombinación y la electrostática a lo largo del diodo. Abra el editor de parámetros eléctricos desde la ventana principal mediante Device structure → Electrical parameters. Cada capa de la pila del dispositivo tiene su propia pestaña de parámetros. En este tutorial usamos el mismo modelo de material GaAs en las cuatro regiones, pero las interpretamos de forma diferente: p+ y n+ actúan como regiones de contacto de baja resistencia, mientras que p y n forman la unión PN activa.
Las Figuras ??– ?? muestran el editor de parámetros eléctricos para cada región (p+, p, n, n+). Para GaAs, los parámetros más llamativos de inmediato son las movilidades de portadores: la movilidad electrónica es alta en comparación con el silicio, mientras que la movilidad de huecos es más modesta. Esta asimetría es una característica definitoria del GaAs y sustenta su uso generalizado en electrónica de alta frecuencia.
Debido a que el transporte de portadores en GaAs suele ser rápido, especialmente para electrones, el comportamiento I–V en oscuridad de una unión PN de GaAs a menudo no está limitado por el transporte volumétrico. En su lugar, el equilibrio entre inyección, electrostática y recombinación determina la respuesta del dispositivo. Por tanto, los parámetros mostrados en el editor controlan principalmente cuán eficientemente se eliminan los portadores inyectados mediante procesos de recombinación una vez que la barrera de la unión se reduce.
Las densidades efectivas de estados mostradas en el editor (por ejemplo ??) establecen la estadística de portadores y las concentraciones de portadores en equilibrio para el GaAs. Estos valores difieren de los del silicio debido a la diferente estructura de bandas y masas efectivas del GaAs, e influyen directamente tanto en los niveles de inyección de portadores como en las tasas de recombinación a través de las densidades de electrones \(n\) y huecos \(p\).




Recombinación libre-a-libre (radiativa)
Debido a que el GaAs es un semiconductor de banda prohibida directa, la recombinación entre electrones libres y huecos libres puede ocurrir eficientemente mediante transiciones radiativas. En GaAs de alta calidad, este canal de recombinación libre-a-libre es a menudo el mecanismo de pérdida dominante en la unión activa bajo polarización directa. En OghmaNano, este proceso está controlado por la constante de tasa de recombinación de electrón libre a hueco libre visible en el editor de parámetros eléctricos (véase, por ejemplo, ??).
La tasa de recombinación correspondiente tiene la forma
\[ R_{\mathrm{rad}} = B \left( np - n_i^2 \right), \]donde \(B\) es el coeficiente de recombinación libre-a-libre (radiativa). En GaAs, este término puede dominar el equilibrio de recombinación una vez que los portadores se inyectan en la unión, particularmente cuando las densidades de defectos son bajas. Como resultado, la característica I–V en oscuridad de un diodo de GaAs de alta calidad a menudo refleja la física de recombinación radiativa en lugar de un comportamiento limitado por defectos.
Recombinación Shockley–Read–Hall (SRH)
La recombinación Shockley–Read–Hall (SRH) captura la recombinación mediada por defectos a través de estados electrónicos en la banda prohibida. En OghmaNano esto se controla usando los parámetros de equilibrium SRH trap mostrados en el editor (véase ??): una energía de trampa \(E_t\) (relativa al centro de la banda prohibida), una densidad de trampas \(N_t\), y secciones eficaces de captura de electrones y huecos \(\sigma_n\) y \(\sigma_p\).
En GaAs, la recombinación SRH no suele representar el límite intrínseco de recombinación del material. En cambio, proporciona una medida de la calidad del material y de la densidad de defectos. En GaAs epitaxial de alta calidad, la recombinación SRH es débil y domina la recombinación radiativa; en material de menor calidad o cerca de interfaces y daños de procesado, la recombinación SRH puede volverse significativa.
Los tiempos de vida SRH están definidos por
\[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \]y la tasa de recombinación resultante es
\[ R_{\mathrm{SRH}} = \frac{np - n_i^2} {\tau_p (n + n_1) + \tau_n (p + p_1)} . \]En este tutorial, la recombinación SRH se mantiene deliberadamente. Le permite explorar cómo el aumento de la densidad de defectos o la reducción del tiempo de vida de portadores desplaza el diodo desde un comportamiento dominado por recombinación radiativa hacia una operación limitada por recombinación, lo cual es particularmente relevante para comprender dispositivos reales donde el procesado y las interfaces desempeñan un papel crítico.
Electrostática y parámetros de banda
Finalmente, los parámetros de estructura de bandas y electrostáticos usados para definir el GaAs son visibles en cada pestaña de región (por ejemplo ??): la afinidad electrónica, la banda prohibida (\(E_g \approx 1.42\,\mathrm{eV}\) a temperatura ambiente), y la permitividad relativa (\(\varepsilon_r \approx 12.9\)). Estos parámetros establecen el potencial incorporado de la unión PN y determinan la escala de voltaje sobre la que se produce una inyección significativa de portadores.
Para el GaAs, la combinación de banda prohibida directa y alta movilidad de portadores significa que, una vez que se reduce la barrera de la unión, los portadores se inyectan eficientemente y la física de recombinación se convierte en el factor dominante que da forma a la curva I–V en oscuridad. Comprender cómo trabajan conjuntamente estos parámetros eléctricos es por tanto esencial para interpretar tanto los resultados de la simulación como el comportamiento real de dispositivos GaAs.
5. Ejecución de la simulación, curvas I–V en oscuridad y extracción de parámetros
Una vez definidos la estructura del dispositivo, el perfil de dopado y los parámetros eléctricos, la simulación del diodo puede ejecutarse directamente desde la ventana principal. Haga clic en Run simulation para iniciar el solucionador. Durante la ejecución, la información de convergencia para cada punto de polarización se escribe en el terminal, permitiéndole supervisar la estabilidad del solucionador y el progreso (véase ??).


jv.csv es el resultado principal de interés.
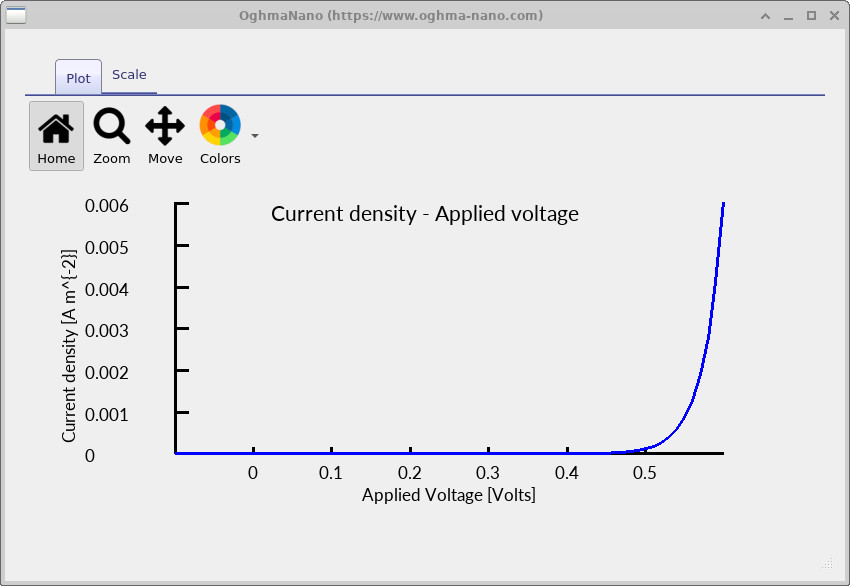
Para inspeccionar la característica del diodo, abra la pestaña Output y haga doble clic en
jv.csv
(véase ??).
Para un diodo de GaAs configurado correctamente, la curva I–V debe ser suave y monótona.
En polarización inversa, la corriente permanece pequeña y débilmente dependiente del voltaje,
reflejando una saturación limitada por recombinación.
En polarización directa, la corriente aumenta rápidamente con el voltaje aplicado,
correspondiendo a la inyección de portadores a través de la unión PN.
La forma de la región de polarización directa contiene información física útil. En una gráfica semilogarítmica, la pendiente de la región exponencial puede usarse para extraer un factor de idealidad, que indica si la corriente está dominada por transporte limitado por difusión (\(n \approx 1\)) o por procesos limitados por recombinación (\(n \approx 2\)). La intersección extrapolada de esta región proporciona una estimación de la corriente de saturación inversa, que está directamente vinculada a los parámetros de recombinación SRH y Auger discutidos en la Sección 4. En GaAs, la banda prohibida directa y las movilidades típicamente altas significan que la inyección puede ser muy eficiente, por lo que los ajustes de recombinación a menudo tienen una firma particularmente clara en la pendiente e intersección en polarización directa.
Como regla práctica, inspeccione siempre la curva I–V antes de interpretar cualquier magnitud derivada. Discontinuidades, convenciones de signo inesperadas o saltos no físicos en la corriente suelen indicar problemas con las condiciones de contorno, el paso de polarización, los ajustes de recombinación o la convergencia del solucionador. Para un diodo PN simple de GaAs como este, la curva I–V en oscuridad debe ser físicamente intuitiva y fácil de interpretar.
6. Examen de snapshots de la simulación: bandas, recombinación y flujo de corriente
Durante un barrido I–V, OghmaNano almacena la solución interna de las ecuaciones de drift–diffusion en cada punto de polarización en el directorio snapshots. Estos archivos exponen lo que el solucionador está prediciendo dentro del diodo: curvatura de bandas, separación de niveles cuasi-Fermi, actividad de recombinación y transporte de corriente. Examinar estas magnitudes es esencial para entender por qué surge una determinada característica I–V.
En esta sección inspeccionamos tres puntos de polarización representativos: una polarización inversa cercana al equilibrio (−0.1 V), una polarización directa moderada cerca del encendido (≈0.45 V), y una polarización directa alta (0.8 V). En conjunto, estos snapshots ilustran la transición desde el equilibrio, pasando por el transporte limitado por inyección, hasta la operación en alta inyección. Para el GaAs, se mantiene la misma transición cualitativa, mientras que el canal de recombinación dominante en la región activa suele ser libre-a-libre (radiativo) en lugar de SRH limitado por defectos.
6.1 Bordes de banda y niveles cuasi-Fermi
Para reproducir los diagramas de bandas, abra el visor de snapshots y añada los archivos
Ec.csv, Ev.csv, Fn.csv, y Fp.csv.
Estos corresponden al borde de la banda de conducción, el borde de la banda de valencia,
el nivel cuasi-Fermi de electrones y el nivel cuasi-Fermi de huecos respectivamente.
A −0.1 V (Figura ??), el diodo está cerca del equilibrio. La curvatura de bandas refleja el potencial incorporado impuesto por el perfil de dopado, y los niveles cuasi-Fermi son casi planos y coincidentes, lo que indica un flujo de corriente neta despreciable. La región de agotamiento es claramente visible como la región de fuerte curvatura de bandas en la unión. A ≈0.45 V (Figura ??), la polarización directa reduce la barrera de la unión. Los niveles cuasi-Fermi de electrones y huecos se separan a través de la región de agotamiento, lo cual es la firma interna de la inyección de portadores. Esta separación de niveles cuasi-Fermi es directamente responsable del aumento exponencial de la corriente observado en la curva I–V. A 0.8 V (Figura ??), la unión está profundamente en polarización directa. La barrera está fuertemente suprimida, los niveles cuasi-Fermi están ampliamente separados, y el dispositivo opera en un régimen de alta inyección donde las densidades de portadores son grandes en gran parte de la estructura. En GaAs, esta separación cuasi-Fermi es particularmente informativa porque está directamente vinculada a una fuerte inyección de portadores y a una recombinación libre-a-libre eficiente en la región activa.
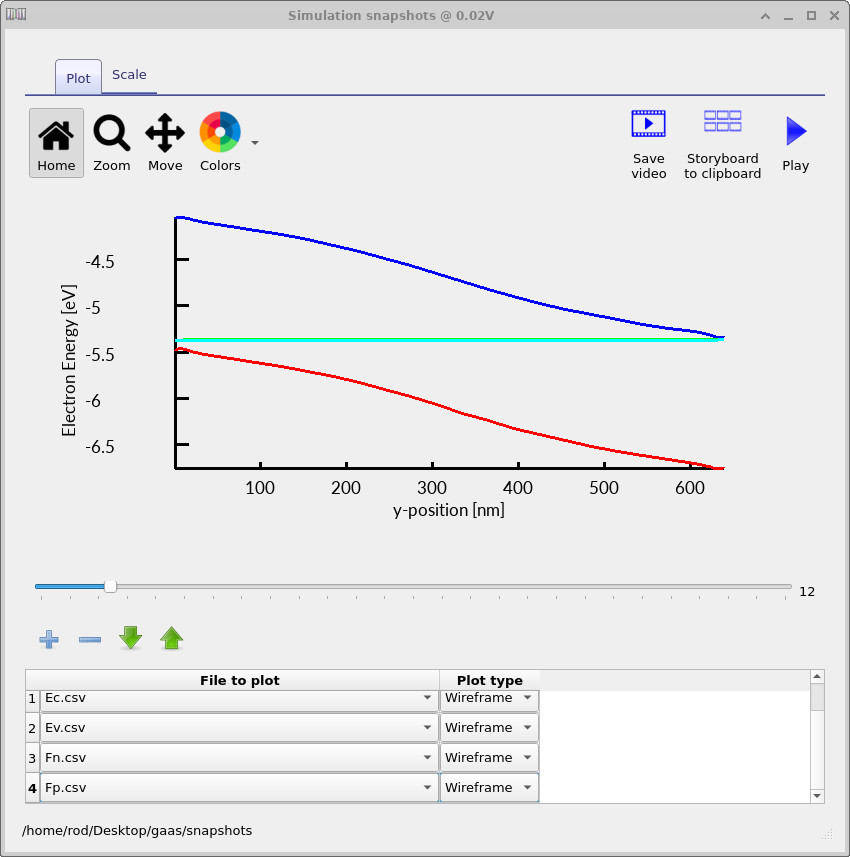
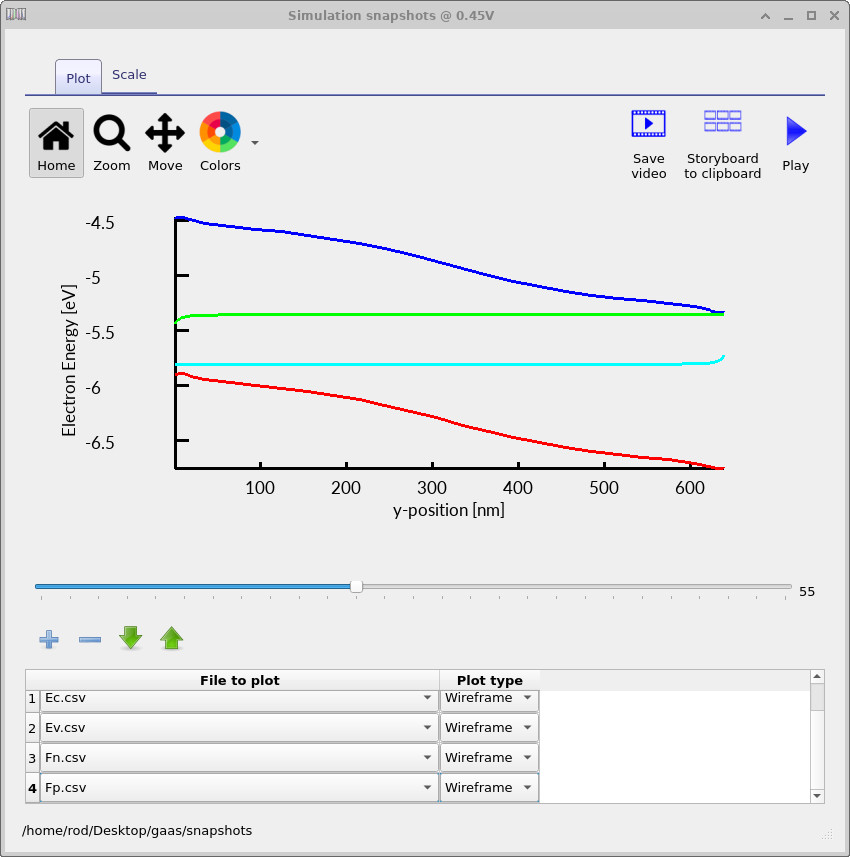

6.4 Recombinación libre-a-libre (radiativa) en la región activa
La recombinación libre-a-libre puede examinarse graficando R_nfree_to_pfree.csv,
que informa la tasa local de recombinación radiativa en función de la posición.
En GaAs, este canal suele ser el mecanismo de recombinación dominante en la unión activa bajo polarización directa,
porque el GaAs es un semiconductor de banda prohibida directa y las transiciones radiativas son eficientes.
Al interpretar estas gráficas, la característica más importante no es la estructura espacial fina,
sino la forma global del perfil de recombinación y cómo evoluciona su magnitud con la polarización.
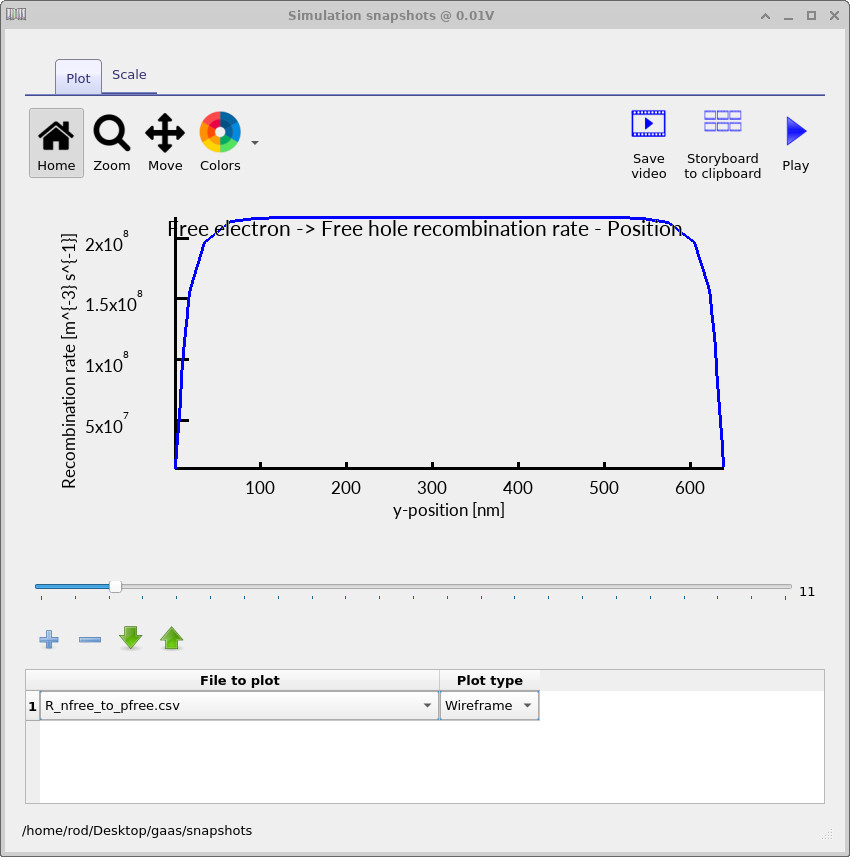
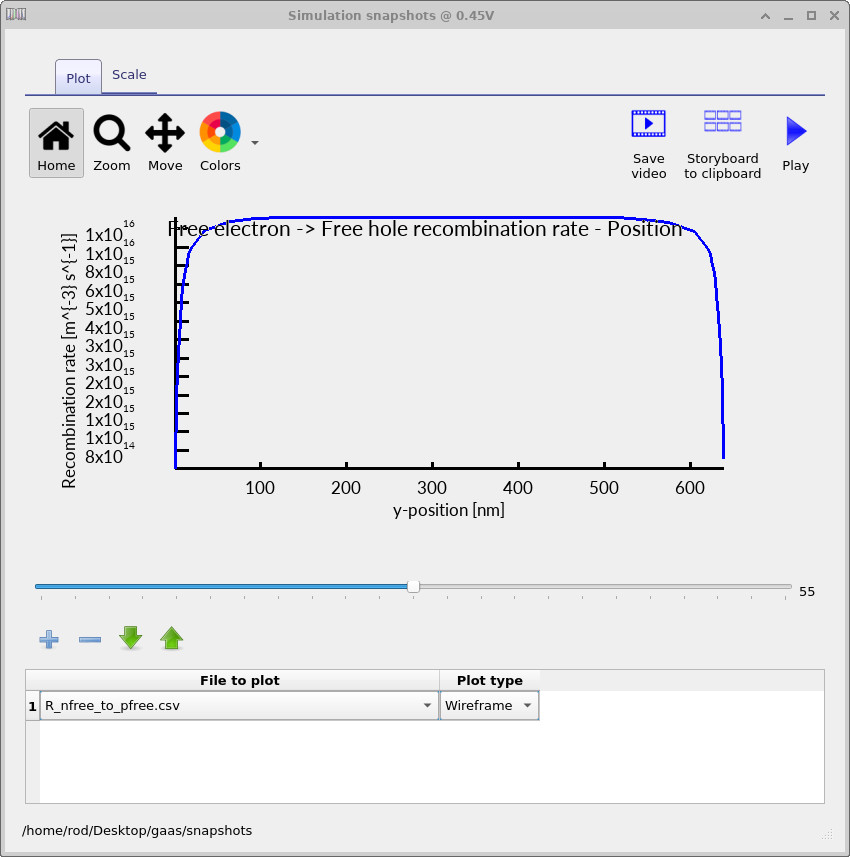
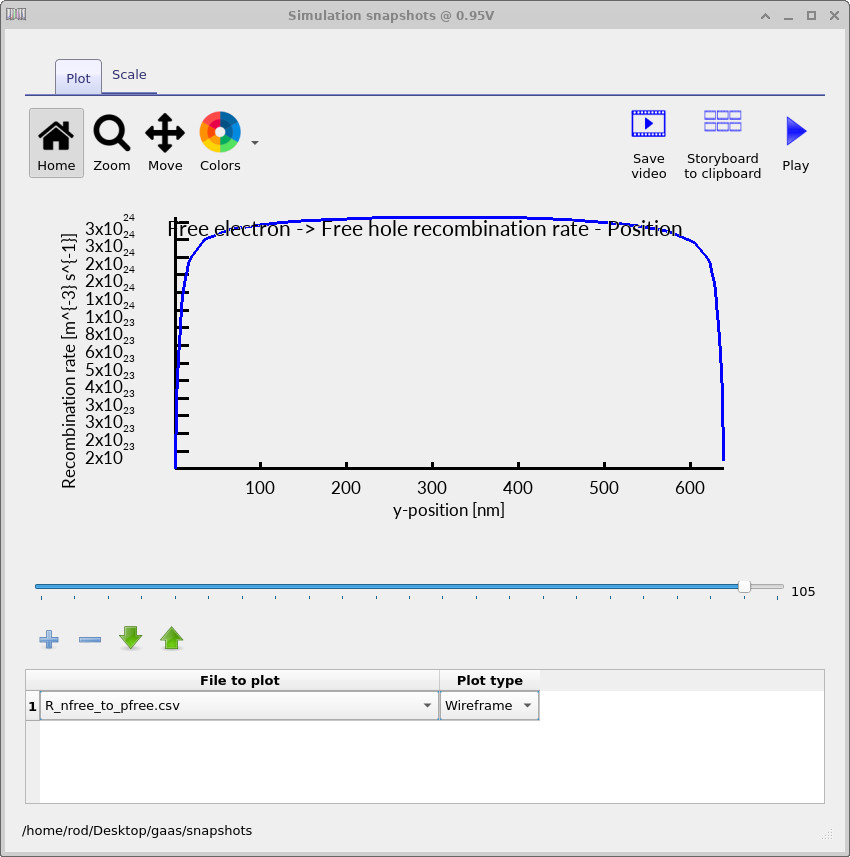
A polarización muy baja (Figura ??), la recombinación libre-a-libre es débil porque el dispositivo está cerca del equilibrio y el producto de portadores \(np\) permanece cercano a \(n_i^2\). Aunque el GaAs soporta transiciones radiativas eficientes, las densidades de portadores requeridas para impulsar una gran tasa radiativa aún no están presentes.
A medida que el diodo se lleva a polarización directa (Figura ??), electrones y huecos inyectados coexisten a través de la mayor parte de la estructura. El perfil resultante de recombinación libre-a-libre adopta una forma amplia, suavemente curvada, tipo “cúpula” que se extiende sobre casi todo el dispositivo. Esta forma refleja el hecho de que la recombinación radiativa depende principalmente del producto local de portadores \(np\), que es relativamente uniforme a lo largo de las regiones cuasi-neutras una vez establecida la inyección. A diferencia de la recombinación SRH, no existe una fuerte localización en la región de agotamiento.
A alta polarización directa (Figura ??), la forma del perfil de recombinación libre-a-libre permanece ampliamente similar, mientras que su magnitud aumenta en muchos órdenes de magnitud. Esta es una característica diagnóstica clave de la recombinación dominada por radiación en GaAs: aumentar la polarización eleva principalmente las densidades de portadores en todas partes, en lugar de cambiar dónde ocurre la recombinación. El perfil suave que abarca todo el dispositivo indica que la recombinación radiativa actúa como un proceso de volumen a lo largo de las regiones inyectadas.
Este comportamiento contrasta fuertemente con la recombinación mediada por defectos. La recombinación SRH suele producir picos estrechos centrados en la unión que solo se ensanchan a alta inyección, mientras que la recombinación libre-a-libre en GaAs produce una única “cúpula” de recombinación extendida cuya altura —y no su extensión espacial— codifica el nivel de inyección. En dispositivos de banda prohibida directa, este amplio perfil radiativo es por tanto una firma de alta calidad del material e inyección eficiente de portadores, y a menudo proporciona la contribución dominante al equilibrio de recombinación que da forma a la característica I–V.
6.2 Recombinación Shockley–Read–Hall
Para examinar la recombinación mediada por defectos, grafique R_ss_srh.csv, que muestra la tasa de recombinación
Shockley–Read–Hall resuelta espacialmente dentro del diodo.
Las tres gráficas de abajo corresponden a los mismos puntos de polarización utilizados en el análisis de diagramas de bandas:
−0.1 V, ≈0.45 V y 0.8 V.
Para el GaAs, estas gráficas se interpretan mejor como un diagnóstico de pérdida asistida por trampas más que como el canal de recombinación dominante en una unión de alta calidad.
El punto clave en el que centrarse es cómo la localización espacial de la recombinación SRH se compara con el perfil libre-a-libre más amplio mostrado arriba.
A −0.1 V (Figura ??), el diodo está cerca del equilibrio. Los electrones dominan el lado tipo n y los huecos dominan el lado tipo p, por lo que una recombinación SRH significativa solo puede ocurrir en la estrecha región alrededor de la unión donde ambos tipos de portadores están presentes simultáneamente. Como resultado, la tasa de recombinación SRH está fuertemente localizada en el centro del dispositivo, coincidiendo con la región de agotamiento. A ≈0.45 V (Figura ??), la polarización directa inyecta portadores a través de la unión y aumenta el producto local de densidades de electrones y huecos. El pico SRH crece sustancialmente en magnitud, pero permanece espacialmente confinado a la región central del dispositivo. Esto indica que la SRH sigue siendo un canal de pérdida centrado en la unión, controlado por el solapamiento de portadores y la actividad de trampas en y cerca de la región de agotamiento. A 0.8 V (Figura ??), el comportamiento se ensancha a medida que aumenta la inyección de portadores a lo largo de la estructura. Sin embargo, incluso cuando la SRH se extiende, normalmente sigue estando más fuertemente ponderada hacia la región de la unión que la recombinación libre-a-libre, que tiende a distribuirse a través de las regiones cuasi-neutras inyectadas en GaAs.
Comparar los dos canales de recombinación proporciona una imagen interna útil del funcionamiento del diodo de GaAs. La recombinación libre-a-libre proporciona un sumidero volumétrico una vez establecida la inyección, y comúnmente domina el equilibrio total de recombinación en el volumen activo del dispositivo. La recombinación SRH, por el contrario, pone de relieve dónde se concentra la pérdida asistida por trampas—a menudo en y cerca de la región de agotamiento—lo que la convierte en un indicador sensible de la calidad del material y del daño interfacial. Esta distinción ayuda a explicar por qué los diodos de GaAs pueden mostrar una inyección fuerte y corrientes grandes, y seguir siendo al mismo tiempo muy sensibles a defectos en la unión.



6.3 Densidades de corriente de electrones y huecos
Por último, inspeccione las corrientes de portadores graficando Jn.csv y Jp.csv,
que muestran respectivamente las densidades de corriente de electrones y huecos resueltas espacialmente.
Estas gráficas proporcionan una visión directa de cómo se transporta la carga a través del diodo
bajo distintas condiciones de polarización y de cómo el dispositivo transita desde el equilibrio
a la conducción estacionaria en polarización directa.
A −0.1 V (Figura
??),
el diodo está cerca del equilibrio y la corriente física real es extremadamente pequeña.
Los flujos de electrones y huecos están casi equilibrados en todas partes del dispositivo,
por lo que la corriente neta surge de la diferencia entre dos cantidades casi iguales.
En este régimen, el problema numérico está intrínsecamente mal condicionado,
y son esperables pequeñas oscilaciones o ruido aparente en los perfiles de corriente.
En esta demostración de GaAs el efecto puede parecer más pronunciado: la combinación de transporte muy rápido de portadores
(especialmente para electrones) y corriente neta extremadamente pequeña agudiza el problema de cancelación,
por lo que las trazas crudas de Jn/Jp pueden parecer visiblemente ruidosas aunque la física subyacente sea simplemente “corriente casi nula”. A ≈0.45 V (Figura
??),
la polarización directa impulsa la inyección de portadores a través de la unión.
La corriente electrónica domina en el lado n y la corriente de huecos domina en el lado p,
pero ambas corrientes son continuas a través del dispositivo,
reflejando la conservación de carga en estado estacionario.
La densidad de corriente aumenta rápidamente en comparación con el caso cercano al equilibrio,
aunque los perfiles todavía pueden mostrar pequeña estructura numérica cerca de la unión donde los gradientes son pronunciados.
En GaAs, donde la inyección puede establecerse rápidamente una vez reducida la barrera, es común ver que las corrientes “se estabilizan”
solo después de que el dispositivo haya salido claramente del régimen de baja corriente dominado por cancelación. A 0.8 V (Figura
??),
el diodo opera profundamente en polarización directa.
Las densidades de portadores son altas a través de toda la estructura,
y tanto las corrientes de electrones como de huecos se vuelven grandes, más suaves y más uniformes
a lo largo de las regiones cuasi-neutras.
Incluso aquí, las simulaciones de GaAs pueden conservar algo de ondulación residual en los perfiles de corriente crudos,
particularmente si el solucionador informa corrientes puntuales sin filtrar; el diagnóstico clave es que la tendencia a gran escala sea físicamente consistente,
con flujo continuo de corriente y sin inversiones espurias de signo a través del dispositivo activo.
En conjunto, estas gráficas de densidad de corriente proporcionan una imagen interna coherente del funcionamiento del diodo: desde la cancelación casi perfecta de los flujos de electrones y huecos en equilibrio, pasando por la conducción directa limitada por inyección, hasta el transporte estacionario de alta corriente a gran polarización directa.




