갈륨 비소(GaAs) PN 접합 다이오드(1D) — 드리프트–확산(암 I–V, SRH 재결합)
1. 소개

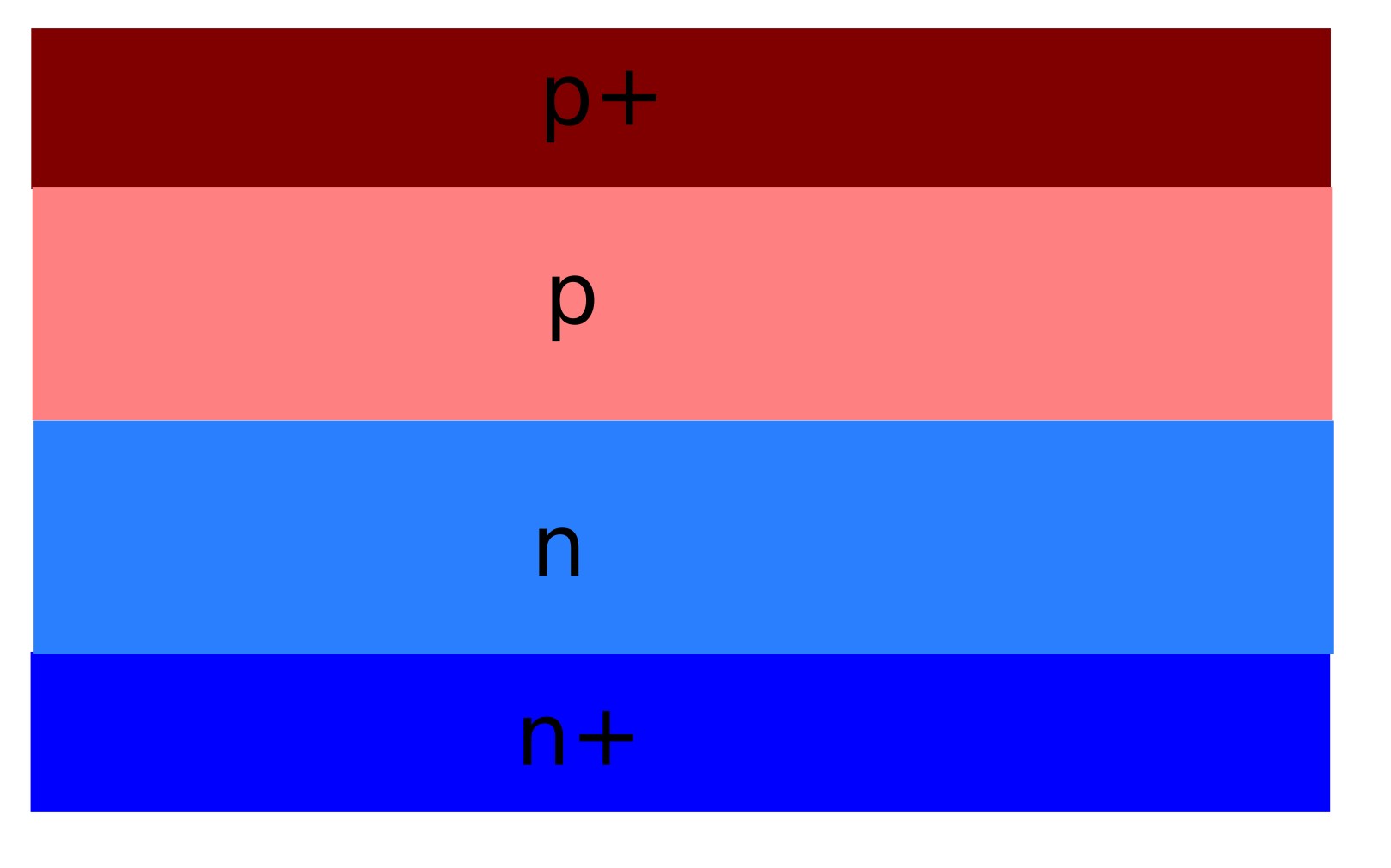
갈륨 비소(GaAs) PN 접합 다이오드는 기본적인 III–V 반도체 소자입니다. 이는 소형 PN 접합이 RF 프런트엔드 내에서 정류, 바이어싱, 보호 및 스위칭 기능을 지원하는 GaAs RF 및 마이크로파 집적 회로에 널리 집적됩니다. 대표적인 응용 맥락은 ??에 제시되어 있으며, 현대 고주파 전자소자에 사용되는 GaAs 칩 스케일 플랫폼의 유형을 보여줍니다.
갈륨 비소는 높은 전자 이동도로 인해 이러한 응용에 매우 적합하며, 이는 빠른 캐리어 수송과 낮은 저항 손실을 가능하게 하여 5G 시스템에 사용되는 GHz 및 밀리미터파 주파수에서의 효율적인 동작을 지원합니다. 실제로 여기서 모델링한 것과 같은 짧은 PN 접합은 바이어스 소자, 클램프, ESD 및 보호 다이오드, 스위칭 구조로서 RF 설계 전반에 걸쳐 사용됩니다. ??의 층 구조는 칩 상에서 사용되는 소형 수직 기하를 반영하며, 얇고 고농도로 도핑된 접촉 영역과 짧은 활성 접합이 결합되어 있습니다.
이 튜토리얼에서 시뮬레이션하는 소자는 단순하지만, 기본 구성 블록으로 이해해야 합니다. 동일한 접합 정전기학이 고속 전자 및 광전자용 GaAs 기술에 사용되는 다이오드 연결 구조, 절연 영역, 주입 층을 지배합니다. 여기서 사용한 층상 도핑 구조는 ??에 개략적으로 도시되어 있습니다.
이 튜토리얼에서는 OghmaNano의 결합된 드리프트–확산 + Poisson 해석기를 사용하여 1차원의 GaAs PN 접합 다이오드를 시뮬레이션합니다. 이상적인 Shockley 방정식에만 의존하는 대신, 이 접근법은 내장 전기장, 공핍 영역, 그리고 캐리어 밀도와 전류의 공간 분포를 해석합니다.
2. 새 시뮬레이션 만들기
시작하려면 OghmaNano 메인 창에서 새 시뮬레이션을 생성합니다. 툴바에서 New simulation 버튼을 클릭합니다. 그러면 시뮬레이션 유형 선택 대화상자가 열립니다 (?? 참조).
시뮬레이션 유형 대화상자에서 GaAs demos를 더블클릭한 다음, GaAs 접합/다이오드 예제를 선택합니다 (?? 참조). OghmaNano는 미리 정의된 GaAs 접합 구조를 로드하며, 이를 PN 다이오드로 취급할 것입니다.
로드된 소자 구조는 메인 시뮬레이션 창에 표시됩니다 (?? 참조). 이 튜토리얼에서 푸는 전기적 문제는 1차원이지만, 3D 뷰는 수직 층 구조와 캐리어 수송 및 재결합에 참여하는 영역을 명확하게 시각화해 줍니다.
다이오드는 수직으로 적층된 일련의 GaAs 층으로 구현되며, 고농도로 도핑된 p+ 영역, 더 낮게 도핑된 p 영역, 낮게 도핑된 n 영역, 그리고 고농도로 도핑된 n+ 영역으로 구성됩니다. 이 구조는 Layer editor에 명시적으로 나열되어 있으며 (?? 참조), 각 층에는 두께, 재료, 전기적 역할이 지정됩니다.
중심의 p 및 n 층이 활성 PN 접합을 형성합니다. 평형 상태에서 이 계면을 가로질러 공핍 영역이 형성되며, 이에 따라 캐리어 분리와 수송을 제어하는 내장 전기장이 발생합니다. 얇고 고농도로 도핑된 p+ 및 n+ 층은 저저항 접촉 영역으로 작용하여 인가 전압이 접촉부가 아니라 주로 접합에 걸리도록 합니다.
이후 섹션에서는 이 구조를 1차원 소자로 취급합니다. 즉, 모든 변화는 성장 방향을 따라 해석되며, 측면 방향 변화는 무시됩니다. 이러한 단순화에도 불구하고, 모델은 실제 광전자 및 고속 전자 소자 스택에 사용되는 GaAs PN 접합 다이오드의 암 I–V 거동을 지배하는 핵심 정전기학, 캐리어 수송, 및 재결합 물리를 포착합니다.


3. 도핑 프로파일 살펴보기
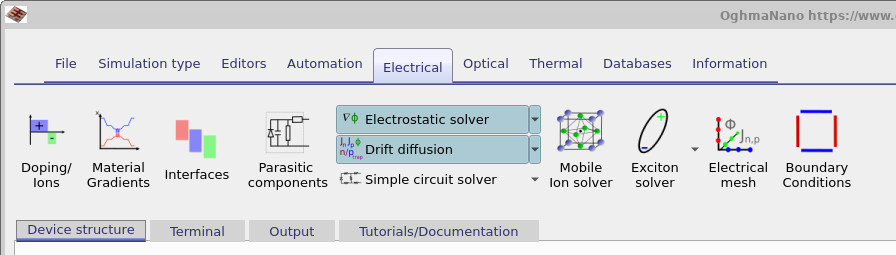
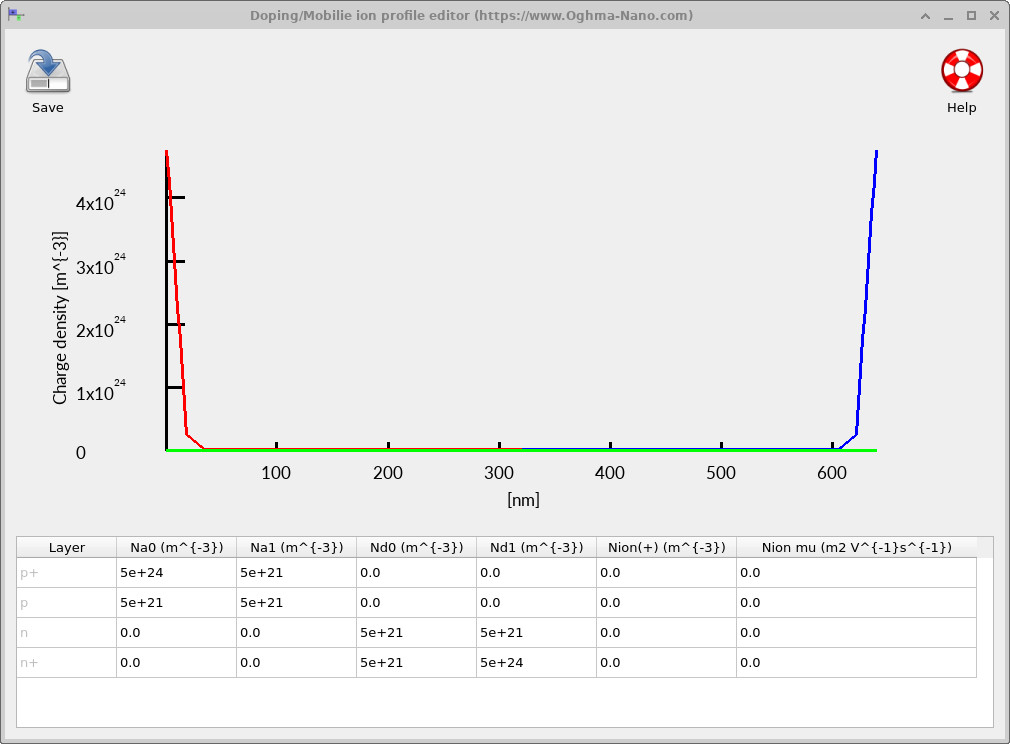
도핑 프로파일은 GaAs PN 접합을 정의하므로 다이오드의 기본 정전기학을 결정합니다. 이는 접합 위치, 내장 전위, 공핍 폭, 그리고 평형 및 바이어스 하에서 형성되는 내부 전기장을 결정합니다.
도핑 구성을 보려면 Electrical 리본에서 Doping / Ions 편집기를 엽니다 (?? 참조). 편집기는 깊이의 함수로서 이온화된 도너와 억셉터의 공간 분포를 표시합니다 (?? 참조).
이 튜토리얼에서 다이오드는 전통적인 p+/p/n/n+ GaAs 도핑 프로파일을 사용하여 구성됩니다. 중심의 p 및 n 영역은 중간 정도로 도핑되어 활성 PN 접합을 형성하며, 여기에서 공핍 영역과 내장 전기장이 형성됩니다.
얇고 고농도로 도핑된 p+ 및 n+ 층은 저저항 접촉 영역으로 작용합니다. 이들의 역할은 캐리어의 전기적 주입과 추출을 원활하게 제공하면서, 인가 전압의 대부분이 접촉부가 아니라 접합 자체에 걸리도록 하는 것입니다.
이 튜토리얼의 목적상 핵심 점검 사항은 단순히 소자에 하나의 주된 억셉터 도핑 영역과 하나의 주된 도너 도핑 영역이 있고, 그 사이에 명확한 전이가 존재하는지입니다. 정확한 수치적 도핑 밀도 값은 주로 공핍 폭과 내장 전계 세기에 영향을 미치며, 이는 이후 섹션에서 다이오드의 암 I–V 특성을 통해 간접적으로 탐구됩니다.
4. 전기적 파라미터와 재결합 메커니즘 살펴보기
전기적 재료 파라미터는 영역별로 정의되며 다이오드 전체에서 캐리어 수송, 재결합, 정전기학을 제어합니다. 메인 창에서 Device structure → Electrical parameters를 통해 전기적 파라미터 편집기를 엽니다. 소자 스택의 각 층은 고유한 파라미터 탭을 가집니다. 이 튜토리얼에서는 네 영역 모두에 동일한 GaAs 재료 모델을 사용하지만, 이를 다르게 해석합니다. p+ 및 n+는 저저항 접촉 영역으로 작용하고, p 및 n은 활성 PN 접합을 형성합니다.
그림 ??– ??는 각 영역 (p+, p, n, n+)의 전기적 파라미터 편집기를 보여줍니다. GaAs에서 가장 눈에 띄는 파라미터는 캐리어 이동도입니다. 전자 이동도는 실리콘에 비해 높고, 정공 이동도는 더 낮은 편입니다. 이러한 비대칭성은 GaAs의 정의적인 특징이며, 고주파 전자소자에서 널리 사용되는 이유입니다.
GaAs에서 캐리어 수송은 일반적으로, 특히 전자에 대해, 빠르기 때문에 GaAs PN 접합의 암 I–V 거동은 흔히 벌크 수송에 의해 제한되지 않습니다. 대신, 주입, 정전기학, 재결합의 균형이 소자 응답을 결정합니다. 따라서 편집기에 표시된 파라미터는 접합 장벽이 낮아졌을 때 주입된 캐리어가 재결합 과정에 의해 얼마나 효율적으로 제거되는지를 주로 제어합니다.
편집기에 표시된 유효 상태 밀도 (예: ??)는 GaAs의 캐리어 통계와 평형 캐리어 농도를 설정합니다. 이 값들은 GaAs의 서로 다른 밴드 구조와 유효 질량 때문에 실리콘과 다르며, 전자 및 정공 밀도 \(n\)과 \(p\)를 통해 캐리어 주입 수준과 재결합 속도에 직접적으로 영향을 미칩니다.




자유 캐리어 간(복사) 재결합
GaAs는 직접 천이형 밴드갭 반도체이므로 자유 전자와 자유 정공 사이의 재결합이 복사 전이를 통해 효율적으로 일어날 수 있습니다. 고품질 GaAs에서는 이 자유 캐리어 간 재결합 경로가 순방향 바이어스 하에서 활성 접합의 지배적인 손실 메커니즘인 경우가 많습니다. OghmaNano에서 이 과정은 전기적 파라미터 편집기에서 보이는 자유 전자–자유 정공 재결합 속도 상수로 제어됩니다 (예를 들어, ?? 참조).
이에 대응하는 재결합 속도는 다음과 같은 형태를 가집니다.
\[ R_{\mathrm{rad}} = B \left( np - n_i^2 \right), \]여기서 \(B\)는 자유 캐리어 간(복사) 재결합 계수입니다. GaAs에서는 캐리어가 접합에 주입되면 이 항이 재결합 균형을 지배할 수 있으며, 특히 결함 밀도가 낮을 때 그러합니다. 따라서 고품질 GaAs 다이오드의 암 I–V 특성은 흔히 결함 제한 거동이 아니라 복사 재결합 물리를 반영합니다.
Shockley–Read–Hall (SRH) 재결합
Shockley–Read–Hall (SRH) 재결합은 밴드갭 내 전자 상태를 통한 결함 매개 재결합을 포착합니다. OghmaNano에서는 편집기에 표시된 평형 SRH 트랩 파라미터를 사용하여 이를 제어합니다 (?? 참조): 트랩 에너지 \(E_t\) (중간 밴드갭 기준), 트랩 밀도 \(N_t\), 그리고 전자 및 정공 포획 단면적 \(\sigma_n\) 및 \(\sigma_p\)입니다.
GaAs에서 SRH 재결합은 일반적으로 재료의 본질적인 재결합 한계를 나타내지 않습니다. 대신 이는 재료 품질과 결함 밀도의 척도를 제공합니다. 고품질 에피택셜 GaAs에서는 SRH 재결합이 약하고 복사 재결합이 우세하지만, 품질이 낮은 재료나 계면 및 공정 손상 근처에서는 SRH 재결합이 중요해질 수 있습니다.
SRH 수명은 다음과 같이 정의됩니다.
\[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \]그리고 그 결과 재결합 속도는 다음과 같습니다.
\[ R_{\mathrm{SRH}} = \frac{np - n_i^2} {\tau_p (n + n_1) + \tau_n (p + p_1)} . \]이 튜토리얼에서는 SRH 재결합을 의도적으로 유지합니다. 이를 통해 결함 밀도를 증가시키거나 캐리어 수명을 줄이는 것이 다이오드를 복사 지배 거동에서 재결합 제한 동작으로 어떻게 이동시키는지 탐구할 수 있으며, 이는 공정과 계면이 중요한 역할을 하는 실제 소자를 이해하는 데 특히 중요합니다.
정전기학과 밴드 파라미터
마지막으로, GaAs를 정의하는 데 사용되는 밴드 구조 및 정전기 파라미터는 각 영역 탭에서 볼 수 있습니다 (예: ??): 전자 친화도, 밴드갭(\(E_g \approx 1.42\,\mathrm{eV}\), 상온), 그리고 상대 유전율(\(\varepsilon_r \approx 12.9\))입니다. 이 파라미터들은 PN 접합의 내장 전위를 설정하고 유의미한 캐리어 주입이 일어나는 전압 스케일을 결정합니다.
GaAs에서는 직접 천이형 밴드갭과 높은 캐리어 이동도의 조합으로 인해 접합 장벽이 낮아지면 캐리어가 효율적으로 주입되고 재결합 물리가 암 I–V 곡선을 형성하는 지배적 요인이 됩니다. 따라서 이러한 전기적 파라미터가 함께 어떻게 작용하는지 이해하는 것은 시뮬레이션 결과와 실제 GaAs 소자 거동을 해석하는 데 필수적입니다.
5. 시뮬레이션 실행, 암 I–V 곡선, 그리고 파라미터 추출
소자 구조, 도핑 프로파일, 전기적 파라미터가 정의되면 다이오드 시뮬레이션은 메인 창에서 직접 실행할 수 있습니다. 해석기를 시작하려면 Run simulation을 클릭합니다. 실행 중에는 각 바이어스 지점에 대한 수렴 정보가 터미널에 기록되므로, 해석기의 안정성과 진행 상황을 모니터링할 수 있습니다 (?? 참조).


jv.csv가 가장 중요한 결과입니다.
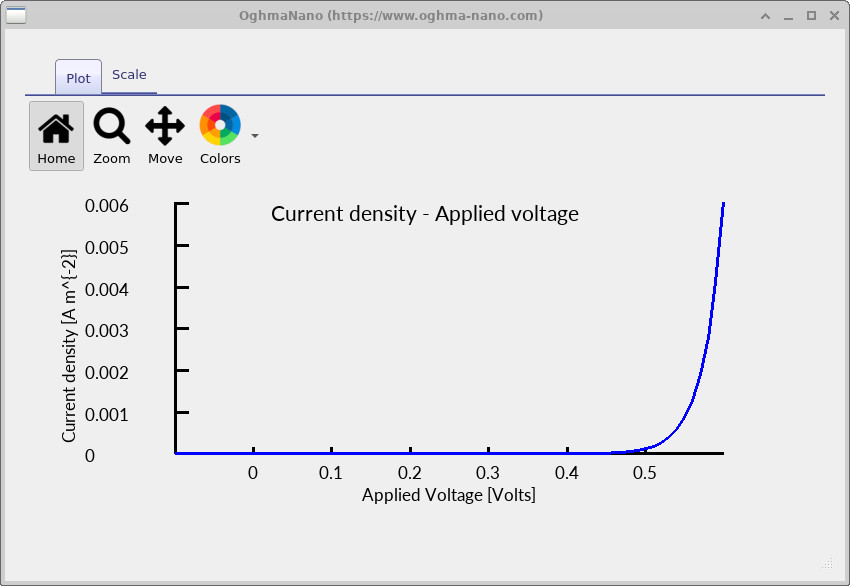
다이오드 특성을 확인하려면 Output 탭을 열고
jv.csv를 더블클릭합니다
(?? 참조).
올바르게 구성된 GaAs 다이오드라면 I–V 곡선은 매끄럽고 단조로워야 합니다.
역바이어스에서는 전류가 작고 전압 의존성이 약하며,
이는 재결합 제한 포화를 반영합니다.
순방향 바이어스에서는 인가 전압과 함께 전류가 빠르게 증가하며,
이는 PN 접합을 가로지르는 캐리어 주입에 해당합니다.
순방향 바이어스 영역의 형태에는 유용한 물리 정보가 담겨 있습니다. 반로그 플롯에서 지수 영역의 기울기는 이상성 인자를 추출하는 데 사용할 수 있으며, 전류가 확산 제한 수송(\(n \approx 1\))에 의해 지배되는지 또는 재결합 제한 과정(\(n \approx 2\))에 의해 지배되는지를 나타냅니다. 이 영역의 외삽 절편은 역포화 전류의 추정치를 제공하며, 이는 4절에서 논의한 SRH 및 Auger 재결합 파라미터와 직접적으로 연결됩니다. GaAs에서는 직접 천이형 밴드갭과 일반적으로 높은 이동도로 인해 주입이 매우 효율적일 수 있으므로, 재결합 설정이 순방향 바이어스 기울기와 절편에 특히 뚜렷한 흔적을 남기는 경우가 많습니다.
실용적인 규칙으로서, 항상 어떤 유도된 물리량을 해석하기 전에 I–V 곡선을 먼저 확인하십시오. 불연속, 예상치 못한 부호 규약, 또는 비물리적인 전류 점프는 보통 경계 조건, 바이어스 스텝 설정, 재결합 설정, 또는 해석기 수렴에 문제가 있음을 나타냅니다. 이와 같은 단순한 GaAs PN 다이오드의 경우 암 I–V 곡선은 물리적으로 직관적이고 해석이 쉬워야 합니다.
6. 시뮬레이션 스냅샷 살펴보기: 밴드, 재결합, 전류 흐름
I–V 스윕 동안 OghmaNano는 각 바이어스 지점에서 드리프트–확산 방정식의 내부 해를 snapshots 디렉터리에 저장합니다. 이 파일들은 해석기가 다이오드 내부에서 무엇을 예측하는지 보여줍니다. 밴드 굽힘, 준-페르미 준위 분리, 재결합 활성도, 전류 수송입니다. 이러한 물리량을 살펴보는 것은 특정 I–V 특성이 왜 나타나는지 이해하는 데 필수적입니다.
이 절에서는 세 가지 대표적인 바이어스 지점을 살펴봅니다. 평형에 가까운 역바이어스(−0.1 V), 턴온 부근의 중간 순방향 바이어스(≈0.45 V), 그리고 높은 순방향 바이어스(0.8 V)입니다. 이 스냅샷들은 함께 평형에서, 주입 제한 수송을 거쳐, 고주입 동작으로의 전이를 보여줍니다. GaAs의 경우 동일한 정성적 전이가 성립하지만, 활성 영역의 지배적 재결합 채널은 일반적으로 결함 제한 SRH가 아니라 자유 캐리어 간(복사) 재결합입니다.
6.1 밴드 에지와 준-페르미 준위
밴드 다이어그램을 재현하려면 스냅샷 뷰어를 열고
Ec.csv, Ev.csv, Fn.csv, Fp.csv 파일을 추가합니다.
이들은 각각 전도대 에지, 가전자대 에지,
전자 준-페르미 준위, 정공 준-페르미 준위에 해당합니다.
−0.1 V에서(그림 ??), 다이오드는 평형에 가깝습니다. 밴드 굽힘은 도핑 프로파일에 의해 부과된 내장 전위를 반영하며, 준-페르미 준위는 거의 평평하고 서로 일치하여, 순 전류 흐름이 무시할 만큼 작음을 나타냅니다. 공핍 영역은 접합에서 강한 밴드 곡률을 보이는 영역으로 명확히 보입니다. ≈0.45 V에서(그림 ??), 순방향 바이어스는 접합 장벽을 낮춥니다. 전자 및 정공 준-페르미 준위는 공핍 영역을 가로질러 분리되며, 이는 캐리어 주입의 내부적 신호입니다. 이 준-페르미 준위 분리는 I–V 곡선에서 관찰되는 전류의 지수적 증가를 직접적으로 유발합니다. 0.8 V에서(그림 ??), 접합은 깊은 순방향 바이어스 상태에 있습니다. 장벽은 크게 억제되고 준-페르미 준위는 넓게 분리되며, 소자는 구조의 상당 부분에서 캐리어 밀도가 큰 고주입 영역에서 동작합니다. GaAs에서는 이 준-페르미 분리가 특히 유용한데, 이는 활성 영역에서 강한 캐리어 주입과 효율적인 자유 캐리어 간 재결합에 직접적으로 연결되기 때문입니다.
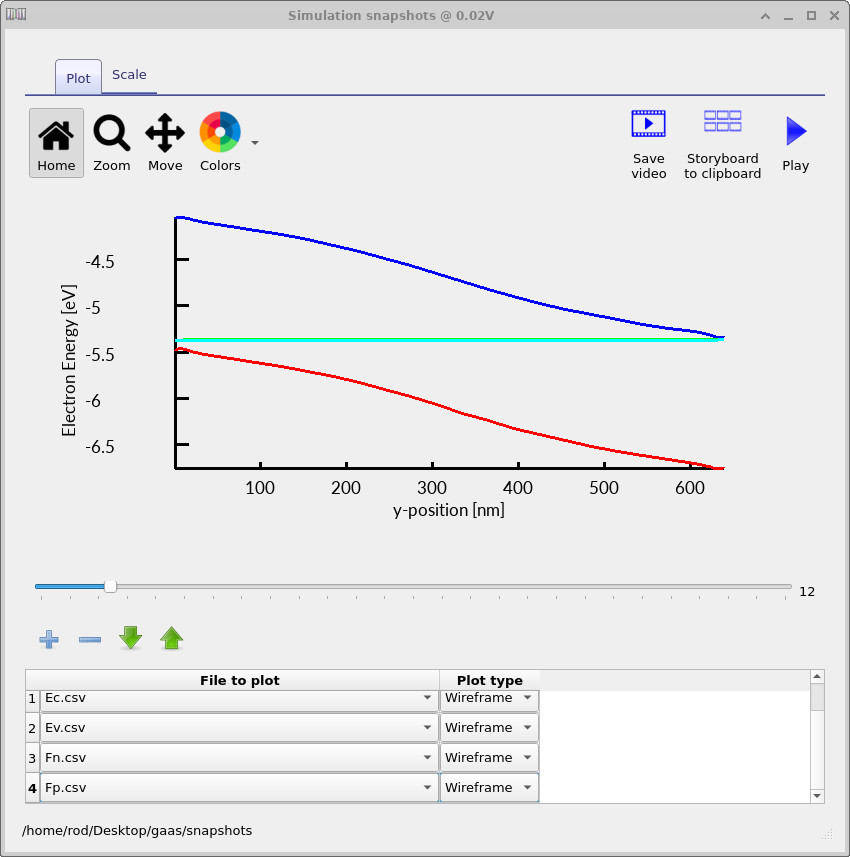
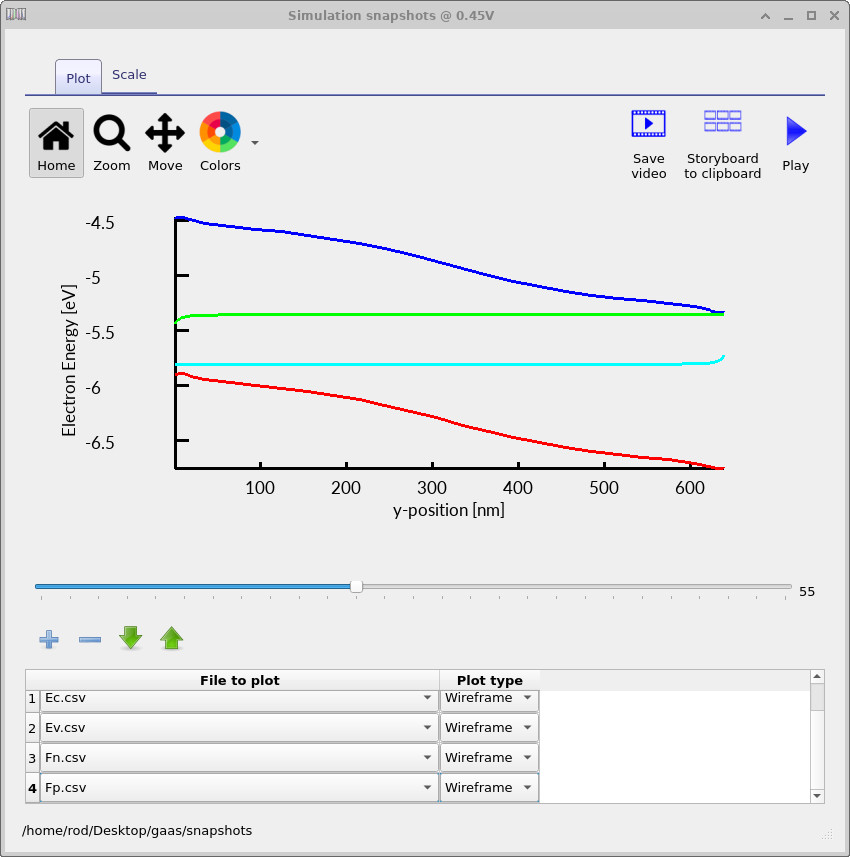

6.4 활성 영역에서의 자유 캐리어 간(복사) 재결합
자유 캐리어 간 재결합은 R_nfree_to_pfree.csv를 플로팅하여 확인할 수 있으며,
이는 위치의 함수로서 국소 복사 재결합 속도를 보고합니다.
GaAs에서는 이 채널이 순방향 바이어스 하에서 활성 접합의 지배적인 재결합 메커니즘인 경우가 많은데,
이는 GaAs가 직접 천이형 밴드갭 반도체이기 때문이며 복사 전이가 효율적이기 때문입니다.
이러한 플롯을 해석할 때 가장 중요한 특징은 미세한 공간 구조가 아니라,
재결합 프로파일의 전체적인 형태와 그 크기가 바이어스에 따라 어떻게 변화하는가입니다.
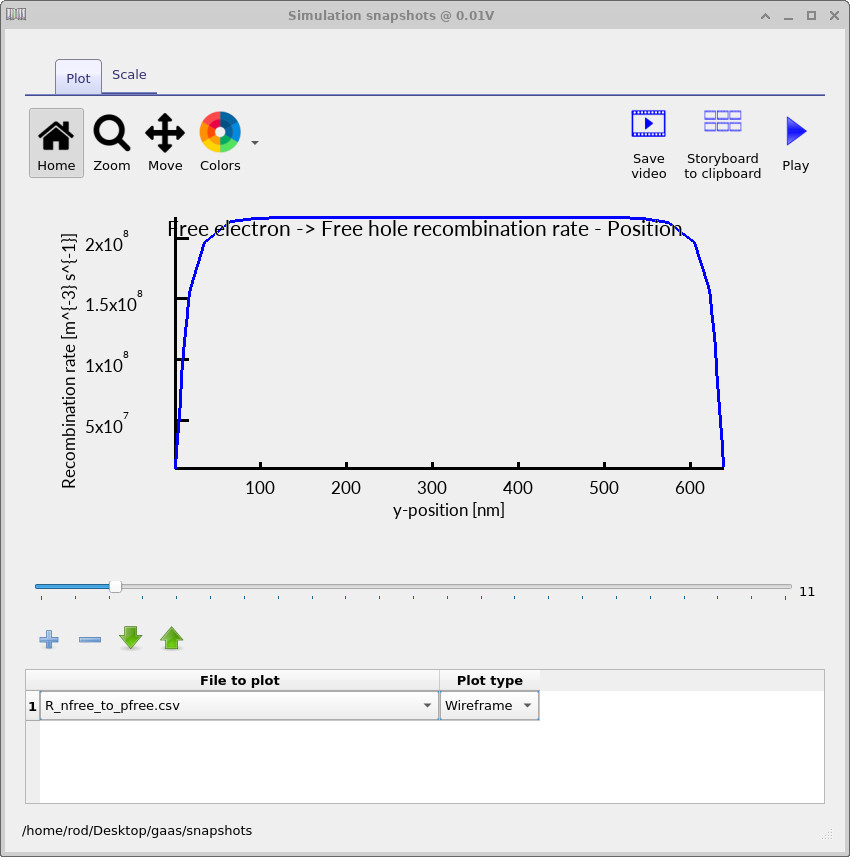
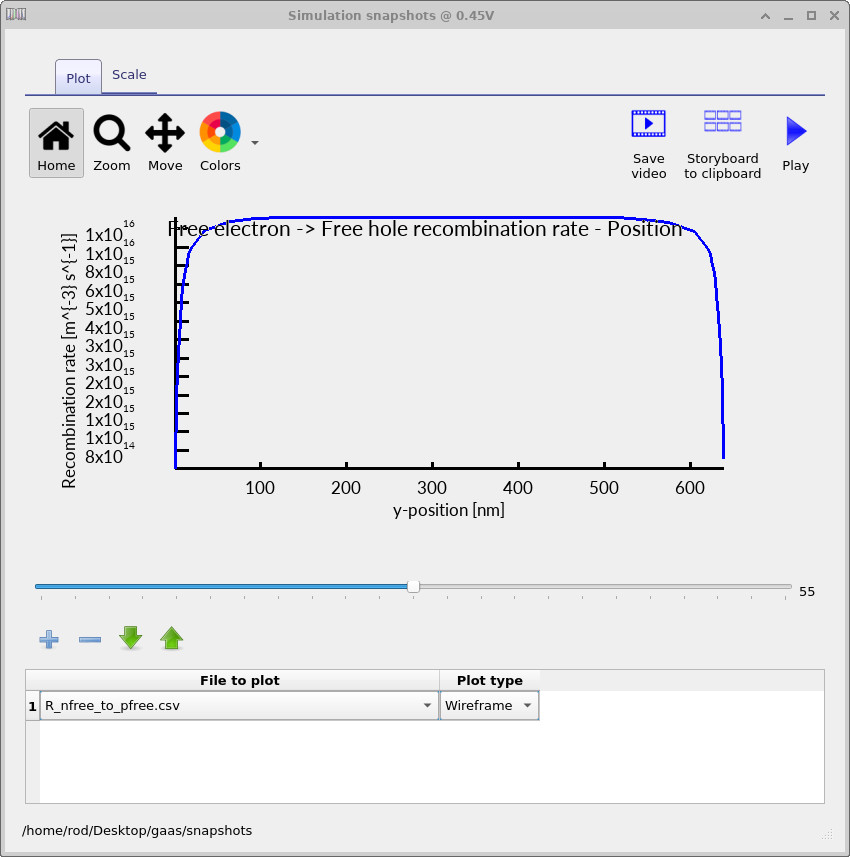
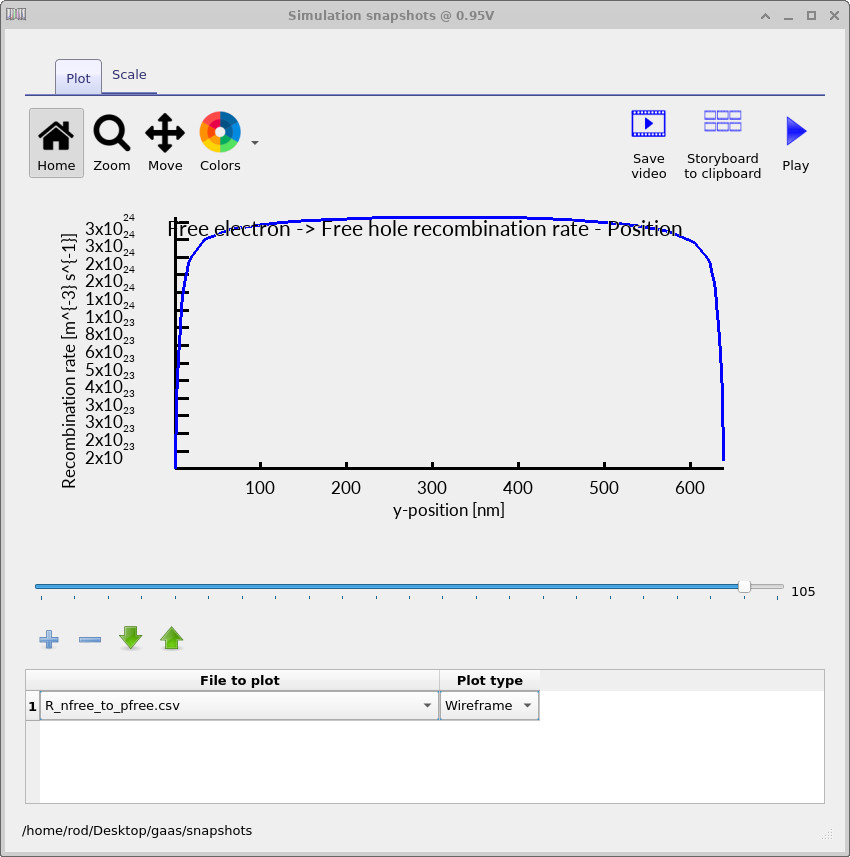
매우 낮은 바이어스에서(그림 ??), 자유 캐리어 간 재결합은 소자가 평형에 가깝고 캐리어 곱 \(np\)가 \(n_i^2\)에 가깝게 유지되기 때문에 약합니다. GaAs는 효율적인 복사 전이를 지원하지만, 큰 복사 재결합 속도를 유도하는 데 필요한 캐리어 밀도는 아직 존재하지 않습니다.
다이오드가 순방향 바이어스 상태로 들어가면(그림 ??), 주입된 전자와 정공이 구조의 대부분에 걸쳐 공존하게 됩니다. 그 결과 자유 캐리어 간 재결합 프로파일은 거의 전체 소자에 걸쳐 퍼지는 넓고 완만하게 굽은 “캡” 모양을 띱니다. 이 형태는 복사 재결합이 주로 국소 캐리어 곱 \(np\)에 의존하며, 주입이 확립되면 준중성 영역 전체에서 이 값이 비교적 균일하기 때문에 나타납니다. SRH 재결합과 달리, 공핍 영역에 강하게 국소화되지 않습니다.
높은 순방향 바이어스에서(그림 ??), 자유 캐리어 간 재결합 프로파일의 형태는 대체로 유사하게 유지되는 반면, 그 크기는 수 자릿수 이상 증가합니다. 이는 GaAs에서 복사 지배 재결합의 핵심적인 진단 특징입니다. 즉, 바이어스를 증가시키면 주로 모든 곳에서 캐리어 밀도가 증가하며, 재결합이 일어나는 위치 자체가 바뀌는 것은 아닙니다. 이 매끄럽고 소자 전반에 걸친 프로파일은 복사 재결합이 주입된 영역 전체에서 부피 과정으로 작용함을 나타냅니다.
이러한 거동은 결함 매개 재결합과 뚜렷하게 대조됩니다. SRH 재결합은 일반적으로 좁고 접합 중심의 피크를 만들며 높은 주입에서만 넓어지지만, GaAs의 자유 캐리어 간 재결합은 단일하고 확장된 재결합 “돔”을 만들며 그 높이만이 공간적 범위가 아니라 주입 수준을 부호화합니다. 따라서 직접 천이형 밴드갭 소자에서 이러한 넓은 복사 프로파일은 높은 재료 품질과 효율적인 캐리어 주입의 신호이며, I–V 특성을 형성하는 재결합 균형에 지배적인 기여를 제공하는 경우가 많습니다.
6.2 Shockley–Read–Hall 재결합
결함 매개 재결합을 조사하려면 R_ss_srh.csv를 플로팅하십시오. 이는 다이오드 내부의 공간적으로 해석된
Shockley–Read–Hall 재결합 속도를 보여줍니다.
아래의 세 플롯은 밴드 다이어그램 분석에서 사용한 것과 동일한 바이어스 지점에 대응합니다.
−0.1 V, ≈0.45 V, 그리고 0.8 V입니다.
GaAs의 경우 이러한 플롯은 고품질 접합에서 지배적인 재결합 채널이라기보다 트랩 보조 손실의 진단으로 해석하는 것이 가장 적절합니다.
주목해야 할 핵심은 SRH 재결합의 공간적 국소화가 위의 더 넓은 자유 캐리어 간 프로파일과 어떻게 비교되는가입니다.
−0.1 V에서(그림 ??), 다이오드는 평형에 가깝습니다. 전자는 n형 측에서 우세하고 정공은 p형 측에서 우세하므로, 유의미한 SRH 재결합은 두 캐리어가 동시에 존재하는 접합 주변의 좁은 영역에서만 일어날 수 있습니다. 그 결과 SRH 재결합 속도는 소자 중심에 강하게 국소화되며, 공핍 영역과 일치합니다. ≈0.45 V에서(그림 ??), 순방향 바이어스는 접합을 가로질러 캐리어를 주입하고 전자 및 정공 밀도의 국소 곱을 증가시킵니다. SRH 피크는 크기가 크게 증가하지만, 여전히 소자의 중앙 영역에 공간적으로 제한되어 있습니다. 이는 SRH가 공핍 영역 내부 및 그 근처에서의 캐리어 중첩과 트랩 활성에 의해 제어되는 접합 중심 손실 채널로 남아 있음을 나타냅니다. 0.8 V에서(그림 ??), 구조 전체에서 캐리어 주입이 증가함에 따라 이 거동은 더 넓어집니다. 그러나 SRH가 퍼지더라도 일반적으로 GaAs의 주입된 준중성 영역 전반에 분포하는 경향이 있는 자유 캐리어 간 재결합보다 접합 영역 쪽에 더 강하게 가중됩니다.
두 재결합 채널을 비교하면 GaAs 다이오드 동작에 대한 유용한 내부 그림을 얻을 수 있습니다. 자유 캐리어 간 재결합은 주입이 확립되면 부피적 싱크를 제공하며, 활성 소자 부피에서 전체 재결합 균형을 지배하는 경우가 흔합니다. 반면 SRH 재결합은 트랩 보조 손실이 집중되는 위치—종종 공핍 영역 내부와 그 근처—를 강조하므로 재료 품질과 계면 손상에 민감한 지표가 됩니다. 이러한 구분은 왜 GaAs 다이오드가 강한 주입과 큰 전류를 보이면서도 접합의 결함에는 매우 민감할 수 있는지를 설명하는 데 도움이 됩니다.



6.3 전자 및 정공 전류 밀도
마지막으로 Jn.csv와 Jp.csv를 플로팅하여 캐리어 전류를 확인합니다.
이는 각각 공간적으로 해석된 전자 및 정공 전류 밀도를 보여줍니다.
이러한 플롯은 서로 다른 바이어스 조건에서 전하가
다이오드를 통해 어떻게 수송되는지,
그리고 소자가 평형에서 정상상태 순방향 전도로 어떻게 전이하는지를 직접적으로 보여줍니다.
−0.1 V에서(그림
??),
다이오드는 평형에 가깝고 실제 물리적 전류는 극히 작습니다.
전자 및 정공 플럭스는 소자 전반에서 거의 균형을 이루므로,
순 전류는 거의 같은 두 양의 차이로부터 발생합니다.
이 영역에서는 수치 문제가 본질적으로 조건수가 나쁘며,
전류 프로파일에서 작은 진동이나 겉보기 잡음이 예상됩니다.
이 GaAs 데모에서는 그 효과가 더 두드러져 보일 수 있습니다. 매우 빠른 캐리어 수송
(특히 전자에 대해)과 극히 작은 순 전류의 조합이 상쇄 문제를 더 날카롭게 만들기 때문에,
원시 Jn/Jp 곡선은 기저 물리가 단순히 “거의 0 전류”임에도 불구하고 눈에 띄게 잡음이 있는 것처럼 보일 수 있습니다. ≈0.45 V에서(그림
??),
순방향 바이어스는 접합을 가로질러 캐리어 주입을 유도합니다.
전자 전류는 n측에서 우세하고 정공 전류는 p측에서 우세하지만,
두 전류 모두 소자를 통해 연속적이며,
이는 정상상태 전하 보존을 반영합니다.
전류 밀도는 평형 근처 경우와 비교해 빠르게 증가하지만,
구배가 큰 접합 근처에서는 프로파일에 여전히 작은 수치 구조가 나타날 수 있습니다.
장벽이 낮아지면 주입이 빠르게 확립될 수 있는 GaAs에서는,
소자가 상쇄 지배 저전류 영역에서 분명히 벗어난 후에야 전류가 “안정화”되는 것이 흔합니다. 0.8 V에서(그림
??),
다이오드는 깊은 순방향 바이어스에서 동작합니다.
캐리어 밀도는 구조 전체에서 높고,
전자 및 정공 전류는 모두 커지고 더 매끄러워지며 준중성 영역 전반에서 더 균일해집니다.
이 경우에도, 특히 해석기가 필터링되지 않은 점별 전류를 보고하는 경우
원시 전류 프로파일에는 약간의 잔류 리플이 남을 수 있지만, 핵심 진단 기준은
큰 스케일의 추세가 물리적으로 일관되며 활성 소자를 통해 연속적인 전류 흐름이 있고 허위 부호 반전이 없다는 점입니다.
이러한 전류 밀도 플롯을 종합하면, 다이오드 동작에 대한 일관된 내부 그림을 제공합니다. 평형에서 전자 및 정공 플럭스의 거의 완벽한 상쇄에서 시작하여, 주입 제한 순방향 전도를 거쳐, 큰 순방향 바이어스에서의 고전류 정상상태 수송에 이릅니다.




