シリコン PN 接合ダイオード (1D) — ドリフト–拡散 (Dark I–V, SRH Recombination)
1. はじめに
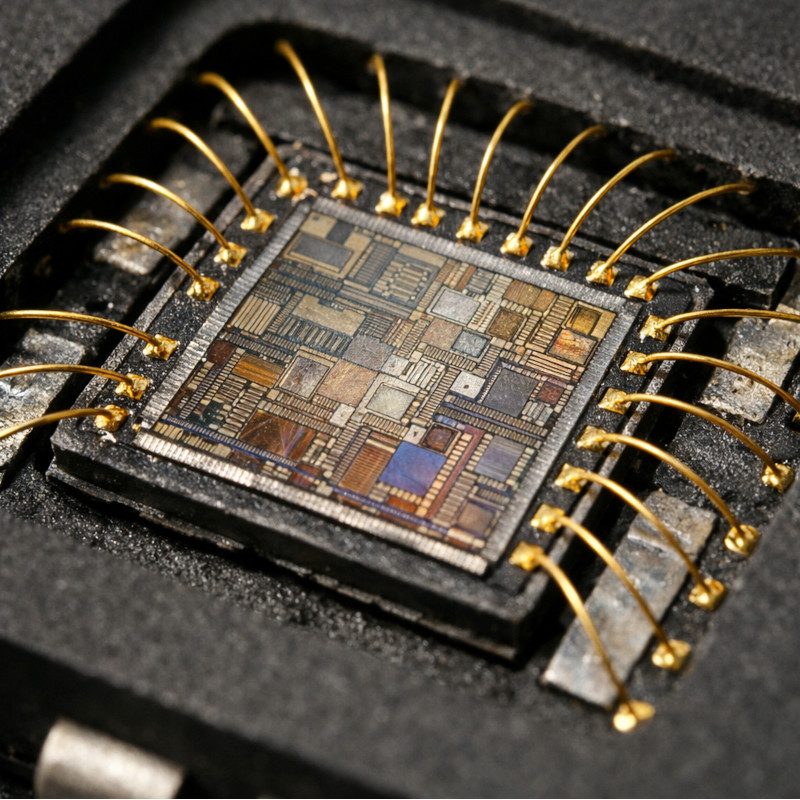
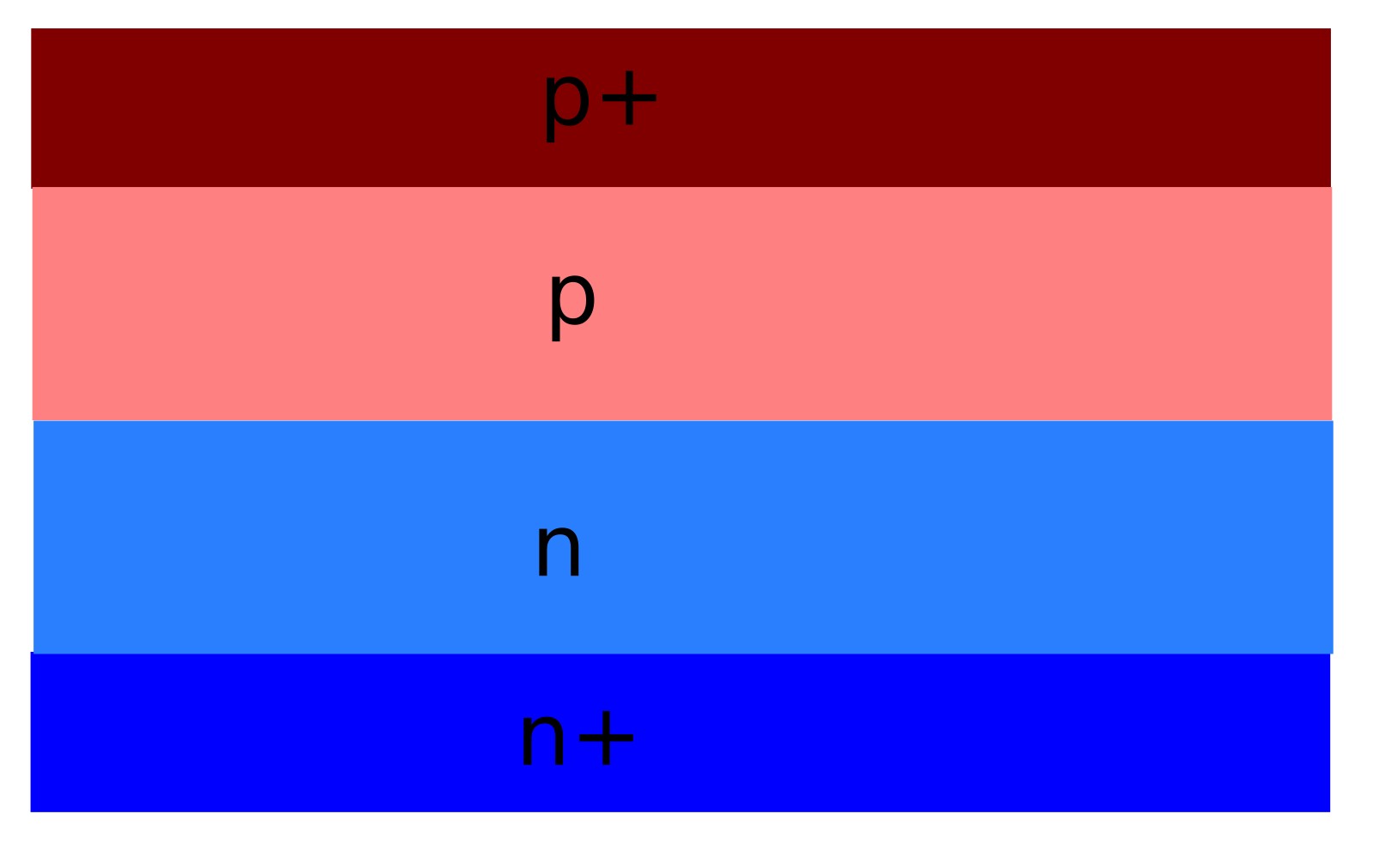
シリコン PN 接合ダイオード は半導体デバイスの典型例です。 それは離散部品として明示的に現れるだけでなく、電力整流器からロジック回路、アナログ回路に至るまで、 ほぼすべての集積電子システム全体に暗黙的に現れます。 代表的な応用コンテキストが ?? に示されており、そこでは PN 接合が単独デバイスとしてではなく、集積回路内に組み込まれています。
このチュートリアルでシミュレーションするデバイスは単純ですが、基本的な構成要素 として理解すべきです。 同じ接合物理は、ダイオード接続デバイス、トランジスタ接合、および 集積シリコン技術内部の絶縁構造を支配します。 ここで使用する層状ドーピング構造は ?? に模式的に示されています。
このチュートリアルでは、OghmaNano の連成 ドリフト–拡散 + ポアソン ソルバーを用いて、 一次元でシリコン PN 接合ダイオードをシミュレーションします。 理想的な Shockley 方程式だけに頼るのではなく、この手法では 内蔵電界、空乏領域、 およびキャリア密度と電流の空間分布を解像します。
再結合物理、特に Shockley–Read–Hall (SRH) 再結合を明示的に扱うことで、 ドーピングや寿命の変化をターンオン挙動や理想性の変化に直接結び付けることが可能になります。 Dark I–V 曲線を生成し、バイアス下でのバンド端と準フェルミ準位を調べ、 さらに 寿命スイープ を実行してダイオード応答における再結合律速領域を特定します。
2. 新しいシミュレーションの作成
まず、OghmaNano のメインウィンドウから新しいシミュレーションを作成します。 ツールバーの New simulation ボタンをクリックしてください。 これによりシミュレーションタイプ選択ダイアログが開きます (?? を参照)。
シミュレーションタイプダイアログで Si demos をダブルクリックし、次にシリコン接合/ダイオードの例を選択します (?? を参照)。 OghmaNano は事前定義されたシリコン接合構造を読み込み、これを PN ダイオードとして扱います。
読み込まれたデバイス構造はメインシミュレーションウィンドウに表示されます (?? を参照)。 このチュートリアルで解く電気問題は一次元ですが、 3D ビューは垂直層スタックと、キャリア輸送および再結合に関与する領域を 明確に可視化します。
ダイオードは、強くドープされた p+ 領域、 より軽くドープされた p 領域、 軽くドープされた n 領域、 そして強くドープされた n+ 領域から成る、 垂直に積層されたシリコン層の列として実装されています。 この構造は Layer editor に明示的に一覧表示されており (?? を参照)、 各層には厚さ、材料、および電気的役割が割り当てられています。
中央の p 層と n 層が能動的な PN 接合を形成します。 平衡状態では、この界面に空乏領域が発達し、キャリア分離と輸送を制御する 内蔵電界が生じます。 薄く強くドープされた p+ 層と n+ 層は、 低抵抗のコンタクト領域として機能し、印加バイアスが主にコンタクトではなく 接合全体にかかることを保証します。
以下の節では、この構造を一次元デバイスとして扱います。 すなわち、すべての変化は成長方向に沿って解像され、横方向の変化は無視されます。 この単純化にもかかわらず、このモデルは実用的な電子デバイスに組み込まれた シリコン PN 接合ダイオードの Dark I–V 挙動を支配する、 本質的な静電特性、キャリア輸送、および再結合物理を捉えます。


3. ドーピングプロファイルの確認
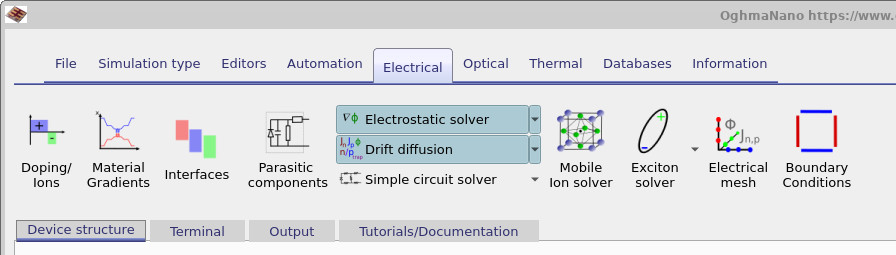
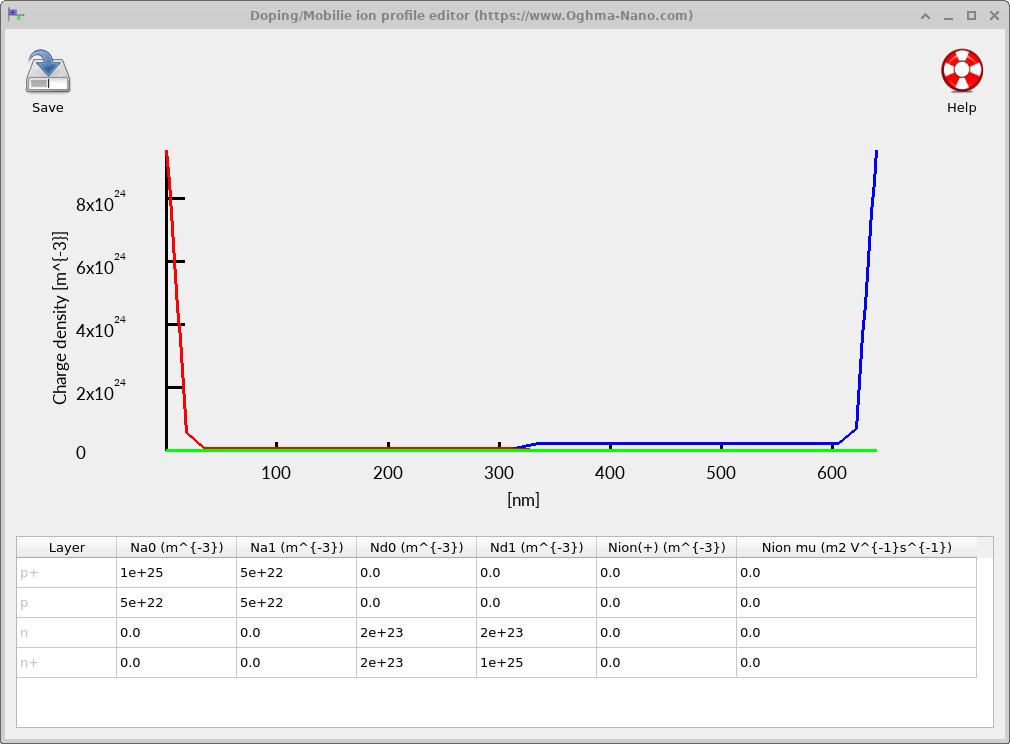
ドーピングプロファイルはシリコン PN 接合を定義し、したがってダイオードの基本的な静電特性を決定します。 それは接合位置、内蔵電位、空乏幅、 および平衡時およびバイアス下で発達する内部電界を決定します。
ドーピング設定を表示するには、 Electrical リボンから Doping / Ions エディタを開きます (?? を参照)。 このエディタは、イオン化されたドナーとアクセプタの空間分布を深さの関数として表示します (?? を参照)。
このチュートリアルでは、ダイオードは従来の p+/p/n/n+ シリコンドーピングプロファイルを用いて構築されます。 中央の p 領域と n 領域は中程度にドープされており、能動的な PN 接合を形成し、 そこに空乏領域と内蔵電界が発達します。
薄く強くドープされた p+ 層と n+ 層は 低抵抗のコンタクト領域として機能します。 それらの役割は、キャリアの良好な電気的注入と抽出を提供しつつ、 印加電圧の大部分がコンタクトではなく接合自体にかかることを保証することです。
このチュートリアルの目的では、重要な確認事項は単にデバイスが 主としてアクセプタドープされた領域を 1 つ、主としてドナードープされた領域を 1 つ含み、 それらの間に明確な遷移があることです。 ドーピング密度の正確な数値は主に空乏幅 と内蔵電界強度に影響し、これらは後の節で ダイオードの Dark I–V 特性を通じて間接的に調べます。
4. 電気パラメータと再結合機構の確認
電気材料パラメータは 領域ごと に定義され、ダイオード全体のキャリア輸送、 再結合、および静電特性を制御します。メインウィンドウから Device structure → Electrical parameters を介して 電気パラメータエディタを開いてください。 デバイススタック内の各層には専用のパラメータタブがあります。 このチュートリアルでは 4 つの領域すべてで同じシリコン材料モデルを使用しますが、 それらを異なる役割として 解釈 します。 すなわち、p+ と n+ は低抵抗コンタクト領域として機能し、 p と n が能動的な接合を形成します。
図 ??– ?? は各領域 (p+、p、n、n+) の電気パラメータエディタを示しています。 このデモでは、電子および正孔移動度はそれぞれおよそ 0.135 および 0.048 m2V−1s−1 に設定されています (例えば ?? を参照)。 これらの値は結晶シリコンに典型的なものです。すなわち、アモルファスシリコンや多くの溶液プロセス半導体のような 無秩序または欠陥律速材料で見られるものよりはるかに高い一方で、 GaAs のような高移動度 III–V 材料よりは低い値です。 その結果、このチュートリアルにおけるダイオード挙動は主として接合静電特性と再結合によって制御され、 バルク輸送制限にはあまり支配されません。
ここで使用されている有効状態密度もエディタ内で確認できます (例: ??)。 自由電子の有効状態密度はおよそ 2.8×1025 m−3 に、 自由正孔の有効状態密度は 1.04×1025 m−3 に設定されています。 これらのパラメータは、与えられたバンド構造に対するキャリア統計と平衡キャリア濃度を決定し、 \(n\) と \(p\) を通じて再結合および注入挙動に暗黙的に関与します。
Shockley–Read–Hall (SRH) 再結合
SRH 再結合は、バンドギャップ内の電子状態を介した欠陥媒介再結合を表します。 OghmaNano では、これはエディタに示される equilibrium SRH trap パラメータを用いて制御されます (?? を参照)。 すなわち、トラップエネルギー \(E_t\)(ミッドギャップに対する相対値)、トラップ密度 \(N_t\)、 および電子・正孔捕獲断面積 \(\sigma_n\) と \(\sigma_p\) です。 ここに示す設定では、トラップエネルギーはミッドギャップ近傍にあり(\(E_t \approx 0\))、 トラップ密度は \(N_t \approx 10^{21}\,\mathrm{m^{-3}}\)、 捕獲断面積は \(\sigma_n \approx \sigma_p \approx 10^{-21}\,\mathrm{m^2}\) です。
これらの微視的パラメータは、次式によって SRH 寿命を定義します
\[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \]ここで \(v_{\mathrm{th}}\) は熱キャリア速度です。 したがって、トラップ密度または捕獲断面積を増加させるとキャリア寿命が減少し、 再結合が強まります。
ドリフト–拡散形式では、結果として得られる SRH 再結合率は次式で与えられます
\[ R_{\mathrm{SRH}} = \frac{np - n_i^2} {\tau_p (n + n_1) + \tau_n (p + p_1)} . \]後の節で「寿命をスイープ」するとき、実際には \(N_t\)、\(\sigma_n\)、および \(\sigma_p\) によって符号化された トラップ支援再結合強度を変更しています。 最も強い影響は、空乏領域内およびその近傍での再結合が注入キャリア集団を支配する場合、 すなわち順方向バイアス下で再結合律速挙動が生じる場合に観測されます。
Auger 再結合
Auger 再結合は高キャリア密度での損失機構であり、したがって 強くドープされた p+ および n+ コンタクト領域で最も重要です。 パラメータエディタでは、Auger 係数 \(C_n\) および \(C_p\) が指定されています (?? と ?? を参照)。 このシリコンデモでは、係数は \(C_n \approx 2.8\times10^{-31}\,\mathrm{m^6\,s^{-1}}\) および \(C_p \approx 9.9\times10^{-32}\,\mathrm{m^6\,s^{-1}}\) のオーダーであり、結晶シリコンに典型的な値です。
Auger 再結合率は次式で与えられます
\[ R_{\mathrm{Auger}} = C_n n^2 p + C_p p^2 n . \]実際には、Auger 再結合は高注入時のキャリア蓄積を制限し、 中程度にドープされた接合そのものにおける再結合物理を支配することなく、 コンタクト領域がキャリアに対する効率的なシンクとして振る舞うことを保証します。
静電特性とバンドパラメータ
最後に、シリコンを定義するために使用されるバンド構造および静電パラメータが、 各領域タブで確認できます (例: ??)。 電子親和力はおよそ \(\chi \approx 4.05\,\mathrm{eV}\)、 バンドギャップは \(E_g \approx 1.12\,\mathrm{eV}\)、 相対誘電率は \(\varepsilon_r \approx 11.7\) に設定されています。




5. シミュレーションの実行、Dark I–V 曲線、およびパラメータ抽出
デバイス構造、ドーピングプロファイル、および電気パラメータが定義されたら、 ダイオードシミュレーションはメインウィンドウから直接実行できます。 Run simulation をクリックしてソルバーを開始してください。 実行中、各バイアスポイントの収束情報はターミナルに書き出されるため、 ソルバーの安定性と進行状況を監視できます (?? を参照)。


jv.csv が主たる注目結果です。
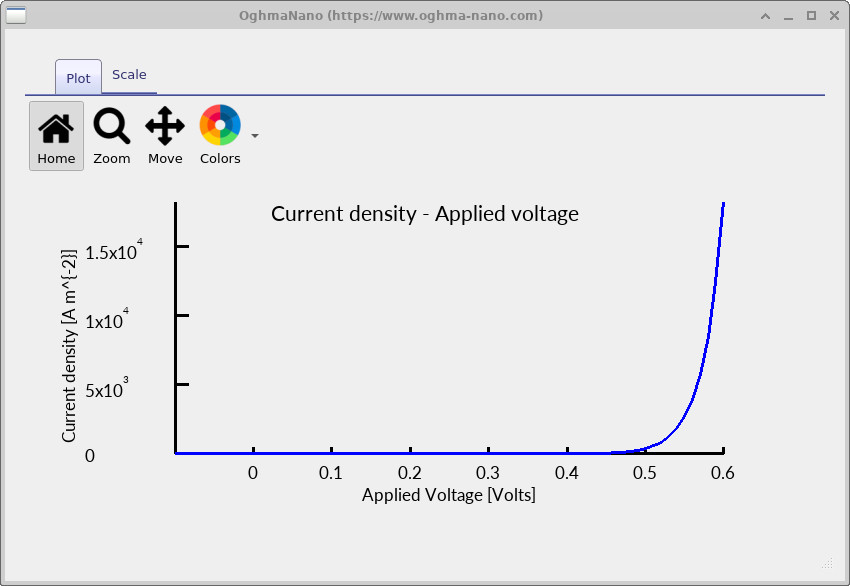
ダイオード特性を確認するには、Output タブを開き、
jv.csv をダブルクリックしてください
(?? を参照)。
正しく設定されたシリコンダイオードでは、I–V 曲線は滑らかで単調であるはずです。
逆バイアスでは、電流は小さく、電圧依存性も弱く、
再結合律速の飽和を反映します。
順バイアスでは、電流は印加電圧とともに急速に増加し、
PN 接合を横切るキャリア注入に対応します。
順方向バイアス領域の形状には有用な物理情報が含まれます。 半対数プロットでは、指数領域の傾きから 理想性因子 を抽出でき、 電流が拡散律速輸送(\(n \approx 1\))によって支配されているか、 あるいは再結合律速過程(\(n \approx 2\))によって支配されているかを示します。 この領域を外挿した切片は 逆方向飽和電流 の推定値を与え、 これは Section 4 で議論した SRH および Auger 再結合パラメータと直接結び付いています。
実用的なルールとして、導出量を解釈する前に必ず I–V 曲線を確認してください。 不連続、予期しない符号規約、あるいは非物理的な電流ジャンプは通常、 境界条件、バイアス刻み、再結合設定、またはソルバー収束に問題があることを示します。 このような単純なシリコン PN ダイオードでは、Dark I–V 曲線は物理的に直感的であり、 解釈しやすいはずです。
6. シミュレーションスナップショットの確認: バンド、再結合、および電流フロー
I–V スイープ中、OghmaNano はドリフト–拡散方程式の内部解を 各バイアスポイントで snapshots ディレクトリに保存します。 これらのファイルは、ソルバーがダイオード 内部 で何を予測しているかを明らかにします。 すなわち、バンドの曲がり、準フェルミ準位の分離、再結合活性、および電流輸送です。 これらの量を確認することは、特定の I–V 特性がなぜ現れるのかを理解するために不可欠です。
この節では、3 つの代表的なバイアスポイントを確認します。 すなわち、平衡に近い逆バイアス(−0.1 V)、 ターンオン近傍の中程度の順バイアス(≈0.45 V)、 および高順バイアス(0.8 V)です。 これらのスナップショットは合わせて、平衡から、 注入律速輸送を経て、 高注入動作への遷移を示します。
6.1 バンド端と準フェルミ準位
バンド図を再現するには、snapshot viewer を開き、
Ec.csv、Ev.csv、Fn.csv、および Fp.csv を追加します。
これらはそれぞれ、伝導帯端、価電子帯端、
電子準フェルミ準位、および正孔準フェルミ準位に対応します。
−0.1 V(図 ??)では、 ダイオードは平衡に近い状態にあります。 バンドの曲がりはドーピングプロファイルによって課される内蔵電位を反映し、 準フェルミ準位はほぼ平坦かつ一致しており、 正味電流フローが無視できることを示しています。 空乏領域は、接合部でバンド曲率が強い領域として明瞭に見えます。≈0.45 V(図 ??)では、 順バイアスにより接合障壁が低下します。 電子と正孔の準フェルミ準位は空乏領域をまたいで分離し、 これがキャリア注入の内部的な指標です。 この準フェルミ準位の分離が、I–V 曲線で観測される 電流の指数的上昇の直接的な原因です。 0.8 V(図 ??)では、 接合は深い順バイアス状態にあります。 障壁は大きく抑制され、準フェルミ準位は大きく分離し、 デバイスは高注入領域で動作し、構造の大部分でキャリア密度が大きくなります。

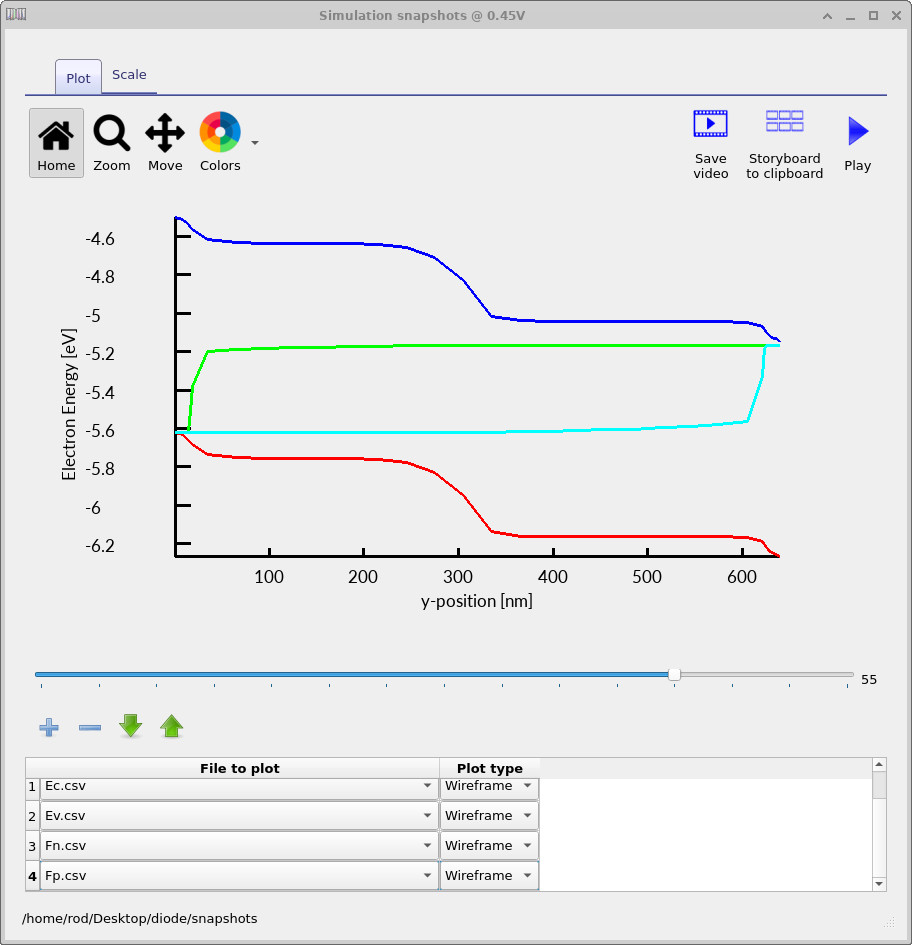
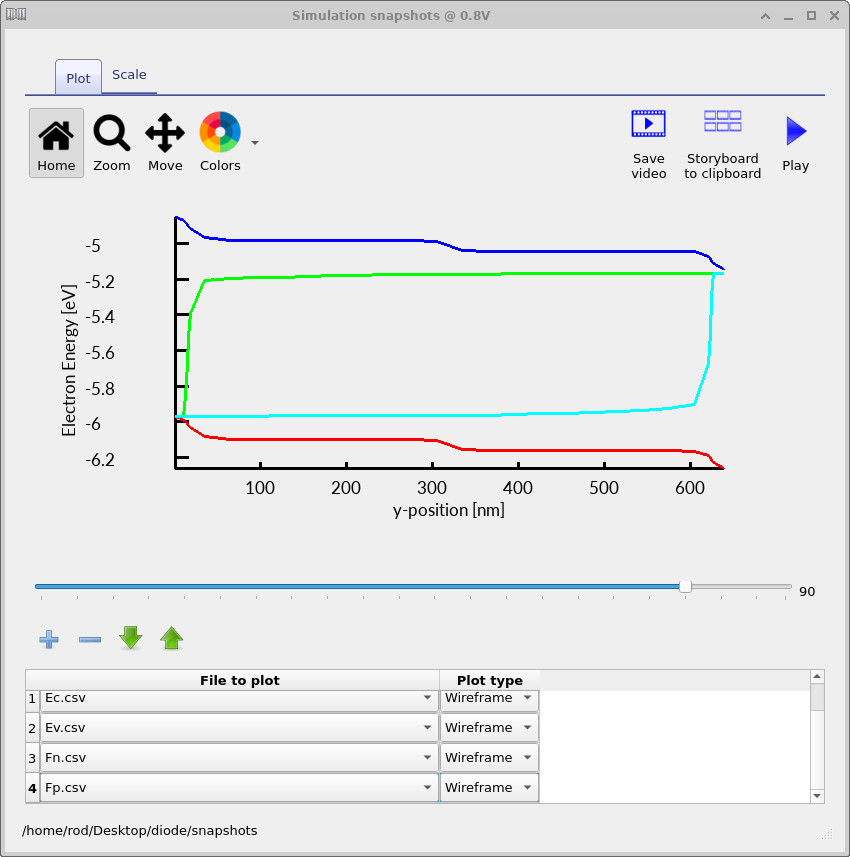
6.2 Shockley–Read–Hall 再結合
再結合を調べるには、ダイオード内部の空間分解された
Shockley–Read–Hall 再結合率を示す R_ss_srh.csv をプロットします。
以下の 3 つのプロットは、バンド図解析で用いたものと同じバイアスポイント、
すなわち −0.1 V、≈0.45 V、および 0.8 V に対応しています。
着目すべき重要な点は、再結合率の絶対値そのものではなく、
印加バイアスに伴ってその 空間的局在 がどのように変化するかです。
−0.1 V(図 ??)では、 ダイオードは平衡に近い状態にあります。 電子は n 型側を支配し、正孔は p 型側を支配するため、 顕著な再結合は両キャリア種が同時に存在する接合周辺の狭い領域でのみ起こり得ます。 その結果、SRH 再結合率はデバイス中心部に強く局在し、 空乏領域と一致します。≈0.45 V(図 ??)では、 順バイアスにより接合を横切ってキャリアが注入され、電子密度と正孔密度の局所積が増加します。 再結合ピークは大きく増大しますが、 空間的には依然としてデバイス中央領域に限定されています。 これは、このバイアス範囲では SRH 再結合が依然として主として 接合中心過程 であり、 空乏領域内およびその近傍でのキャリア重なりによって制御されていることを示します。0.8 V(図 ??)では、 挙動が質的に変化します。 キャリア注入が十分に強くなり、ダイオードの大部分全体で 電子と正孔の両方が高濃度で存在します。 SRH 再結合率はもはや接合に限定されず、 デバイスの大きな部分に広がります。 この空間的広がりは、高注入条件の開始を示しており、 再結合がもはや狭い中心領域に限定されないことを意味します。
鋭く局在した再結合ピークから 空間的に広がった再結合プロファイルへの進行は、 ダイオードが平衡から、接合律速動作を経て、 構造全体で再結合が起こる領域へ遷移する様子の 明確な内部像を与えます。 この発展はバンド図で見られる変化を反映しており、 順方向 I–V 特性の傾きの変化を支えています。


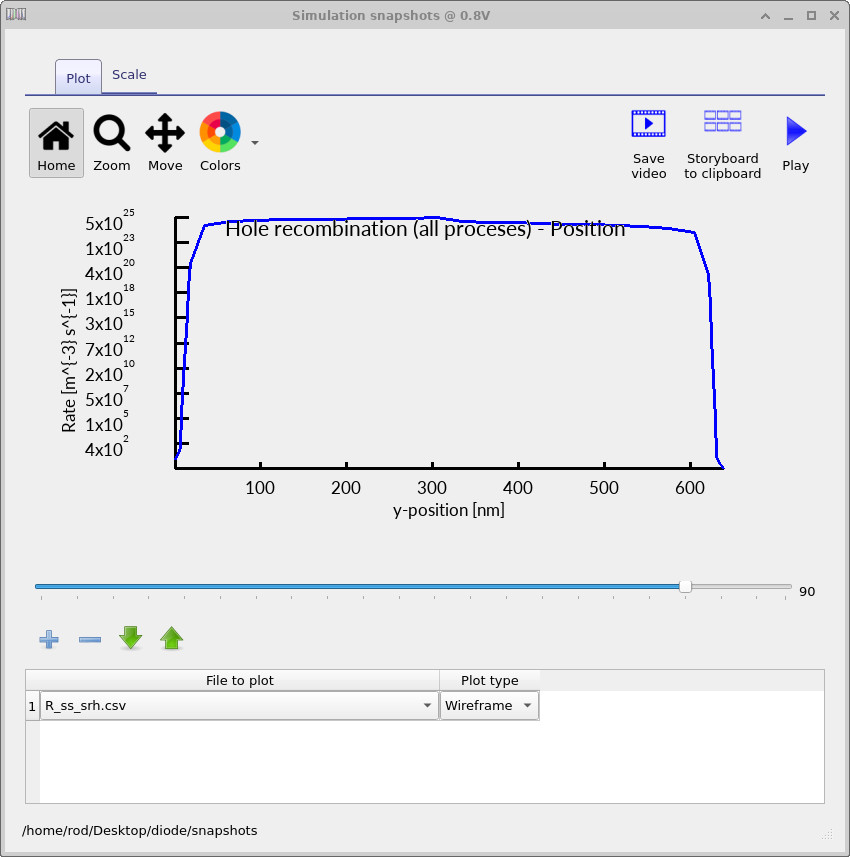
6.3 電子および正孔電流密度
最後に、Jn.csv および Jp.csv をプロットしてキャリア電流を確認します。
これらはそれぞれ空間分解された電子電流密度と正孔電流密度を示します。
これらのプロットは、異なるバイアス条件下で電荷がダイオードを通じて
どのように輸送されるか、そしてデバイスが平衡から
定常順方向伝導へどのように遷移するかを直接示します。
−0.1 V(図 ??)では、 ダイオードは平衡に近く、真の物理電流は極めて小さいです。 電子フラックスと正孔フラックスはデバイス全体でほぼ釣り合っており、 正味電流はほぼ等しい 2 つの量の差として生じます。 この領域では数値問題は本質的に悪条件であり、 電流プロファイルに小さな振動や見かけのノイズが現れるのは予想されることです。 これらの特徴は数値起源であり、実際のキャリア輸送には対応しません。≈0.45 V(図 ??)では、 順バイアスが接合を横切るキャリア注入を駆動します。 電子電流は n 側で支配的であり、正孔電流は p 側で支配的ですが、 両電流はデバイス全体で連続であり、 定常状態の電荷保存を反映しています。 電流密度は平衡近傍の場合と比べて急速に増加しますが、 依然として接合近傍で空間構造を持っており、 再結合により制御された注入律速輸送と整合しています。0.8 V(図 ??)では、 ダイオードは深い順バイアスで動作しています。 キャリア密度は構造全体で高く、 電子電流と正孔電流の両方が大きく、滑らかで、準中性領域全体でほぼ一様になります。 この領域では、デバイスは強く導通する要素として振る舞い、 電流は障壁注入よりも主に輸送と再結合によって制限されます。
これらの電流密度プロットを総合すると、ダイオード動作の一貫した内部像が得られます。 すなわち、平衡時には電子フラックスと正孔フラックスがほぼ完全に打ち消し合い、 その後、注入律速の順方向伝導を経て、 大きな順方向バイアスでは高電流の定常輸送へと移行します。


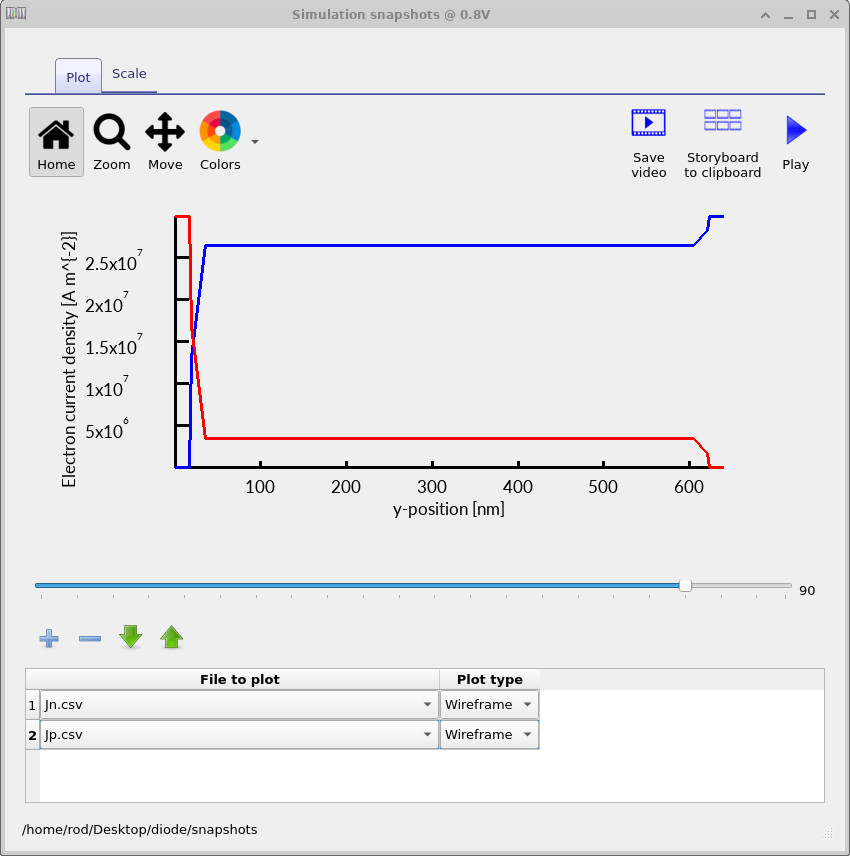
6.4 強くドープされた領域における Auger 再結合
Auger 再結合は、位置の関数として局所的な Auger 再結合率を報告する
R_auger.csv をプロットすることで確認できます。
電子と正孔が同程度の密度で共存する場所で最も強くなる SRH 再結合とは異なり、
Auger 再結合はキャリア密度に強く比例し、
そのため 強くドープされた 領域で支配的になります。



非常に低いバイアス(図 ??)では、 Auger 再結合はすでに p+ および n+ コンタクト層で見られます。 これは平衡近傍であっても、これらの領域が意図的に強くドープされているために起こり、 局所的には 3 粒子(Auger)過程が支配的となるほど高いキャリア濃度が生じるためです。
ダイオードが順バイアスへ駆動されると(図 ??)、 Auger 再結合率は急速に増加しますが、 空間的には依然としてコンタクト領域に限定されます。 この局在は、Auger 再結合の強い密度依存性を反映しています。 すなわち、キャリアは接合を横切って注入されるものの、 最も高いキャリア密度は依然として縮退したコンタクト層に存在します。
高順バイアス(図 ??)では、 Auger 再結合はコンタクト内で極めて大きくなり、 大きさの点で SRH 再結合をはるかに上回ります。 この挙動は予想されるものであり、物理的に正しいものです。 ここでの Auger 再結合の役割は接合電流を直接制限することではなく、 高注入下でキャリア密度が無制限に増大してしまうような領域において、 非物理的なキャリア蓄積を防ぐことです。
重要なのは、Auger 再結合率が数値的には SRH 率よりはるかに大きくても、 ダイオードの理想性やターンオン挙動を 支配しない ということです。 それらの特徴は依然として主として空乏領域内およびその近傍での 再結合によって制御されます。 むしろ Auger 再結合は、コンタクト層における高密度安定化機構として働き、 大電流時に現実的な挙動を保証します。

