硅 PN 结二极管(1D)— 漂移–扩散(暗态 I–V,SRH 复合)
1. 引言
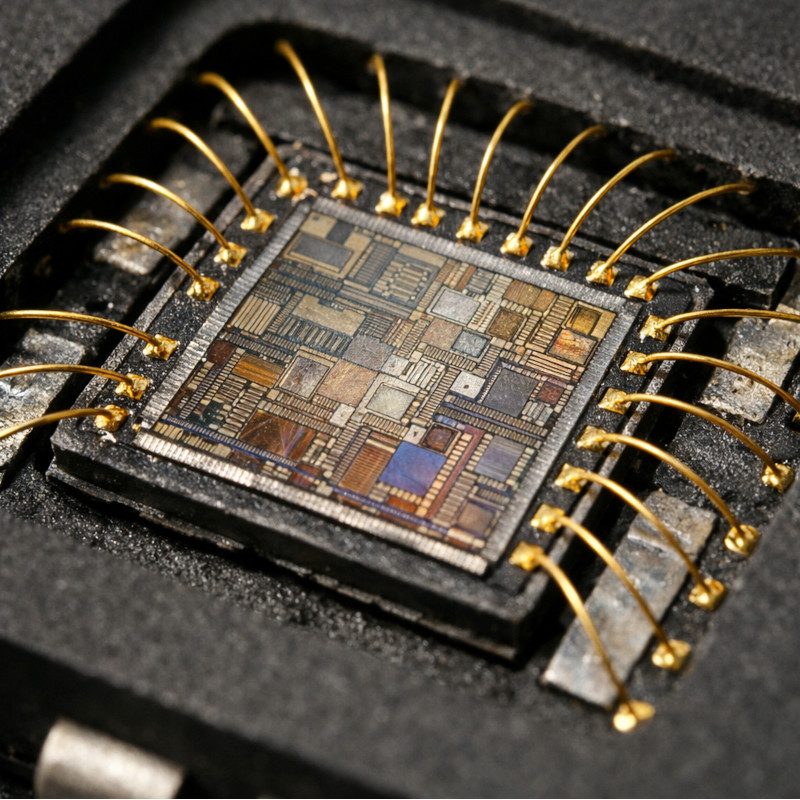
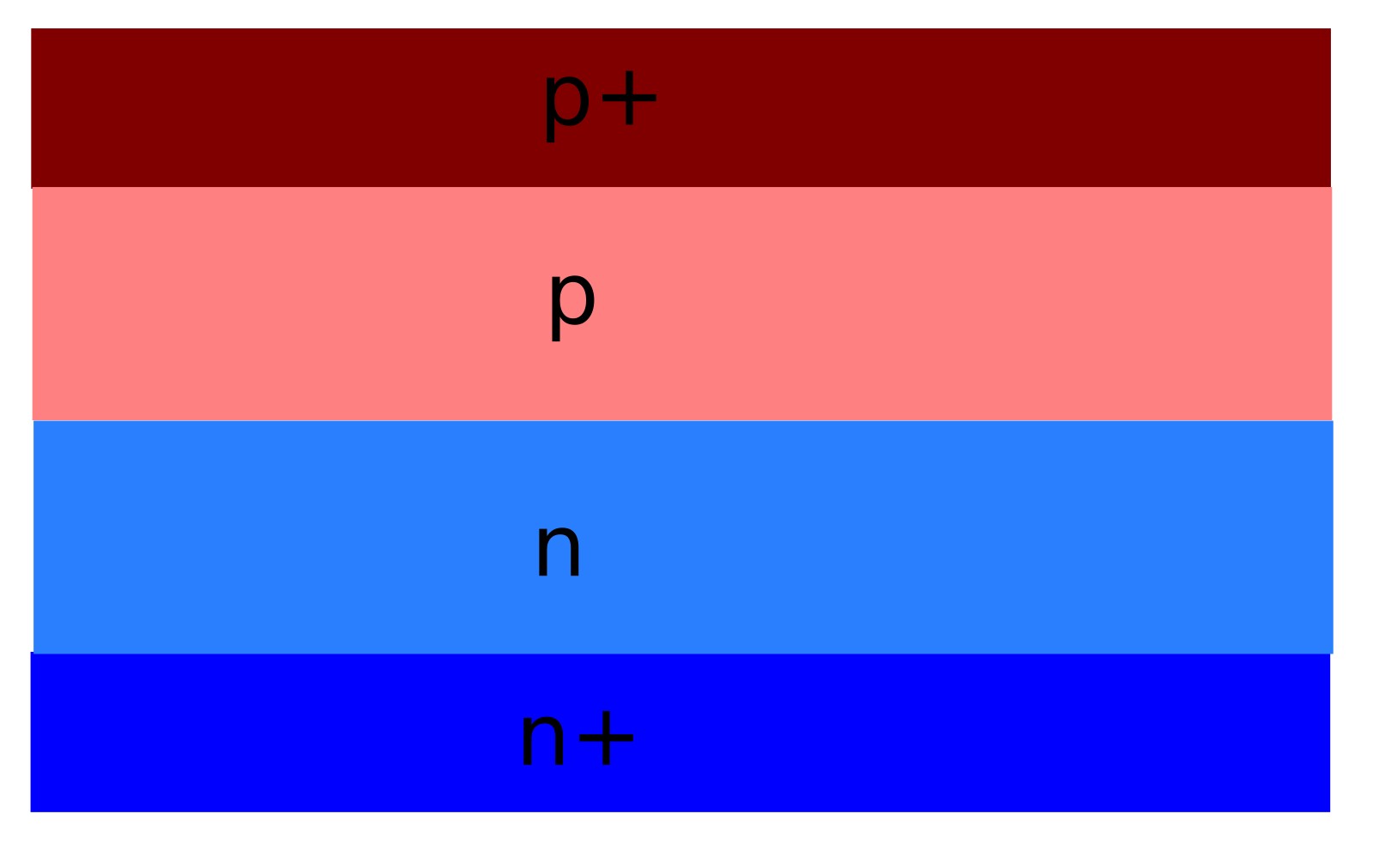
硅 PN 结二极管是最经典的半导体器件。 它既可作为离散元件明确存在,也隐含存在于几乎所有集成电子系统中, 从功率整流器到逻辑和模拟电路。 一个代表性的应用背景见 ??, 其中 PN 结被嵌入在集成电路内部,而不是作为独立器件使用。
尽管本教程中仿真的器件很简单,但应将其理解为一个基础构建模块。 相同的结物理主导着二极管连接器件、晶体管结以及 集成硅技术中的隔离结构。 这里使用的层状掺杂结构在 ?? 中给出了示意图。
在本教程中,你将使用 OghmaNano 的耦合 漂移–扩散 + 泊松求解器在一维中仿真一个硅 PN 结二极管。 这种方法并不只是依赖理想 Shockley 方程,而是显式求解 内建电场、耗尽区, 以及载流子密度和电流的空间分布。
对复合物理——尤其是 Shockley–Read–Hall(SRH)复合——的显式处理,使得可以将掺杂和寿命的变化 直接与开启行为和理想因子的变化联系起来。 你将生成一条暗态 I–V 曲线,检查偏压下的能带边缘和准费米能级, 然后执行一个寿命扫描,以识别二极管响应中的复合受限区间。
2. 创建一个新仿真
首先,从 OghmaNano 主窗口创建一个新仿真。 点击工具栏中的 New simulation 按钮。 这将打开仿真类型选择对话框 (见 ??)。
在仿真类型对话框中,双击 Si demos,然后选择硅结/二极管示例 (见 ??)。 OghmaNano 将加载一个预定义的硅结结构,我们将在本教程中将其视为 PN 二极管。
加载后的器件结构显示在主仿真窗口中 (见 ??)。 尽管本教程中求解的电学问题是一维的, 但 3D 视图仍然能够清楚地可视化垂直层堆栈以及 参与载流子输运和复合的区域。
该二极管被实现为一系列垂直堆叠的硅层, 包括一个重掺杂的 p+ 区域、 一个较轻掺杂的 p 区域、 一个轻掺杂的 n 区域, 以及一个重掺杂的 n+ 区域。 这一结构在 Layer editor 中有明确列出 (见 ??), 其中每一层都分配了厚度、材料和电学角色。
中间的 p 和 n 层形成有源 PN 结。 在平衡状态下,一个耗尽区会在该界面附近形成,从而产生控制载流子分离和输运的内建电场。 薄而重掺杂的 p+ 和 n+ 层充当 低电阻接触区域,确保施加偏压主要降落在结上 而不是在接触处。
在接下来的章节中,该结构将被视为一个一维器件: 所有变化都沿生长方向求解,而横向变化被忽略。 尽管有这种简化,该模型仍能捕捉控制硅 PN 结二极管 暗态 I–V 行为的基本静电学、载流子输运 和复合物理,这些二极管嵌入在实际电子器件中。


3. 检查掺杂分布
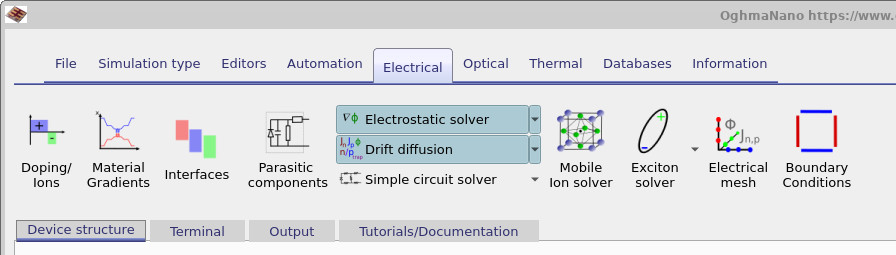
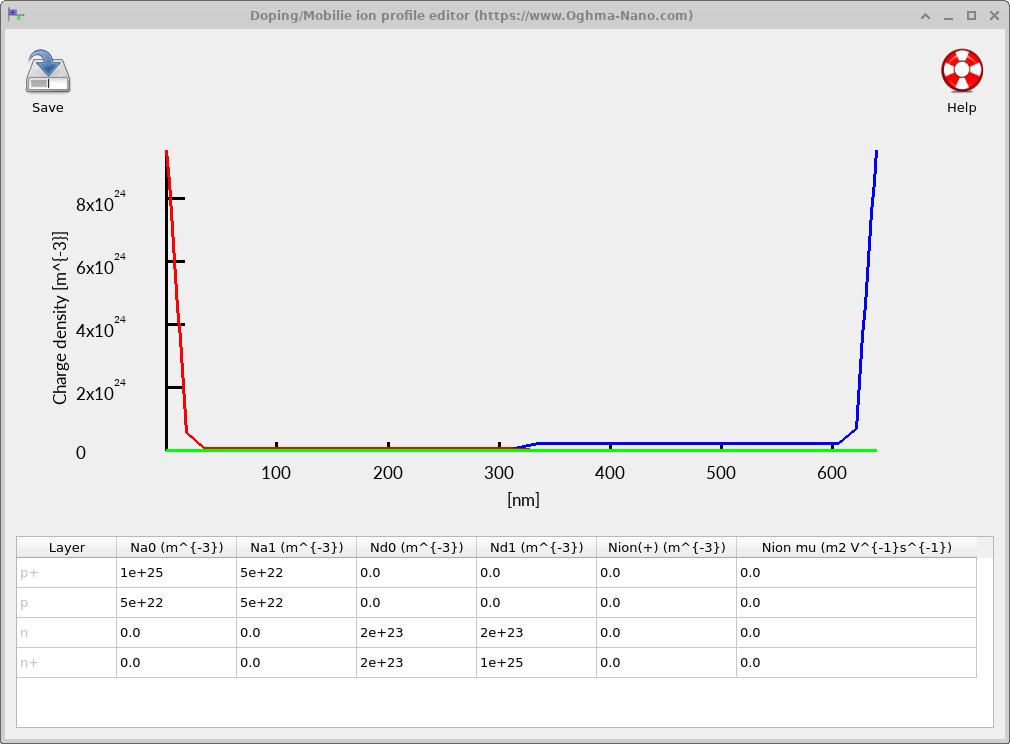
掺杂分布定义了硅 PN 结,因此决定了二极管的基本静电学。 它决定了结的位置、内建电势、耗尽宽度, 以及在平衡和偏压下形成的内部电场。
要查看掺杂配置,请从 Electrical 功能区中打开 Doping / Ions 编辑器 (见 ??)。 该编辑器显示了离化施主和受主随深度变化的空间分布 (见 ??)。
在本教程中,二极管采用常规的 p+/p/n/n+ 硅掺杂分布构建。 中间的 p 和 n 区域为中等掺杂,并形成有源 PN 结, 耗尽区和内建电场就在此处形成。
薄而重掺杂的 p+ 和 n+ 层充当 低电阻接触区域。 它们的作用是提供良好的载流子电注入和提取, 同时确保大部分施加电压降落在结本身 而非接触处。
对于本教程而言,关键检查只是确认器件中包含 一个主要受主掺杂区和一个主要施主掺杂区, 并且两者之间存在清晰过渡。 掺杂密度的精确数值主要影响耗尽宽度 和内建电场强度,这些将在后续章节中通过二极管的 暗态 I–V 特性间接体现。
4. 检查电学参数与复合机制
电学材料参数以逐区域方式定义,并控制整个二极管中的载流子输运、 复合和静电学。从主窗口通过 Device structure → Electrical parameters 打开电学参数编辑器。 器件堆栈中的每一层都有其自己的参数选项卡。 在本教程中,四个区域都使用相同的硅材料模型,但我们对它们的解释不同: p+ 和 n+ 充当低电阻接触区域,而 p 和 n 形成有源结。
图 ??– ?? 显示了各个区域 (p+、p、n、n+)的电学参数编辑器。 在该演示中,电子和空穴迁移率分别设置为约 0.135 和 0.048 m2V−1s−1 (例如见 ??)。 这些数值是晶体硅的典型值:它们远高于非晶硅或许多溶液加工半导体等无序或缺陷受限材料中的迁移率, 但低于 GaAs 等高迁移率 III–V 材料。 因此,本教程中的二极管行为主要由结静电学和复合控制, 而不是由体输运限制控制。
这里使用的有效态密度在编辑器中也可见 (例如 ??): 有效自由电子态密度设置为约 2.8×1025 m−3,有效自由空穴态密度设置为 1.04×1025 m−3。 这些参数设定了给定能带结构下的载流子统计和平衡载流子浓度,并通过 \(n\) 和 \(p\) 隐式进入复合与注入行为。
Shockley–Read–Hall(SRH)复合
SRH 复合描述通过带隙内电子态发生的缺陷辅助复合。 在 OghmaNano 中,这通过编辑器中所示的 equilibrium SRH trap 参数来控制 (见 ??): 一个陷阱能级 \(E_t\)(相对于中带隙)、一个陷阱密度 \(N_t\),以及电子和空穴捕获截面 \(\sigma_n\) 和 \(\sigma_p\)。 对于这里所示的设置,陷阱能级位于接近中带隙处(\(E_t \approx 0\)), 陷阱密度为 \(N_t \approx 10^{21}\,\mathrm{m^{-3}}\),捕获截面为 \(\sigma_n \approx \sigma_p \approx 10^{-21}\,\mathrm{m^2}\)。
这些微观参数通过下式定义 SRH 寿命:
\[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \]其中 \(v_{\mathrm{th}}\) 为热载流子速度。 因此,增加陷阱密度或捕获截面会降低载流子寿命 并增强复合。
在漂移–扩散形式中,得到的 SRH 复合速率为
\[ R_{\mathrm{SRH}} = \frac{np - n_i^2} {\tau_p (n + n_1) + \tau_n (p + p_1)} . \]在后续章节中,当你“扫描寿命”时,本质上是在改变由 \(N_t\)、\(\sigma_n\) 和 \(\sigma_p\) 编码的陷阱辅助复合强度。 当耗尽区内部及附近的复合控制注入载流子布居时, 会观察到最显著的影响,从而导致复合受限的正向偏压行为。
Auger 复合
Auger 复合是一种高载流子密度损耗机制,因此它在重掺杂的 p+ 和 n+ 接触区域中最相关。 在参数编辑器中,Auger 系数 \(C_n\) 和 \(C_p\) 被指定 (见 ?? 和 ??)。 对于这个硅演示,系数数量级约为 \(C_n \approx 2.8\times10^{-31}\,\mathrm{m^6\,s^{-1}}\) 和 \(C_p \approx 9.9\times10^{-32}\,\mathrm{m^6\,s^{-1}}\), 这是晶体硅的典型数值。
Auger 复合速率由下式给出
\[ R_{\mathrm{Auger}} = C_n n^2 p + C_p p^2 n . \]在实际中,Auger 复合会限制高注入下的载流子积累, 并确保接触区域表现为高效的载流子汇, 而不会在中等掺杂的结本身中主导复合物理。
静电学与能带参数
最后,用于定义硅的能带结构和静电学参数在每个区域选项卡中均可见 (例如 ??): 电子亲和势设置为约 \(\chi \approx 4.05\,\mathrm{eV}\),带隙为 \(E_g \approx 1.12\,\mathrm{eV}\), 相对介电常数为 \(\varepsilon_r \approx 11.7\)。




5. 运行仿真、暗态 I–V 曲线与参数提取
一旦器件结构、掺杂分布和电学参数都已定义好, 就可以直接从主窗口运行二极管仿真。 点击 Run simulation 以启动求解器。 在执行过程中,每个偏压点的收敛信息都会写入终端, 以便你监控求解器稳定性和进度 (见 ??)。


jv.csv 是主要关注的结果。
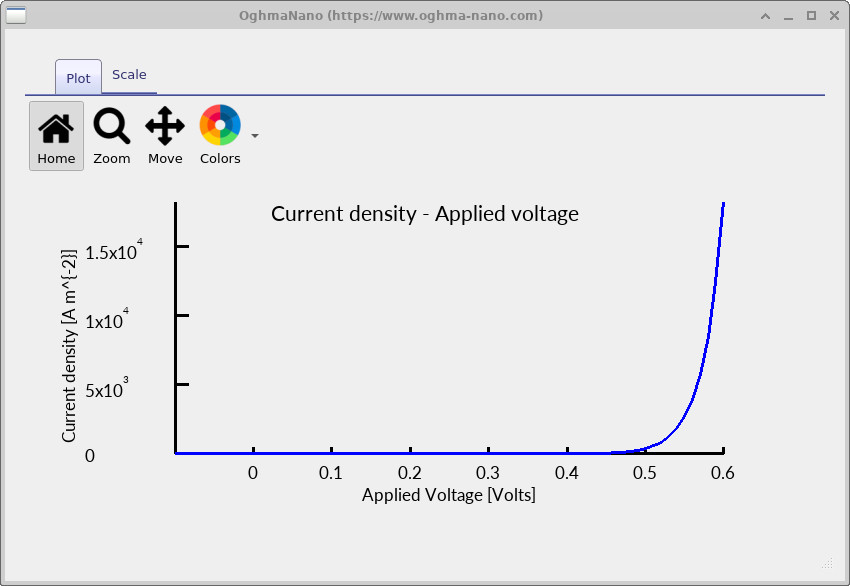
要检查二极管特性,请打开 Output 选项卡并双击
jv.csv
(见 ??)。
对于一个正确配置的硅二极管,I–V 曲线应当是平滑且单调的。
在反向偏压下,电流保持较小且对电压依赖较弱,
反映了复合受限的饱和行为。
在正向偏压下,电流会随施加电压迅速增加,
对应于跨越 PN 结的载流子注入。
正向偏压区的形状包含有用的物理信息。 在半对数图上,指数区的斜率可以用来提取 理想因子,以判断电流是由 扩散受限输运(\(n \approx 1\))还是复合受限过程 (\(n \approx 2\))所主导。 该区域的外推截距给出了 反向饱和电流的估计, 它与第 4 节中讨论的 SRH 和 Auger 复合参数直接相关。
实际上,一个经验规则是:在解释任何派生量之前,始终先检查 I–V 曲线。 电流中的不连续、意外符号约定或非物理跳变通常意味着 边界条件、偏压步进、复合设置或求解器收敛存在问题。 对于像这样简单的硅 PN 二极管,暗态 I–V 曲线应当在物理上直观, 并且易于解释。
6. 检查仿真快照:能带、复合与电流流动
在 I–V 扫描期间,OghmaNano 会将漂移–扩散方程的内部解 存储到 snapshots 目录中,对应每一个偏压点。 这些文件揭示了求解器对二极管内部的预测: 能带弯曲、准费米能级分裂、复合活性和电流输运。 检查这些量对于理解特定 I–V 特性为何出现至关重要。
在本节中,我们检查三个代表性偏压点: 接近平衡的反向偏压(−0.1 V)、 接近开启的中等正向偏压(≈0.45 V), 以及高正向偏压(0.8 V)。 这些快照共同展示了从平衡态、 到注入受限输运、 再到高注入工作状态的转变。
6.1 能带边缘与准费米能级
要重现实验中的能带图,请打开快照查看器并添加文件
Ec.csv、Ev.csv、Fn.csv 和 Fp.csv。
它们分别对应导带边缘、价带边缘、
电子准费米能级和空穴准费米能级。
在 −0.1 V 时(图 ??), 二极管接近平衡。 能带弯曲反映了由掺杂分布施加的内建电势, 而准费米能级几乎平坦并且重合, 表明净电流流动可以忽略。 耗尽区清晰可见,其对应于结处强烈能带弯曲的区域。在 ≈0.45 V 时(图 ??), 正向偏压降低了结势垒。 电子和空穴准费米能级在耗尽区两侧发生分裂, 这是载流子注入的内部标志。 这种准费米能级分离正是 I–V 曲线中 电流指数上升的直接原因。 在 0.8 V 时(图 ??), 结已经深度进入正向偏压。 势垒被显著抑制,准费米能级广泛分离, 器件工作在高注入状态,此时整个结构中的大部分区域 都具有较高载流子密度。

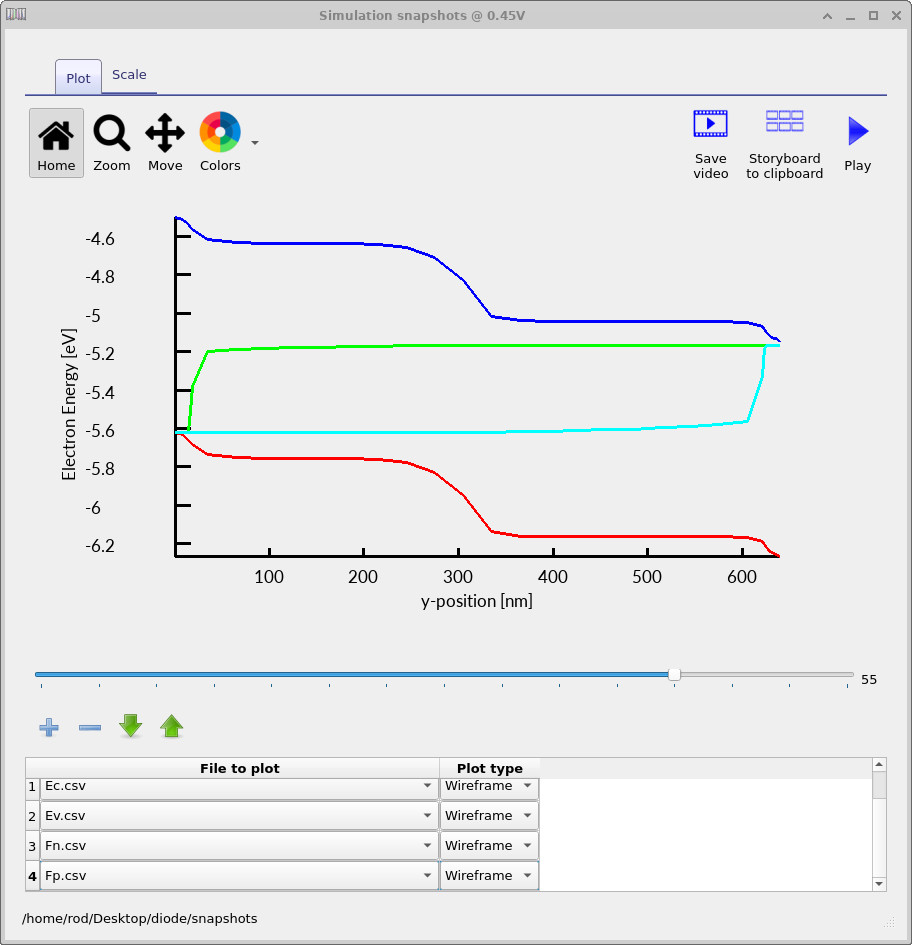
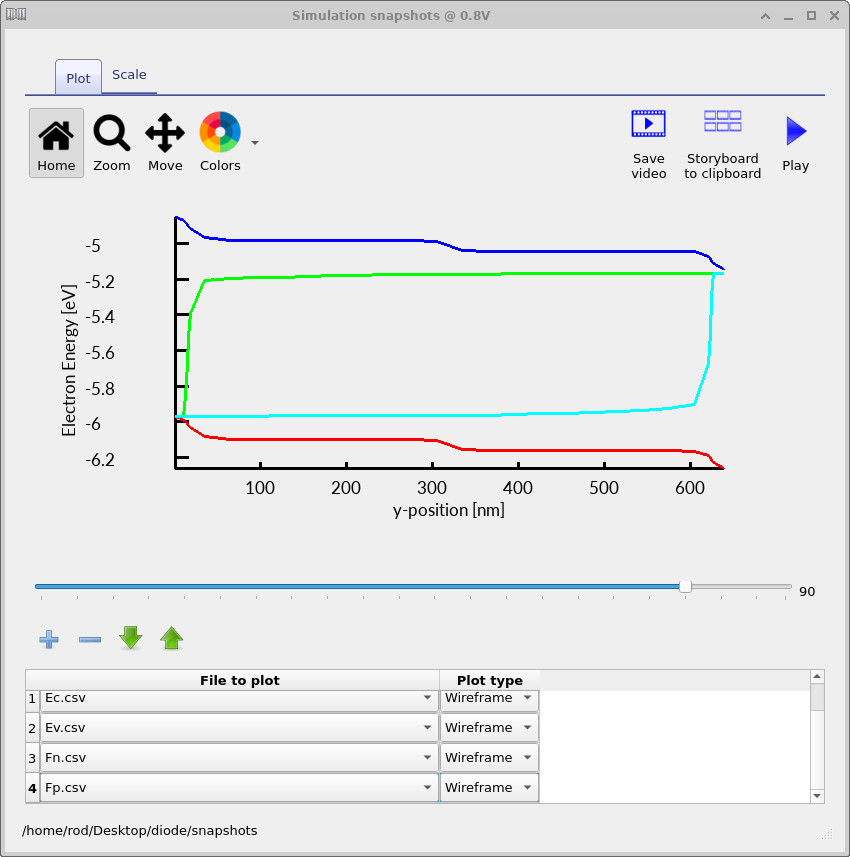
6.2 Shockley–Read–Hall 复合
要检查复合,请绘制 R_ss_srh.csv,它显示了二极管内部
空间分辨的 Shockley–Read–Hall 复合速率。
下方三张图对应于能带分析中使用的相同偏压点:
−0.1 V、≈0.45 V 和 0.8 V。
需要关注的关键点不是复合速率的绝对大小,
而是它的空间局域性如何随施加偏压而变化。
在 −0.1 V 时(图 ??), 二极管接近平衡。 电子主导 n 型一侧,空穴主导 p 型一侧, 因此显著复合只能发生在结周围那一窄区域中, 因为只有在那里两类载流子才会同时存在。 因此,SRH 复合速率强烈局域在器件中心, 与耗尽区重合。在 ≈0.45 V 时(图 ??), 正向偏压驱动载流子跨结注入,并提高 电子和空穴密度的局部乘积。 复合峰值在幅值上显著增长, 但它在空间上仍然局限于器件中心区域。 这表明,在这一偏压范围内,SRH 复合仍然主要是一个 以结为中心的过程, 由耗尽区及其附近的载流子重叠所控制。在 0.8 V 时(图 ??), 行为发生了定性变化。 载流子注入已经足够强,以至于电子和空穴在二极管的大部分区域中 都以高浓度存在。 SRH 复合速率不再局限于结附近, 而是扩展到器件的很大一部分区域。 这种空间展宽标志着高注入条件的开始, 此时复合不再只局限于狭窄的中心区域。
从尖锐局域的复合峰 到空间扩展的复合分布 的演化过程,清楚地展示了二极管如何从平衡态、 经过结受限工作状态, 过渡到整个结构中都发生复合的区间。 这种演化与能带图中看到的变化相呼应, 并支撑了正向 I–V 特性斜率的变化。


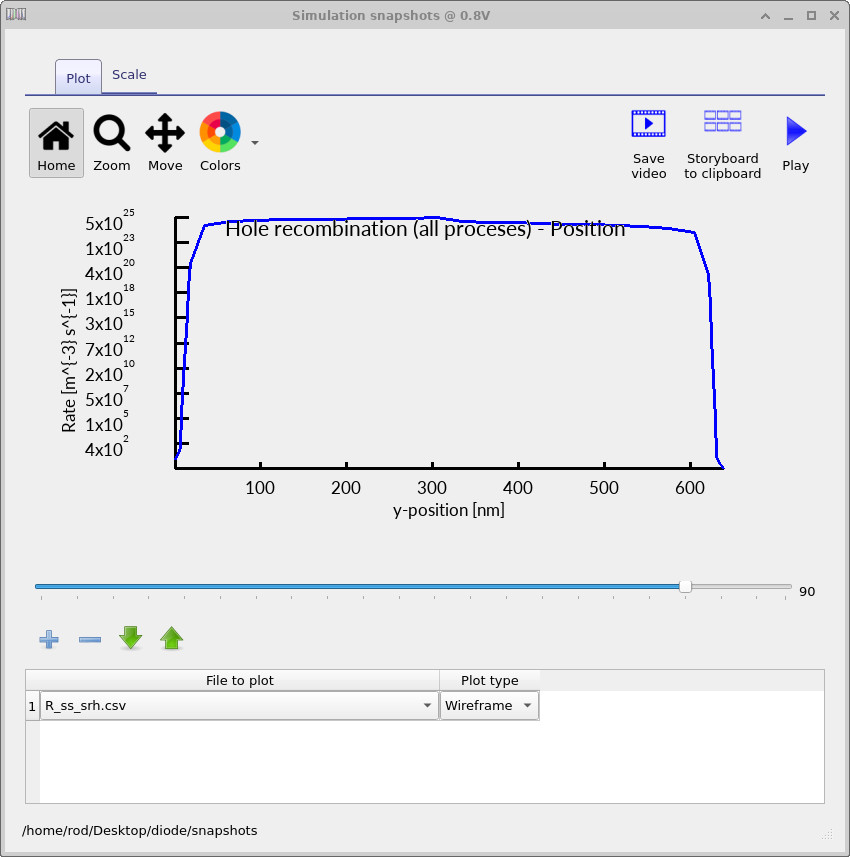
6.3 电子与空穴电流密度
最后,通过绘制 Jn.csv 和 Jp.csv 来检查载流子电流,
它们分别显示空间分辨的电子和空穴电流密度。
这些图直接展示了在不同偏压条件下电荷如何通过二极管输运,
以及器件如何从平衡态
过渡到稳态正向导通。
在 −0.1 V 时(图 ??), 二极管接近平衡,真实物理电流极小。 电子和空穴通量在整个器件中几乎彼此平衡, 因此净电流来源于两个几乎相等量的差值。 在这种情况下,数值问题本质上是病态的, 因此电流分布中的微小振荡或表观噪声是可以预期的。 这些特征来源于数值误差,并不对应真实载流子输运。在 ≈0.45 V 时(图 ??), 正向偏压驱动载流子跨结注入。 电子电流在 n 侧占主导,空穴电流在 p 侧占主导, 但两种电流在整个器件中都是连续的, 这反映了稳态电荷守恒。 相比近平衡情况,电流密度迅速增加, 但在结附近仍保留空间结构, 这与由复合控制的注入受限输运一致。在 0.8 V 时(图 ??), 二极管工作在深正向偏压下。 整个结构中的载流子密度都很高, 电子和空穴电流都变得很大、平滑,并且在准中性区域中几乎均匀。 在这一状态下,器件表现为一个强导通元件, 其电流主要受输运和复合限制,而不是受势垒注入限制。
综合来看,这些电流密度图给出了一个一致的二极管内部工作图景: 从平衡状态下电子和空穴通量的近乎完全相消, 经过注入受限的正向导通, 再到高正向偏压下的大电流稳态输运。


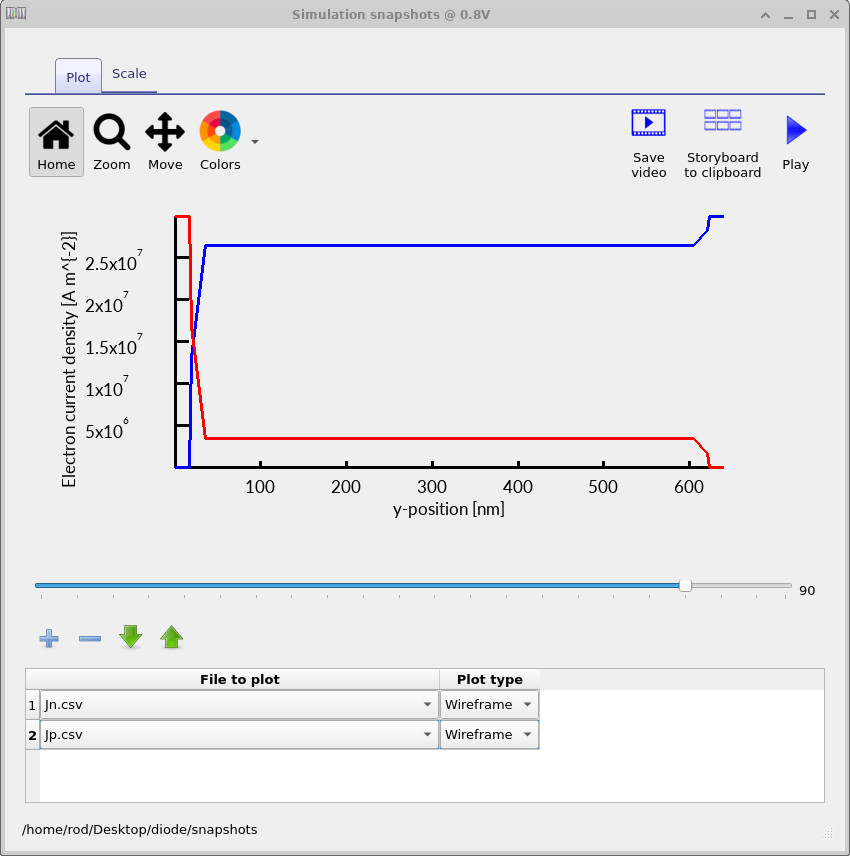
6.4 重掺杂区域中的 Auger 复合
可以通过绘制 R_auger.csv 来检查 Auger 复合,
该文件给出局部 Auger 复合速率随位置的变化。
与 SRH 复合不同,后者在电子和空穴以可比较密度共存时最强,
Auger 复合对载流子密度具有强烈依赖,
因此会在重掺杂区域中占主导。



在很低的偏压下(图 ??), 在 p+ 和 n+ 接触层中已经可以观察到 Auger 复合。 即使在近平衡时,这也是会发生的,因为这些区域本来就是故意 重掺杂的,从而使载流子浓度足够高, 使三粒子(Auger)过程在局部占主导。
当二极管被驱动进入正向偏压时(图 ??), Auger 复合速率会在幅值上迅速增加,但仍然 空间局限于接触区域。 这种局域性反映了 Auger 复合对密度的强依赖: 尽管载流子跨结注入,但最高载流子 密度仍然位于简并接触层中。
在高正向偏压下(图 ??), 接触中的 Auger 复合会变得极大, 在幅值上远超 SRH 复合。 这种行为是预期的,并且在物理上是正确的。 此处 Auger 复合的作用并不是直接限制结电流, 而是防止在高注入下那些载流子密度 否则会无限增长的区域中出现非物理的载流子积累。
重要的是,尽管 Auger 复合速率在数值上远大于 SRH 速率,但它并不主导二极管的理想因子或 开启行为。 这些特征仍然主要由耗尽区内部及其附近的复合控制。 相反,Auger 复合作为接触层中的一种高密度稳定化机制, 保证了大电流下的真实行为。

