Diodo de Junção PN de Silício (1D) — Drift–Diffusion (I–V no Escuro, Recombinação SRH)
1. Introdução
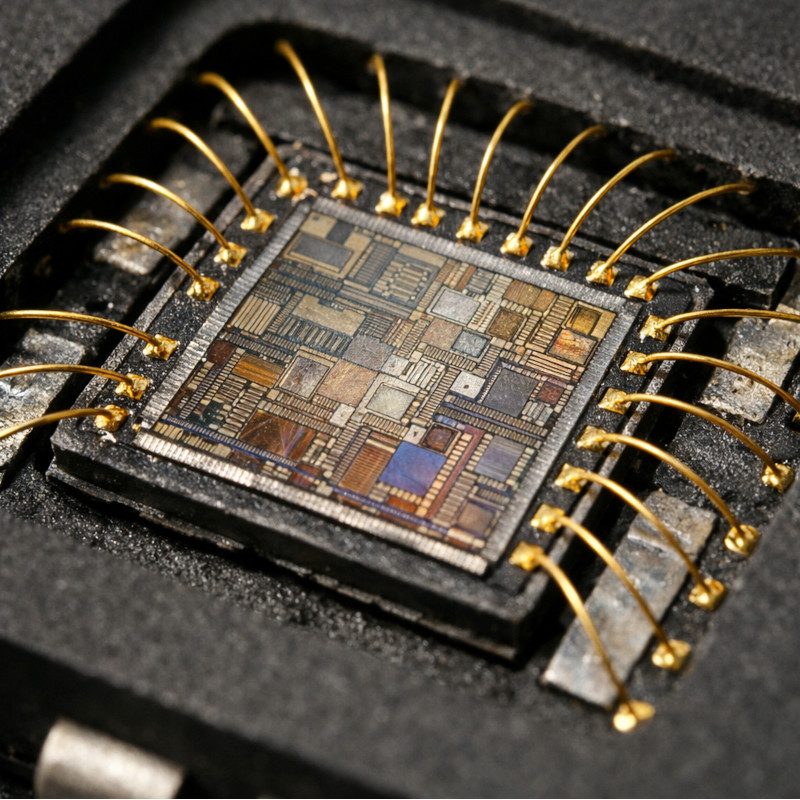
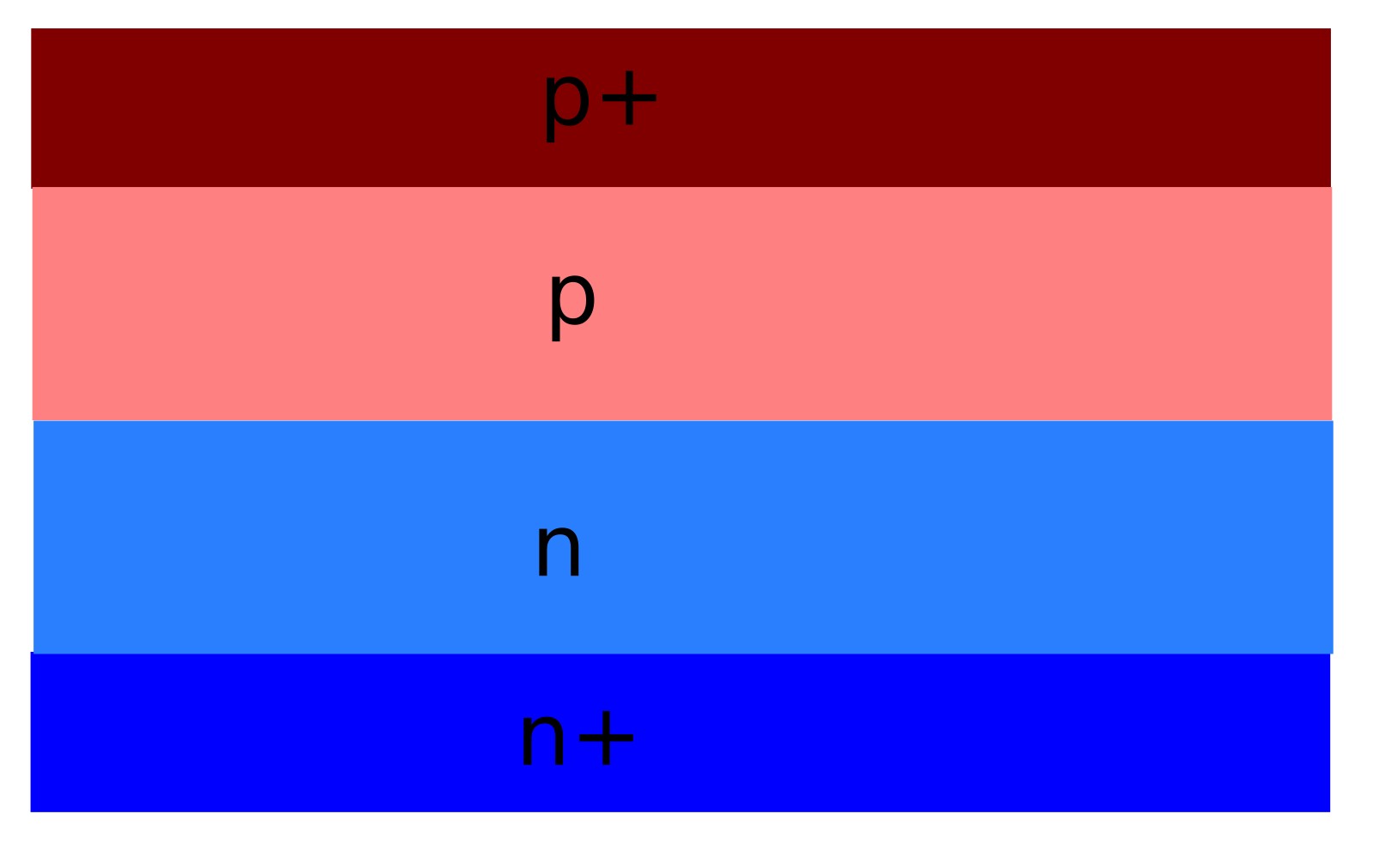
O diodo de junção PN de silício é o dispositivo semicondutor canônico. Ele aparece explicitamente como componente discreto e implicitamente em quase todo sistema eletrônico integrado, desde retificadores de potência até circuitos lógicos e analógicos. Um contexto de aplicação representativo é mostrado em ??, onde as junções PN estão embutidas em um circuito integrado, em vez de serem usadas como dispositivos isolados.
Embora o dispositivo simulado neste tutorial seja simples, ele deve ser entendido como um bloco construtivo primitivo. A mesma física de junção governa dispositivos conectados como diodos, junções de transistores e estruturas de isolamento dentro de tecnologias integradas de silício. A estrutura de dopagem em camadas usada aqui é ilustrada esquematicamente em ??.
Neste tutorial, você simulará um diodo de junção PN de silício em uma dimensão usando o solver acoplado de drift–diffusion + Poisson do OghmaNano. Em vez de depender apenas da equação ideal de Shockley, essa abordagem resolve o campo elétrico interno, a região de depleção, e as distribuições espaciais de densidades e correntes de portadores.
O tratamento explícito da física de recombinação—em particular da recombinação Shockley–Read–Hall (SRH)—torna possível conectar mudanças na dopagem e no tempo de vida diretamente a mudanças no comportamento de turn-on e na idealidade. Você irá gerar uma curva I–V no escuro, inspecionar as bordas de banda e os níveis de quase-Fermi sob polarização, e então realizar uma varredura de tempo de vida para identificar regimes limitados por recombinação na resposta do diodo.
2. Criando uma nova simulação
Para começar, crie uma nova simulação a partir da janela principal do OghmaNano. Clique no botão Nova simulação na barra de ferramentas. Isso abre a caixa de diálogo de seleção do tipo de simulação (veja ??).
Na caixa de diálogo de tipo de simulação, clique duas vezes em Si demos e então selecione o exemplo de junção/diodo de silício (veja ??). O OghmaNano carregará uma estrutura de junção de silício predefinida, que trataremos como um diodo PN.
A estrutura do dispositivo carregado é mostrada na janela principal de simulação (veja ??). Embora o problema elétrico resolvido neste tutorial seja unidimensional, a visualização 3D fornece uma visualização clara do empilhamento vertical de camadas e das regiões que participam do transporte de portadores e da recombinação.
O diodo é implementado como uma sequência de camadas verticais empilhadas de silício, consistindo em uma região p+ fortemente dopada, uma região p mais fracamente dopada, uma região n fracamente dopada, e uma região n+ fortemente dopada. Essa estrutura é listada explicitamente no Editor de camadas (veja ??), onde cada camada recebe uma espessura, um material e uma função elétrica.
As camadas centrais p e n formam a junção PN ativa. Em equilíbrio, uma região de depleção se desenvolve através dessa interface, dando origem ao campo elétrico interno que controla a separação e o transporte de portadores. As finas camadas p+ e n+ fortemente dopadas atuam como regiões de contato de baixa resistência, garantindo que a polarização aplicada caia principalmente sobre a junção e não nos contatos.
Nas seções a seguir, essa estrutura será tratada como um dispositivo unidimensional: todas as variações são resolvidas ao longo da direção de crescimento, enquanto as variações laterais são desprezadas. Apesar dessa simplificação, o modelo captura a eletrostática essencial, o transporte de portadores, e a física de recombinação que governam o comportamento I–V no escuro de diodos de junção PN de silício incorporados em dispositivos eletrônicos práticos.


3. Examinando o perfil de dopagem
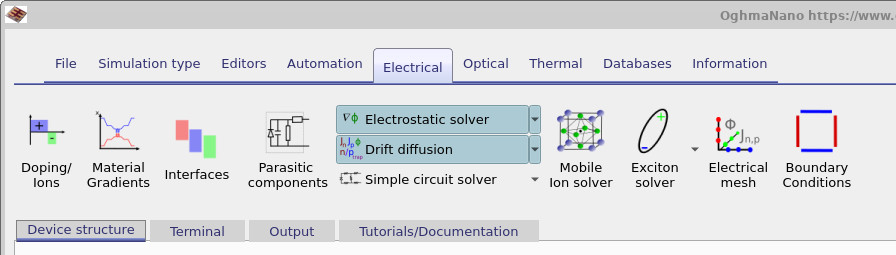
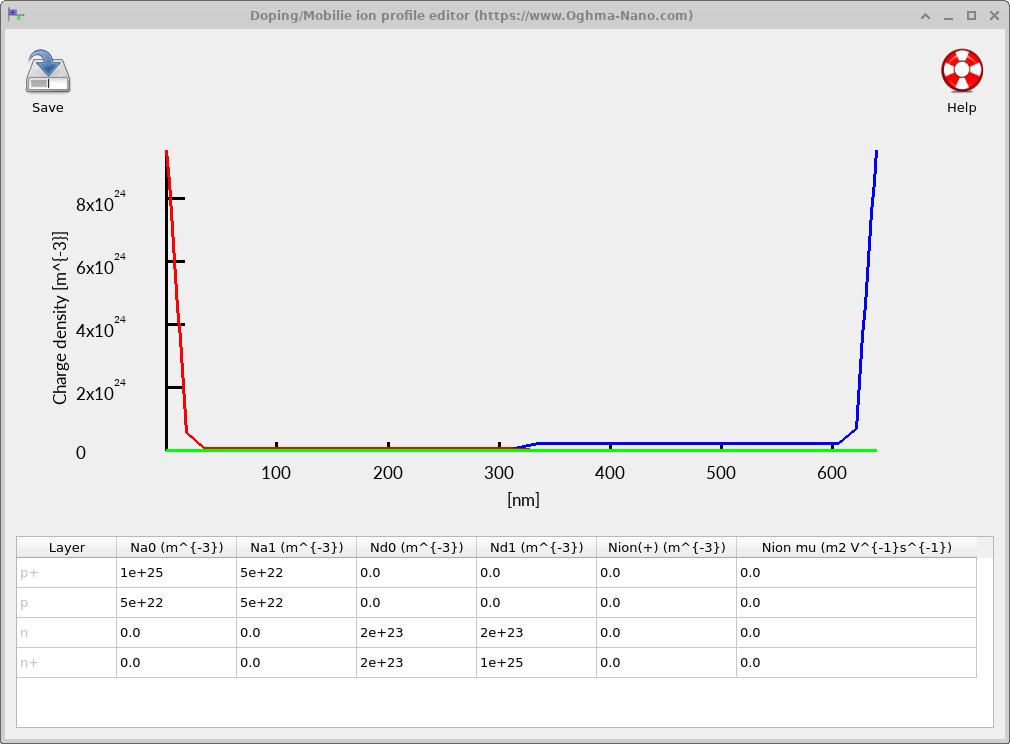
O perfil de dopagem define o diodo de junção PN de silício e, portanto, determina a eletrostática fundamental do diodo. Ele determina a posição da junção, o potencial interno, a largura de depleção, e o campo elétrico interno que se desenvolve em equilíbrio e sob polarização.
Para visualizar a configuração de dopagem, abra o editor Dopagem / Íons a partir da faixa Elétrica (veja ??). O editor mostra a distribuição espacial de doadores e aceitadores ionizados em função da profundidade (veja ??).
Neste tutorial, o diodo é construído usando um perfil de dopagem de silício convencional p+/p/n/n+. As regiões centrais p e n são moderadamente dopadas e formam a junção PN ativa, onde se desenvolvem a região de depleção e o campo elétrico interno.
As finas camadas p+ e n+ fortemente dopadas atuam como regiões de contato de baixa resistência. O papel delas é fornecer boa injeção e extração elétrica de portadores, garantindo ao mesmo tempo que a maior parte da tensão aplicada caia sobre a própria junção e não nos contatos.
Para os propósitos deste tutorial, a verificação principal é simplesmente confirmar que o dispositivo contém uma região predominantemente dopada com aceitadores e uma região predominantemente dopada com doadores, com uma transição clara entre elas. Os valores numéricos exatos das densidades de dopagem afetam principalmente a largura de depleção e a intensidade do campo interno, que serão exploradas indiretamente por meio das características I–V no escuro do diodo nas seções posteriores.
4. Examinando os parâmetros elétricos e os mecanismos de recombinação
Os parâmetros elétricos do material são definidos por região e controlam o transporte de portadores, a recombinação e a eletrostática em todo o diodo. Abra o editor de parâmetros elétricos a partir da janela principal por Estrutura do dispositivo → Parâmetros elétricos. Cada camada na pilha do dispositivo possui sua própria aba de parâmetros. Neste tutorial usamos o mesmo modelo de material de silício nas quatro regiões, mas as interpretamos de forma diferente: p+ e n+ atuam como regiões de contato de baixa resistência, enquanto p e n formam a junção ativa.
As Figuras ??– ?? mostram o editor de parâmetros elétricos para cada região (p+, p, n, n+). Nesta demonstração, as mobilidades de elétrons e lacunas são definidas como aproximadamente 0.135 e 0.048 m2V−1s−1, respectivamente (veja, por exemplo, ??). Esses valores são típicos do silício cristalino: são muito maiores do que os encontrados em materiais desordenados ou limitados por defeitos como o silício amorfo ou muitos semicondutores processados em solução, mas menores do que em materiais III–V de alta mobilidade como o GaAs. Como resultado, o comportamento do diodo neste tutorial é controlado principalmente pela eletrostática da junção e pela recombinação, e não por limitações de transporte no volume.
As densidades efetivas de estados usadas aqui também são visíveis no editor (por exemplo ??): a densidade efetiva de estados de elétrons livres é definida como aproximadamente 2.8×1025 m−3 e a densidade efetiva de estados de lacunas livres como 1.04×1025 m−3. Esses parâmetros definem a estatística de portadores e as concentrações de portadores em equilíbrio para uma dada estrutura de bandas, e entram implicitamente no comportamento de recombinação e injeção por meio de \(n\) e \(p\).
Recombinação Shockley–Read–Hall (SRH)
A recombinação SRH captura a recombinação mediada por defeitos por meio de estados eletrônicos na banda proibida. No OghmaNano isso é controlado usando os parâmetros de armadilha SRH em equilíbrio mostrados no editor (veja ??): uma energia de armadilha \(E_t\) (relativa ao meio da banda proibida), uma densidade de armadilhas \(N_t\), e seções de choque de captura de elétrons e lacunas \(\sigma_n\) e \(\sigma_p\). Para as configurações mostradas aqui, a energia da armadilha está próxima do meio da banda proibida (\(E_t \approx 0\)), a densidade de armadilhas é \(N_t \approx 10^{21}\,\mathrm{m^{-3}}\), e as seções de choque de captura são \(\sigma_n \approx \sigma_p \approx 10^{-21}\,\mathrm{m^2}\).
Esses parâmetros microscópicos definem os tempos de vida SRH por meio de
\[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \]onde \(v_{\mathrm{th}}\) é a velocidade térmica dos portadores. Aumentar a densidade de armadilhas ou as seções de choque de captura, portanto, reduz o tempo de vida dos portadores e intensifica a recombinação.
Na forma de drift–diffusion, a taxa de recombinação SRH resultante é
\[ R_{\mathrm{SRH}} = \frac{np - n_i^2} {\tau_p (n + n_1) + \tau_n (p + p_1)} . \]Nas seções posteriores, quando você “varrer o tempo de vida”, estará efetivamente modificando a intensidade da recombinação assistida por armadilhas codificada por \(N_t\), \(\sigma_n\) e \(\sigma_p\). O impacto mais forte é observado quando a recombinação na região de depleção e próxima a ela controla a população de portadores injetados, levando a um comportamento em polarização direta limitado por recombinação.
Recombinação Auger
A recombinação Auger é um mecanismo de perda em alta densidade de portadores e, portanto, é mais relevante nas regiões de contato p+ e n+ fortemente dopadas. No editor de parâmetros, os coeficientes de Auger \(C_n\) e \(C_p\) são especificados (veja ?? e ??). Para esta demonstração de silício, os coeficientes são da ordem de \(C_n \approx 2.8\times10^{-31}\,\mathrm{m^6\,s^{-1}}\) e \(C_p \approx 9.9\times10^{-32}\,\mathrm{m^6\,s^{-1}}\), que são valores típicos para o silício cristalino.
A taxa de recombinação Auger é dada por
\[ R_{\mathrm{Auger}} = C_n n^2 p + C_p p^2 n . \]Na prática, a recombinação Auger limita o acúmulo de portadores em alta injeção e garante que as regiões de contato se comportem como sumidouros eficientes para portadores, sem dominar a física de recombinação na própria junção moderadamente dopada.
Eletrostática e parâmetros de banda
Finalmente, os parâmetros de estrutura de bandas e eletrostáticos usados para definir o silício são visíveis em cada aba de região (por exemplo ??): a afinidade eletrônica é definida como aproximadamente \(\chi \approx 4.05\,\mathrm{eV}\), o gap de banda como \(E_g \approx 1.12\,\mathrm{eV}\), e a permissividade relativa como \(\varepsilon_r \approx 11.7\).




5. Executando a simulação, curvas I–V no escuro e extração de parâmetros
Quando a estrutura do dispositivo, o perfil de dopagem e os parâmetros elétricos estiverem definidos, a simulação do diodo pode ser executada diretamente a partir da janela principal. Clique em Executar simulação para iniciar o solver. Durante a execução, as informações de convergência para cada ponto de polarização são gravadas no terminal, permitindo monitorar a estabilidade do solver e o progresso (veja ??).


jv.csv é o principal resultado de interesse.
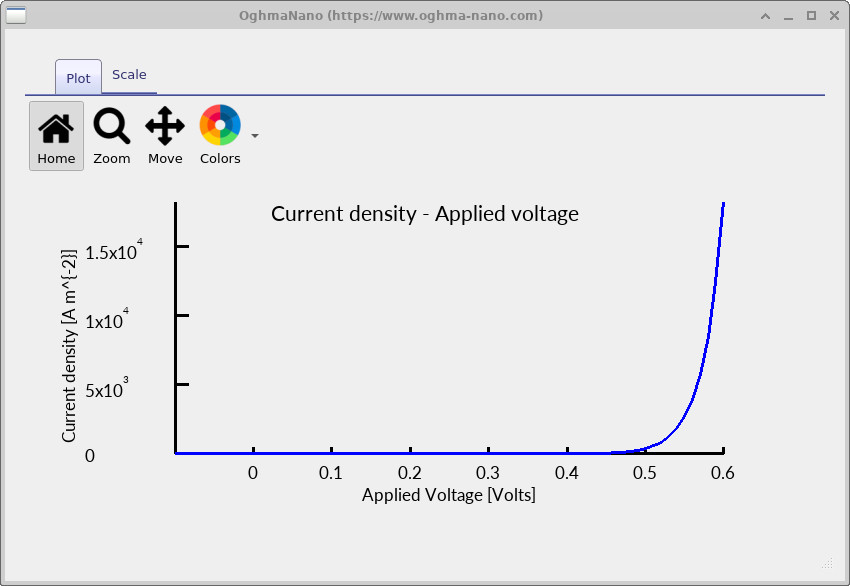
Para inspecionar a característica do diodo, abra a aba Saída e clique duas vezes em
jv.csv
(veja ??).
Para um diodo de silício corretamente configurado, a curva I–V deve ser suave e monotônica.
Em polarização reversa, a corrente permanece pequena e fracamente dependente da tensão,
refletindo uma saturação limitada por recombinação.
Em polarização direta, a corrente aumenta rapidamente com a tensão aplicada,
correspondendo à injeção de portadores através da junção PN.
A forma da região de polarização direta contém informações físicas úteis. Em um gráfico semilogarítmico, a inclinação da região exponencial pode ser usada para extrair um fator de idealidade, indicando se a corrente é dominada por transporte limitado por difusão (\(n \approx 1\)) ou por processos limitados por recombinação (\(n \approx 2\)). A interseção extrapolada dessa região fornece uma estimativa da corrente de saturação reversa, que está diretamente ligada aos parâmetros de recombinação SRH e Auger discutidos na Seção 4.
Como regra prática, sempre inspecione a curva I–V antes de interpretar quaisquer quantidades derivadas. Descontinuidades, convenções de sinal inesperadas ou saltos não físicos na corrente normalmente indicam problemas com condições de contorno, incrementos de polarização, configurações de recombinação ou convergência do solver. Para um diodo PN de silício simples como este, a curva I–V no escuro deve ser fisicamente intuitiva e fácil de interpretar.
6. Examinando instantâneos da simulação: bandas, recombinação e fluxo de corrente
Durante uma varredura I–V, o OghmaNano armazena a solução interna das equações de drift–diffusion em cada ponto de polarização no diretório snapshots. Esses arquivos mostram o que o solver está prevendo dentro do diodo: curvatura de bandas, separação dos níveis de quase-Fermi, atividade de recombinação e transporte de corrente. Examinar essas quantidades é essencial para entender por que uma determinada característica I–V emerge.
Nesta seção, inspecionamos três pontos de polarização representativos: uma polarização reversa próxima do equilíbrio (−0.1 V), uma polarização direta moderada próxima do turn-on (≈0.45 V), e uma polarização direta alta (0.8 V). Juntos, esses instantâneos ilustram a transição do equilíbrio, passando pelo transporte limitado por injeção, até a operação em alta injeção.
6.1 Bordas de banda e níveis de quase-Fermi
Para reproduzir os diagramas de bandas, abra o visualizador de snapshots e adicione os arquivos
Ec.csv, Ev.csv, Fn.csv, e Fp.csv.
Eles correspondem, respectivamente, à borda da banda de condução, à borda da banda de valência,
ao nível de quase-Fermi dos elétrons e ao nível de quase-Fermi das lacunas.
Em −0.1 V (Figura ??), o diodo está próximo do equilíbrio. A curvatura de bandas reflete o potencial interno imposto pelo perfil de dopagem, e os níveis de quase-Fermi são quase planos e coincidentes, indicando fluxo de corrente líquida desprezível. A região de depleção é claramente visível como a região de forte curvatura de bandas na junção. Em ≈0.45 V (Figura ??), a polarização direta reduz a barreira da junção. Os níveis de quase-Fermi de elétrons e lacunas se separam através da região de depleção, o que é a assinatura interna da injeção de portadores. Essa separação dos níveis de quase-Fermi é diretamente responsável pelo aumento exponencial da corrente observado na curva I–V. Em 0.8 V (Figura ??), a junção está profundamente em polarização direta. A barreira é fortemente suprimida, os níveis de quase-Fermi estão amplamente separados, e o dispositivo opera em um regime de alta injeção em que as densidades de portadores são grandes em grande parte da estrutura.

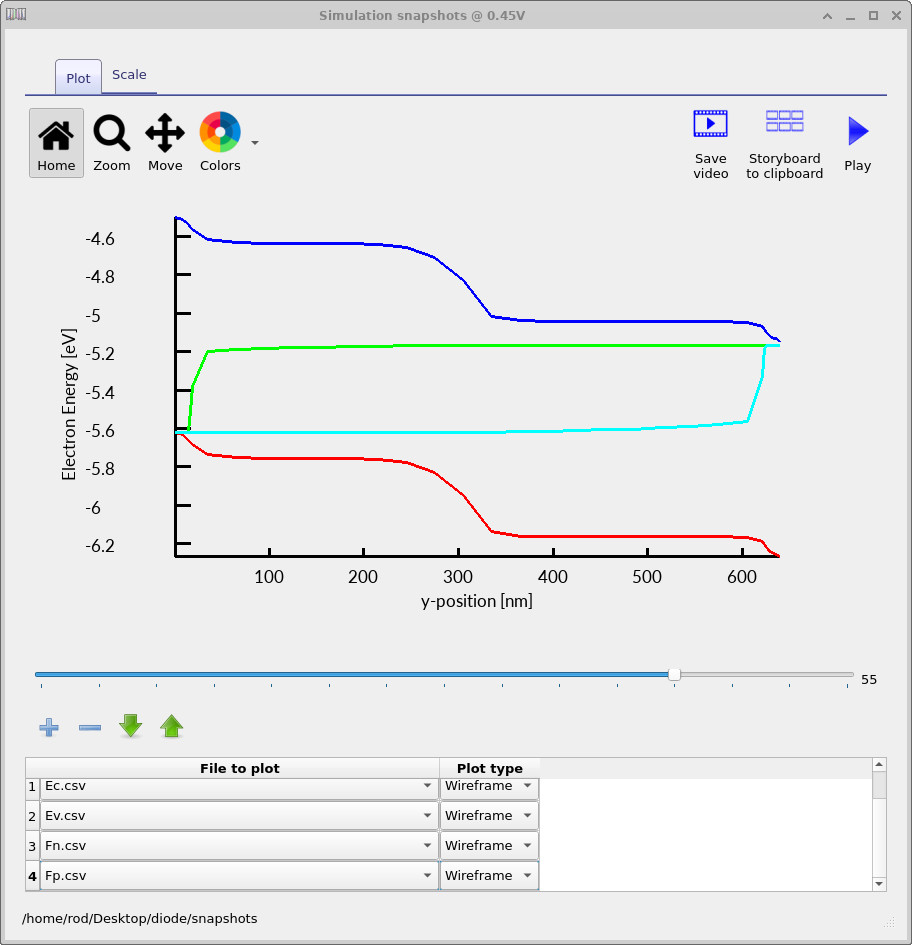
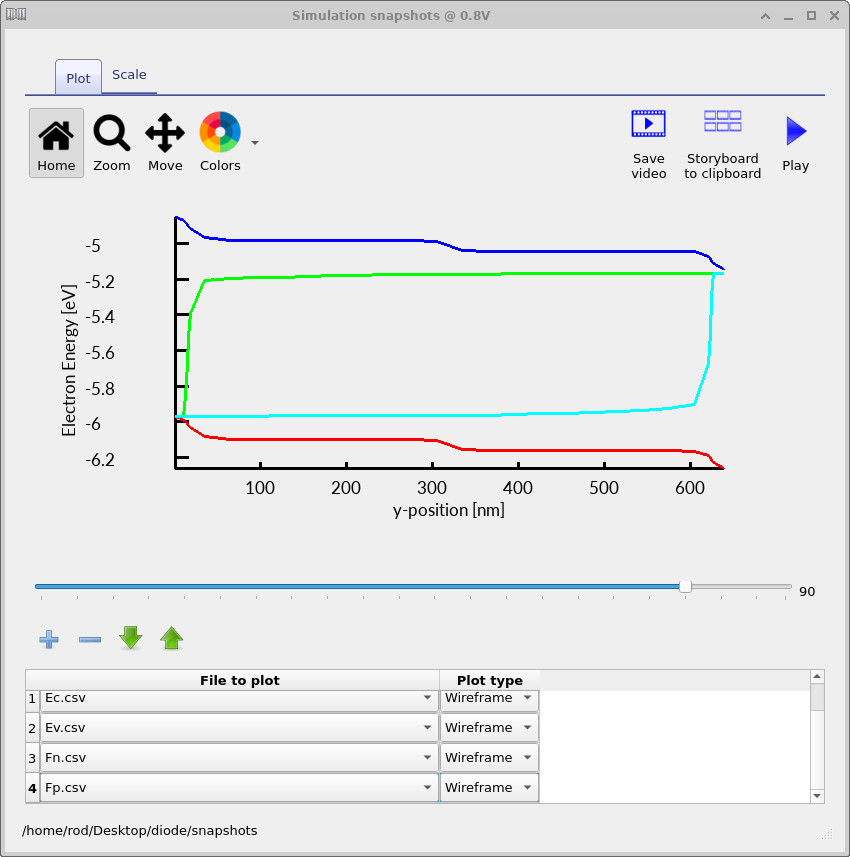
6.2 Recombinação Shockley–Read–Hall
Para examinar a recombinação, plote R_ss_srh.csv, que mostra a taxa de recombinação
Shockley–Read–Hall resolvida espacialmente dentro do diodo.
Os três gráficos abaixo correspondem aos mesmos pontos de polarização usados na análise do diagrama de bandas:
−0.1 V, ≈0.45 V e 0.8 V.
O ponto principal a observar não é a magnitude absoluta da taxa de recombinação,
mas como sua localização espacial muda com a polarização aplicada.
Em −0.1 V (Figura ??), o diodo está próximo do equilíbrio. Elétrons dominam o lado do tipo n e lacunas dominam o lado do tipo p, de modo que recombinação significativa só pode ocorrer na região estreita ao redor da junção onde ambos os tipos de portadores estão presentes simultaneamente. Como resultado, a taxa de recombinação SRH é fortemente localizada no centro do dispositivo, coincidindo com a região de depleção. Em ≈0.45 V (Figura ??), a polarização direta injeta portadores através da junção e aumenta o produto local das densidades de elétrons e lacunas. O pico de recombinação cresce substancialmente em magnitude, mas permanece espacialmente confinado à região central do dispositivo. Isso indica que, nessa faixa de polarização, a recombinação SRH ainda é principalmente um processo centrado na junção, controlado pela sobreposição de portadores na região de depleção e próximo a ela. Em 0.8 V (Figura ??), o comportamento muda qualitativamente. A injeção de portadores é suficientemente forte para que elétrons e lacunas estejam presentes em altas concentrações em grande parte do diodo. A taxa de recombinação SRH não fica mais confinada à junção, mas se espalha por uma grande fração do dispositivo. Esse alargamento espacial sinaliza o início de condições de alta injeção, em que a recombinação não está mais limitada a uma região central estreita.
A progressão de um pico de recombinação fortemente localizado para um perfil de recombinação espacialmente estendido fornece uma imagem interna clara de como o diodo transita do equilíbrio, passando pela operação limitada pela junção, até um regime em que a recombinação ocorre em toda a estrutura. Essa evolução reflete as mudanças vistas nos diagramas de bandas e sustenta a mudança de inclinação da característica I–V em polarização direta.


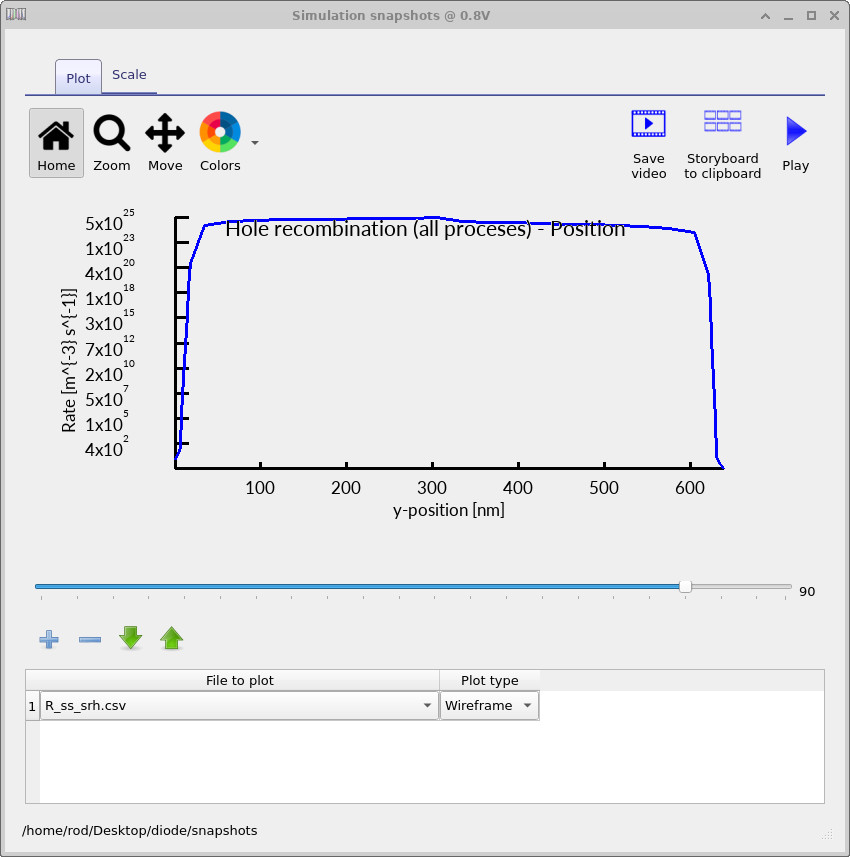
6.3 Densidades de corrente de elétrons e lacunas
Por fim, inspecione as correntes de portadores plotando Jn.csv e Jp.csv,
que mostram, respectivamente, as densidades de corrente de elétrons e lacunas resolvidas espacialmente.
Esses gráficos fornecem uma visão direta de como a carga é transportada através do diodo
sob diferentes condições de polarização e de como o dispositivo transita do equilíbrio
para a condução em regime estacionário em polarização direta.
Em −0.1 V (Figura ??), o diodo está próximo do equilíbrio e a corrente física real é extremamente pequena. Os fluxos de elétrons e lacunas estão quase equilibrados em todo o dispositivo, de modo que a corrente líquida surge da diferença entre duas quantidades quase iguais. Nesse regime, o problema numérico é intrinsecamente mal condicionado, e pequenas oscilações ou ruído aparente nos perfis de corrente são esperados. Essas características são de origem numérica e não correspondem a transporte real de portadores. Em ≈0.45 V (Figura ??), a polarização direta impulsiona a injeção de portadores através da junção. A corrente de elétrons domina no lado n e a corrente de lacunas domina no lado p, mas ambas as correntes são contínuas através do dispositivo, refletindo conservação de carga em regime estacionário. A densidade de corrente aumenta rapidamente em comparação com o caso próximo do equilíbrio, mas permanece espacialmente estruturada perto da junção, consistente com transporte limitado por injeção controlado pela recombinação. Em 0.8 V (Figura ??), o diodo opera profundamente em polarização direta. As densidades de portadores são altas em toda a estrutura, e as correntes de elétrons e lacunas tornam-se grandes, suaves e quase uniformes através das regiões quase neutras. Nesse regime, o dispositivo se comporta como um elemento fortemente condutor, com corrente limitada principalmente por transporte e recombinação, em vez de injeção sobre barreira.
Em conjunto, esses gráficos de densidade de corrente fornecem uma imagem interna consistente da operação do diodo: desde o cancelamento quase perfeito dos fluxos de elétrons e lacunas em equilíbrio, passando pela condução direta limitada por injeção, até o transporte em regime estacionário de alta corrente em grande polarização direta.


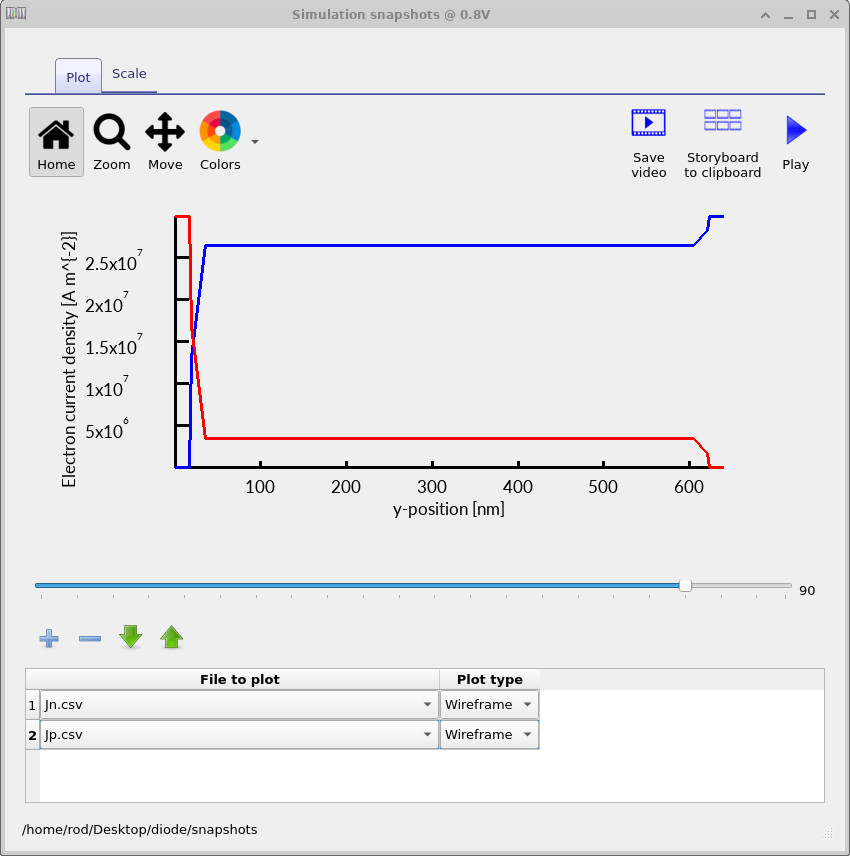
6.4 Recombinação Auger em regiões fortemente dopadas
A recombinação Auger pode ser examinada plotando R_auger.csv,
que informa a taxa local de recombinação Auger em função da posição.
Diferentemente da recombinação SRH, que é mais forte onde elétrons e lacunas coexistem
em densidades comparáveis, a recombinação Auger escala fortemente com a densidade de portadores
e, portanto, torna-se dominante em regiões fortemente dopadas.



Em polarização muito baixa (Figura ??), a recombinação Auger já é visível nas camadas de contato p+ e n+. Isso ocorre mesmo próximo do equilíbrio porque essas regiões são intencionalmente fortemente dopadas, resultando em concentrações de portadores altas o suficiente para que processos de três partículas (Auger) dominem localmente.
À medida que o diodo é levado à polarização direta (Figura ??), a taxa de recombinação Auger aumenta rapidamente em magnitude, mas permanece espacialmente confinada às regiões de contato. Essa localização reflete a forte dependência com a densidade da recombinação Auger: embora portadores sejam injetados através da junção, as maiores densidades de portadores ainda residem nas camadas de contato degeneradas.
Em alta polarização direta (Figura ??), a recombinação Auger torna-se extremamente grande nos contatos, superando em muito a recombinação SRH em magnitude. Esse comportamento é esperado e fisicamente correto. O papel da recombinação Auger aqui não é limitar diretamente a corrente da junção, mas impedir acúmulo não físico de portadores em regiões onde a densidade de portadores de outra forma cresceria sem limite sob alta injeção.
É importante notar que, embora a taxa de recombinação Auger seja numericamente muito maior do que a taxa SRH, ela não domina a idealidade do diodo nem o comportamento de turn-on. Essas características ainda são controladas principalmente pela recombinação na região de depleção e próxima dela. A recombinação Auger atua, em vez disso, como um mecanismo de estabilização em alta densidade nas camadas de contato, garantindo comportamento realista em correntes elevadas.

