NMOS 电容教程(Part A):2D 中的静电学与耗尽
1. 引言
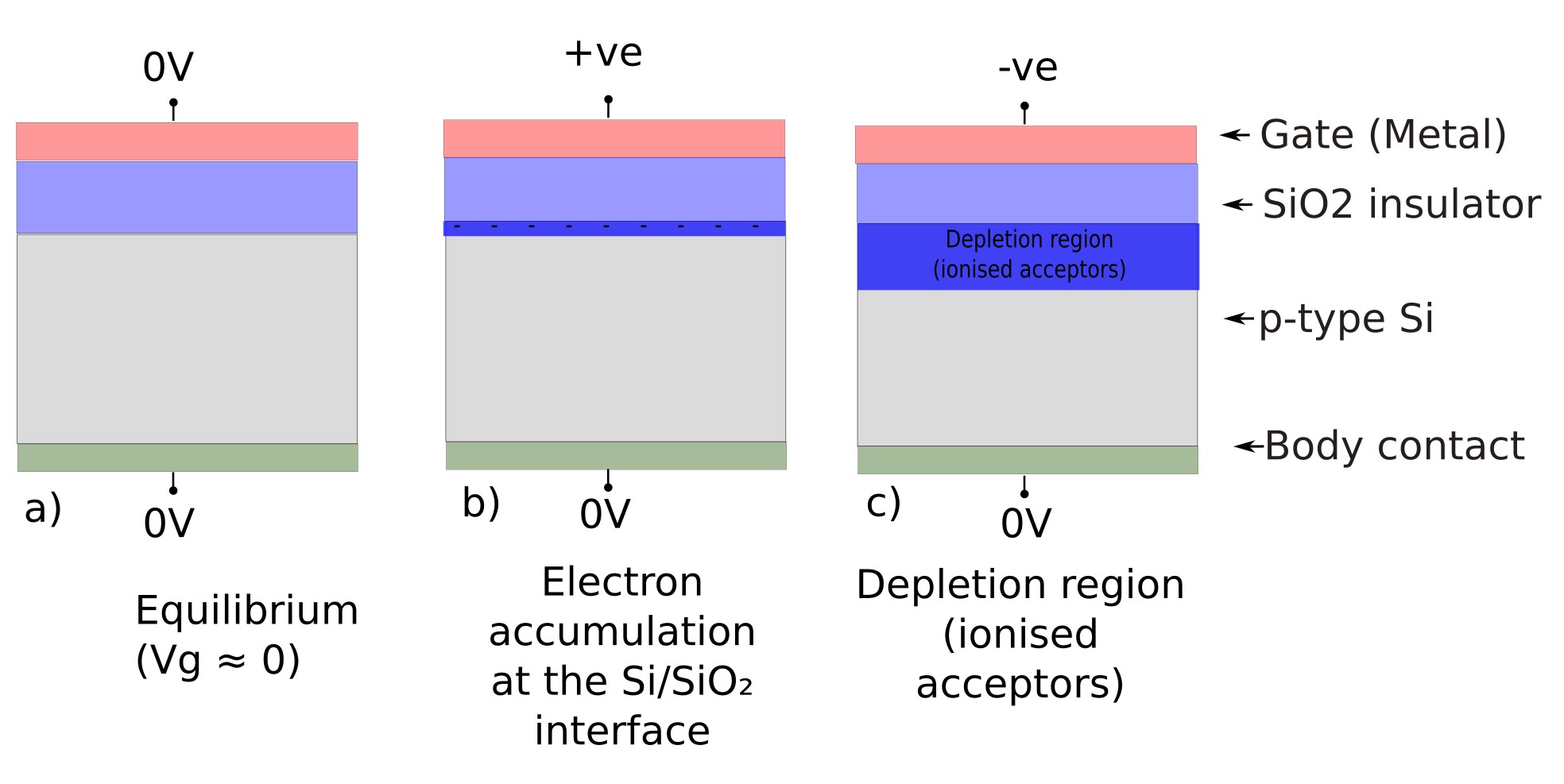
MOSFET(金属–氧化物–半导体场效应晶体管)通过栅极电压 静电控制半导体表面的载流子密度来工作。MOSFET 物理的最简单“原子” 是MOS 电容:金属栅极、绝缘氧化层以及掺杂半导体。如果你理解 MOS 电容, 就理解了使 MOSFET 实现开关的静电学 (见 ??)。
NMOS 器件之所以称为 “NMOS”,是因为在晶体管结构中加偏置时, 它会形成n 型反型沟道——导电载流子是电子。在实际中, 这通常通过p 型硅体区(受主掺杂 Si)和足够正的栅极偏压来实现。 即使在引入源极和漏极之前,同样的栅极静电效应也可以在 MOS 电容中观察到: 正栅压将电子吸引到 Si/SiO2 界面(表面积累),而负栅压会排斥空穴, 并留下固定的电离受主区域(耗尽区),如 ?? 所示。
PMOS 器件是互补情况:它形成p 型沟道(空穴为导电载流子), 通常在n 型体区并施加负栅极偏压实现。NMOS 和 PMOS 共同构成 CMOS 逻辑中 使用的基本互补对。
在本教程中,我们将在 OghmaNano 中建立并探索一个2D NMOS 电容结构。 我们有意将重点放在积累区和耗尽区,在这些区域中物理过程主要由静电学主导, 结果也更容易解释。强反型(真正形成导电沟道)将在 Part B 以及后续教程中介绍。
2. 启动 OghmaNano
从 Windows 开始菜单启动 OghmaNano。主 OghmaNano 窗口将出现,如 ?? 所示。 点击 New simulation。这将打开可用器件类型库,如 ?? 所示。 双击 Si demos 以打开硅示例集合,然后选择 nMOS capacitor 示例, 如 ?? 所示。 出现提示时,将仿真保存到具有写入权限的本地文件夹。保存后, 主仿真窗口将打开(见 ??)。
💡 提示:为获得最佳性能,请将仿真保存到本地驱动器(例如 C:\)。
网络或云同步文件夹可能会减慢重复求解器运行的速度。


3. 检查器件结构(层和材料)
创建项目后,主仿真窗口将打开,显示一个刻意简化的 NMOS MOS 电容结构:金属栅极、SiO2 栅氧化层以及 p 型硅衬底和体接触。它被称为 NMOS 电容, 因为半导体体区是 p 型,并且正栅压会使表面静电状态 趋向电子积累。该结构代表典型的 NMOS 静电配置, 并广泛用于研究 Si/SiO2 界面处的能带弯曲、 积累和耗尽。
在实际器件中,MOS 电容通常嵌入更复杂的版图中, 或与额外的接触组合。这里刻意省略这些元素, 以便完全专注于 NMOS 电容本身的垂直静电学。 通过去除横向传输和几何复杂性,可以直接且无歧义地 研究半导体中电荷重新分布和静电势变化的物理来源。
可以在 Layer editor 中查看层结构。为了清晰起见, 本教程中的氧化层厚度选择为 略大于现代硅技术中的值,以便在输出图中清楚地 看到电势降、积累层和耗尽区。在当代 NMOS 电容中, 氧化层厚度通常在 10 nm 或更小 的量级。完成本教程后, 建议你调整层厚度并探索当结构接近真实 器件尺寸时静电响应如何变化。
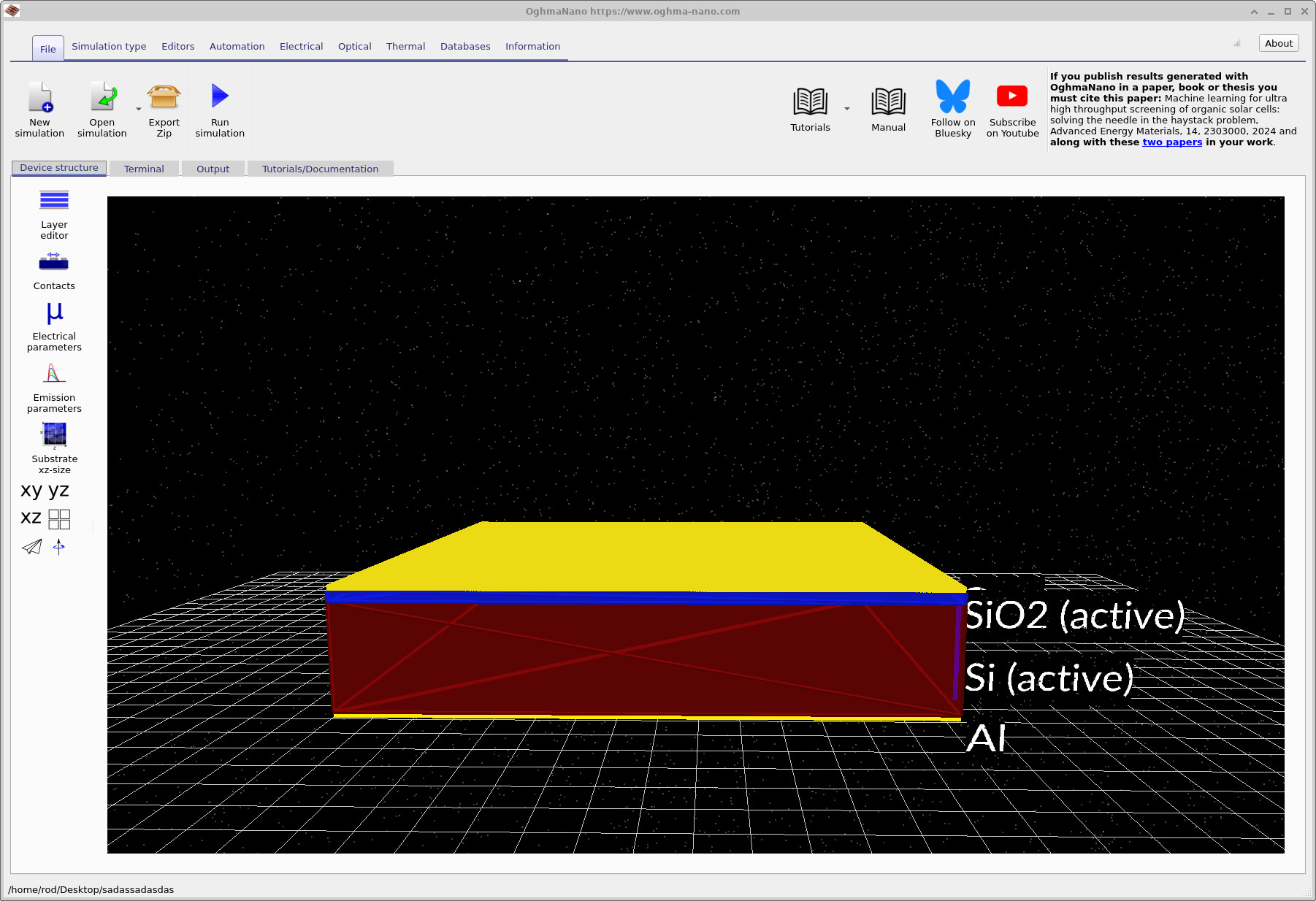

4. 检查 Electrical 功能区和 2D 网格
NMOS 电容的大部分工作流程位于 Electrical 功能区。 在这里你可以选择活动的电学模型、编辑参数、检查掺杂并配置网格。 点击 Electrical mesh 将打开网格编辑器 (见 ??)。
本教程使用2D 网格:器件在两个维度上离散化, 以捕捉界面附近的能带弯曲和耗尽,同时保持运行时间较短。 在示例中,一个方向(横向)只有少量网格点, 而在氧化层和硅厚度方向(垂直方向)有更密集的采样, 因为静电梯度主要存在于该方向。 你可以增加网格点数量,但计算成本大致随未知量数量增加 (对于非线性问题,还包括每个偏置点的迭代次数)。

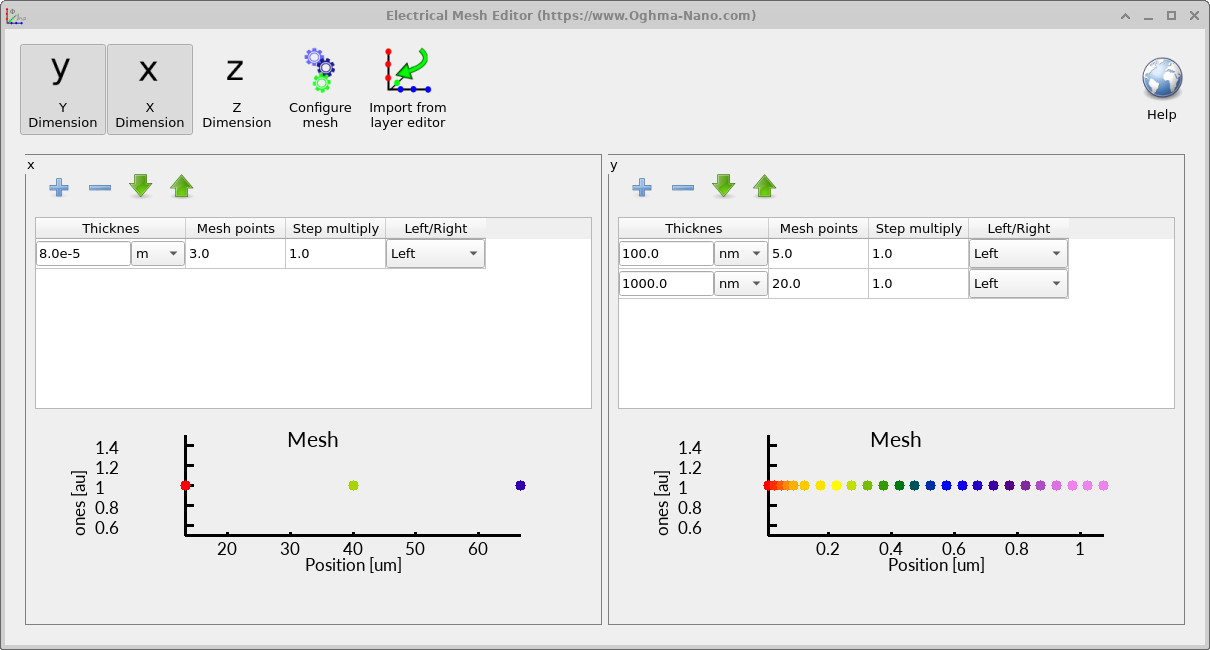
5. Electrical Parameter Editor(氧化层与硅)
点击 Electrical parameters 将打开 Electrical Parameter Editor。 该编辑器按材料组织:SiO2 选项卡包含氧化层参数, 而 Si 选项卡包含硅参数。 对于硅层,我们使用一组物理上合理的参数: 相对介电常数约为 11.7, 电子亲和势和带隙采用标准硅值, 有限的电子和空穴迁移率, 以及现实的有效态密度。 重要的是,我们选择Fermi–Dirac 统计而不是 Maxwell–Boltzmann 统计, 因为在栅极偏压下, Si/SiO2 界面附近的载流子密度 可能足够高,从而使简并效应变得重要。
相比之下,对于氧化层, 在本教程中起核心作用的唯一参数是 相对介电常数。 SiO2 被视为理想绝缘体: 它可以支持电场和电压降, 但不支持可移动电荷。 因此,NMOS 电容的静电行为 由栅极电压在氧化层和硅之间如何分配决定, 而这完全由氧化层厚度和介电常数决定。
这种建模选择体现在编辑器顶部的按钮中。 在 SiO2 层中, drift–diffusion 被禁用, 因此只求解 Poisson 方程。 而在 silicon 层中, drift–diffusion 被启用, 以正确捕捉电子和空穴在栅极偏压作用下的重新分布。 这种划分反映了两种材料在 NMOS 电容中的物理角色: 氧化层传递电场,而硅承载可移动载流子。
你可能会注意到, 在 SiO2 中列出的 electron affinity 和 band gap 等参数看起来与硅相似。 在本教程中,这是刻意设置且不会造成问题。 由于氧化层中不求解载流子传输方程, 这些能带参数不会影响解: 在模型中没有机制允许电子或空穴进入氧化层。 因此 SiO2 只通过其介电响应参与, 而不会通过其电子能带结构参与。


6. Doping 编辑器(衬底掺杂分布)
最后,从 Electrical 功能区打开 Doping 编辑器, 以查看掺杂分布 (见 ??)。 对于 NMOS 电容, 硅衬底通常是p 型(受主掺杂)。 在零栅压或负栅压下, 空穴是 Si/SiO2 界面附近的多数载流子。 随着栅压变为正值, 栅极电场会将空穴从表面排斥, 留下电离受主(固定负电荷), 并形成耗尽区。
掺杂浓度强烈控制电容的静电响应。 较高的 p 型掺杂会在给定表面电势下产生 更薄的耗尽区, 而较低的掺杂会产生 更宽的耗尽区 以及更大的能带弯曲空间范围。 在 Part B 中, 我们将使用该编辑器故意改变衬底掺杂, 并观察耗尽宽度、静电势和能带结构的变化。

7. 运行仿真(Terminal 输出)
点击主窗口中的 Run simulation(蓝色箭头)。 OghmaNano 将切换到 Terminal 选项卡并开始运行求解器。 一次典型运行的第一阶段如 ?? 所示, 其中可以看到用于启动核心求解器的命令行, 随后是项目加载和模型初始化。 重复出现的 Generating... 行表示 OghmaNano 正在构建 Fermi–Dirac 统计的查找表 (用于所选层中的电子和空穴)。 准确计算 Fermi–Dirac 积分代价较高, 因此代码会先对这些量进行表格化, 然后在非线性迭代过程中重复使用。 当看到 Loading file 时, 表示正在重新加载缓存的表(或其他缓存中间数据), 以避免在每次运行时重新生成。
第二个关键阶段是偏压递增。 在主扫描开始之前, 求解器会将栅极电压从一个已知、容易收敛的起点 (通常接近平衡态) 逐渐递增到第一个所需偏压点 (此处为 -2 V)。 这是一种延续策略: Newton 类求解器只有在初始猜测 与真实解足够接近时才能可靠收敛。 如果直接跳到较大的偏压, 初始猜测可能“距离解过远”, 从而导致发散或缓慢且不稳定的收敛。 通过逐步增加栅极电压, 每一步的解都为下一步提供良好的初始猜测。
当栅极达到起始电压后, 求解器将继续执行栅极扫描 (“J–V”/偏压曲线)。 器件体区保持在 0 V (如终端中所示)。 你可能会注意到, 打印出的电流密度在符号和大小上波动, 即使电容在稳态下应具有 (几乎)零 DC 电流。 这种行为在这里是正常的: 求解器报告的是 接近非线性求解数值噪声底部的极小残余电流。 换句话说, 这些“尖峰”并不是物理 DC 电流, 而是试图以很高相对精度计算一个 实际上约为 0 的量时出现的数值现象。
以 f(...)= 打印的量是
非线性残差/误差度量(收敛指标)。
当该值非常小时,
静电解(电势、电荷、能带弯曲)
被认为已经收敛。
右侧显示的时间(毫秒)
是每个偏压步/迭代块的运行时间,
可用于性能分析以及评估增加网格密度的代价。


f(...) 值是求解器残差(收敛指标)。
8. 输出文件和接触电流
运行完成后,
切换到 Output 选项卡以查看仿真生成的文件
(见 ??)。
你可以双击
iv_contact_0.csv 和
iv_contact_1.csv
等条目以打开接触电流图。
对于理想 MOS 电容, 稳态 DC 电流基本为零, 因为该结构是纯静电的。 因此, 接触电流图主要用于 背景信息和完整性, 以及简单检查是否存在 非预期的电流路径。 曲线应在整个偏压扫描中保持接近零; 小幅波动是正常的, 仅仅反映真实电流极其微小。
在下一节中, 我们将超越这些辅助输出, 重点关注仿真的 物理意义结果: NMOS 电容内部的静电势、 能带边缘、 Fermi 能级以及载流子分布。


💡 到目前为止你已经学到: 在本教程中, 你建立并检查了一个 NMOS 电容仿真 (器件结构、网格、材料参数和掺杂)。 在 Part B 中,我们将在此基础上施加栅极偏压, 并解读仿真输出—— 能带弯曲、静电势、 载流子密度和表面耗尽。