سلول خورشیدی سیلیکون پلیکریستالی (1D) — n+/p/p+ صنعتی (رده Al-BSF)
1. مقدمه

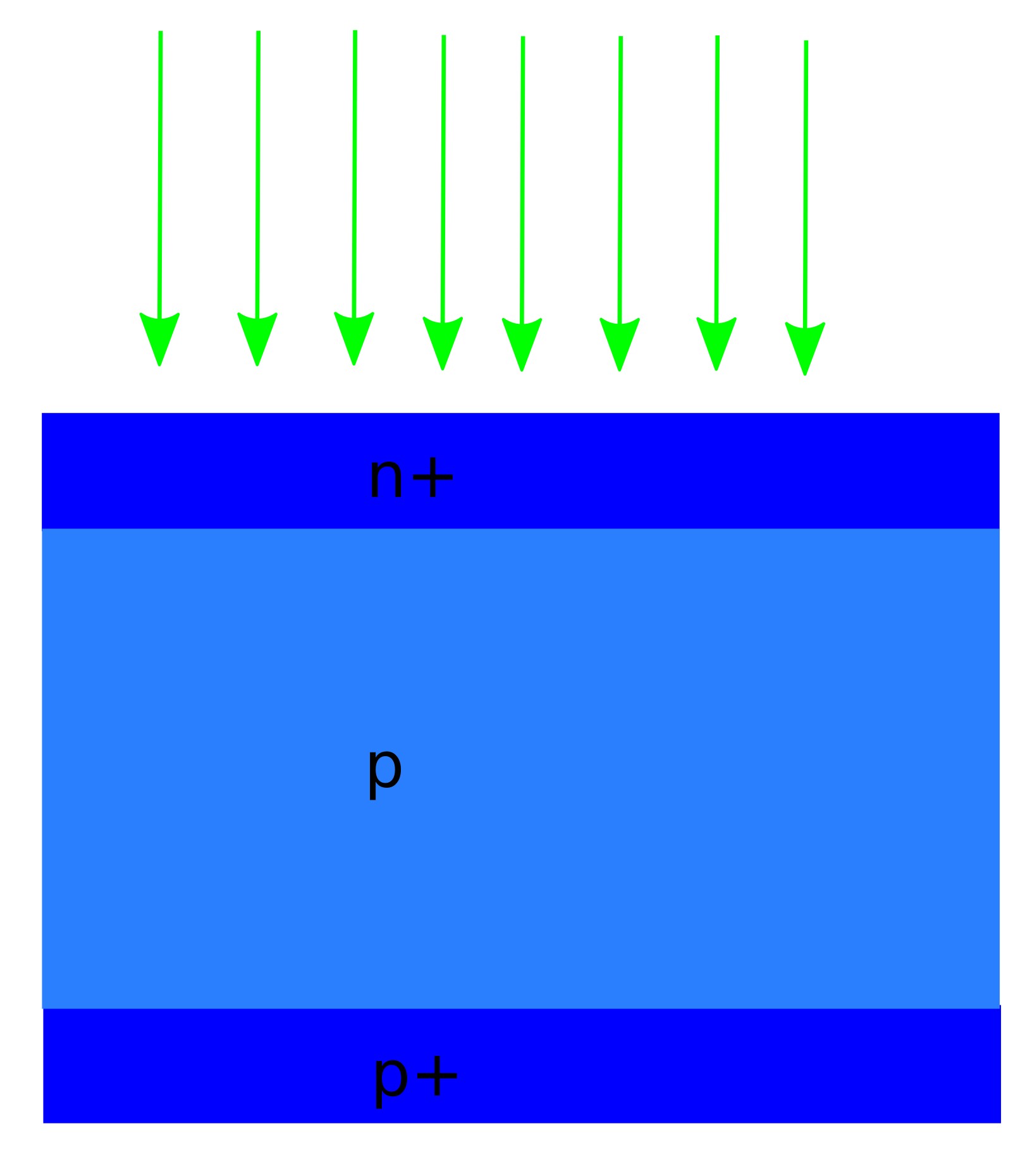
سلولهای خورشیدی سیلیکون پلیکریستالی نقش مرکزی در توسعه صنعت جهانی فتوولتائیک داشتهاند و همچنان بهطور گسترده استفاده میشوند، بهویژه در کاربردهای بزرگمساحت و حساس به هزینه مانند نیروگاههای خورشیدی مقیاس-نیروگاهی (نگاه کنید به ??). اگرچه روندهای اخیر تولید به قالبهای تککریستالی گرایش داشتهاند، دستگاههای سیلیکون پلیکریستالی همچنان یک فناوری مرجع مهم با حدود عملکرد و سازوکارهای اتلاف بهخوبی شناختهشده باقی ماندهاند.
این آموزش یک جریانکار عملی و مبتنی بر فیزیک برای شبیهسازی یک سلول خورشیدی سیلیکونی در 1D با استفاده از OghmaNano ارائه میدهد. مدل، انتقال حامل drift–diffusion جفتشده با الکترواستاتیک پواسون را، همراه با تولید نوری وابسته به عمق و بازترکیب با انگیزه فیزیکی (Shockley–Read–Hall و Auger) حل میکند. هدف این است که خروجیهای استاندارد—منحنیهای JV، Voc، و رفتار Suns–Voc— را به متغیرهای داخلی زیربنایی (باندها، شبهترازهای فرمی، بار، و زمان بازترکیب) متصل کنیم.
شما یک سلول خورشیدی سیلیکون پلیکریستالی یکبعدی با یک معماری صنعتی n+/p/p+ back-surface field آلومینیومی (Al-BSF) خواهید ساخت و شبیهسازی خواهید کرد (نگاه کنید به ??). دستگاه بهصورت زیر تعریف شده است: ساختار (جلو → پشت): n+ Si / p Si / p+ Si / Al. با استفاده از این دستگاه پایه، شما یک منحنی JV روشنشده تولید خواهید کرد، شاخصهای کلیدی عملکرد را استخراج خواهید کرد، و پیمایشهای Voc و Suns–Voc را برای شناسایی اتلاف ولتاژ محدودشده توسط بازترکیب و وابستگی آن به چگالی حامل اجرا خواهید کرد.
2. ساخت یک شبیهسازی جدید
برای شروع، از پنجره اصلی OghmaNano یک شبیهسازی جدید بسازید. روی دکمه شبیهسازی جدید در نوار ابزار کلیک کنید. این کار پنجره انتخاب نوع شبیهسازی را باز میکند (نگاه کنید به ??).


در پنجره انتخاب نوع شبیهسازی، روی Si demos دوبار کلیک کنید، سپس روی Polycrystalline silicon دوبار کلیک کنید (نگاه کنید به ??). OghmaNano یک شبیهسازی از پیش تعریفشده سلول خورشیدی سیلیکون پلیکریستالی را بارگذاری خواهد کرد.


پنجره اصلی (نگاه کنید به ??) یک نمای سهبعدی از ساختار دستگاه فراهم میکند. میتوانید از ماوس برای چرخاندن، جابهجایی، و بزرگنمایی صحنه برای بررسی هندسه استفاده کنید. اگرچه در این آموزش از یک مدل الکتریکی یکبعدی استفاده میشود، نمای سهبعدی راهی مناسب برای بصریسازی پشته لایهها و تماسها فراهم میکند.
روی زبانه Layer editor کلیک کنید تا جدول لایهها باز شود (نگاه کنید به ??). در اینجا میتوانید ساختار عمودی دستگاه، از جمله امیتر n+، پایه نوع p، back-surface field نوع p+، و تماس پشتی آلومینیومی، را همراه با ضخامتها و مواد انتسابیافته بررسی کنید.
3. بررسی پروفایل دوپینگ
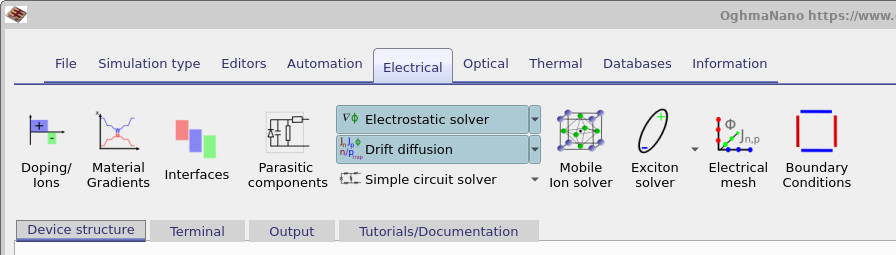
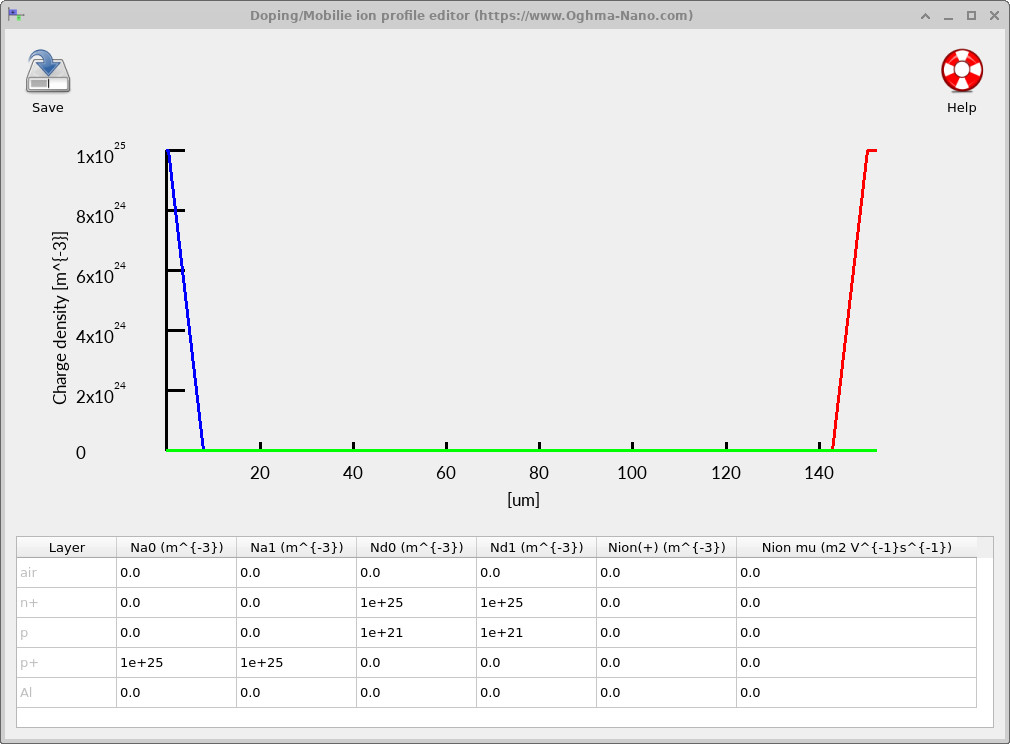
پروفایل دوپینگ چشمانداز الکترواستاتیکی دستگاه را پیش از اعمال روشنایی و بایاس تعیین میکند. در عمل، این پروفایل تعیین میکند پیوند p–n در کجا قرار دارد، پهنای ناحیه تخلیه چقدر است، و بزرگی میدان الکتریکی built-in که حاملهای نوریزاده را جدا میکند چه مقدار است. برای یک سلول خورشیدی صنعتی سیلیکونی، دوپینگ همچنین بهطور راهبردی برای کنترل بازترکیب در تماسها استفاده میشود: نواحی سطحی با دوپینگ سنگین برای تشکیل پیوندهای انتخابی و کاهش اتلاف حاملهای اقلیت در نزدیکی فلزها وارد میشوند.
برای مشاهده دوپینگ در OghmaNano، به نوار Electrical در پنجره اصلی بروید و روی Doping / Ions کلیک کنید (نگاه کنید به ??). این کار ویرایشگر پروفایل را باز میکند (نگاه کنید به ??), که چگالی بار را بر حسب عمق رسم میکند و چگالیهای عددی دهنده و پذیرنده منتسب به هر لایه را فهرست میکند.
دستگاه از یک پروفایل دوپینگ استاندارد سیلیکون پلیکریستالی n+/base/p+ استفاده میکند. در سطح جلویی روشنشده، یک امیتر نازک n+ با غلظت دهنده بسیار بالا (با بیشینه \(\sim 10^{25}\,\mathrm{m^{-3}}\)) وارد میشود که به چند میکرون ابتدایی ساختار محدود است. این ناحیه با دوپینگ سنگین یک میدان الکتریکی قوی نزدیک سطح ایجاد میکند و یک تماس اهمی انتخابگر الکترون برای استخراج کارآمد حامل فراهم میسازد. سپس غلظت امیتر درون توده دستگاه بهشدت کاهش مییابد. ناحیه مرکزی ساختار جاذب ضخیم سیلیکونی (پایه) است که چندین مرتبه بزرگی سبکتر دوپ شده است (در اینجا \(\sim 10^{21}\,\mathrm{m^{-3}}\)). این ناحیه حجم اصلی برای جذب نوری و انتقال حامل را فراهم میکند و در عین حال مقاومت ویژه متوسط را حفظ کرده و اثرات بار فضایی دور از تماسها را محدود میکند. در پشت دستگاه، یک لایه نازک p+ مجاور تماس آلومینیومی بهشدت با پذیرنده دوپ شده است (باز هم \(\sim 10^{25}\,\mathrm{m^{-3}}\)) و یک back-surface field تشکیل میدهد. back-surface field p+ خمیدگی باند را در نزدیکی تماس پشتی شکل میدهد، حاملهای اقلیت را از فصلمشترک فلزی دور میکند، و بازترکیب تماس پشتی را سرکوب میکند، و از این طریق جمعآوری حامل را بهبود داده و ولتاژ مدار باز را حفظ میکند.
4. پارامترهای الکتریکی: انتقال، الکترواستاتیک، و بازترکیب
ویرایشگر پارامترهای الکتریکی را از پنجره اصلی باز کنید: Device structure → Electrical parameters. پارامترها برای هر ناحیه با استفاده از زبانههای n+، p، و p+ (بهترتیب امیتر، پایه، و back-surface field) تعریف میشوند. تنظیمات این ویرایشگر ضرایب انتقال drift–diffusion، همترازی انرژی، و سازوکارهای بازترکیب مورد استفاده در طی پیمایش JV را تعیین میکنند.



انتقال در هر ناحیه با تحرکپذیری الکترون و حفره تعیین میشود. در پایه p (نگاه کنید به ??), تحرکپذیریها برابر μn = 0.03 m2V-1s-1 و μp = 0.01 m2V-1s-1 تنظیم شدهاند که انتقال کارآمد را از میان جاذب ضخیم فراهم میکند. در نواحی با دوپینگ سنگین n+ و p+ (نگاه کنید به ?? و ??), تحرکپذیریها پایینتر تنظیم شدهاند (μn = 0.003، μp = 0.001 m2V-1s-1) تا کاهش تحرک حامل که معمولاً با نواحی تماس پلیکریستالی/با دوپینگ سنگین همراه است نمایش داده شود. این مقادیر بر سهم مقاومت سری در جریان بالا و گرادیانهای موضعی حامل لازم برای پایدار نگه داشتن استخراج اثر میگذارند.
چگالیهای مؤثر حالات Nc = 2.8×1025 m-3 و Nv = 1.04×1025 m-3 هستند (در هر زبانه قابل مشاهدهاند). این پارامترها همراه با گافباند، چگالی ذاتی حامل و جمعیتهای تعادلی حامل را تعیین میکنند. الکترواستاتیک با affinity الکترونی χ = 4.05 eV، گافباند Eg = 1.12 eV، و گذردهی نسبی εr = 11.7 تعریف میشود که با سیلیکون در دمای اتاق سازگار است. این مقادیر مرجع لبههای باند، رفتار ناحیه تخلیه، و میدان built-in حاصل از ترکیب با پروفایل دوپینگ را تعریف میکنند.
بازترکیب برای هر ناحیه بهصورت جداگانه فعال میشود. در امیتر با دوپینگ سنگین n+ و BSF نوع p+، بازترکیب Auger فعال شده است (دکمه Auger فشرده است در ?? و ??), با ضرایب Cn = 2.8×10-43 m6s-1 و Cp = 9.9×10-43 m6s-1. بازترکیب Auger سازوکار اتلاف غالب در چگالیهای بالای این نواحی را ثبت میکند؛ یک فرم رایج آن چنین است \[ R_{\mathrm{Auger}} = C_n\,n^2 p + C_p\,p^2 n, \] بنابراین نرخ هنگامی که غلظت حاملها زیاد باشد—چنانکه در لایههای مجاور تماس با دوپینگ سنگین تحت تزریق رخ میدهد—بهسرعت افزایش مییابد. گنجاندن اتلاف Auger در اینجا از انباشت غیرفیزیکی حامل در تماسها جلوگیری میکند و رفتار ولتاژ و جریان واقعبینانهای را هنگامی که دستگاه به تزریق بالا رانده میشود به دست میدهد.
در پایه p، بازترکیب با استفاده از مدل Equilibrium SRH traps بهصورت محدودشده توسط طولعمر ناشی از تلههای Shockley–Read–Hall (SRH) در نظر گرفته میشود (فعال در ??). انرژی تله در میانه گاف تنظیم شده است (Et relative to Eg/2 = 0)، با چگالی تله Nt = 2×1019 m-3 و سطحمقطعهای بهداماندازی σn = σp = 1×10-20 m2. در این صورتبندی تعادلی، سطحمقطعهای بهداماندازی ضرایب بهداماندازی حامل را تعیین میکنند \(c_n = \sigma_n v_{\mathrm{th}}\) و \(c_p = \sigma_p v_{\mathrm{th}}\)، که در آن \(v_{\mathrm{th}}\) سرعت گرمایی است. بنابراین طولعمرهای متناظر الکترون و حفره برابرند با \[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \] و به این ترتیب پارامترهای GUI را مستقیماً به طولعمر مؤثر توده متصل میکنند. نرخ بازترکیب SRH حاصل فرم استاندارد زیر را میگیرد \[ R_{\mathrm{SRH}} = \frac{np - n_i^2}{\tau_p (n+n_1) + \tau_n (p+p_1)}, \] که در آن \(n_1\) و \(p_1\) با تراز انرژی تله \(E_t\) تعیین میشوند. از آنجا که توده بخش اعظم فوتوجریان را تولید میکند، بازترکیب SRH در پایه سازوکار اصلی کنترلکننده Voc در این آموزش است، در حالی که اتلافهای Auger عمدتاً به نواحی سطحی با دوپینگ سنگین محدود میشوند. یک بحث مفصل درباره نظریه SRH در بازترکیب Shockley–Read–Hall، انگیزه فیزیکی گنجاندن تلهها در چرا تلهها لازم هستند، و صورتبندی کاملاً غیرتعادلی در مدلسازی SRH دینامیکی (غیرتعادلی) ارائه شده است.
5. پروفایل تولید نوری
این دمو از یک محاسبه نوری یکبعدی برای تولید یک ترم منبع وابسته به عمق برای حلگر drift–diffusion استفاده میکند. در عمل، مدل نوری محاسبه میکند که طیف AM1.5 فرودی چگونه به درون سیلیکون منتشر میشود، چه مقدار از آن بهعنوان تابعی از طولموج و عمق جذب میشود، و این توان جذبشده را به نرخ تولید جفت الکترون–حفره تبدیل میکند. در یک سلول خورشیدی سیلیکونی، پروفایل نوری عمدتاً Jsc را تثبیت میکند، در حالی که سپس Voc با تعادل میان تولید و بازترکیب تعیین میشود.
برای مشاهده (و بازتولید) حل نوری، به نوار Optical در پنجره اصلی بروید و روی Transfer matrix کلیک کنید. این کار ویرایشگر شبیهسازی نوری را باز میکند. دکمه آبی Run optical simulation (آیکون پخش) را فشار دهید تا میدان نوری محاسبه شده و نمودارها بهروزرسانی شوند (نگاه کنید به ??).
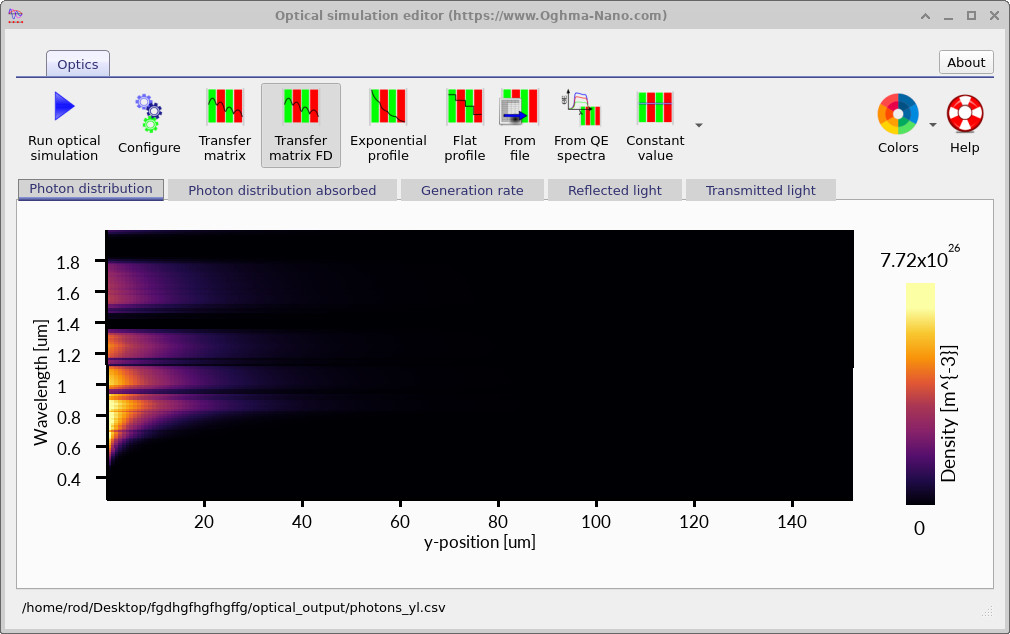
نمودار موجود در ?? یک نقشه طولموج–عمق است. محور افقی عمق درون دستگاه (با برچسب y-position) است، و محور عمودی طولموج است. رنگهای روشن نزدیک سطح روشنشده نشاندهنده جمعیت بالای فوتون هستند؛ افت سریع با عمق نشان میدهد که نور هنگام انتشار به درون سیلیکون جذب میشود.
برای سیلیکون پلیکریستالی این رفتار front-loaded مورد انتظار است. سیلیکون در طولموجهای کوتاهتر جذب قوی دارد، بنابراین فوتونهای آبی/مرئی خیلی سریع در نزدیکی سطح جلویی تهی میشوند، در حالی که طولموجهای بلندتر پیش از جذب، عمیقتر نفوذ میکنند. بنابراین باید نقشه را از پایین به بالا بخوانید: طولموجهای کوتاه در نزدیکی جلو میمیرند؛ طولموجهای بلندتر عمیقتر امتداد مییابند. در طولموجهای فراتر از حدود 1.1 µm انرژی فوتون کمتر از گافباند سیلیکون است، بنابراین این فوتونها تولید حامل باند-به-باند را پیش نمیبرند و حتی اگر در طیف حضور داشته باشند سهم کمی در جریان فتوولتائیک دارند.
ویرایشگر نوری چندین زبانه فراهم میکند زیرا «چگالی فوتون» با «نرخ تولید» یکسان نیست. نمای Photon distribution (که در بالا نشان داده شده) به شما میگوید میدان نوری کجا وجود دارد. زبانههای Photon distribution absorbed و Generation rate همانهایی هستند که برای مدل الکتریکی اهمیت دارند: نقشه فوتون جذبشده به یک نرخ تولید جفت الکترون–حفره وابسته به عمق تبدیل میشود که همان ترم منبع تزریقشده به معادلات drift–diffusion است. برای این سلول، پروفایل تولید حاصل نزدیک جلو بیشینه است و به درون پایه افت میکند، که با یک دستگاه n+/p با روشنسازی از جلو سازگار است.
6. اجرای شبیهسازی، منحنیهای JV، و استخراج پارامترها
هنگامی که ساختار دستگاه، پارامترهای الکتریکی، و تولید نوری تعریف شدند، میتوان شبیهسازی را مستقیماً از پنجره اصلی اجرا کرد. برای شروع حلگر روی دکمه Run simulation در نوار ابزار کلیک کنید. در حین اجرا، پیشرفت حلگر و اطلاعات همگرایی در پنجره terminal نوشته میشوند (نگاه کنید به ??).
اگرچه خروجی terminal مفصل به نظر میرسد، اما از یک ساختار روشن پیروی میکند. برای هر نقطه بایاس، ابتدا ولتاژ اعمالی روی تماس بالا فهرست میشود و سپس چگالی جریان حاصل میآید. تحت روشنایی، جریان در ابتدا منفی است که نشاندهنده تولید توان است. با افزایش ولتاژ اعمالی، بزرگی جریان کاهش مییابد تا آنکه در ولتاژ مدار باز از صفر عبور کند. فراتر از این نقطه، جریان مثبت میشود که متناظر با عملکرد دیودی تحت بایاس مستقیم است. خروجی terminal همچنین ولتاژ و جریان در تماس پایینی، باقیمانده حلگر (خطا)، و زمان لازم برای همگرا شدن هر گام بایاس را گزارش میکند. باقیماندههای کوچک نشان میدهند که معادلات جفتشده drift–diffusion و پواسون با دقت حل میشوند.


jv.csv و siminfo.dat هستند.
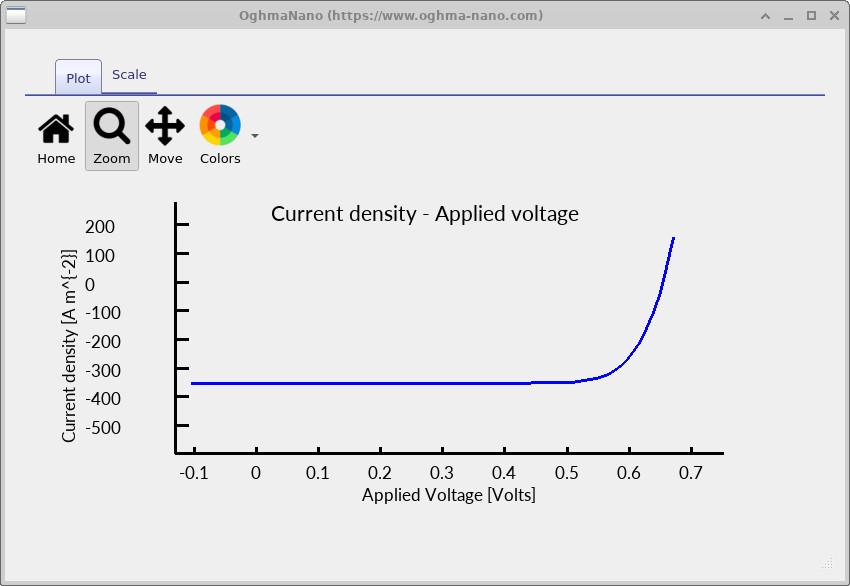
jv.csv بهدست میآید. منحنی در ولتاژ کم جریان منفی را نشان میدهد،
در Voc از صفر عبور میکند، و در بایاس بالاتر رسانش مستقیم دارد.

siminfo.dat باز میشود و شاخصهای استخراجشده دستگاه
مانند Voc، Jsc، ضریب پرشدگی، و بازده را فهرست میکند.
برای بررسی ویژگیهای الکتریکی، زبانه Output را باز کنید و روی
jv.csv دوبار کلیک کنید. این کار منحنی جریان-چگالی–ولتاژ (JV) را نمایش میدهد
(نگاه کنید به ??).
منحنی JV مهمترین ابزار تشخیصی برای رفتار دستگاه است: باید از جریان مدار کوتاه
در بایاس صفر عبور کند و در ولتاژ مدار باز از جریان صفر بگذرد.
با دوبار کلیک روی siminfo.dat پنجره اطلاعات شبیهسازی باز میشود
(نگاه کنید به ??),
که شاخصهای عملکرد استخراجشده، از جمله ضریب پرشدگی، بازده تبدیل توان،
نقطه بیشینه توان، Voc، و Jsc را گزارش میکند.
کمیتهای تشخیصی اضافی، مانند چگالیهای حامل آزاد در مدار باز، نیز فهرست میشوند و برای
تفسیر رفتار محدودشده توسط بازترکیب مفید هستند.
یک قاعده عملی این است که همیشه پیش از تفسیر شاخصهای عددی، منحنی JV را بررسی کنید.
اگر منحنی JV بهطور تمیز از مدار کوتاه و مدار باز عبور نکند، یا اگر جریان علامت یا شکل
غیرمنتظرهای داشته باشد، کمیتهای مشتقشده در siminfo.dat نیز قابل اعتماد نخواهند بود.
در عمل، بازرسی دیداری منحنی JV سریعترین راه برای تشخیص مسائل پیکربندی یا مدلسازی است.
7. بررسی snapshotهای داخلی: باندها و شبهترازهای فرمی
در طول یک پیمایش JV، OghmaNano حل داخلی کامل را در هر نقطه بایاس درون پوشه snapshots ذخیره میکند. این فایلهای snapshot حالت داخلی دستگاه—لبههای باند، شبهترازهای فرمی، چگالیهای حامل، جریانها، و کمیتهای مرتبط—را در بر دارند و مستقیمترین راه برای راستیآزمایی کار حلگر درون ساختار هستند، بهجای آنکه رفتار فقط از منحنی JV استنباط شود.
زبانه Output را باز کنید، پوشه snapshots را پیدا کنید، و برای راهاندازی نمایشگر snapshot روی آن دوبار کلیک کنید. نمایشگر یک پنجره ترسیم تعاملی است که میتواند چندین متغیر داخلی را روی یک محور همپوشانی دهد و به شما اجازه میدهد با استفاده از لغزنده ولتاژ از میان نقاط بایاس ذخیرهشده حرکت کنید.
برای بازتولید نمودار باند/شبهفرمی مورد استفاده در این آموزش، با استفاده از دکمه + چهار trace اضافه کنید.
در بخش File to plot، بهترتیب Ec.csv، Ev.csv، Fn.csv، و Fp.csv را انتخاب کنید.
اینها بهترتیب متناظر با لبه باند رسانش (Ec)، لبه باند ظرفیت (Ev)،
شبهتراز فرمی الکترون (Fn)، و شبهتراز فرمی حفره (Fp) هستند.
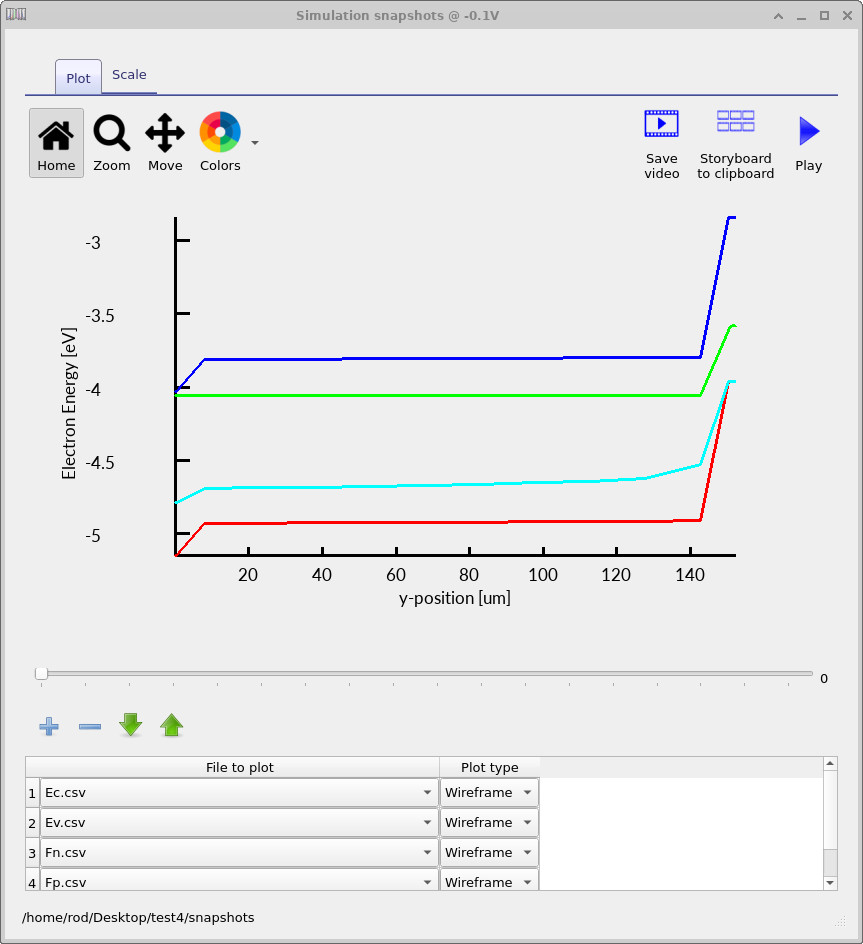
Ec، Ev، Fn، و Fp.
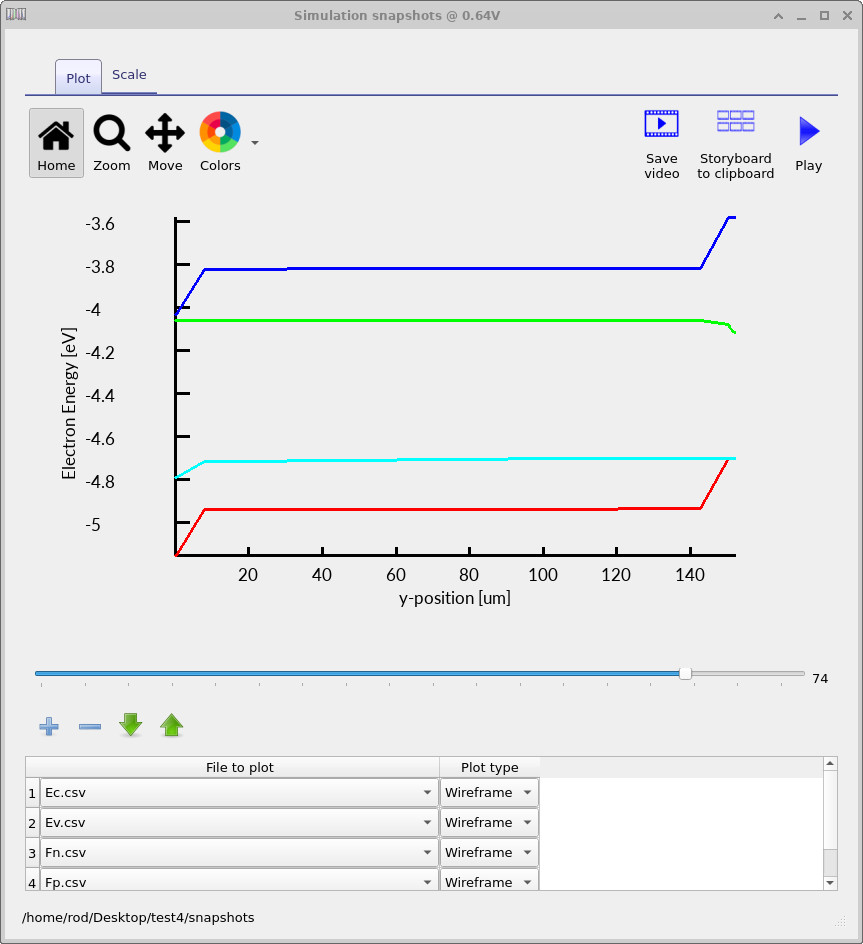
Ec، Ev، Fn، و Fp.
از لغزنده ولتاژ برای حرکت در پیمایش JV از مدار کوتاه تا مدار باز استفاده کنید و مشاهده کنید که انرژیهای داخلی چگونه با کاهش جریان استخراجشده تکامل مییابند. در مدار کوتاه (نگاه کنید به ??), دستگاه در یک رژیم استخراج جریان کار میکند: حاملهای نوریزاده از طریق تماسهای انتخابی خارج میشوند و باید یک نیروی محرکه انتقال محدود حفظ شود. در فرم drift–diffusion، جریانهای الکترون و حفره بهصورت زیر داده میشوند \[ J_n = \frac{\sigma_n}{q}\,\nabla E_{Fn}, \qquad J_p = -\frac{\sigma_p}{q}\,\nabla E_{Fp}, \] بنابراین یک جریان ترمینالی ناصفر مستلزم گرادیان فضایی در دستکم یکی از شبهترازهای فرمی است. در ساختارهای با تماس انتخابی، این گرادیان لزوماً بهطور مساوی تقسیم نمیشود: ممکن است یکی از شبهترازهای فرمی نسبتاً تخت باقی بماند (برای مثال اگر بهوسیله یک تماس اهمی حامل اکثریت بهشدت pin شده باشد) در حالی که دیگری بخش عمده تغییر محرک انتقال را حمل کند. خود لبههای باند لازم نیست تخت باشند و معمولاً خمیدگیهای قابل توجهی در نزدیکی نواحی با دوپینگ سنگین و تماسها نشان میدهند.
با افزایش ولتاژ اعمالی بهسمت مدار باز، جریان خالص ترمینالی کاهش مییابد و حل
به یک حالت ماندگار با جریان صفر نزدیک میشود. درون دستگاه، شبهترازهای فرمی تقریباً تخت میشوند
زیرا هر دو جریان الکترون و حفره ناپدید میشوند،
\[
J_n \approx 0, \qquad J_p \approx 0,
\]
در حالی که لبههای باند رسانش و ظرفیت عموماً به دلیل الکترواستاتیک built-in حاصل از
گرادیانهای دوپینگ، بار فضایی، و انتخابپذیری تماس، خمیده باقی میمانند. در دستگاههای با تماس انتخابی، انحرافهای کوچکی از
تختی کامل شبهترازهای فرمی ممکن است در لایههای مرزی باریکی مجاور تماسهای سدکننده حامل باقی بمانند؛
این انحرافها بازتاب شرایط مرزی zero-flux برای گونه حامل مسدودشده هستند نه جریان واقعی. در مدار باز
(نگاه کنید به ??),
فتو-تولید در سراسر دستگاه با بازترکیب متعادل میشود، و جدایی بین شبهترازهای فرمی الکترون و حفره در توده،
\[
qV_{\mathrm{oc}} = E_{Fn} - E_{Fp},
\]
منشأ میکروسکوپی ولتاژ مدار باز گزارششده در siminfo.dat است. هنگام حرکت از مدار کوتاه
به مدار باز با استفاده از لغزنده، امضای کلیدی که باید به آن توجه کنید، آرامشیافتن گرادیانهای محرک انتقال
درون دستگاه است، در حالی که شکافت شبهترازهای فرمی پابرجا میماند.
8. منحنیهای Suns–Voc
اندازهگیریهای Suns–Voc بررسی میکنند که ولتاژ مدار باز چگونه با شدت روشنایی تغییر میکند. از آنجا که Voc توسط جدایی شبهترازهای فرمی الکترون و حفره تعیین میشود، وابستگی آن به شدت نور بینش مستقیمی درباره سازوکارهای بازترکیب غالب در دستگاه فراهم میکند. در اصل، یک منحنی Suns–Voc را میتوان با اجرای تعداد زیادی پیمایش JV روشنشده و استخراج Voc در هر شدت ساخت. بهجای ساختن دنبالهای از منحنیهای JV و استخراج دستی Voc، OghmaNano یک حالت شبیهسازی اختصاصی Suns–Voc فراهم میکند. برای فعال کردن آن، نوار Simulation type را در پنجره اصلی باز کنید (نگاه کنید به ??) و Suns–Voc را انتخاب کنید. این کار حلگر را از پیمایش ولتاژ به یک پیمایش شدت که بهطور صریح در مدار باز انجام میشود تغییر میدهد.
پس از انتخاب Suns–Voc، روی Run simulation کلیک کنید.
برای هر سطح روشنایی، حلگر ولتاژ ترمینالی را تنظیم میکند تا
جریان خالص صفر شود و در نتیجه نقطه کاری مدار باز را مستقیماً محاسبه کند.
دادههای حاصل بهطور خودکار روی دیسک نوشته میشوند و میتوان آنها را از
زبانه Output بررسی کرد. در میان فایلهای تولیدشده، suns_voc.csv قرار دارد که ولتاژ مدار باز را
بهعنوان تابعی از شدت نور در بر دارد.
با دوبار کلیک روی این فایل، نمودار Voc–شدت نشاندادهشده در
?? باز میشود.


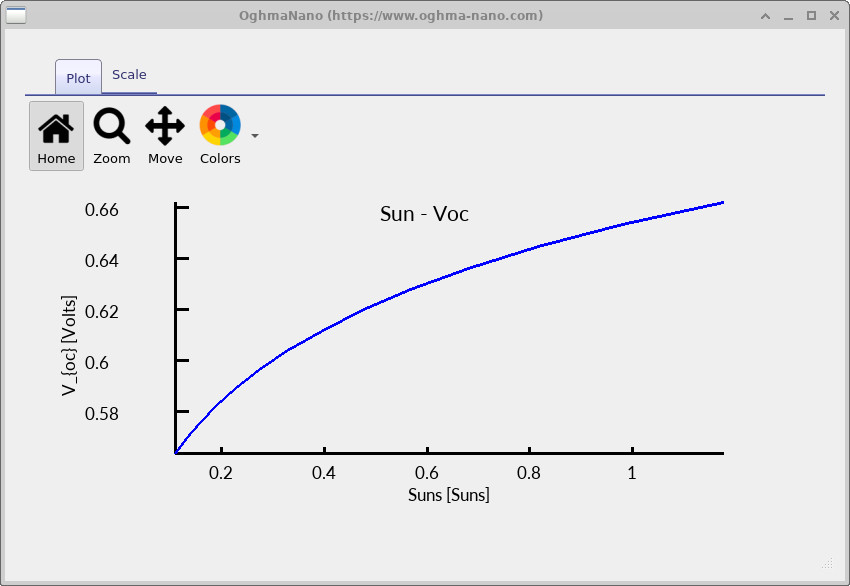
در روشنایی پایین، Voc با شدت نور بهسرعت افزایش مییابد، که با وابستگی لگاریتمی جدایی شبهترازهای فرمی به چگالی حامل سازگار است. با افزایش سطح روشنایی، شیب منحنی Voc–شدت کاهش مییابد، که نشان میدهد بازترکیب بهطور فزاینده افزایش بیشتر ولتاژ را محدود میکند. برای آشکارتر کردن این گذار، بازه روشنایی را به شدتهای بالاتر گسترش دهید. ویرایشگر Suns–Voc را از نوار Editors باز کنید و stop intensity را از 1.1 به 100 suns افزایش دهید، سپس شبیهسازی را دوباره اجرا کنید.


شبیهسازی را دوباره اجرا کنید و suns_voc.csv را مجدداً باز کنید.
بازه روشنایی توسعهیافته، رفتار Voc در شدت بالا را آشکار میکند.
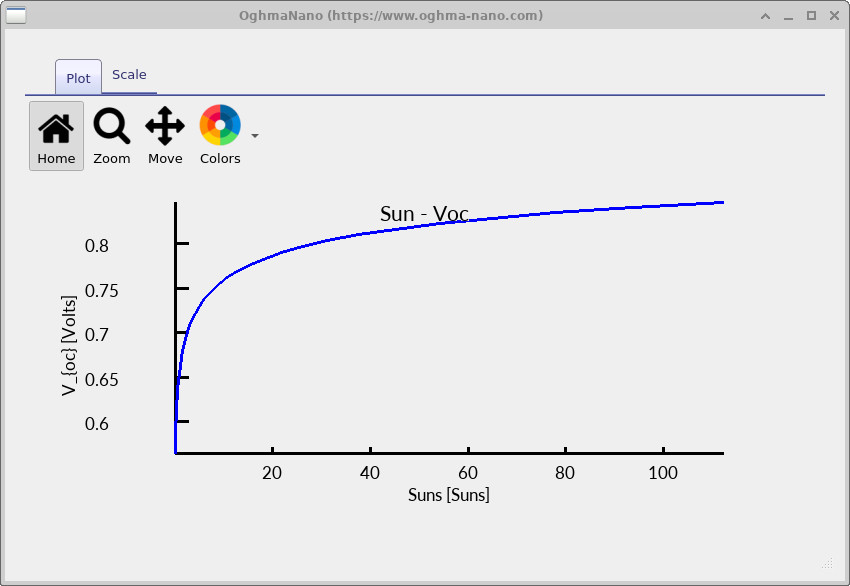
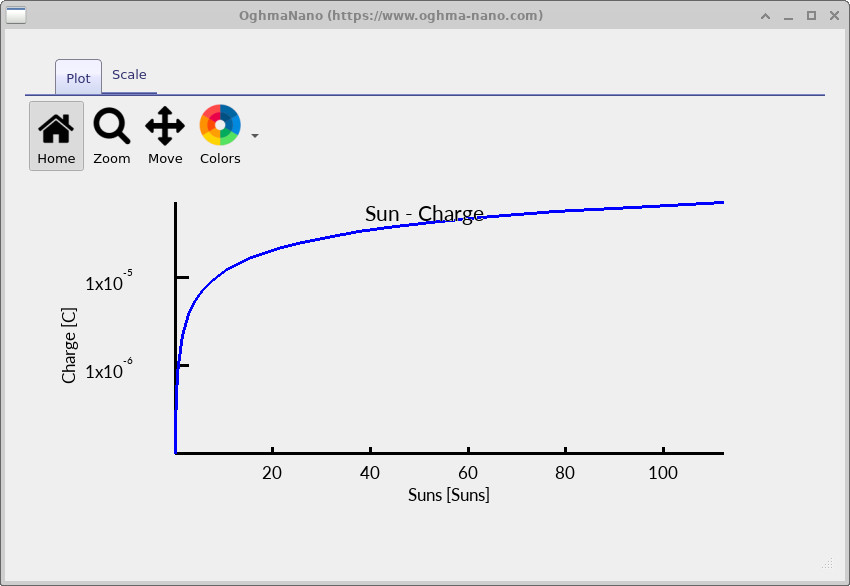
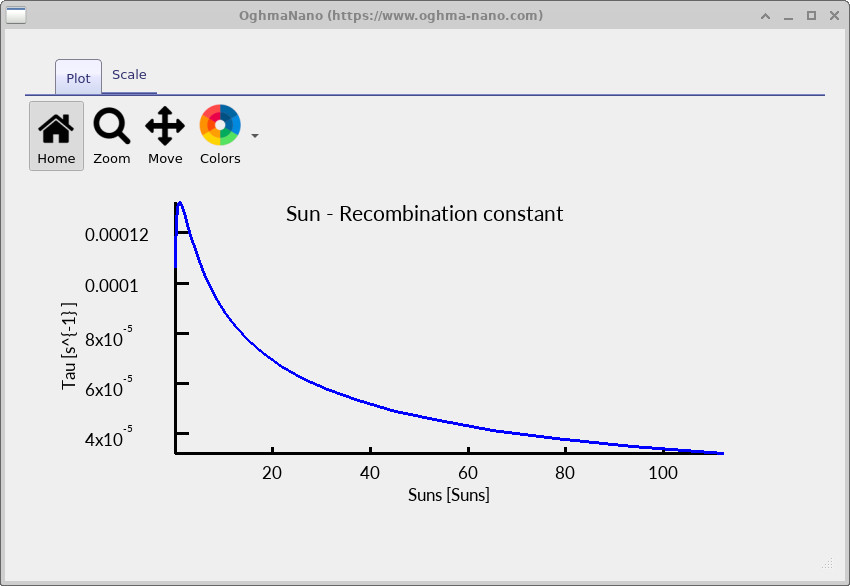
با افزایش سطح روشنایی، چگالی کل حامل اضافی در دستگاه افزایش مییابد. تحت شرایط مدار باز، این بار باید بهطور موضعی بازترکیب شود، بنابراین نرخ بازترکیب حالت ماندگار با چگالی حامل افزایش مییابد. برای فرایندهای بازترکیب باند-به-باند و کمکگرفته از عیب، نرخ بازترکیب تقریباً بهصورت R ∝ n p مقیاس میشود، در حالی که بازترکیب Auger یک ترم اضافی در چگالی بالا وارد میکند RAuger ∝ n2p + np2. در نتیجه، طولعمر مؤثر حامل τeff = Δn / R با افزایش روشنایی کاهش مییابد.
ولتاژ مدار باز با شکافت شبهترازهای فرمی تعیین میشود، qVoc = EFn - EFp , که برای یک نیمهرسانای غیرواگنشی میتوان آن را بهصورت Voc = (kT/q) ln(n p / ni2) نوشت. افزایش روشنایی چگالی حامل را بالا میبرد و بنابراین Voc را افزایش میدهد، اما فقط بهصورت لگاریتمی. هنگامی که بازترکیب به اندازه کافی شتاب بگیرد، افزایش بیشتر در چگالی حامل تنها افزایشهای کاهندهای در جدایی شبهترازهای فرمی تولید میکند.
این رقابت میان تولید و بازترکیب باعث میشود Voc در روشنایی زیاد اشباع شود. بیشینه ولتاژ زیر گافباند سیلیکون باقی میماند (Eg = 1.12 eV)، زیرا بازترکیب مانع از آن میشود که شبهترازهای فرمی الکترون و حفره بهطور همزمان به لبههای باند برسند. بنابراین اختلاف Eg/q − Voc نماینده اتلاف ولتاژ ذاتی تحمیلشده توسط بازترکیب تحت شرایط تزریق بالا برای این دستگاه است.