多結晶シリコン太陽電池 (1D) — 工業用 n+/p/p+ (Al-BSF クラス)
1. はじめに

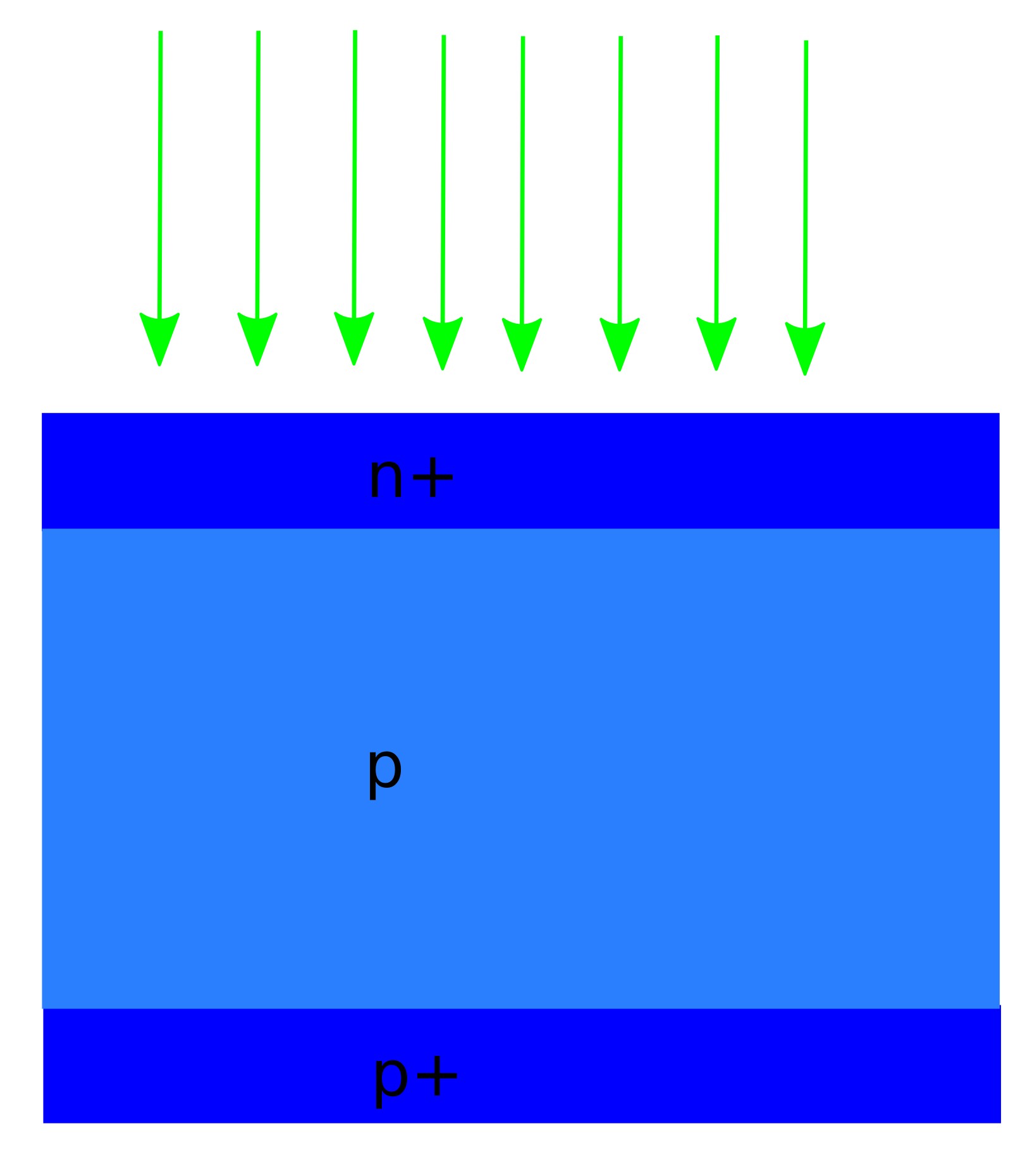
多結晶シリコン太陽電池 は、世界の太陽光発電産業の発展において中心的な役割を果たしてきており、 特に大面積かつコスト重視の用途、たとえば大規模太陽光発電所などで今なお広く展開されています (?? を参照)。 近年の製造動向では単結晶形式が優勢になってきていますが、多結晶シリコンデバイスは、 性能限界と損失機構がよく理解された重要な参照技術であり続けています。
このチュートリアルでは、OghmaNano を用いて 1D でシリコン太陽電池をシミュレーションするための、 実践的かつ物理ベースのワークフローを提供します。 このモデルは、深さ依存の光学生成および物理的に妥当な再結合(Shockley–Read–Hall と Auger)と結合した、 drift–diffusion キャリア輸送と Poisson 静電場を解きます。 目的は、標準出力である JV 曲線、Voc、および Suns–Voc 挙動を、 基礎となる内部変数(バンド、準フェルミ準位、電荷、および再結合時間)に結び付けることです。
工業用 n+/p/p+ アルミニウム裏面電界 (Al-BSF) アーキテクチャを持つ 一次元多結晶シリコン太陽電池を構築してシミュレーションします (?? を参照)。 デバイスは次のように定義されます: 構造 (front → back): n+ Si / p Si / p+ Si / Al。 このベースラインデバイスを用いて、照明下の JV 曲線を生成し、主要な性能指標を抽出し、 Voc および Suns–Voc スイープを実行して、 再結合律速電圧損失とそのキャリア密度依存性を特定します。
2. 新しいシミュレーションの作成
まず、OghmaNano メインウィンドウから新しいシミュレーションを作成します。 ツールバーの New simulation ボタンをクリックしてください。 これによりシミュレーションタイプ選択ダイアログが開きます (?? を参照)。


シミュレーションタイプダイアログで Si demos をダブルクリックし、 次に Polycrystalline silicon をダブルクリックします (?? を参照)。 OghmaNano は事前定義された多結晶シリコン太陽電池シミュレーションを読み込みます。


メインウィンドウ (?? を参照) はデバイス構造の三次元表示を提供します。 マウスを使ってシーンを回転、パン、およびズームし、ジオメトリを確認できます。 本チュートリアルでは一次元電気モデルを使用しますが、 3D ビューは層スタックとコンタクトを可視化する便利な手段を提供します。
Layer editor タブをクリックしてレイヤー表を開きます (?? を参照)。 ここでは、 n+ エミッタ、p 型ベース、p+ 裏面電界、およびアルミニウム裏面コンタクトを含む 垂直デバイス構造と、それらの厚さおよび割り当てられた材料を確認できます。
3. ドーピングプロファイルの確認
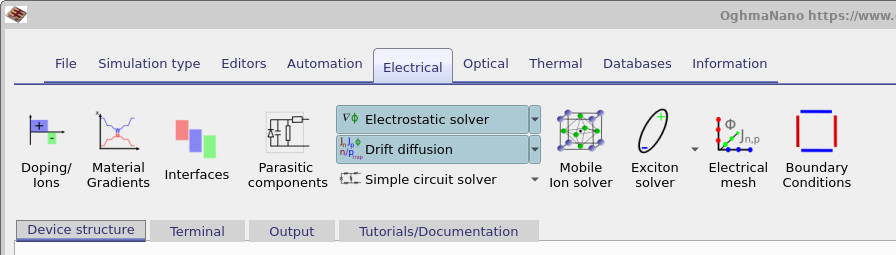
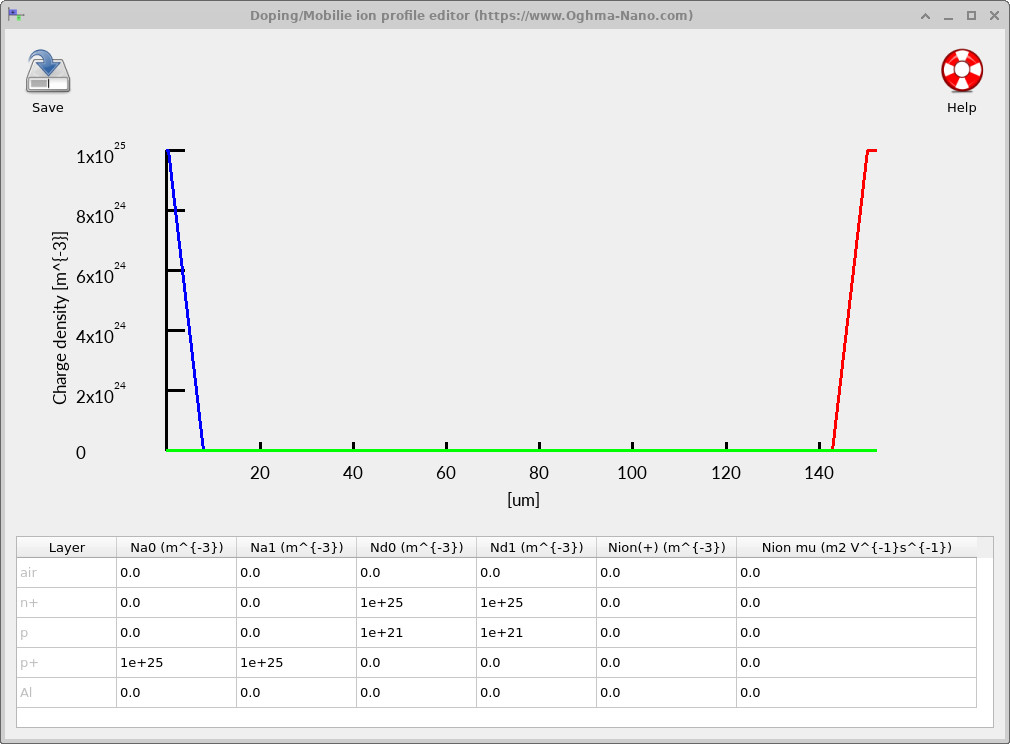
ドーピングプロファイルは、照明およびバイアスが印加される前のデバイスの静電的景観を設定します。 実際には、p–n 接合の位置、空乏領域の幅、および光生成キャリアを分離する内蔵電場の大きさを決定します。 工業用シリコン太陽電池では、ドーピングはコンタクトでの再結合を制御するためにも戦略的に用いられます。 強くドープされた表面領域は、選択的接合を形成し、金属近傍での少数キャリア損失を低減するために導入されます。
OghmaNano でドーピングを確認するには、メインウィンドウの Electrical リボンに移動し、 Doping / Ions をクリックします (?? を参照)。 これによりプロファイルエディタ (?? を参照) が開き、深さに対する電荷密度をプロットするとともに、各層に割り当てられた数値的なドナー密度およびアクセプタ密度が表示されます。
このデバイスは、標準的な n+/base/p+ 多結晶シリコンドーピングプロファイルを使用しています。 照射される前面表面では、非常に高いドナー濃度 (ピーク値 \(\sim 10^{25}\,\mathrm{m^{-3}}\))を持つ薄い n+ エミッタが導入されており、 構造の最初の数マイクロメートルに限定されています。この強くドープされた領域は 強い表面近傍電場を形成し、効率的なキャリア抽出のためのオーミックで電子選択的なコンタクトを提供します。 その後、エミッタ濃度はデバイスのバルクへ向かって急激に低下します。構造中央の領域は厚いシリコン吸収体(ベース)であり、 数桁低いドーピング(ここでは \(\sim 10^{21}\,\mathrm{m^{-3}}\))が施されています。 この領域は、適度な抵抗率を維持しつつ、コンタクトから離れた位置での空間電荷効果を抑えながら、 光吸収とキャリア輸送の主たる体積を提供します。デバイス後部では、アルミニウムコンタクトに隣接する薄い p+ 層が 再び強いアクセプタドーピング(\(\sim 10^{25}\,\mathrm{m^{-3}}\))を受けており、 裏面電界を形成します。この p+ 裏面電界は裏面コンタクト近傍のバンドベンディングを整形し、 金属界面から少数キャリアを反発させ、裏面コンタクト再結合を抑制することで、 キャリア収集を改善し、開放電圧を維持します。
4. 電気パラメータ: 輸送、静電場、および再結合
メインウィンドウから電気パラメータエディタを開きます: Device structure → Electrical parameters。パラメータは各領域ごとに n+、p、および p+ タブ (それぞれエミッタ、ベース、および裏面電界)で定義されます。 このエディタの設定は、JV スイープ中に使用される drift–diffusion 輸送係数、エネルギー整列、および 再結合機構を決定します。



各領域の輸送は電子および正孔移動度によって設定されます。p ベース (?? を参照) では、移動度は μn = 0.03 m2V-1s-1 および μp = 0.01 m2V-1s-1 に設定されており、 厚い吸収体を通じた効率的な輸送を提供します。強ドープされた n+ および p+ 領域 (?? および ?? を参照) では、移動度はより低く (μn = 0.003, μp = 0.001 m2V-1s-1) 設定されており、強ドープ/多結晶コンタクト領域に典型的に伴うキャリア移動度の低下を表現しています。 これらの値は、高電流時の直列抵抗成分および抽出を維持するために必要な局所キャリア勾配に影響します。
有効状態密度 Nc = 2.8×1025 m-3 および Nv = 1.04×1025 m-3(各タブに表示) は、バンドギャップとともに、 真性キャリア密度および平衡キャリア密度を設定します。静電場は電子親和力 χ = 4.05 eV、バンドギャップ Eg = 1.12 eV、 および相対誘電率 εr = 11.7 によって定義され、 これは室温のシリコンと整合します。これらの値は、 ドーピングプロファイルと組み合わせたときに生じるバンド端基準、空乏挙動、および内蔵電場を定義します。
再結合は領域ごとに有効化されます。強ドープされた n+ エミッタおよび p+ BSF では、 Auger 再結合が有効化されています(Auger ボタンが ?? および ?? で押下状態)、 係数は Cn = 2.8×10-43 m6s-1 および Cp = 9.9×10-43 m6s-1 です。 Auger 再結合はこれらの領域における支配的な高密度損失機構を捉えます。一般的な形は \[ R_{\mathrm{Auger}} = C_n\,n^2 p + C_p\,p^2 n, \] であり、そのためレートはキャリア濃度が大きいと急速に増加します。これは、注入下でコンタクト隣接層が強ドープされている場合に当てはまります。 ここで Auger 損失を含めることにより、コンタクトでの非物理的なキャリア蓄積を防ぎ、 デバイスが高注入で駆動された際に現実的な電圧および電流挙動が得られます。
p ベースでは、再結合は Equilibrium SRH traps モデルを用いる Shockley–Read–Hall (SRH) トラップによる寿命律速として扱われます ( ?? で有効化)。 トラップエネルギーはミッドギャップに設定されており (Et relative to Eg/2 = 0)、 トラップ密度は Nt = 2×1019 m-3、 捕獲断面積は σn = σp = 1×10-20 m2 です。 この平衡定式化では、捕獲断面積がキャリア捕獲係数 \(c_n = \sigma_n v_{\mathrm{th}}\) および \(c_p = \sigma_p v_{\mathrm{th}}\) を決定し、 ここで \(v_{\mathrm{th}}\) は熱速度です。 対応する電子および正孔寿命はしたがって \[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \] となり、GUI パラメータが有効バルク寿命に直接結び付けられます。 得られる SRH 再結合レートは標準形 \[ R_{\mathrm{SRH}} = \frac{np - n_i^2}{\tau_p (n+n_1) + \tau_n (p+p_1)}, \] を取ります。ここで \(n_1\) と \(p_1\) はトラップ準位 \(E_t\) によって設定されます。 バルクが光電流の大部分を生成するため、このチュートリアルではベース内の SRH 再結合が Voc を支配する主要機構であり、 Auger 損失は主に強ドープ表面領域に限定されます。 SRH 理論の詳細は Shockley–Read–Hall recombination、 トラップを含める物理的動機は Why traps are required、 そして完全な非平衡定式化は Dynamic (non-equilibrium) SRH modelling に記載されています。
5. 光学生成プロファイル
このデモでは、drift–diffusion ソルバーのための深さ依存ソース項を生成するために、 一次元光学計算を使用します。実際には、光学モデルは入射 AM1.5 スペクトルが シリコン内部にどのように伝搬するか、波長および深さの関数としてどれだけ吸収されるかを計算し、 その吸収電力を電子–正孔対生成率に変換します。 シリコン太陽電池では、光学プロファイルが主として Jsc を決定し、一方で Voc は 生成と再結合のバランスによって設定されます。
光学解を確認し(および再生成し)たい場合は、メインウィンドウの Optical リボンに移動し、 Transfer matrix をクリックします。これにより光学シミュレーションエディタが開きます。 青い Run optical simulation ボタン (再生アイコン)を押すと、光学場が計算され、プロットが更新されます (?? を参照)。
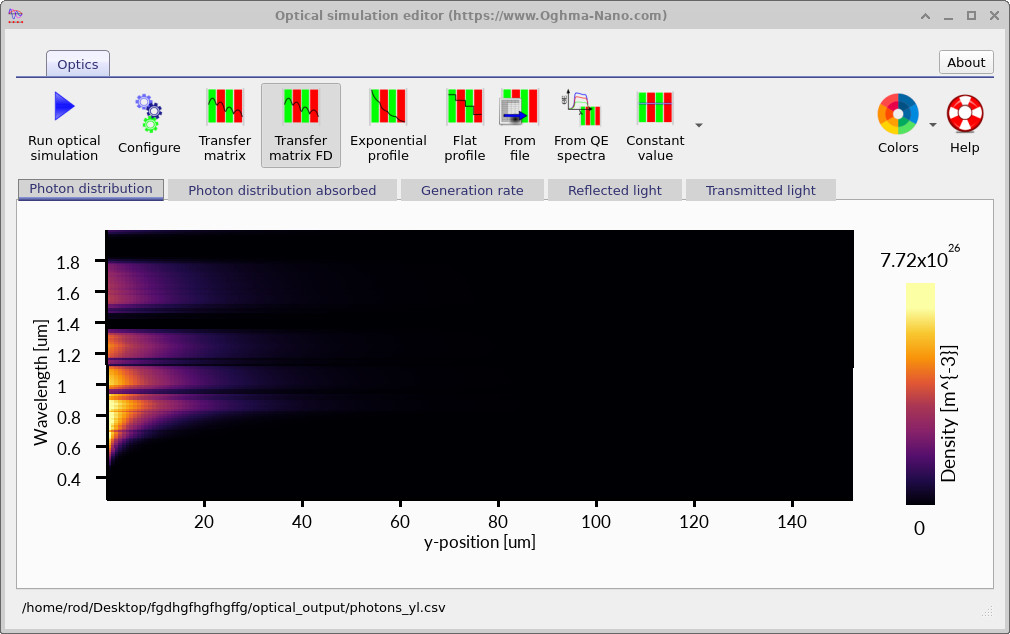
?? のプロットは、波長–深さマップです。横軸はデバイス内部への深さ(y-position と表示)で、 縦軸は波長です。照射面近傍の明るい色は高い光子密度を示し、 深さとともに急速に薄れることは、光がシリコン内部へ伝搬するにつれて吸収されていることを示します。
多結晶シリコンでは、この前面集中型の挙動は期待されるものです。 シリコンは短波長で強く吸収するため、青色/可視光の光子は前面表面近傍で非常に速く枯渇し、 一方で長波長は吸収される前により深くまで到達します。 したがって、このマップは下から上へ読むべきです: 短波長は前面近傍で消滅し、 長波長はより深くまで伸びます。 およそ 1.1 µm を超える波長では、光子エネルギーはシリコンのバンドギャップ未満であるため、 それらの光子はバンド間キャリア生成を駆動せず、スペクトル中に存在していても 太陽光発電電流への寄与は小さいです。
光学エディタには複数のタブがあります。これは「光子密度」が「生成率」と同じではないためです。 上に示した Photon distribution ビューは、光学場がどこに存在するかを示します。 電気モデルにとって重要なのは Photon distribution absorbed および Generation rate タブです: 吸収光子マップは、深さ依存の電子–正孔対生成率に変換され、 これが drift–diffusion 方程式に注入されるソース項となります。 このセルでは、得られる生成プロファイルは前面近傍でピークを持ち、ベース内部へ向かって減衰し、 前面照射の n+/p 接合デバイスと整合しています。
6. シミュレーションの実行、JV 曲線、およびパラメータ抽出
デバイス構造、電気パラメータ、および光学生成が定義されたら、 シミュレーションはメインウィンドウから直接実行できます。 ツールバーの Run simulation ボタンをクリックしてソルバーを開始します。 実行中、ソルバーの進行状況と収束情報はターミナルウィンドウに書き込まれます (?? を参照)。
ターミナル出力は冗長に見えますが、明確な構造に従っています。 各バイアスポイントについて、まず上部コンタクトに印加された電圧が表示され、 次に得られた電流密度が表示されます。照明下では、電流は初め負であり、 これは発電を示します。印加電圧を増加させると、電流の絶対値は減少し、 開放電圧でゼロを横切ります。この点を超えると電流は正となり、 順方向バイアスダイオード動作に対応します。ターミナル出力には、 下部コンタクトの電圧と電流、ソルバー残差(誤差)、および各バイアスステップの収束に要した時間も表示されます。 小さな残差は、結合した drift–diffusion 方程式と Poisson 方程式が正確に解かれていることを示します。


jv.csv および siminfo.dat が含まれます。
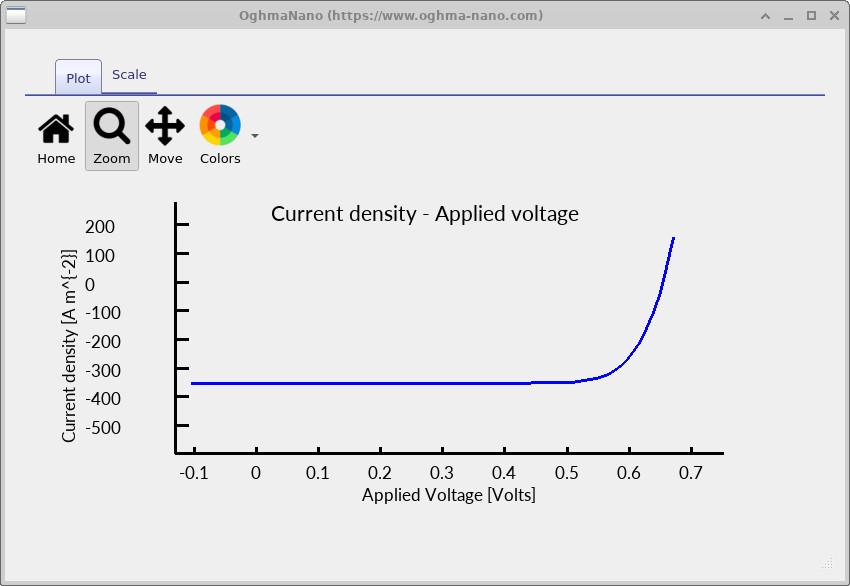
jv.csv を開いて得られた JV 曲線。曲線は低電圧で負電流を示し、
Voc でゼロ電流を横切り、高バイアスで順方向伝導を示します。

siminfo.dat から開いたシミュレーション情報ウィンドウで、
Voc、Jsc、フィルファクタ、および効率などの抽出デバイス指標を一覧表示しています。
電気特性を確認するには、Output タブを開き、
jv.csv をダブルクリックします。これにより
電流密度–電圧 (JV) 曲線が表示されます
(?? を参照)。
JV 曲線はデバイス挙動の主要診断です: ゼロバイアスで短絡電流を通過し、
開放電圧でゼロ電流を横切るはずです。
siminfo.dat をダブルクリックするとシミュレーション情報ウィンドウが開きます
(?? を参照)。
ここにはフィルファクタ、電力変換効率、
最大電力点、Voc、および Jsc を含む抽出性能指標が表示されます。
開放回路における自由キャリア密度などの追加診断量も一覧表示され、
再結合律速挙動を解釈するのに有用です。
実践的なルールとして、数値指標を解釈する前に必ず JV 曲線を確認してください。
JV 曲線が短絡および開放回路をきれいに通過していない場合、あるいは電流に
予期しない符号や形状がある場合、siminfo.dat の導出量も信頼できません。
実際には、JV 曲線の目視確認が設定またはモデリング上の問題を診断する最速の方法です。
7. 内部スナップショットの確認: バンドと準フェルミ準位
JV スイープ中、OghmaNano は各バイアスポイントにおける完全な内部解を snapshots ディレクトリに保存します。 これらのスナップショットファイルには、内部状態―バンド端、 準フェルミ準位、キャリア密度、電流、および関連量―が含まれており、 JV 曲線から挙動を推測するだけでなく、 ソルバーが構造内部で何をしているかを直接検証する最も直接的な方法です。
Output タブを開き、snapshots フォルダを見つけて、 それをダブルクリックしてスナップショットビューアを起動します。 このビューアはインタラクティブなプロットウィンドウであり、複数の内部変数を 同じ軸に重ねて表示でき、電圧スライダを使って保存されたバイアスポイントを順に確認できます。
このチュートリアルで使用するバンド/準フェルミプロットを再現するには、
+ ボタンを用いて 4 つのトレースを追加します。
File to plot の下で、順に
Ec.csv、Ev.csv、Fn.csv、および Fp.csv を選択します。
これらは伝導帯端 (Ec)、価電子帯端 (Ev)、
電子準フェルミ準位 (Fn)、および正孔準フェルミ準位 (Fp) に対応します。
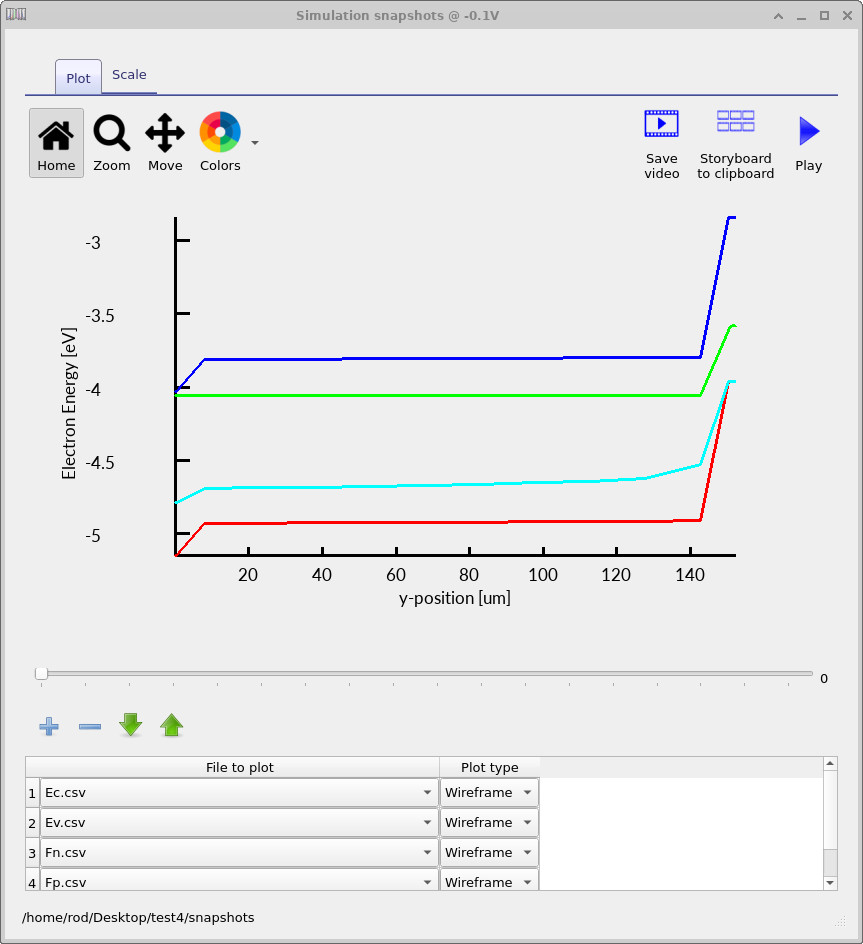
Ec、Ev、Fn、および Fp。
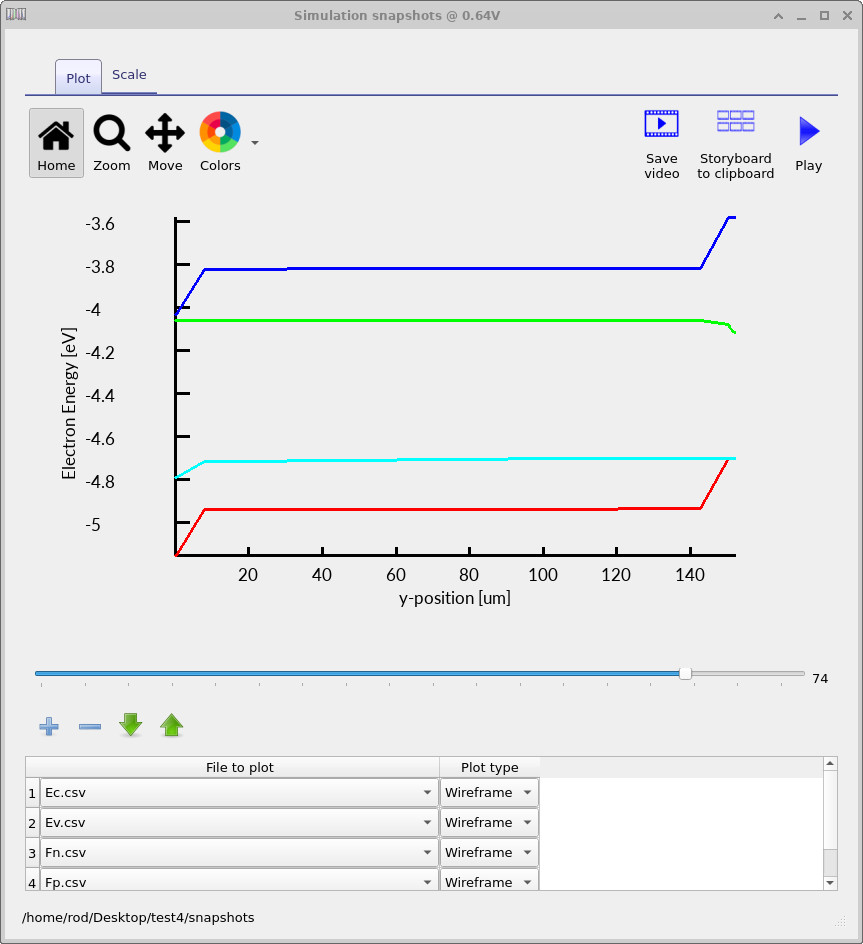
Ec、Ev、Fn、および Fp。
電圧スライダを使って JV スイープを短絡から開放回路まで移動し、 抽出電流が減少するにつれて内部エネルギーがどのように変化するかを観察してください。 短絡時( ?? を参照)、 デバイスは電流抽出レジームで動作します: 光生成キャリアは選択的コンタクトを通じて除去され、 有限の輸送駆動力が維持されなければなりません。drift–diffusion 形式では、 電子および正孔電流は \[ J_n = \frac{\sigma_n}{q}\,\nabla E_{Fn}, \qquad J_p = -\frac{\sigma_p}{q}\,\nabla E_{Fp}, \] と与えられるため、非ゼロ端子電流には少なくとも一方の準フェルミ準位に空間勾配が必要です。 選択的コンタクト構造では、この勾配は必ずしも等しく分担される必要はありません: 一方の準フェルミ準位は比較的平坦なまま(たとえば、多数キャリアのオーミックコンタクトに強くピン止めされている場合)であり、 他方が輸送駆動変動の大部分を担うことがあります。 バンド端自体が平坦である必要はなく、通常は強ドープ領域およびコンタクト近傍で顕著なバンドベンディングを示します。
印加電圧が開放回路へ向かって増加すると、正味端子電流は減少し、
解はゼロ電流定常状態へ近づきます。デバイス内部では、電子電流および正孔電流の両方が消失するため、
準フェルミ準位はほぼ平坦になります:
\[
J_n \approx 0, \qquad J_p \approx 0,
\]
一方で、伝導帯端および価電子帯端は一般に、
ドーピング勾配、空間電荷、およびコンタクト選択性から生じる内蔵静電場のために曲がったままです。
選択的コンタクトデバイスでは、キャリア遮断コンタクトに隣接する狭い境界層内で、
完全な準フェルミ準位平坦性からの小さな逸脱が残ることがあります;
これは電流流れではなく、遮断されたキャリア種に対するゼロフラックス境界条件を反映しています。
開放回路では
(?? を参照)、
光生成はデバイス全体で再結合と釣り合っており、バルクにおける電子および正孔準フェルミ準位の分離
\[
qV_{\mathrm{oc}} = E_{Fn} - E_{Fp},
\]
が siminfo.dat に報告される開放電圧の微視的起源です。
スライダを用いて短絡から開放回路へ移動する際に注目すべき主要な特徴は、
デバイス内部における輸送駆動勾配が緩和する一方で、
準フェルミ準位分離は維持されることです。
8. Suns–Voc 曲線
Suns–Voc 測定は、開放電圧 が照明強度とともにどのように変化するかを調べます。 Voc は電子および正孔準フェルミ準位の分離によって設定されるため、 その光強度依存性は、デバイスにおける支配的な再結合機構に関する直接的な洞察を与えます。 原理的には、Suns–Voc 曲線は多数の照明下 JV スイープを実行し、 各強度で Voc を抽出することで構築できます。 JV 曲線列を構築して Voc を手動で抽出する代わりに、 OghmaNano は専用の Suns–Voc シミュレーションモードを提供します。 これを有効にするには、メインウィンドウの Simulation type リボンを開き (?? を参照)、 Suns–Voc を選択します。 これにより、ソルバーは電圧スイープから、明示的に開放回路で実行される強度スイープに切り替わります。
Suns–Voc を選択した後、Run simulation をクリックします。
各照明レベルについて、ソルバーは
正味電流がゼロになるまで端子電圧を調整し、開放回路動作点を直接計算します。
結果データは自動的にディスクへ書き込まれ、
Output タブから確認できます。
生成されるファイルの中には、光強度の関数として開放電圧を含む
suns_voc.csv があります。
このファイルをダブルクリックすると、
??
に示す Voc–強度プロットが開きます。


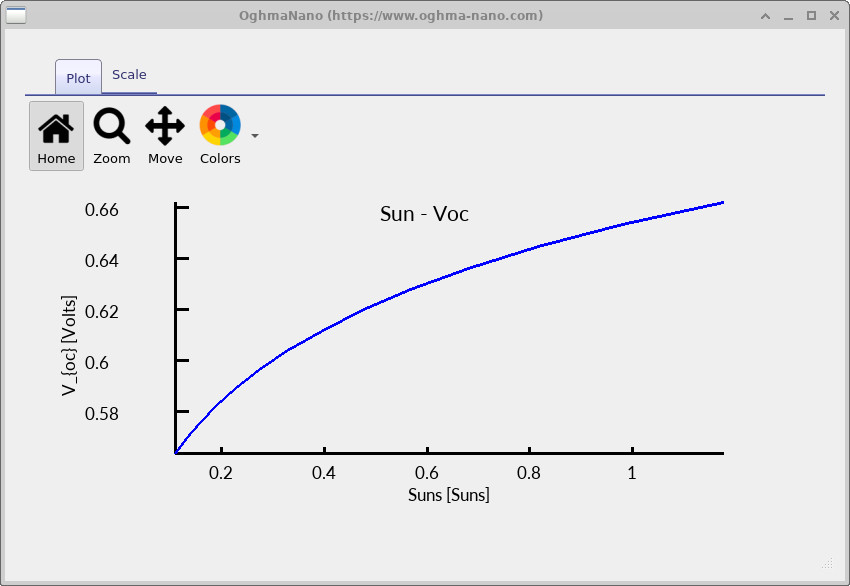
低照明では、Voc は光強度とともに急速に増加し、 これはキャリア密度に対する準フェルミ準位分離の対数依存性と整合しています。 照明レベルが上がるにつれて、Voc–強度曲線の傾きは減少し、 再結合がさらなる電圧増加をますます制限していることを示します。 この遷移をより明瞭に示すために、照明範囲を高強度側へ拡張してください。 Editors リボンから Suns–Voc editor を開き、 stop intensity を 1.1 から 100 suns に増やし、その後シミュレーションを再実行します。


シミュレーションを再実行し、再び suns_voc.csv を開きます。
拡張された照明範囲により、Voc の高強度挙動が明らかになります。
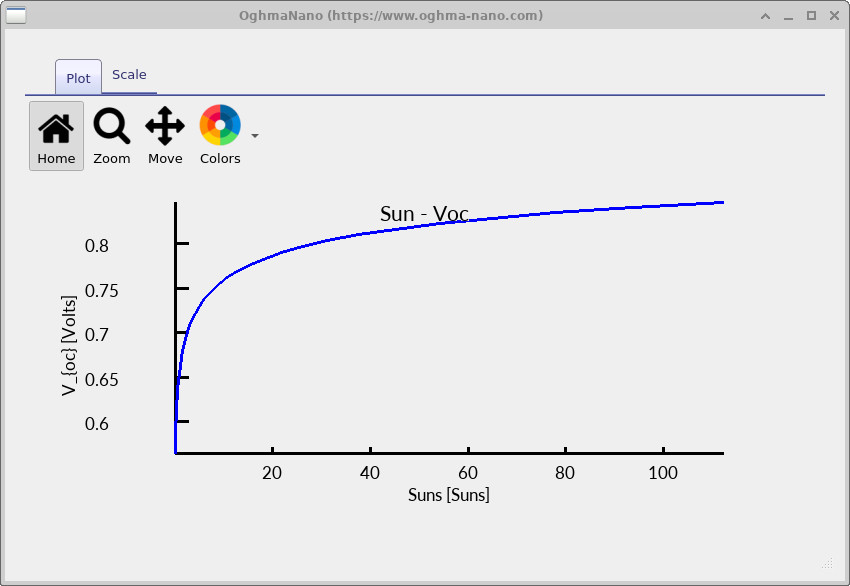
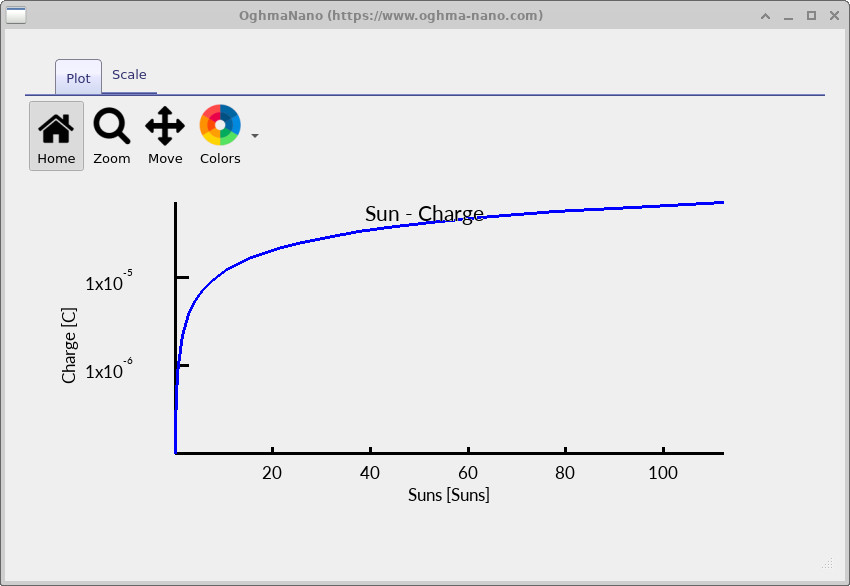
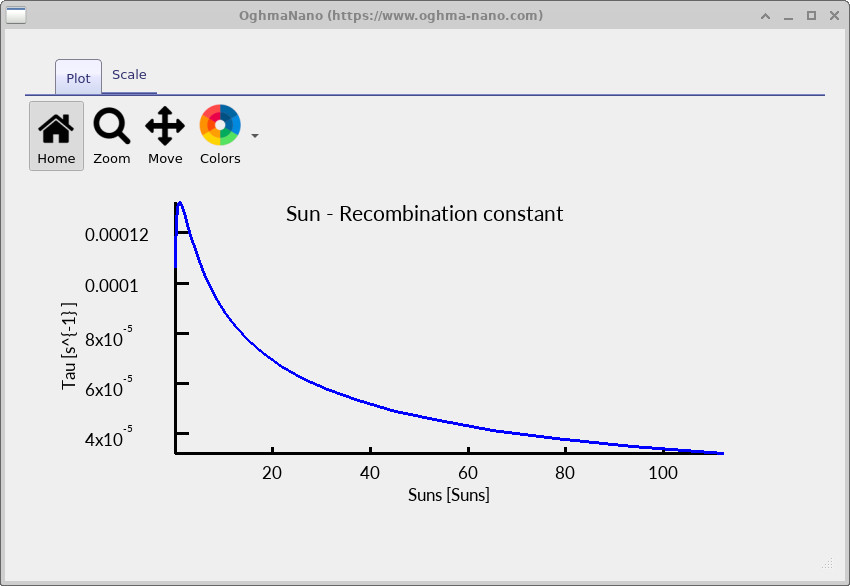
照明レベルが増加すると、デバイス内の総過剰キャリア密度は上昇します。 開放回路条件では、この電荷は局所的に再結合しなければならないため、 定常状態の再結合レートはキャリア密度とともに増加します。 バンド間再結合および欠陥支援再結合では、再結合レートは おおよそ R ∝ n p に比例し、一方 Auger 再結合は追加の高密度項 RAuger ∝ n2p + np2 を導入します。 その結果、有効キャリア寿命 τeff = Δn / R は照明増加とともに減少します。
開放電圧は準フェルミ準位分離 qVoc = EFn - EFp によって設定され、非縮退半導体では Voc = (kT/q) ln(n p / ni2) と書けます。 照明を増やすとキャリア密度が上昇するため Voc も増加しますが、その増加は対数的です。 再結合が十分に加速すると、キャリア密度をさらに増加させても、 準フェルミ準位分離の増加は次第に小さくなります。
生成と再結合のこの競合により、Voc は高照明で飽和します。 最大電圧はシリコンのバンドギャップ (Eg = 1.12 eV)より低いままです。これは、 再結合が電子および正孔準フェルミ準位が同時にバンド端へ到達することを妨げるためです。 差 Eg/q − Voc はしたがって、このデバイスにおける高注入条件下で再結合によって課される 固有の電圧損失を表します。