Célula Solar de Silício Policristalino (1D) — Industrial n+/p/p+ (classe Al-BSF)
1. Introdução

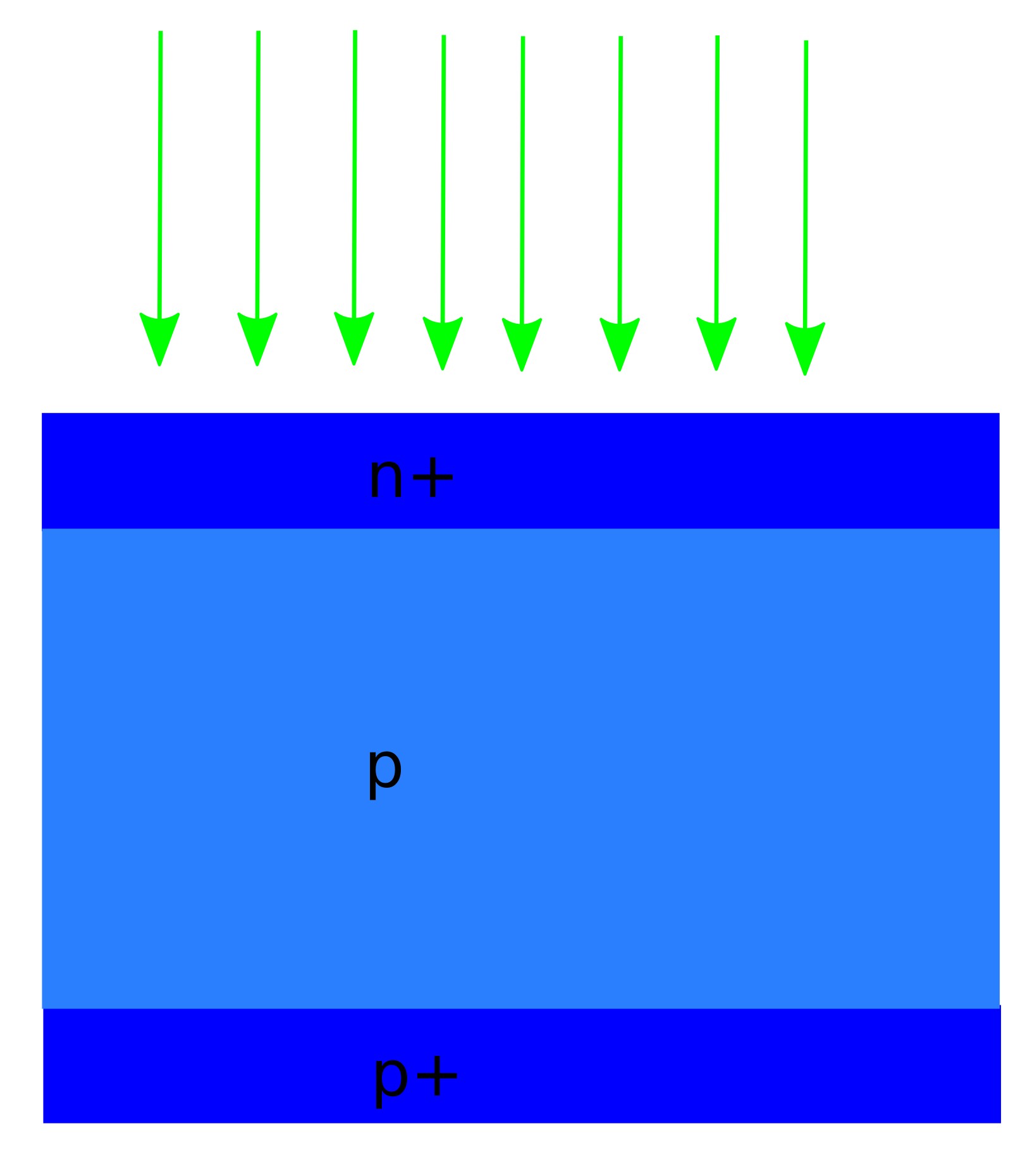
Células solares de silício policristalino desempenharam um papel central no desenvolvimento da indústria fotovoltaica global e continuam amplamente implantadas, particularmente em aplicações de grande área e sensíveis a custo, como fazendas solares em escala de utilidade (veja ??). Embora tendências recentes de fabricação tenham favorecido formatos monocristalinos, dispositivos de silício policristalino continuam sendo uma importante tecnologia de referência com limites de desempenho e mecanismos de perda bem compreendidos.
Este tutorial fornece um fluxo de trabalho prático, baseado em física, para simular uma célula solar de silício em 1D usando OghmaNano. O modelo resolve o transporte de portadores por drift–diffusion acoplado à eletrostática de Poisson, com geração óptica dependente da profundidade e recombinação fisicamente motivada (Shockley–Read–Hall e Auger). O objetivo é conectar saídas padrão—curvas JV, Voc e comportamento Suns–Voc—às variáveis internas subjacentes (bandas, níveis de quase-Fermi, carga e tempo de recombinação).
Você construirá e simulará uma célula solar de silício policristalino unidimensional com uma arquitetura industrial de campo de superfície traseira de alumínio (Al-BSF) n+/p/p+ (veja ??). O dispositivo é definido como: Estrutura (frente → traseira): n+ Si / p Si / p+ Si / Al. Usando este dispositivo base, você irá gerar uma curva JV iluminada, extrair métricas-chave de desempenho e executar varreduras de Voc e Suns–Voc para identificar perda de tensão limitada por recombinação e sua dependência da densidade de portadores.
2. Criando uma Nova Simulação
Para começar, crie uma nova simulação a partir da janela principal do OghmaNano. Clique no botão Nova simulação na barra de ferramentas. Isso abre a caixa de diálogo de seleção do tipo de simulação (veja ??).


Na caixa de diálogo de tipo de simulação, clique duas vezes em Si demos, depois clique duas vezes em Silício policristalino (veja ??). O OghmaNano carregará uma simulação predefinida de célula solar de silício policristalino.


A janela principal (veja ??) fornece uma visualização tridimensional da estrutura do dispositivo. Você pode usar o mouse para girar, deslocar e ampliar a cena para inspecionar a geometria. Embora o presente tutorial use um modelo elétrico unidimensional, a visualização 3D fornece uma forma conveniente de visualizar a pilha de camadas e os contatos.
Clique na aba Editor de camadas para abrir a tabela de camadas (veja ??). Aqui você pode inspecionar a estrutura vertical do dispositivo, incluindo o emissor n+, a base do tipo p, o campo de superfície traseira p+, e o contato traseiro de alumínio, juntamente com suas espessuras e materiais atribuídos.
3. Examinando o perfil de dopagem
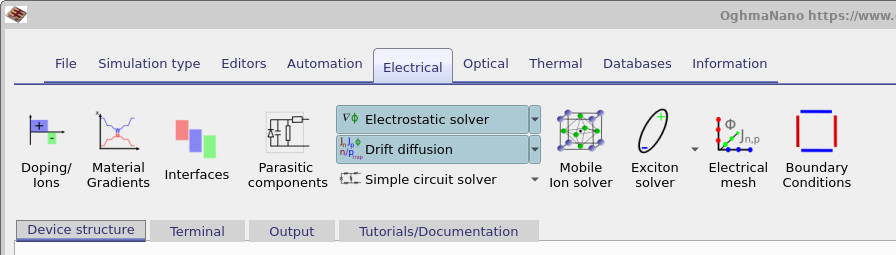
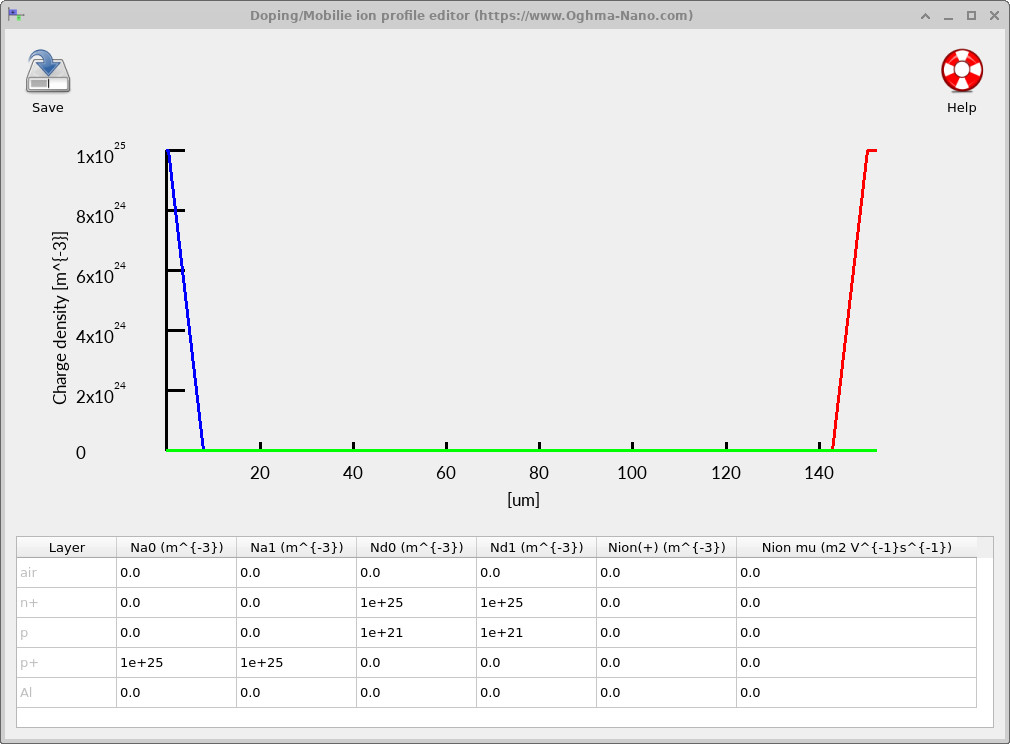
O perfil de dopagem define a paisagem eletrostática do dispositivo antes da aplicação de iluminação e polarização. Na prática, ele determina onde a junção p–n se localiza, quão larga é a região de depleção, e a magnitude do campo elétrico interno que separa os portadores fotogerados. Para uma célula solar industrial de silício, a dopagem também é usada estrategicamente para controlar a recombinação nos contatos: regiões superficiais fortemente dopadas são introduzidas para formar junções seletivas e reduzir perdas de portadores minoritários próximas aos metais.
Para visualizar a dopagem no OghmaNano, vá à faixa Elétrica na janela principal e clique em Dopagem / Íons (veja ??). Isso abre o editor de perfil (veja ??), que plota a densidade de carga versus profundidade e lista as densidades numéricas de doadores e aceitadores atribuídas a cada camada.
O dispositivo usa um perfil de dopagem padrão de silício policristalino n+/base/p+. Na superfície frontal iluminada, um emissor fino n+ é introduzido com uma concentração de doadores muito alta (atingindo um pico em \(\sim 10^{25}\,\mathrm{m^{-3}}\)), confinada aos primeiros poucos micrômetros da estrutura. Essa região fortemente dopada estabelece um forte campo elétrico próximo à superfície e fornece um contato ôhmico seletivo para elétrons para extração eficiente de portadores. A concentração do emissor então cai acentuadamente no volume do dispositivo. A região central da estrutura é o absorvedor espesso de silício (a base), que é dopada várias ordens de magnitude mais levemente (aqui \(\sim 10^{21}\,\mathrm{m^{-3}}\)). Essa região fornece o principal volume para absorção óptica e transporte de portadores enquanto mantém resistividade moderada e limita efeitos de carga espacial longe dos contatos. Na parte traseira do dispositivo, uma fina camada p+ adjacente ao contato de alumínio é fortemente dopada com aceitadores (novamente \(\sim 10^{25}\,\mathrm{m^{-3}}\)), formando um campo de superfície traseira. O campo de superfície traseira p+ molda a curvatura de bandas próximo ao contato traseiro, repele portadores minoritários da interface metálica e suprime a recombinação no contato traseiro, melhorando assim a coleta de portadores e preservando a tensão de circuito aberto.
4. Parâmetros elétricos: transporte, eletrostática e recombinação
Abra o editor de parâmetros elétricos a partir da janela principal: Estrutura do dispositivo → Parâmetros elétricos. Os parâmetros são definidos por região usando as abas n+, p, e p+ (emissor, base e campo de superfície traseira, respectivamente). As configurações neste editor determinam os coeficientes de transporte por drift–diffusion, o alinhamento energético, e os mecanismos de recombinação usados durante a varredura JV.



O transporte em cada região é definido pelas mobilidades de elétrons e lacunas. Na base p (veja ??), as mobilidades são definidas como μn = 0.03 m2V-1s-1 e μp = 0.01 m2V-1s-1, fornecendo transporte eficiente através do absorvedor espesso. Nas regiões fortemente dopadas n+ e p+ (veja ?? e ??), as mobilidades são definidas mais baixas (μn = 0.003, μp = 0.001 m2V-1s-1) para representar a mobilidade reduzida de portadores tipicamente associada a regiões de contato fortemente dopadas/policristalinas. Esses valores afetam a contribuição da resistência em série em alta corrente e os gradientes locais de portadores necessários para sustentar a extração.
As densidades efetivas de estados Nc = 2.8×1025 m-3 e Nv = 1.04×1025 m-3 (visíveis em cada aba). Juntamente com o gap de banda, esses parâmetros definem a densidade intrínseca de portadores e as populações de portadores em equilíbrio. A eletrostática é definida pela afinidade eletrônica χ = 4.05 eV, gap de banda Eg = 1.12 eV, e permissividade relativa εr = 11.7, consistentes com silício à temperatura ambiente. Esses valores definem a referência das bordas de banda, o comportamento de depleção, e o campo interno que surge quando combinados com o perfil de dopagem.
A recombinação é ativada por região. No emissor n+ fortemente dopado e no BSF p+, a recombinação Auger é ativada (botão Auger pressionado em ?? e ??), com coeficientes Cn = 2.8×10-43 m6s-1 e Cp = 9.9×10-43 m6s-1. A recombinação Auger captura o mecanismo de perda dominante em alta densidade nessas regiões; uma forma comum é \[ R_{\mathrm{Auger}} = C_n\,n^2 p + C_p\,p^2 n, \] portanto a taxa aumenta rapidamente quando as concentrações de portadores são grandes, como ocorre em camadas fortemente dopadas adjacentes aos contatos sob injeção. Incluir a perda Auger aqui evita acúmulo não físico de portadores nos contatos e produz comportamento realista de tensão e corrente quando o dispositivo é levado a alta injeção.
Na base p, a recombinação é tratada como limitada pelo tempo de vida por armadilhas Shockley–Read–Hall (SRH) usando o modelo Armadilhas SRH em equilíbrio (ativado em ??). A energia da armadilha é definida no meio do gap (Et relativo a Eg/2 = 0), com densidade de armadilhas Nt = 2×1019 m-3 e seções de choque de captura σn = σp = 1×10-20 m2. Nesta formulação de equilíbrio, as seções de choque de captura determinam os coeficientes de captura de portadores \(c_n = \sigma_n v_{\mathrm{th}}\) e \(c_p = \sigma_p v_{\mathrm{th}}\), onde \(v_{\mathrm{th}}\) é a velocidade térmica. Os tempos de vida correspondentes de elétrons e lacunas são, portanto, \[ \tau_n = \frac{1}{\sigma_n v_{\mathrm{th}} N_t}, \qquad \tau_p = \frac{1}{\sigma_p v_{\mathrm{th}} N_t}, \] ligando diretamente os parâmetros da GUI ao tempo de vida efetivo no volume. A taxa de recombinação SRH resultante assume a forma padrão \[ R_{\mathrm{SRH}} = \frac{np - n_i^2}{\tau_p (n+n_1) + \tau_n (p+p_1)}, \] onde \(n_1\) e \(p_1\) são definidos pelo nível de energia da armadilha \(E_t\). Como o volume gera a maior parte da fotocorrente, a recombinação SRH na base é o mecanismo primário que controla Voc neste tutorial, enquanto as perdas Auger ficam confinadas principalmente às regiões superficiais fortemente dopadas. Uma discussão detalhada da teoria SRH é dada em Recombinação Shockley–Read–Hall, a motivação física para incluir armadilhas em Por que armadilhas são necessárias, e a formulação totalmente fora do equilíbrio em Modelagem SRH dinâmica (fora do equilíbrio).
5. Perfil de geração óptica
Esta demonstração usa um cálculo óptico unidimensional para gerar um termo fonte dependente da profundidade para o solver de drift–diffusion. Na prática, o modelo óptico calcula como o espectro incidente AM1.5 se propaga no silício, quanto é absorvido em função do comprimento de onda e da profundidade, e converte essa potência absorvida em uma taxa de geração de pares elétron–lacuna. Em uma célula solar de silício, o perfil óptico fixa em grande parte Jsc, enquanto Voc é então definido pelo balanço entre geração e recombinação.
Para visualizar (e regenerar) a solução óptica, vá à faixa Óptica na janela principal e clique em Matriz de transferência. Isso abre o editor de simulação óptica. Pressione o botão azul Executar simulação óptica (o ícone de play) para calcular o campo óptico e atualizar os gráficos (veja ??).
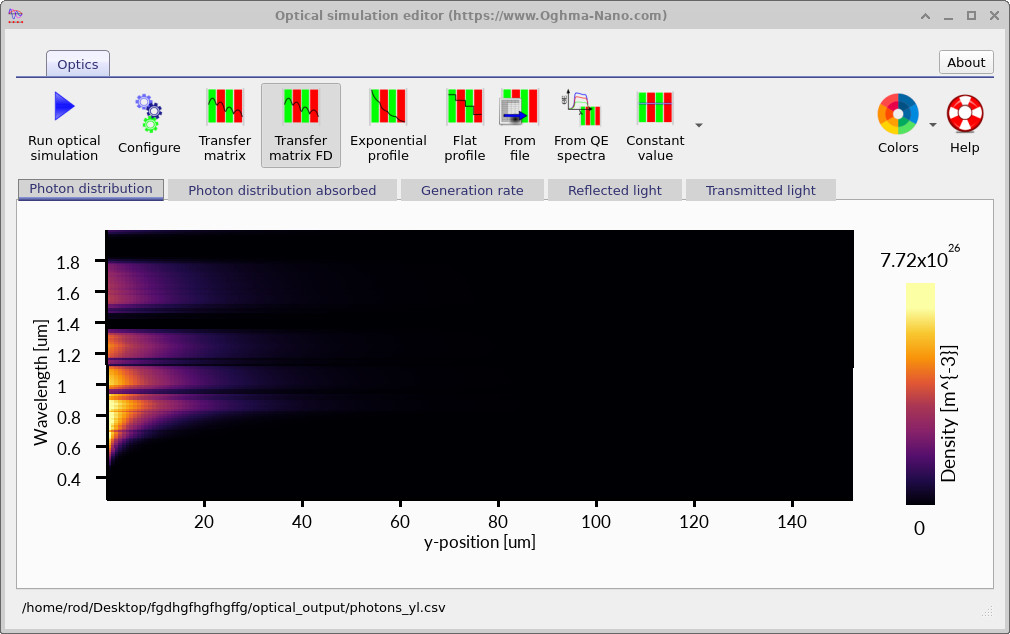
O gráfico em ?? é um mapa de comprimento de onda–profundidade. O eixo horizontal é a profundidade no dispositivo (rotulado como posição y), e o eixo vertical é o comprimento de onda. Cores brilhantes próximas à superfície iluminada indicam uma alta população de fótons; o desvanecimento rápido com a profundidade mostra que a luz está sendo absorvida à medida que se propaga no silício.
Para silício policristalino, esse comportamento concentrado na frente é esperado. O silício absorve fortemente em comprimentos de onda menores, então fótons azuis/visíveis se esgotam muito rapidamente perto da superfície frontal, enquanto comprimentos de onda maiores penetram mais antes de serem absorvidos. Portanto, você deve ler o mapa de baixo para cima: comprimentos de onda curtos morrem perto da frente; comprimentos de onda maiores se estendem mais profundamente. Em comprimentos de onda acima de aproximadamente 1.1 µm, a energia do fóton está abaixo do gap do silício, então esses fótons não promovem geração banda-a-banda de portadores e contribuem pouco para a corrente fotovoltaica, mesmo que estejam presentes no espectro.
O editor óptico fornece várias abas porque “densidade de fótons” não é a mesma coisa que “taxa de geração”. A visualização Distribuição de fótons (mostrada acima) informa onde o campo óptico existe. As abas Distribuição de fótons absorvidos e Taxa de geração são as que importam para o modelo elétrico: o mapa de fótons absorvidos é convertido em uma taxa de geração de pares elétron–lacuna dependente da profundidade, que é o termo fonte injetado nas equações de drift–diffusion. Para esta célula, o perfil de geração resultante atinge o pico próximo à frente e decai na base, consistente com um dispositivo de junção n+/p iluminado pela frente.
6. Executando a simulação, curvas JV e extração de parâmetros
Uma vez que a estrutura do dispositivo, os parâmetros elétricos e a geração óptica estejam definidos, a simulação pode ser executada diretamente a partir da janela principal. Clique no botão Executar simulação na barra de ferramentas para iniciar o solver. Durante a execução, o progresso do solver e as informações de convergência são gravados na janela do terminal (veja ??).
Embora a saída do terminal pareça detalhada, ela segue uma estrutura clara. Para cada ponto de polarização, a tensão aplicada no contato superior é listada primeiro, seguida pela densidade de corrente resultante. Sob iluminação, a corrente é inicialmente negativa, indicando geração de potência. À medida que a tensão aplicada é aumentada, a magnitude da corrente diminui até cruzar zero na tensão de circuito aberto. Além desse ponto, a corrente se torna positiva, correspondendo à operação de diodo polarizado diretamente. A saída do terminal também informa a tensão e a corrente no contato inferior, o resíduo do solver (erro), e o tempo necessário para convergir cada passo de polarização. Resíduos pequenos indicam que as equações acopladas de drift–diffusion e Poisson estão sendo resolvidas com precisão.


jv.csv e siminfo.dat.
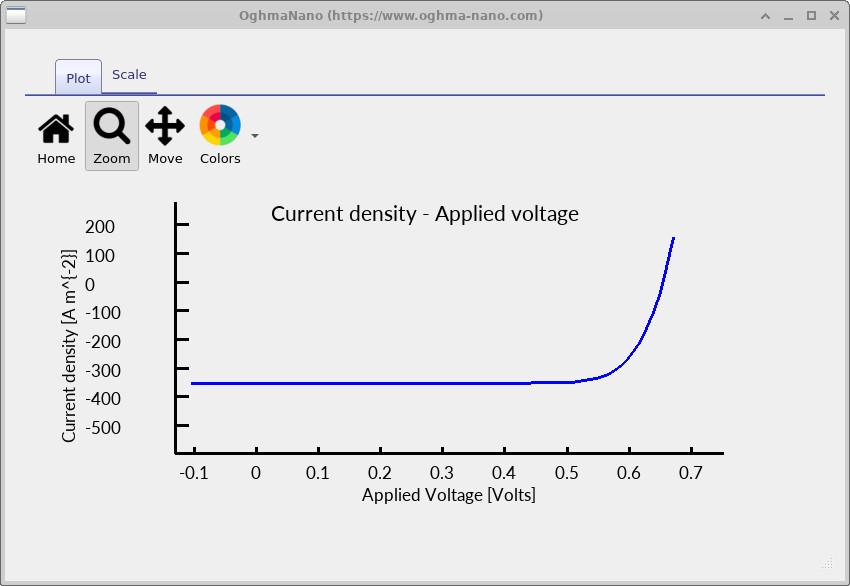
jv.csv. A curva mostra corrente negativa em baixa tensão,
um cruzamento em corrente zero em Voc, e condução direta em polarização mais alta.

siminfo.dat, listando métricas extraídas do dispositivo
como Voc, Jsc, fator de preenchimento e eficiência.
Para inspecionar as características elétricas, abra a aba Saída e clique duas vezes em
jv.csv. Isso exibe a curva de densidade de corrente–tensão (JV)
(veja ??).
A curva JV é o principal diagnóstico do comportamento do dispositivo: ela deve passar pela corrente de curto-circuito
em polarização zero e cruzar corrente zero na tensão de circuito aberto.
Clicar duas vezes em siminfo.dat abre a janela de informações da simulação
(veja ??),
que informa as métricas extraídas de desempenho, incluindo fator de preenchimento, eficiência de conversão de potência,
ponto de potência máxima, Voc, e Jsc.
Quantidades diagnósticas adicionais, como densidades de portadores livres em circuito aberto, também são listadas e são
úteis para interpretar o comportamento limitado por recombinação.
Uma regra prática é sempre inspecionar a curva JV antes de interpretar as métricas numéricas.
Se a curva JV não passar de forma limpa por curto-circuito e circuito aberto, ou se a corrente apresentar um
sinal ou forma inesperados, as quantidades derivadas em siminfo.dat também serão pouco confiáveis.
Na prática, a inspeção visual da curva JV é a forma mais rápida de diagnosticar problemas de configuração ou modelagem.
7. Examinando snapshots internos: bandas e níveis de quase-Fermi
Durante uma varredura JV, o OghmaNano salva a solução interna completa em cada ponto de polarização no diretório snapshots. Esses arquivos de snapshot contêm o estado interno do dispositivo—bordas de banda, níveis de quase-Fermi, densidades de portadores, correntes e quantidades relacionadas—e são a forma mais direta de verificar o que o solver está fazendo dentro da estrutura, em vez de inferir o comportamento apenas pela curva JV.
Abra a aba Saída, localize a pasta snapshots, e clique duas vezes nela para iniciar o visualizador de snapshots. O visualizador é uma janela interativa de plotagem que pode sobrepor múltiplas variáveis internas nos mesmos eixos e permite percorrer os pontos de polarização salvos usando o controle deslizante de tensão.
Para reproduzir o gráfico de bandas/quase-Fermi usado neste tutorial, adicione quatro traços usando o botão +.
Em Arquivo para plotar, selecione (nesta ordem) Ec.csv, Ev.csv, Fn.csv, e Fp.csv.
Eles correspondem à borda da banda de condução (Ec), borda da banda de valência (Ev),
nível de quase-Fermi de elétrons (Fn), e nível de quase-Fermi de lacunas (Fp).
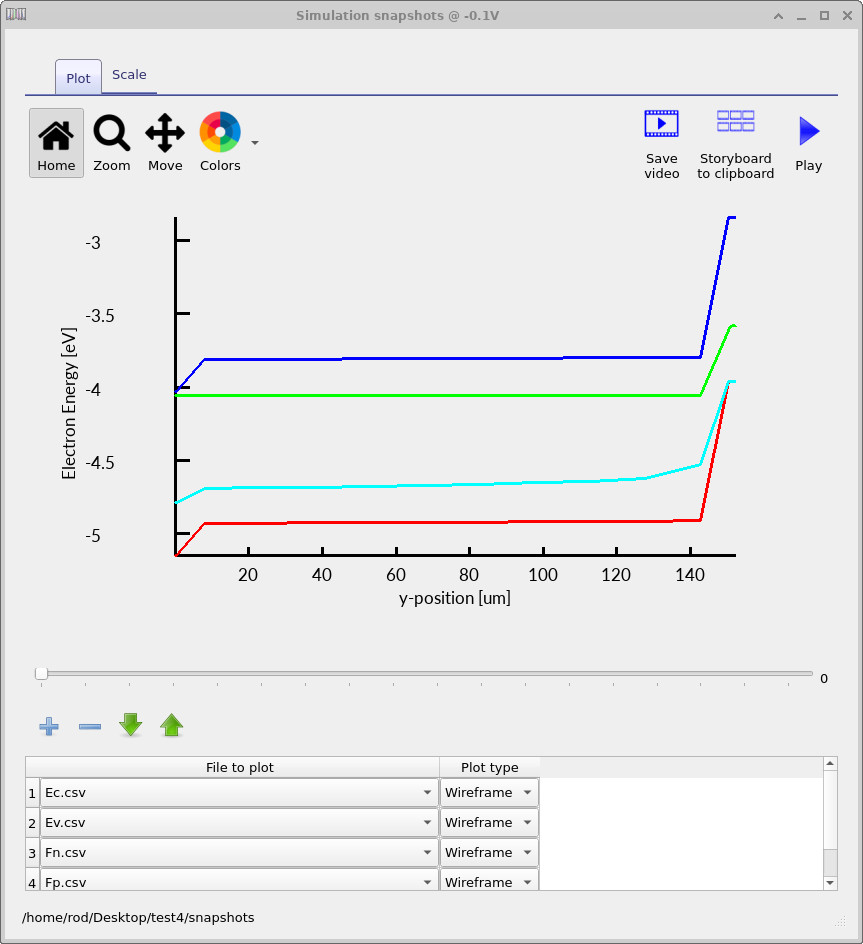
Ec, Ev, Fn, e Fp.
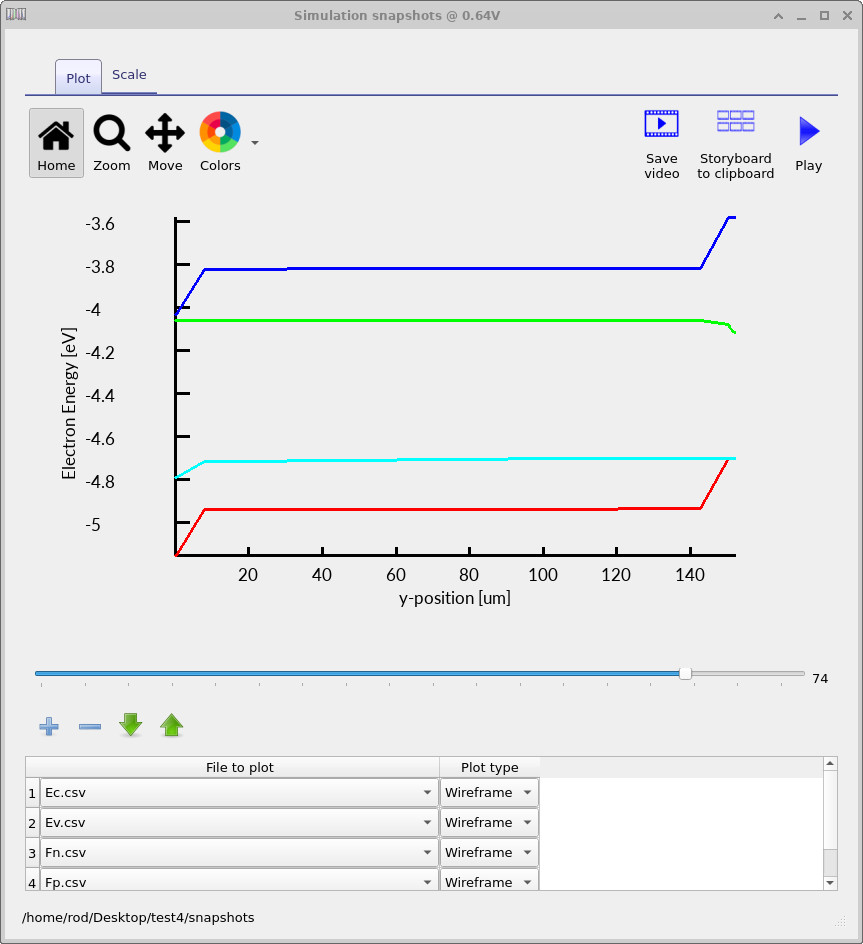
Ec, Ev, Fn, e Fp.
Use o controle deslizante de tensão para percorrer a varredura JV de curto-circuito até circuito aberto e observe como as energias internas evoluem à medida que a corrente extraída é reduzida. Em curto-circuito (veja ??), o dispositivo opera em um regime de extração de corrente: os portadores fotogerados são removidos através dos contatos seletivos e uma força motriz de transporte finita deve ser sustentada. Na forma drift–diffusion, as correntes de elétrons e lacunas são dadas por \[ J_n = \frac{\sigma_n}{q}\,\nabla E_{Fn}, \qquad J_p = -\frac{\sigma_p}{q}\,\nabla E_{Fp}, \] portanto, uma corrente terminal não nula requer um gradiente espacial em pelo menos um dos níveis de quase-Fermi. Em estruturas com contatos seletivos, esse gradiente não precisa ser compartilhado igualmente: um nível de quase-Fermi pode permanecer relativamente plano (por exemplo, se estiver fortemente fixado por um contato ôhmico de portador majoritário) enquanto o outro carrega a maior parte da variação que impulsiona o transporte. As próprias bordas de banda não precisam ser planas e tipicamente exibem curvatura pronunciada próximo a regiões fortemente dopadas e contatos.
À medida que a tensão aplicada é aumentada em direção ao circuito aberto, a corrente terminal líquida diminui e a solução
se aproxima de um estado estacionário de corrente zero. No interior do dispositivo, os níveis de quase-Fermi tornam-se aproximadamente planos
porque tanto a corrente de elétrons quanto a de lacunas se anulam,
\[
J_n \approx 0, \qquad J_p \approx 0,
\]
enquanto as bordas das bandas de condução e valência geralmente permanecem curvadas devido à eletrostática interna decorrente de
gradientes de dopagem, carga espacial e seletividade dos contatos. Em dispositivos com contatos seletivos, pequenos desvios da
planicidade perfeita dos níveis de quase-Fermi podem persistir em camadas de contorno estreitas adjacentes a contatos bloqueadores de portadores;
estes refletem condições de contorno de fluxo zero para a espécie de portador bloqueada, e não fluxo de corrente. Em circuito aberto
(veja ??),
a fotogeração é equilibrada pela recombinação em todo o dispositivo, e a separação entre os níveis de quase-Fermi de elétrons e lacunas no volume,
\[
qV_{\mathrm{oc}} = E_{Fn} - E_{Fp},
\]
é a origem microscópica da tensão de circuito aberto reportada em siminfo.dat. Ao passar de curto-circuito para
circuito aberto usando o controle deslizante, a principal assinatura a observar é o relaxamento dos gradientes que impulsionam o transporte
no interior do dispositivo enquanto a separação dos níveis de quase-Fermi persiste.
8. Curvas Suns–Voc
Medições Suns–Voc investigam como a tensão de circuito aberto evolui com a intensidade de iluminação. Como o Voc é definido pela separação dos níveis de quase-Fermi de elétrons e lacunas, sua dependência com a intensidade de luz fornece informação direta sobre os mecanismos dominantes de recombinação no dispositivo. Em princípio, uma curva Suns–Voc pode ser construída executando um grande número de varreduras JV iluminadas e extraindo Voc em cada intensidade. Em vez de construir uma sequência de curvas JV e extrair Voc manualmente, o OghmaNano fornece um modo dedicado de simulação Suns–Voc. Para ativá-lo, abra a faixa Tipo de simulação na janela principal (veja ??) e selecione Suns–Voc. Isso muda o solver de uma varredura de tensão para uma varredura de intensidade realizada explicitamente em circuito aberto.
Após selecionar Suns–Voc, clique em Executar simulação.
Para cada nível de iluminação, o solver ajusta a tensão terminal até que a
corrente líquida seja zero, calculando assim diretamente o ponto operacional de circuito aberto.
Os dados resultantes são gravados automaticamente em disco e podem ser inspecionados na
aba Saída. Entre os arquivos gerados está suns_voc.csv, que contém a tensão de circuito aberto
em função da intensidade luminosa.
Clicar duas vezes neste arquivo abre o gráfico de Voc–intensidade mostrado em
??.


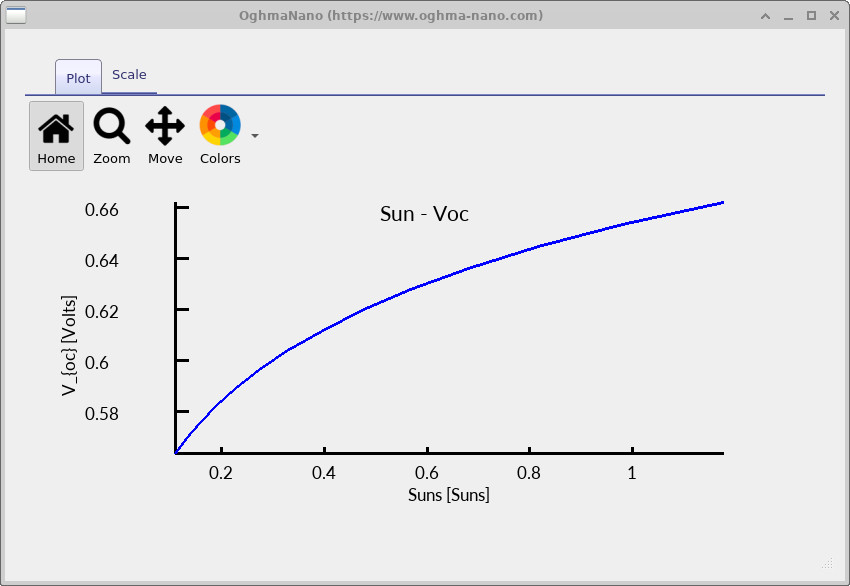
Em baixa iluminação, Voc aumenta rapidamente com a intensidade luminosa, consistente com a dependência logarítmica da separação dos níveis de quase-Fermi com a densidade de portadores. À medida que o nível de iluminação aumenta, a inclinação da curva Voc–intensidade diminui, sinalizando que a recombinação está limitando cada vez mais ganhos adicionais de tensão. Para expor essa transição com mais clareza, estenda a faixa de iluminação para intensidades mais altas. Abra o Editor Suns–Voc a partir da faixa Editores e aumente a intensidade final de 1.1 para 100 sóis, então execute novamente a simulação.


Execute novamente a simulação e abra suns_voc.csv outra vez.
A faixa estendida de iluminação revela o comportamento de Voc em alta intensidade.
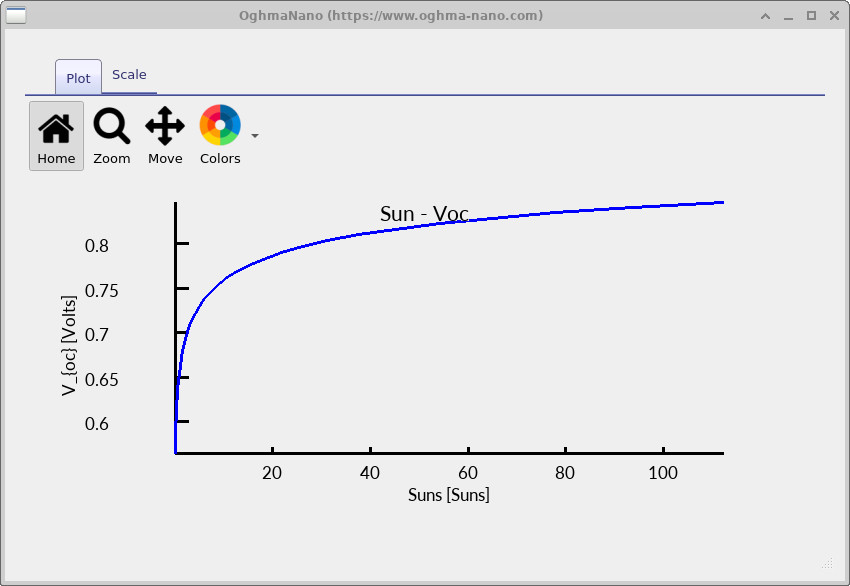
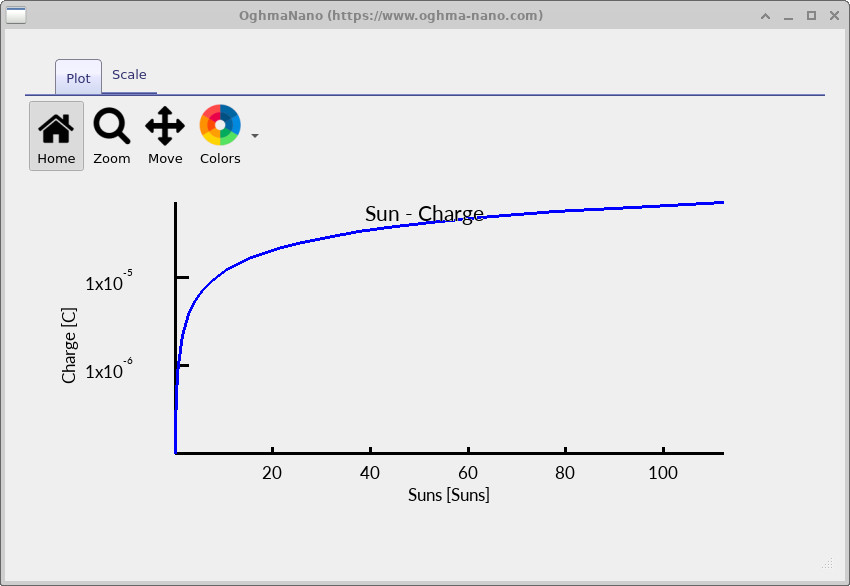
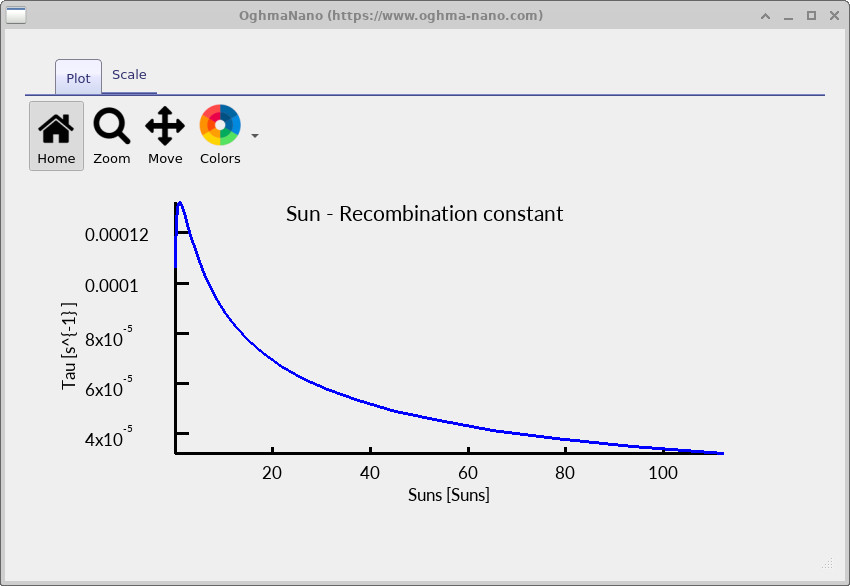
À medida que o nível de iluminação aumenta, a densidade total de portadores em excesso no dispositivo cresce. Em condições de circuito aberto, essa carga deve se recombinar localmente, de modo que a taxa de recombinação em regime estacionário aumenta com a densidade de portadores. Para processos de recombinação banda-a-banda e assistidos por defeitos, a taxa de recombinação escala aproximadamente como R ∝ n p, enquanto a recombinação Auger introduz um termo adicional em alta densidade RAuger ∝ n2p + np2. Como resultado, o tempo de vida efetivo dos portadores τeff = Δn / R diminui à medida que a iluminação aumenta.
A tensão de circuito aberto é definida pela separação dos níveis de quase-Fermi, qVoc = EFn - EFp , que, para um semicondutor não degenerado, pode ser escrita como Voc = (kT/q) ln(n p / ni2) . Aumentar a iluminação eleva a densidade de portadores e, portanto, aumenta Voc, mas apenas de forma logarítmica. Quando a recombinação acelera suficientemente, aumentos adicionais na densidade de portadores produzem ganhos decrescentes na separação dos níveis de quase-Fermi.
Essa competição entre geração e recombinação faz com que Voc sature em alta iluminação. A tensão máxima permanece abaixo do gap do silício (Eg = 1.12 eV), porque a recombinação impede que os níveis de quase-Fermi de elétrons e lacunas atinjam simultaneamente as bordas de banda. A diferença Eg/q − Voc representa, portanto, a perda intrínseca de tensão imposta pela recombinação sob condições de alta injeção para este dispositivo.